Si(100)�ĵ���CeO2��Ĥ�����弤���Ʊ��������о�
������ɫ�����о���Ժ�Ƚ����Ӳ����о���
ժ Ҫ��
��CeO2�մɰв�,ʹ�����弤�����(PLD)������Si(100)�ĵ����Ʊ���CeO2��Ĥ���о��˳ĵ��¶ȡ�������ѹ�Ա�Ĥ���ܵ�Ӱ��,ʵ���Ʊ����˸߶�(111)ȡ���CeO2��Ĥ��ʹ��X��������(XRD)������ʽ���ܵ�������(RHEED)�Ա�Ĥ���о���ṹ�ı������������:���ųĵ��¶ȵ�����,��Ĥ�еIJ�����Ӧ��(��Ӧ��)����Ӧ����С,��Ĥ�ᾧ�����������,��������ѹ�Դ�Ӱ���С��RHEEDͼ����ʾʹ��PLD������Si�ĵ��ϳ����ı�Ĥ�߱��ϸߵĽᾧ�Լ�ԭ�Ӽ�ƽ���ı��档ʹ��ԭ��������(AFM)����Ʒ���б���ֲڶȷ���,���ֲ�ͬ�¶��������ı�Ĥ�����й⻬�ı���,�������ֲڶ�(RMS)����0.4 nm���¡�ʹ��Keithley4200�뵼������ǡ���ƫ�ǶԱ�Ĥ���е����ܼ���ѧ���ܷ���,���ֳĵ��¶ȶԱ�Ĥ�ĵ�ѧ����������Ӱ��,����CeO2��Ĥ�ᾧ״̬���ѧ������ֱ�ӵ���ϵ��
�ؼ��ʣ�
��ͼ����ţ� TB43
����飺����(1986-),��,����������,˶ʿ�о���;�о�����:��Ĥ����;��־��(E-mail:power@grinm.com);
�ո����ڣ�2011-03-22
����������Ȼ��ѧ����ίԱ����й����������о�Ժ���ϻ���������Ŀ(11076005);
Fabrication and Properties of High Orientated CeO2 Thin Film on Si(100) Substrate by Pulsed Laser Deposition
Abstract��
Thin films of CeO2 were grown on Si(100)single crystal substrates by pulsed laser deposition using CeO2 ceramic target.The influence of substrate temperature and oxygen pressure on the properties of the film was studied.Strong preference for CeO2(111) orientation thin film was achieved.The structural characteristics of CeO2 thin films were characterized by X-ray diffraction(XRD),reflection high-energy electron diffraction(RHEED).Experimental results showed that macro-stress and micro-stress in the film decreased with the increase of substrate temperature while deposition pressure had little influence on this.RHEED image showed that a perfect crystallinity and smooth surface were achieved by PLD.Based on the AFM analysis,all the RMS of the films deposited at different temperatures were less than 0.4 nm and almost independent with substrate temperature.The electrical and optical characteristics of the film were analyzed by using Keithley 4200 and ellipsometer,respectively.The results showed that substrate temperature had significant influence on the electrical characteristics of CeO2 thin film and the direct relationship between electrical characteristics and crystallinity was proved.
Keyword��
CeO2;thin film;pulsed laser deposition(PLD);
Received�� 2011-03-22
CeO2�������������ƽṹ, ������0.541 nm, ��Si������(0.543 nm)��ʧ���ֻ��0.35%, �������õĸ����ȶ���, �������SOI�ṹ��Ե����
CeO2��Ĥ�ĵ�ѧ�� ��ѧ�����������Ʊ��������ղ����� һ�����, �ϵ͵���ѹ�ͽϸߵijĵ��¶��������������������
1 ʵ ��
ʵ��ѡ�����������մɰ�(99.9%)�������弤��ij����� �в���������۾������ս��Ƴɡ� ��Ĥϵͳ���й���ѧԺ������ѧ������������PL-450���弤�����ϵͳ, ������Ϊ�¹�Lambda Physik��˾��KrF���Ӽ�����(248 nm, 20 ns, 1��50 Hz), ʵ��ѡ��(100)ȡ��Ĺ赥��(P�� 2��5 ����cm)���ĵ�, ����RCA��ϴ������ϴ��Ѹ�ٷ�����ճ�����, Ȼ����ճ�����1��10-5 Pa�� ���弤������150 mJ/pulse, �ظ�Ƶ��1 Hz, �в���ĵ���7 cm, �ĵ��¶���27��600 ���仯, ����ѹ�仯��Χ��5��10-4��15 Pa��
��Ĥ�ľ���ṹ��X��������(XRD)���б���, ����XRD����/2��ɨ���ȡ��Ĥ�ر��淨�߷����ȡ����Ϣ, ��ɨ���ȡ��Ĥ������ȡ����Ϣ�� ��Ĥ�ı���ԭ�ӽṹ�÷���ʽ���ܵ�������(RHEED)�۲졣 ��ԭ��������(AFM)�Ա�Ĥ���б���ֲڶȷ����� ʹ��Keithley 4200�뵼������ǡ� ��ƫ�ǶԱ�Ĥ���е�ѧ���ܼ���ѧ���ܷ�����
2 ���������
2.1 ��Ĥ�ľ���ṹ����
ͼ1(a)�Dz�ͬ�ĵ��¶����Ʊ���Ĥ��XRD ��/2��ɨ��ͼ�ס� ��ͼ�п��Կ����ڸ�ѡ���¶���, �������ı�Ĥ����(111)����ȡ�� ����ʱ, �����ǿ�Ⱥ���, ˵����Ĥ�Ľᾧ�Ȳ��ߡ� ���ĵ��¶ȹ̶���600 ��, ����ѹ��5��10-4 Pa������15 Pa, ��ĤXRD����ͼ����ͼ1(b)��ʾ, ��ͼ�п��Կ���, ��5��10-4��15 Pa�ϴ�ij�������ѹ��Χ��, ��Ĥ������(111)ȡ��, ���κ��ӷ塣 ������/2��ɨ��ͼ���п�������ѹ�Ա�Ĥ�ᾧ״̬��Ӱ�������
��������Ĥ��ƷXRD(111)������λ�� ��߿����в���, �������1��ʾ, �������: (1) ���ųĵ��¶ȵ�����, ��Ĥ(111)����忪ʼ����, �ӽ�CeO2����λ(28.54��); ͬʱ��Ĥ(111)�����İ�߿���С�� (2) ������, ��ѹ�Ա�Ĥ�����λ����߿���Ӱ���С�� ������ʵ������֪���ųĵ��¶ȵ�����, ��Ĥ�еIJ�����Ӧ��(��Ӧ��)��С
ͼ1 XRD ��/2��ɨ��ͼ��
Fig.1 XRD patterns of CeO2 film
(a) Different temperature; (b) Different oxygen pressure
�ĵ��¶ȵ�����, �ܹ��������ԭ�ӵĻ����, �Ӷ����Ʊ�Ĥ������ �㹻�ߵijĵ��¶Ȳ��ܱ�֤��Ĥ�ᾧ�����������, ʹ������ԭ�ӻ������Ÿ������ڳĵױ�����ɢ, ���������ϵ͵ľ�����λ��, �ͷ�Ӧ��, ��߽ᾧ������ ���, �����¶ȵ�����, ��Ĥ�ᾧ����������ߡ� ��PLD������, ��ѹ�������������ӵ����ɳ�, ��ѹԽ��, �������ӵ����ɳ�Խ��, ���ӵ���ĵ�ǰ��������ӵ���ײ����Ҳ����Ӧ����, �Ӷ��������䵽�ĵױ������ӵĶ��ܼ�С�� �������������ļ�С, �ή�������ڳĵױ������ɢ����, �������κ˽ᾧ, Ȼ���ڱ�ʵ����, ��û�й۲쵽��Ĥ�ᾧ��������ѹ�������Եı仯�� ��������, �������������ԭ��, ���ȳĵ��¶���600 ��ʱ, �ܹ���֤���������ڱ����ֵ���ɢ�κ�; ����, ��ʵ�����õļ���������, �������ӱ������кܸߵ�����, ��������ײ�����ĵ�������ռ������С��
Ϊ�˽�һ����ȡ��Ĥ����ṹ�������Ϣ, �Ա�Ĥ��Ʒ����XRD ��ɨ��, ���ڸ�����¶Ա�Ĥ�������RHEED�۲⡣ ͨ����ҡ�����߰�߿��IJ���, ���ֱ�Ĥ������ȡ���������Ǻܺ�, ����600 ��, 0.5 Pa�������Ʊ�����Ʒ������Խ�С��߿�(4.23��), ��ͼ2��ʾ�� ͼ3����Ʒ�����RHEEDͼ��, ͼ�е����仨���������Եĵȼ������״����, ˵��ʹ��PLD������Si�ĵ��ϳ����ı�Ĥ�߱��ϸ߽ᾧ���Լ�ԭ�Ӽ�ƽ���ı���, �����άԭ��������������
2.2 ����ֲڶȷ���
��0.5 Pa, ��ͬ�¶����Ʊ��ı�Ĥ��Ʒ����AFM������ò����
��1 ��ͬ�¶ȡ� ��ѹ�±�Ĥ(111)�������Ϣ
Table 1 Information of (111) peak
| Parameters | Temperature/�� | Oxygen pressure/Pa | ||||||
| 200 | 400 | 600 | 5��10-4 | 0.05 | 0.5 | 5 | 15 | |
| Peak/(��) | 28.06 | 28.22 | 28.26 | 28.62 | 28.24 | 28.26 | 28.26 | 28.30 |
| FWHM/(��) | 0.84 | 0.66 | 0.58 | 0.57 | 0.58 | 0.56 | 0.58 | 0.52 |


2.3 ��Ĥ��ѧ���ܷ���
ͼ5��0.5 Pa��ѹ��, ��ͬ�¶������� ���20 nm�������污Ĥ�Ʊ���MOS���ݽṹ���C-U, I-U���Խ���� ��ͼ�н����֪, ��ͬ�¶��������ı�Ĥ��糣������С, ����C-U�������߾����н�խ�Ļ��ʹ��ڡ� �����¶Ƚ���, ��ĤC-U������������Ư�ơ� ������, ��Ϊ�����³����ı�Ĥ, ���ڽᾧ�IJ������Ի��γɴ�����ȱ��, ����Щȱ���ڵ糡�����»��γɹ̶����, �Ӷ����C-U���ߵ�Ư��
ͼ6��600 ��, ��ͬ��ѹ�������� ���20 nm�������污Ĥ�Ʊ���MOS���ݽṹ���C-U, I-U���Խ���� ��ͼ�н����֪, ��ͬ��ѹ�������ı�Ĥ��糣������С, ����C-U����Ư�Ƴ̶�Ҳû��ͼ5(a)����ʾ��ô����; ����, �ڵ����(0.05��15 Pa)�³�����CeO2��Ĥ, ©��������������ѹ�ı���仯�� Ȼ����5��10-4 Pa(�����)�³����ı�Ĥ, ©�������������Ʒ������������, ������������ڽϸߵ���ն���, �����ı�Ĥ�д��ڴ���������λ, �Ӷ�ʹ�ñ�Ĥ���ֳ�һ���İ뵼�����ԡ� �������˵��, ����������ѹ�Ա�Ĥ������Ӱ���С��
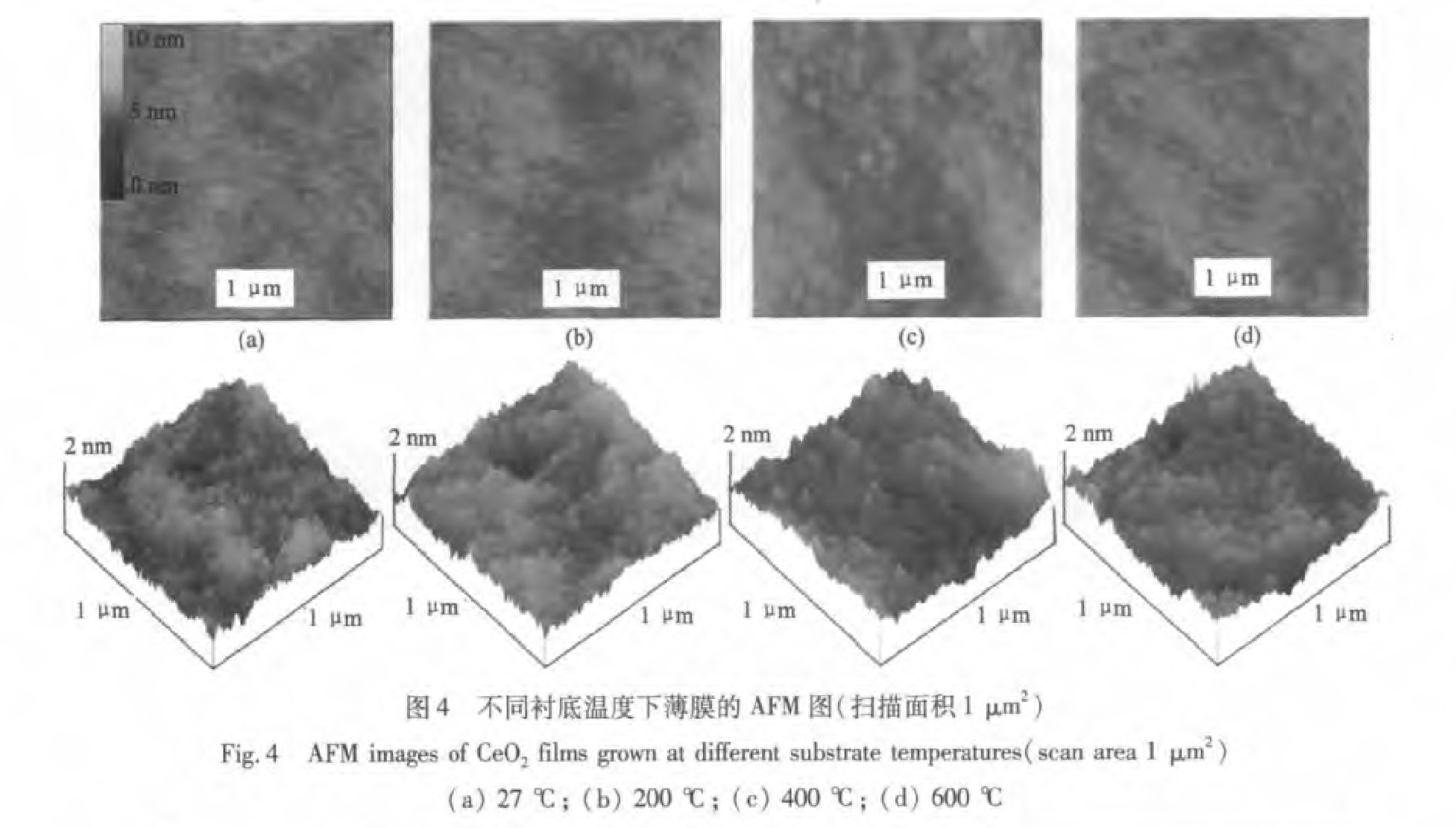

ͼ6 ��ͬ��ѹ�³�����Ĥ����������
Fig.6 Electrical characteristics of the film with different oxygen pressure
(a) C-U; (b) I-U
�ۺϷ���, �ĵ��¶ȶ�CeO2��Ĥ��ѧ����Ӱ������, ��������ѹ��CeO2��Ĥ��ѧ����Ӱ���С�� �������XRD�������, �ĵ��¶������ܹ���߱�Ĥ�ᾧ����, ��������ѹ�Խᾧ״̬Ӱ���С, ��˿��Եó�CeO2��Ĥ�Ľᾧ״̬�������֮�����ֱ�ӵ���ϵ, ��߱�Ĥ�ᾧ������������ߵ�ѧ���ܡ�
2.4 ��Ĥ��ѧ���ܷ���
ʹ����ƫ����632.8 nm�Ĺ�Դ��, �Ժ��Ϊ60 nm�ı�Ĥ��Ʒ�����������ʵIJ���, �������2��ʾ��
��2 ��Ĥ������
Table 2 Refractive index of the film
| Temperature/�� | 200 | 600 | ||
| Oxygen press/Pa | 5��10-4 | 5 | 5��10-4 | 5 |
| n | 2.405 | 2.442 | 2.392 | 2.427 |
���н������, ����ѡʵ���������Ʊ���CeO2��Ĥ, �������ʼ�����2.4����, �dz��ӽ�����������ϵĹ�ѧ����(n=2.40��2.56)
3 �� ��
1. ��CeO2�մɰ�, ʹ��PLD�������Ʊ����߽ᾧ������ �߱���ƽ����, �������õ�ѧ�� ��ѧ���ܵ�CeO2��Ĥ, �Ʊ����ղ����Ա�Ĥ���������Žϴ��Ӱ�졣
2. �ĵ��¶ȶ�CeO2��Ĥ�ᾧ״̬����ѧ����Ӱ������, �ϸߵijĵ��¶������ڱ�Ĥ�ᾧ��������ѧ���ܵ���ߡ� ������ѹ�Ա�Ĥ������Ӱ���С, Ȼ��һ������ѹ�ܹ���֤��Ĥ���нϵ͵�©������ CeO2��Ĥ�Ľᾧ״̬�������֮�����ֱ�ӵ���ϵ, ��߱�Ĥ�ᾧ������������ߵ�ѧ���ܡ� ����, ʹ��PLD����, �ĵ��¶ȶԱ�Ĥ����ֲڶ�Ӱ���С��
3. ʹ��PLD�����Ʊ���CeO2��Ĥ��ѧ�����dz��ӽ������������, ���Ҷ��Ʊ����ղ�����̫���С�
�����
[11] Mario.Birkholz.Thin Film Anaysis by X-Ray Scattering[M].Wiley-Vch Verlag GmbH&Co.KGaA,2006.85.