a-C��F��H��Ĥ�Ļ�ѧ���ṹ
Ф����1, 2, �� ��1, 2, ������1, 2, ���۷�1, ����ɽ2, ������3
(1. ���ϴ�ѧ ������ѧ�뼼��ѧԺ, ��ɳ 410083; 2. ���ϴ�ѧ ���Ͽ�ѧ�빤��ѧԺ, ��ɳ 410083;
3. �Ϻ�������ѧ �����빤��ѧԺ, �Ϻ� 200093)
ժ Ҫ��
ʹ��CF4��CH4ΪԴ����, ������Ƶ����������ǿ��ѧ���������, �Ʊ���a-C��F��H��Ĥ��Ʒ�� �������������ǡ� ����Ҷ�任��������ǡ� X���߹����������(XPS)�Ա�Ĥ�Ľṹ�����˲��Ժͷ����� �о�����: ��Ĥ�ʿռ���״�ṹ, Ĥ��̼����� ��Ľ����Ҫ��sp3��ʽ����, ��sp2��ʽ�ĺ�����Խ���; �ڱ�Ĥ����Ҫ����C��Fx(x=1, 2, 3)�� C��C�� C��H2�� C��H3���Լ�������C-C��ѧ��; ͬʱ, ��Ĥ��C��C��F���ĺ�����C��C��F2���ĺ���Ҫ�ߡ� �ڲ�ͬ�����³����ı�Ĥ, �仯ѧ���ṹ���Բ�ͬ��
�ؼ���: a-C��F��H��Ĥ; ����������ǿ��ѧ�������; �ͽ�糣��; ��ѧ�� ��ͼ�����: TN304.55
���ױ�ʶ��: A
Chemical bands structure of fluorinated amorphous carbon films
XIAO Jian-rong1, 2, XU Hui1, 2, LI You-zhen1, 2, LIU Xiong-fei1,MA Song-shan2, JIAN Xian-zhong3
(1. School of Physics Science and Technology,Central South University, Changsha 410083, China;
2. School of Materials Science and Engineering,Central South University, Changsha 410083, China;
3. School of Electric and Engineering,University of Shanghai Science and Technology, Shanghai 200093, China)
Abstract: Fluorinated amorphous hydrogenated carbon (a-C��F��H) thin films were deposited by radio frequency plasma enhanced chemical vapor deposition (PECVD) reactor with CF4 and CH4 as source gases, at RF-power of 150W or 200W, and 100��. The structure of the films was investigated by Raman spectroscopy, and it is found that the content of the hybrid-bonding configuration of sp3 is more than that of sp2. The component and chemical bands structure of the films were investigated by infrared (IR) absorption and X-ray photoelectron spectroscopy (XPS). The results of IR and XPS analysis suggest that the chemical bonding structures in the films are mainly C��Fx(x=1, 2, 3), C��H2, C��H3, C��C and unsaturated bonding of C-C. The relative content of C��C��F is much more than that of the C��C��F2 in these films. The chemical bonding structures change with different deposition power.
Key words: a-C��F��H thin films; plasma enhanced chemical vapor deposition(PECVD); low dielectric constant; chemical bands
��������̼(a-C��F��H)��Ĥ��һ�����Ͳ���, ���������ͽ�糣���Ľ���Ĥ�� ����Ħ��Ĥ�� �����ʵ�ɫɢС�Ŀ�����Ĥ�� ����ǿ���յı���Ĥ[1-3]�� a-C��F��HĤ���в�ͬ���������������ڱ�Ĥ�ڲ�̼�Ľ�Ϸ�ʽ�ͷ��� ��IJ�ͬ�����������, ������һ������̼������, ��Ĥ�е���Ҫ�ɷ���̼, ��̼ԭ���ܹ���3�ֲ�ͬ���ӻ���ʽsp1�� sp2�� sp3�γɻ�ѧ��, �γɸ��ӵĿռ���״�ṹ, ��������ͬ���ʵ�����ʯĤ�� ��ʯīĤ����ۺ���Ĥ�� ���, ����a-C��F��H��Ĥ�ڵ���ּ���ѧ���ṹ���о���Ĥ�����������кܴ�İ����� Ŀǰ, ��a-C��F��H��Ĥ���о�, �о���ȡ����һЩ��Ҫ�ijɹ�, ��Ҫ���о��˱�Ĥ���Ʊ�������������ʡ� ��ѧ���ʺ�ѧ���ʵĹ�ϵ, ���������ĵ硢 ��ѧ����Ҳ���˽�������о�, �Լ��о��˱�Ĥ�Ľ�糣�������ȶ��ԵĹ���[4-6]�� ������Ĥ���ʱ仯ԭ��ı�Ĥ��ֺͻ�ѧ���ṹ���о�����ȫ���������, Jung��[7]ͨ���о��õ���Ĥ��ֻ����C��Fx��C��CFx�Ȼ�ѧ��; Jeong��[8]����������˻�Ա�Ĥ�ṹ��Ӱ��, �õ���Ĥ����Ҫ����CF�� F2C-C��FC-C�Ȼ�ѧ��; Valentini��[9]������Ĥ��sp����ӻ��ṹ, ��û�н�ϱ�Ĥ�Ļ�ѧ���ṹ; �����о���û�й�ע��H�ڱ�Ĥ�еijɼ�, �Ӷ�Ӱ�쵽�Ա�Ĥ�ĵ硢 ��ѧ���ʵķ����� ���������о���a-C��F��H��Ĥ�Ŀռ�ṹ��Ĥ��C�� F�� H�ļ��Ϸ�ʽ, ���������γɵĸ����ĺ�������һЩ̽�֡�
1 ʵ��
���õ�RF-PECVD�豸����������������[5]�� ʵ�����õ�Դ����ΪCF4��CH4, �����ֱ�Ϊ30��10cm3/min, ѡ��ArΪ��������, ����Ϊ2cm3/min, ����ѹǿΪ10-3 Pa�� a-C��F��H��Ĥ�����ڵ�����(100)������, ��Ƭ����ͪ�� �ƾ���ȥ����ˮ��������ϴ, �Գ�ȥ������л���Ⱦ����Ȼ������, �õ紵�紵��, �����������, �Ծ������ٳ�����Ⱦ�� ����ǰ, ����Ar������100W�Ĺ���, �����Ƭ����10min, ��һ���������档 ����ʱ, ��Ƶ����Ϊ150W, �����¶�Ϊ100��, ������ѹ��5.5~6.5Pa֮��仯, ���������������������¸ı���Ƶ����, �о���Ƶ���ʶԱ�Ĥ�ڻ�ѧ���ṹ��Ӱ�졣
����Raman������(�ͺ�ΪDilor LabRam-INFINITY, ������ΪAr+����, ����Ϊ632.8nm)�Գ����ڵ������ϵ�a-C��F��H��Ĥ�����˲���; ��Dilor LabRam-INFINTY����Ҷ�任�������(FTIR)�ǡ� Microlab 310-F��X���߹����������(XPS)�Ա�Ĥ�����˲���, �����˱�Ĥ����ֺͻ�ѧ���ṹ��ɡ�
2 ��������
2.1 ��Ĥ��Raman����
a-C��F��H��Ĥ��һ��̼������, ���, ��Raman�������п��ܱ��ֳ�̼���ϵ�������λ: ������ʯ��1332cm-1��, ����ʯī��1575cm-1��, �÷�Դ��ʯīRaman�E2g2ģʽ, ͨ����ָ��ΪG��(graphite); ��ʯī�������״���, ��1575cm-1��1355cm-1��, 1355cm-1�����Դ������ӵĵ�һ��ɢ��, ��ɢ�������ھ�ϸ�ľ���ߴ����������, ͨ����ָ��ΪD(disordered)�� ͼ1��ʾΪa-C��F��H��Ĥ��Ʒ��Ramanɢ���ס� ͼ�и߶������ɢ���(522cm-1)��Ӧ����Si, ����Si���ԭ����Ĥ��ϱ�, ������˱�Ĥ, ���䵽�ĵױ���������� ͼ����ʾ����������Ͽ���ɢ���D���G��, D�巴ӳĤ��sp3�ṹ, G�巴ӳĤ��sp2�ṹ; sp3�ṹ�е�4���۵����γɦҼ�, ��sp2�ṹ�е�3���۵����γɦ�, ���ĸ��۵����γɦм�, �м���һ������, ʹ��϶��խ�� ��������ij���, ˵����Ĥ����sp2��sp3�ṹ��ɵİ����Ҽ��ͦм��Ļ�����硣 Ϊ�˱Ƚ�sp2��sp3�ṹ�ڱ�Ĥ���������Ĵ��¶���, ������ɢ�������˹���, ��ͼ2��ʾ�� ��Ϸ������1355��1592cm-1��, �������, ��1355cm-1����D��
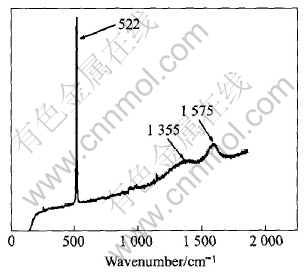
ͼ1 a-C��F��H��Ĥ��Ramanɢ����
Fig.1 Typical spectrum of Raman dispersion of thin films
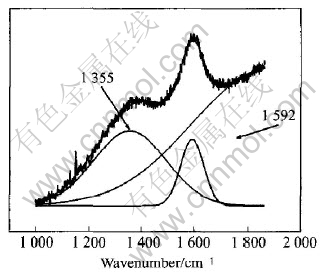
ͼ2 Raman��ĸ�˹���
Fig.2 Scatter peak analyze by fit multi-peaks
�غϵ��൱��, ��G����1575cm-1����1592cm-1, G�����Ƶ�����ƶ�, ����������ڱ�Ĥ�нṹ����Ƚϴ��ԭ������ġ� �Ƚ�����Ϸ��µ����, �ɵó�IG/IDԼΪ0.283, ˵���ڱ�Ĥ��sp2�ĺ�������sp3�ĺ���, Ҳ����˵��Ĥ�е���ʯī�ṹ��������ʯ�ṹ�� ��Ĥ��sp2�ṹ��ʯī�ɷ�ռ���ֱ���, ʹ�ñ�Ĥ�ĵ������½��� ������Ҫ����ǷǾ�̬���ֺ������ɷֽṹ, ������̼Ĥ��
2.2 ��Ĥ��FTIR����
ͼ3��ʾΪa-C��F��H��Ĥ���͵�FTIR�����ס� ��ͼ�п��Կ���, a-C��F��H��Ĥ���䡰����Ƶ�ʡ����͡�ָ���������н�ǿ�����շ�, ��FTIR�ס�����Ƶ������ ���������մ�, �ֱ���2900��1700cm-1������ ��2900cm-1������3��ǿ���շ�2865cm-1(sp3��CH3�ĶԳ�������)�� 2925cm-1(sp3��CH2�IJ��Գ�������)��2956cm-1(sp2��CH2�벻���͵�ϩ������)�� �������������ͼ�в������ԡ� ��3360cm-1����һ���Ͽ������շ�, ��Ҫ��ӦC��H�� O��H��һЩ��ǿ��������, ���ڼ���������õĴ���, ��ͼ�и�����������������Ӧ�ķ�λ�� ����Ϊ1860cm-1��1781cm-1(��ӦF2C-CF)�����շ���ͼ3�и���û��, ��ֻ����1718cm-1(��ӦF2C-C)�ķ�λ�൱ǿ(��������ܰ����в���Ϊ1726cm-1, ��ӦC-O�����շ�), ˵���ڸ�Ĥ�в����͵�C-O�ĺ���������[8, 10-12]�� ��FTIR���ס�ָ���������������շ���Ҫ������1000~1300cm-1��Χ, ������Ҫ��Ӧ��CFx��������[13]; ����FTIR����CFx������Ӧ�IJ���ΪCF(1030�� 1070cm-1)�� CF2(1050�� 1160�� 1220cm-1)��CF3(980�� 1340cm-1)�� ������CFx�������Fԭ����������֮����ǿ�ҵ����, ��һЩ���շ���������Ϊ�����������, ���Ҫ��ͼ�о���ָ��ÿһ���ֱ��Ӧ��һ�����DZȽ����ѵ�, ����һ����÷ַ���и�˹��ϵİ취���������ǿ��, �Ӷ��ó������ĺ����ı仯�� ͨ���������Կ�����a-C��F��H��Ĥ����Ҫ����: CH2 �� CF�� CF2��CF3�Լ�������C-C��ѧ���ȡ�
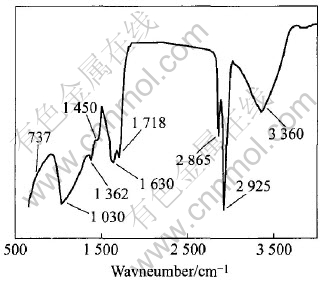
ͼ3 a-C��F��H��Ĥ���͵�FTIR������
Fig.3 Typical FTIR spectrum of a-C��F��H thin films
2.3 ��Ĥ�Ĺ����������
ͼ4��ʾΪ��Ĥ�Ĺ�������ס� ͼ����Ҫ��4����λ, ���Ƿֱ��Ӧ: C1s, O1s, N1s��F1s, ���пɵó��ڱ�Ĥ����Ҫ�ɷ���C, �����F�� ��Դ�����в�����Ԫ��, ���ڱ�Ĥ�г��ֽ϶�����ɷ֡� ��ԭ�������: ��һ, ��Ĥ�Ʊ�ǰ������ڵIJ��������к���������ˮ��, ��Щ��ԭ�Ӳ����˻�ѧ����, �뱡Ĥ�е�C��ϳ�C-O���� ���, ���ڴӱ�Ĥ��Ʒ�Ʊ��õ�����XPS����, ͣ����ʱ�����, ʹ�ñ�Ĥ���汻����, ���б�Ĥ�е����Ҽ���O���, �γ�C-O��; ���ܱ�Ĥ�ڽ���XPS����ʱ�����˸���Ar���ӵĺ��, ��C-O���ɷ��Ǻ�������ġ� Ϊ�˸���һ��������Ĥ��C�� F�� H֮��ļ��Ϸ�ʽ, ������������, �Է�����˸�˹���(��ͼ5)C1s����Խ��Ϊ5����˹��, ���λ�ֱ�Ϊ285.15, 286.70, 288.17, 290.03, 293.90eV, ��Ͻ������1�� ��������[6, 14]�Ľ��, ��4����ֱ��ӦC*��(C��H), C*��CF, C��CF, CF2, CF3�Ȼ�ѧ���� 285.15��
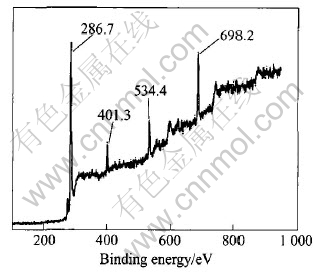
ͼ4 a-C��F��H��Ĥ�ĵ���XPS��
Fig.4 Typical XPS spectrum of a-C��F��H thin films
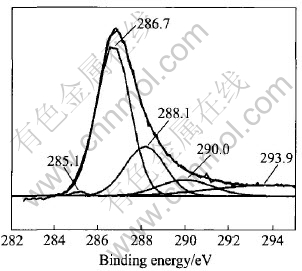
ͼ5 a-C��F��H��Ĥ��XPS��C1s���˹���
Fig.5 C1s region of XPS spectra gaussia analyse of a-C��F��H thin films
286.70eV���ķ�������C1s�ĵ���ԾǨ����*������γɦм�����, ��*���Ĵ���˵���ڱ�Ĥ�д��ڲ����͵�̼̼��, ����C-C��[14]�� �ڽṹ��, ��*���Ĵ��ڱ�Ȼ�������ڴ���C*ԭ�ӡ� ��285.15eVλ��, ������ʱC������ֻ��H��C����ԭ��, ��������ʽΪC-C*H, ��ͼ5��֪, ���ֽṹ�ڱ�Ĥ��ռ�ı����൱��, ��Ȼ, ��Ҳ������C-C*C���ֽṹ; ��286.70eV��288.17eVλ��, C������ֻ��C��һ��Fԭ������ԭ��, �����ʽ����ΪC��C��F��C-C��F��, �����ڱ�Ĥ��ռ�ı����ϴ�, �DZ�Ĥ�л�ѧ������Ҫ�ɷ�; ��290.03eVλ��, C������ֻ��C������Fԭ��, �����ʽΪC��C��F2��, �����ڱ�Ĥ��ռ�ı�������; ��293.90eVλ��, C������ֻ��C��3��Fԭ��, �����ʽΪC��C��F3�� ͨ�����Ϸ���, ��a-C��F��H��Ĥ�ṹ����Ҫ���ڵĻ�ѧ����: C��C�� CH�� CF2�� CF3�Ͳ�����C-C���� �ɼ�, ����������������ķ����������� ��Ĥ�е�C��C��F����, ��Ĥ�Ĺ�����ǿ, ��糣����С, �ȶ��Ժ�; ����Ĥ�е�C��C��F3����, ��Ĥ�Ĺ�������, ��糣����С, ���ȶ��Բ�; ����Ĥ��CF2�ĺ����Խ��ͽ�糣��û�й���[15]�� ����Ҫ�DZ�Ĥ�ڵ��ӵļ�����ʽ�������ġ�
2.4 ��Ƶ���ʵ�Ӱ��
ͼ6��ʾΪ�����¶�Ϊ100�桢 ������Ϊ0.75�� ������ѹΪ5.5Pa, �ֱ���150W��250W��Ƶ�����³����ı�Ĥ��FTIR�ס� ��ͼ�п��Կ���, ���������ڲ���1400~1700cm-1֮�伸���ص�, ���ڲ���1400cm-1���¶��߾������ԵIJ�ͬ: ����683cm-1λ�ö�ӦC��H���ķ�λ, �ڲ�ͬ�Ĺ����·����˱仯; ��250W������, ����1620cm-1���Ҷ�ӦC��C�����ķ�λ, ����150W������������ǿ, ͬʱ, ��Ĥ��CFx��λ�����Ƶ�����ƶ��� ���������Ϊ�ڵ������Ʊ��ı�Ĥ��Ҫ��CF��CF2������, C��O��C��C���ĺ����͵ö�, ���ֱ�Ĥ����Ϊ������ ���� ���ƾۺ���ṹ[16]�� ���ڳ������ʵ�����, F��C�Ľ���ܱ�H��C�Ľ���ܴ�ö�, ���, H�ܴ�һ���ִӱ�Ĥ��������, ʹ�ñ�Ĥ��C��C������Ե�CFx�ijɷ������� ��Ȼ, ���ڳ������ʵ�����, Դ��������HŨ��Ҳ����, ��H��������Ϊ��ʴԭ��, ͨ�����ڱ�Ĥ�����Fԭ�ӷ�Ӧ�����ӷ�
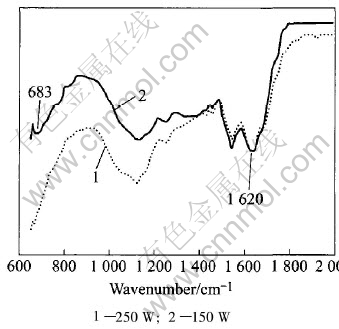
ͼ6 ��ͬ�������Ʊ��ı�Ĥ��FTIR��
Fig.6 FTIR spectrums deposited under different RF-power
�Ե�HF�������˱�Ĥ��F�ĺ����� �����Ϸ����ɵ�, ��Ĥ��H��F�ļ���, �����˱�Ĥ��C��C���ĺ�������, ʹ��Ĥ�Ĺ�����ǿ, ��Ĥ�����ȶ�; ����Ĥ��F�ĺ�������, ��Ա�Ĥ�Ľ�糣������Ӱ�졣
3 ����
1) ��CF4��CH4ΪԴ����, ����PECVD���Ʊ�a-C��F��H��Ĥ, ��Ĥ�ʿռ���״�ṹ, sp3�ṹ�ĺ�������sp2�ĺ�����
2) Ĥ��C�� F�� H��Ҫ��C��C�� C-C�� CH2�� CH3�� CF�� CF2�� CF3��ʽ��ϳɼ���
3) ��Ĥ��, ������C-C �����ܴ�; C��C��F����C��C��F2����Ĥ�е���Ժ���Ҫ��Ķ�, ���Ա�Ĥ�ͽ�糣���Ĺ�����Ҫ��C��F����
4) ������������ʱ, ��Ĥ��CF�� CF2���ĺ�������, ��Ĥ��ԭ�ӹ�����ǿ��
REFERENCES
[1]Endo K, Toru T. Fluorinated amorphous carbon thin films grown by helicon plasma enhanced chemical vapor deposition for low dielectric constant interlayer dielectrics[J]. Appl Phys Lett, 1996, 68(20): 2864-2866.
[2]Endo K, Toru T. Fluorinated amorphous carbon thin films grown by plasma enhanced chemical vapor deposition for low dielectric constant interlayer dielectrics[J]. J Appl Phys, 1995, 78: 1370-1372.
[3]Yokomichi H, Hayashi T, Amano T. Atsushi masuda preparation of fluorinated amorphous carbon thin films[J]. J Non-Cryst Solids, 1998, 227-230: 641-644.
[4]Labelle C B, Karen K. Gleason pulsed plasma-enhanced chemical vapor deposition from CH2F2, C2H2F4 and CHClF2[J]. J Vac Sic Technol A, 1999, A17(2): 445-452.
[5]LIU Xiong-fei , XIAO Jian-rong, JIAN Xian-zhong, et al. Study on a-C��F��H thin films deposited by PECVD[J]. Trans Nonferrous Met Soc China, 2004, 14(3): 426-429.
[6]MA Yang-jun, YANG Hong-ning, Guo J, et al. Structural and electronic properties of low dielectric constant fluorinated amorphous carbon films[J]. Appl Phys Lett, 1998, 72: 3353-3355.
[7]Jung H S, Park H H. Structural and electrical properties of co-sputtered fluorinated amorphous carbon film[J]. Thin Solid Films, 2002, 420-421: 248-252.
[8]Yi J W, Lee Y H. Bakhtier Farouk Annealing effects on structural and electrical properties of fluorinated amorphous carbon films deposited by plasma enhanced chemical vapor deposition[J]. Thin Solid Films, 2003, 423: 97-102.
[9]Alentini L V, Braca E, Kenny J M, et al. Analysis of the role of fluorine content on the thermal stability of a-C��H��F thin films[J]. Diamond and Related Material, 2002, 11: 1100-1105.
[10]Agostino R D��, Cramarossa F, Francassi F. Plasma Deposition, Treatment, and Etching of Polymers[M]. New York: Academic Press, 1990. 144.
[11]Buuron A J M, Driessns R M A, Schram D C, et al. Fast deposition of amorphous carbon films by an expanding cascaded arc plasma jet[J]. J Appl Phys 1995, 78: 528-533.
[12]Ҷ��, ����Ԫ, ��ɺ��. ���ӻ����������������ǿ���������Ǿ�̼��Ĥ�Ĺ�ѧ����[J]. ����ѧ��, 2001, 50(10): 2017-2022.
YE Chao, NING Zhao-yuan, CHENG Shan-hua. Optical properties of amorphous fluorinated carbon films prepared by electron-cyclotron resonance plasma[J]. Acta Phys Sin, 2001, 50(10): 2017-2022.
[13]NING Zhao-yuan, CHENG Shan-hua. Influence of thermal annealing on bonding structure and dielectric properties of fluorinated amorphous carbon film[J]. Current Applied Physics, 2002, 2: 439-443.
[14]Stohr J. NEXFAS Spectroscopy, Springer Series in Surface Sciences[M]. New York: Springer, 1992. 109.
[15]Ariela N, Eizenberg M, Wang Y, et al. Deposition temperature effect on thermal stability of fluorinated amorphous carbon films utilized as low-K dielectrics.[J]. Materials Science in Semiconductor Processing, 2001, 4: 383-391.
[16]Yi J W, Lee Y H, Farouk U B. Low dielectric fluorinated amorphous carbon thin films grown from C6F6 and Ar plasma[J]. Thin Solid Films, 2000, 374: 103-108.
������Ŀ: ���ҽ�������ʿ�����������Ŀ(20020533001)
�ո�����: 2004-07-30; ������: 2005-06-08
�����: Ф����(1967-), ��, ��ʿ�о���
ͨѶ����: Ф����, �绰: 0731-8836762; E-mail: xiaojianrong248@163.com


