���±�ţ�1004-0609(2012)1-0171-08
��̬����ZrCl4��ѹ��ѧ��������Ʊ�ZrCͿ�������
�� �ڣ���������� �裬�����ף����пƣ��� ��
(���ϴ�ѧ ��ĩұ������ص�ʵ���ң���ɳ410083)
ժ Ҫ��
����ZrCl4-CH4-H2-Ar��Ӧ��ϵ����̬����ZrCl4��ĩ��ѹ��ѧ�������(CVD)�Ʊ�ZrCͿ�㡣�о��¶ȶԵ�ѹ��ѧ�������ZrCͿ��������ɡ���������������Ϳ�������ò������ṹ��Ϳ�������ٶȺͳ��������Եȷ����Ӱ�졣�����������ͬ�¶��³�����Ϳ����Ҫ��ZrC��C����ɣ������¶ȵ����ߣ�ZrC����(200)��������������ǿ������ֱ�����������������ӣ���������������Ϳ�����ṹ����״��Ϊ������������Ͽھ�������ӣ�Ϳ��ij���������С��1 500 ��ʱ������ϵͳ�ľ����Ա�1 450 ��ʱ�IJ
�ؼ��ʣ�
ZrCͿ�����¶�����ѹ����ѧ���������
��ͼ����ţ�TQ050.4���� ���ױ�־�룺A
Character of ZrC film prepared by transporting solid ZrCl4 during low pressure chemical vapor deposition
LIU Gang, LI Guo-dong, XIONG Xiang, WANG Ya-lei, CHEN Zhao-ke, SUN Wei
(State Key Laboratory of Powder Metallurgy, Central South University, Changsha 410083, China)
Abstract: ZrC film was deposited by chemical vapor deposition with ZrCl4-CH4-Ar system, and ZrCl4 particles was transported in solid. The influences of temperature on the phase composition, preferential growth of the crystals, surface morphology, fracture surface morphology, deposition rate and deposition uniformity of the coatings were studied. The results show that the film prepared at different temperatures is composed of ZrC and carbon. The crystal plane (200) of ZrC film grows up, micro-crystallites grow up, the surface get densely sintered, and the deposition rate increases with increasing the temperature. The columnar crystal is the main body of the fracture surface structure. The deposition rate decreases gradually with increasing the distance between the sample and the feeds entrance. The uniformity of the deposition system at 1 500 �� is worse than that at 1 450 ��.
Key words: ZrC film; temperature; low pressure; chemical vapor deposition
ZrC����Ҫ�ĸ����մɲ��ϣ����и�Ӳ�ȡ����۵㡢���ȳ��ǿ�ȡ����ȵ��ʵ���������[1]��������ij����¿�����������ˢ������ʴͿ����ϣ�������C/C��������������ܵĺ��ġ������������������������ķ��Ȳ�[2-4]�����⣬ZrC����������һ����������Ѱ��������ϣ���Ϊ�赲�ѱ����ͳ�����Ҫ�غɵĹؼ���[5]�Լ�����[6]������������˲���[7-8]�������㲿��[9]�ȷ��档
Ŀǰ���������Ʊ�ZrCͿ����Ҫ�дſؽ���[10]�����弤�����[11]������ע��[12]��Һ������ŵ�[13]������Ϳ��[14]�Լ���ѧ�������(CVD)[15-16]�ȷ�����������������ȣ�CVD ���������õĽṹ������ԣ�ͨ�������Ŀ��ƣ��ɶ�Ϳ��Ľṹ�ͳ����ٶȽ��п��ƣ�������Ҫ�Ʊ����ض��ṹ�����ܵ�Ϳ�㣬���ҿ����Ʊ����������ZrCͿ�㣬�Ӷ�������������������ڽ���CVD���Ʊ�ZrCͿ�������о��У��¶ȡ�ѹ����̼ﯱȡ���Ӧ������Ͷȡ�������������Ӧ������ʱ�䡢�������塢����ʱ������ض�Ϳ��Ľṹ����������Ҫ��Ӱ�죬���У��¶ȵ�Ӱ����Ϊ�����������������ŷ�Ӧ�ܷ����(����ѧ����)�����һ�Ӱ�췴Ӧ���ٶ��Լ�Ϳ��Ľṹ��ò(����ѧ����)���������[8]��LIU��[17-18]��LIU��[19]��JONG��[20-21]��ZrCl4������ͬCH4��H2��Arһ��ͨ�뷴Ӧ�����Ʊ��õ�ZrC��Ĥ���о���CVD ZrC��Ĥ�ı�����ò���������ƺ���֯�ṹ���������¶Ⱥ�������Ӱ�졣
��CVD���Ʊ�ZrCͿ�㹤���У�Ŀǰ�����ZrCl4-CH4-H2-Ar��ѧ��Ӧ��ϵ[17-21]�����Ƚ�ZrCl4������Ȼ��ͨ��������Я�ؽ��뷴Ӧ������CH4��Ӧ�Ƶ�ZrCͿ�㡣Ȼ��ZrCl4������Ϊ���壬��Ҫ����������������䵽��Ӧ���䣬����������У�ZrCl4�����������������ܵ������������������������ѣ�ԭ�������ʵ͡�Ϊ�˱���˱ˣ��������[22]ר��������ܱջ������ȹ�̬�ͷ�װ�ã�ֱ�ӽ���̬��ZrCl4��ĩ�Թ̶������ȶ����뵽��Ӧ���У��Ӷ����ԭ�ϵ��������빤�յĿɿ�����ɿ��ԡ�Ȼ��������̬��Ӧ����������������ȣ���̬�ͷ�������������������������¶ȳ��кܴ�IJ����Ҫר���о����������[23]��SUN��[4]���ô��ͷ�װ�ã��ڳ�ѹ�½�ZrCl4��ĩ��CH4��H2��Arֱ��ͨ�뷴Ӧ���Ʊ����˿���ʴ��������ZrCͿ�㣬������һЩ�볣��ZrCl4��̬�����Ʊ�CVD ZrCͿ�㲻һ�µĽṹ���ɡ� ����ZrCl4��̬���͵�ѹ��ѧ��������Ļ������ɣ�����δ��������
�������߽�Ϲ�̬�ͷ�װ�ã�����ZrCl4(s)-CH4- H2-Ar��ѧ��Ӧ��ϵ���о��¶ȶԵ�ѹ��ѧ�������ZrCͿ���������ɡ����������������Ϳ�������ò��������֯�ṹ��Ϳ�������ٶȺͳ��������Եȷ����Ӱ�졣
1 ʵ��
ʵ���ó�������Ϊ30 mm��20 mm��5 mm������ʯīƬ���ܶ�Ϊ1.70 g/cm3�����õĻ�ѧ��Ӧ��ϵΪZrCl4-CH4-H2-Ar������ArΪϡ�����壬CH4Ϊ̼Դ��ZrCl4�����ĩ��ΪZrԴ���ܻ�ѧ��Ӧʽ���£�
ZrCl4+CH4=ZrC+4HCl (1)
ZrCl4��ĩͨ���Զ��ͷ�װ����һ�������پ��Ƚ��뷴Ӧ���У���ͨ���CH4���巢����Ӧ����ʯīƬ�ϳ���ZrCͿ�㡣CVD��Ӧ������Ʒװ��ʾ��ͼ��ͼ1��ʾ��������������Ʒ�ڵ�λʱ����Ϳ����������������Ϳ��������Ϊ��Ӧ����ͬһλ�ô�(��Ӧ�������ᣬ������Ͽ�135 mm)��Ʒ��ƽ�����ֵ������ʵ�鹤�ղ������1��ʾ��

ͼ1 CVD��Ӧ��ʾ��ͼ
Fig. 1 Schematic diagram of CVD reactor
�����ձ���ѧD/max2550VB+18K ת��X����������(XRD)��������Ʒ���������ɷ֡�����NONA-NANOSEM230�ͳ�����ɨ���������(SEM)�۲�ZrC��������Ʒ�����������ò�Ͷ���ṹ��
��1 CVD-ZrCͿ�㹤�ղ��������
Table 1 Process parameters and results for CVD-ZrC

2 ���������
2.1 �������������ȡ��
ͼ2��ʾΪ��ͬ�����¶���ZrCͿ���XRD�ס���XRD���������֪����ͬ�¶��³���Ϳ�����ZrC��C������ɡ��ڳ����¶Ƚϵ�ʱ��C���ǿ���������¶����ߣ�C����������1 500~1 600 ��ʱ��C�������ʧ��C��ij�����Ҫ����������ԭ��1)��ʵ����C/Zr��ƫ��һ��������C������Ϳ���У�2)���¶Ƚϵ�ʱ��ZrCl4�ķֽⲻ��֣���ʹͿ����Zr�ĺ�����Խ��٣�������һ����������̼�����¶�����ʱ��ZrCl4�ķֽ��������������ʹC/Zr��������ߣ�����������̼�ij���[3]���ڳ����¶Ƚϵ�ʱ��ZrC���������Ͽ���˵���ᾧ�Ƚϲ������¶����ߣ�ZrC���μ��ᾧ�ȱ�á�

ͼ2 ��ͬ�����¶���ZrCͿ���XRD��
Fig. 2 XRD patterns of ZrC coatings at different deposition temperatures
���ų����¶ȵ����ߣ��������ࡢ�ᾧ�ȷ����ı�֮�⣬��ͬ�����ֵǿ�ȱ�ֵҲ�������Ա仯��ZrC�����������Ҫ������2��Ϊ33.02�㡢38.30�㡢55.30�㡢65.92�㡢69.24���82.02�㴦��������1 400 ��ʱ����2��= 33.02�㴦��(111) �������2��=38.30�㴦��(200)��������ߣ����μ��������¶ȵ����ߣ�Ϳ��(111)������ǿ��������Ϳ��(200)��(400)������ǿ������ǿ���¶ȵ���1 600 ��ʱͿ��(111)�������Ѻ�С�� (200)��������ߣ���˵����������������仯ʱ�� ZrCͿ����(111)��(200)������������������Ϊ�� (200)��һ���������������¶Ƚϵ�ʱ��Ϳ���κ����ʽϴ��κ˺�������Ϊ��ͬ���ڡ���Ϳ�����κ�Ϊ��ʱ��(111)������������[2]����Ϳ��������Ϊ��ʱ��������ӰЧӦ�Ĵ��ڣ�(200)�����������������ԣ��¶Ƚϵ�ʱ��ZrCͿ�����(111)��(200)���������������档�¶�����ʱ��Ϳ���κ����ʽ��ͣ��Ծ�������Ϊ�������������ʲ������ӡ�ͬʱ�¶����ߣ���Ӧ(1)�ٶȼӿ죬ZrC�������ߣ��������ʼӿ죬��ӰЧӦ���ԡ����ԣ�(200)����������������������ɢ�γɵ��͵���״���ṹ��
2.2 ��������
ͼ3��ʾΪ��ͬ�¶���ZrCͿ��ı�����ò����ͼ3��֪���ڲ�ͬ�����¶��£�Ϳ��ı�����ò�нϴ�IJ��졣1 400~1 500 ��֮�䣬Ϳ�����ƽ������������ϸС���������ɣ������¶ȵ����ߣ�����ֱ�����������������Խ��Խ���ܣ���ƽ���Ƚ��͡� 1 500 ��ʱ����֮����ں����ӡ�1 550 ��ʱͿ���������˲˻�״��ò��һ�����ӻ�����ʧ���Ѿ���ۺ�Ϊ���δ�����������֮�����Ƚ����ԡ�1 600 ��ʱ��Ϳ�����Ϊ�⻬��״��������ò�����ڶ������ӵ���Ӵ����ں���ɵģ�ͬʱͿ�����������ܡ�
Ϳ�������ò�����κ˺ͳ����������̹�ͬӰ��ģ�ͬʱ�����������ֶ��ܵ��¶ȵ�Ӱ�졣�ɴ˿�֪���¶���Ϳ�������ò�����еĹ�ϵ���ڿ����κ˹��̣��¶�����Ӱ��Ϳ���ٽ���ĵ����ܶ�(n*)
![]() (2)
(2)
ʽ�У���G*���ٽ���ĵ��κ������ܣ���nsΪһ��������n1�ij������¶���������������ƽ������ѹ���������ٽ���ĵ��κ������ܦ�G*���Ӷ������κ��ʼ�С��ͬʱ���¶�����ʱԭ�ӵ��Ѹ��������ӡ����ǣ��¶�����ʱ�������ܶȼ�С�������������١����ߣ��¶����ߣ���Ҫ�γɵ��ٽ���ĵijߴ�ͻ�Խ���κ˵��ٽ�����������ҲԽ�ߣ����Ը���ʱ�����Ŀ���ֱ����Խ����ʱ�ٽ��κ��������½����γɵĺ�����Ŀ���ӣ��γɵĿ���ϸС���ڿ���������̣��¶ȵ����������˷�Ӧ����������ͬʱҲ�����˾������������ʣ�������ֱ���������¶ȵ����߶�������ǣ������˴�֮��ֱ�ӽӴ��ļ���Ҳ��֮���ӡ������¶Ƚϵ�ʱ(��ͼ3(a))����������ϸС��һ�ο�����ֻ�оֲ��ںϣ��������ɣ�����ƽ����ͼ3(b)�г���������һ�������ںϵľۼ��壬�ںϾۼ������нϽ��ܣ��ۼ�����п�϶��Ϳ��ƽ�������ų����¶ȵ����ߣ��ںϾۼ�����(��ͼ3(c)��(d))��Ϳ�����б�ý��ܣ����������ںϾۼ���ѻ��Ķ��ξۼ��壬Ϳ���ôֲڲ�ƽ����һ������¶ȣ�������ξۼ��忪ʼ�ں����ӣ����ξۼ�����������ԵĽ��ޣ�һ�������Ѿ���ʧ��������ƽ��(��ͼ3(e))����ʱ���˴�ֱ�ӽӴ��Ŀ���������ڱ���ԭ�ӵ���ɢ����̲����ںϡ��������ĺ���֮�䷢����˹�߶����̲����۽ᡢ����ԭ���ŵ�Ǩ�Ƶȹ��̣�������ɱ˴˽��������ľ������Ӷ��γ���������Ϳ�㡣

ͼ3 ��ͬ�����¶���ZrCͿ��ı�����ò
Fig. 3 Surface morphologies of ZrC coating prepared at different deposition temperatures: (a) 1 400 ��; (b) 1 450 ��; (c) 1 500 ��; (d) 1 550 ��; (e) 1 600 ��
2.3 ����ṹ����������
ͼ4��ʾΪZrCͿ�����SEM����ͼ4��֪����̬����ZrCl4��ѹ��ѧ��������Ʊ�ZrCͿ�����֯�ṹ����������ZrCl4��ѹ��ѧ�������ZrCͿ��������������Ϳ����¿��Է�Ϊ���㣺�������ϸ����1����״����2��������֮���й�����A(��ͼ4(b)��(e))������״���������֮�仹��һϸ��������B(��ͼ4(e))������������ZrCl4��ѹ��ѧ�������ZrCͿ�㣬һ��ֻ��һ����֯�ṹ������Ϊ��״��֯������Ϊ��״��֯��һ������״��֯��Ҳû�й��ɲ�A��ֻ�������֮����һϸ��������B����
�����ϸ����1���Ϊ1 ��m���ң���CVDĩ���γ�Ϳ��Ľṹ�������¶ȵ����ߣ���Ȼ������䣬������С������ܶ����ӣ��ڵ�����1 400~1 500 �棬����ϸС����Խ�������棬����ԽϸС������һ���Ŀ�϶����1 550 ��ʱ����϶���Լ��٣�һ�ο����������ɼ�������1 600 ��ʱ����������һ�ο����������Ϳ�����γ������ľ��壬���ֳ����Ե���״���ص㡣������ǹ���ZrCl4�������ȣ������˻������߽������������¶ȡ���״����2ΪͿ������壬Ϳ�����ܣ������Կ������ƣ����ų����¶ȵ����ߡ�����ʱ����ӳ���������ӡ�������(1 400~1 450 ��)����״�������������в����롣���¶���1 500~1 600 ��֮��ʱ����״���������������룬�������¶ȵ����ߣ�����ɢ��ǿ��������ôִ�����A��B��Χ��С��������һ���Ŀ�϶���侧���ߴ綼С����״���ġ�������B���γ���ZrC�ľ�������ʯī����ľ�������ƥ����ɵġ������¶ȵ����ߣ��������ȡ�����������ң����������ֱ���ܱ����ϲ���״��������С�������仹���п�϶���������������ڽ��ͻ�����Ϳ��IJ���Ӧ������������A����CVDĩ���γɵ�Ϳ������״�������Ĺ��ɽṹ�������ڸ��¼�������£����忿����ɢ����״���γɵ��м�״̬��

ͼ4 ��ͬ�����¶���ZrCͿ��������֯�ṹ
Fig. 4 Micrographs of fracture surface of ZrC coating prepared at different deposition temperatures: (a) 1 400 ��; (b) 1 450 ��; (c) 1 500 ��; (d) 1 550 ��; (e) 1 600 ��
��Ϳ���ھ��������ɢ���������սṹ�γɷ��棬�¶����ž��������á�ZrCͿ��ṹ���γ������ʱ�ijĵ�����¶�Ts/Tm(TsΪ�ĵ��¶ȣ�TmΪ�������ʵ��۵�)�Լ�����ԭ�ӹ����Ͷ�������ء��ڱ�ʵ���У�ZrCͿ�������¶�Ts/Tm��0.438~0.490֮�䡣���ݾ������ۿ�֪����0.3��Ts/Tm��0.5ʱ��������ɢ���ʸ߲���һ��������ɢ���ʣ��γɵ���֯Ϊ�Ͼ��ȵ���״����֯����״����ֱ�����¶ȵ����߶�������ͼ4���������������ֱ仯���ơ�ͬʱ�������ڲ�ȱ���ܶȽϵͣ������߽�����ܶȽϸߣ���ʹ��Ϳ����нϸߵ�ǿ�ȡ��������¶ȼ�������(Ts/Tm��0.5)ʱ��ԭ�ӵ�����ɢ��ʼ������Ҫ���á���ʱ��Ϳ�����֯��Ϊ��������ٽᾧ�Ĵִ�ĵ��ᾧ��֯�������ڲ�ȱ�ݽ��͡���1 600 ��(Ts/Tm=0.49)ʱ��Ϳ����(��״����2)�����γɴִ���ᾧ������(��ͼ4(e))��
2.4 �¶ȶԳ������ʵ�Ӱ��
�����¶ȶԳ�������v(��λʱ�����Ϳ����� ��)��Ӱ��dz���ͼ5��ʾΪ�����¶ȶ�CVD ZrCͿ��������ʵ�Ӱ�졣��ͼ5��֪��������¶ȵ����ߣ�������������������1 400~1 450 ��ʱ��������¶ȵ����ӣ��������ʻ�����������1 450~1 600 ��ʱ����������(v)����������ͼ6��ʾΪZrCͿ��� ln k��T -1���ߡ���ͼ6��֪��1 400~1 550 ��ʱZrCͿ��ij������ʵ���Ȼ����������¶ȵĵ��������Թ�ϵ����1 550 �棬��������ѧ���ߴ���һ���յ㣬˵���������̵Ŀ��ƻ��Ʒ���ת�䡣
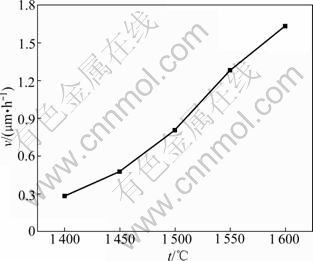
ͼ5 �����¶ȶ�CVD ZrCͿ��������ʵ�Ӱ��
Fig. 5 Effect of deposition temperature on deposition rate of CVD ZrC coating
�������̵Ŀ��ƻ��Ʒ�Ϊ��ɢ���ƺͱ��滯ѧ��Ӧ��������[24]�������������������������(��Ӧ������뼰����������)�������ڱ߽���е���ɢ�Ȳ�����ƣ���ѧ�������������ɢ���ƣ�������������ɱ���������������ɢ����ѧ��Ӧ���������Ȳ�����ƣ���ѧ����������ɱ��滯ѧ��Ӧ���ơ��ڱ��滯ѧ��Ӧ���ƵĹ����У���ѧ�������������Լ���ѧ��Ӧ�Ȳ���Ľ��ж���Ҫһ���Ļ�ܣ�����Ӧ��Ҫͨ��һ�������ݲ��ܽ��У���������ɢ���ƵĹ����У��������˺������ڱ߽���е���ɢ��Ҳ��Ҫһ���Ļ�ܡ�һ����˵�����������ܱ��滯ѧ��Ӧ����ʱ����Ҫ�Ļ��Զ���ڳ�����������ɢ����ʱ����Ҫ�����������������ͨ���Ƚ������εĻ�ܴ�С��ȷ�������εĿ��ƻ��ơ���ܿ���Arrhenius��ʽ����ó�����
![]() (3)
(3)
ʽ�У�kΪ��������ʣ�bΪƵ�����ӣ�EaΪ���̵Ļ�ܣ�RΪĦ�����峣����TΪ�����¶ȡ���ʽ(3)��֪������������Ȼ����������¶ȵĵ��������Թ�ϵ������ѧ���ߵ�б�������ڳ������̵Ļ�ܡ�����û�ѧ�������ZrC��1 400~1 550 ��ʱ�ı��ۻ��Ϊ182.18 kJ����1 550~1 600 ��ʱ�ı��ۻ��ԼΪ73.06 kJ���ɴ˿�֪��CVD ZrCͿ��������̵Ŀ��ƻ�����1 400~1 550 ��ʱΪ���滯ѧ��Ӧ���ƣ���1 550~1 600 ��ʱΪ��ɢ���ơ�
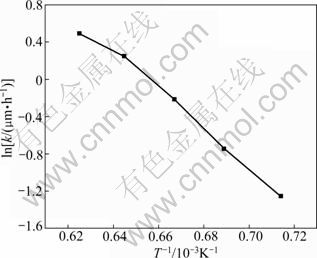
ͼ6 ZrCͿ���ln k��T-1����
Fig. 6 Curves of ln k��T-1 for ZrC coating
2.5 Ϳ�������������
����Ϳ��ľ����ԣ�ѡ��1 450 ���1 500 �����������������жԱ��о���ͼ7��ʾΪ��Ʒ����Ͽھ���H��Ϳ���������(R)�Ĺ�ϵ���ߡ���ͼ7��֪�� 1 500 ��ʱ����������Ͽھ�������ӣ�Ϳ��ij����������ȿ��ټ�С��Ȼ������С��1 450 �� ʱ����ͬλ��Ϳ��������ʵı仯����ͬ1 500 ��ʱ���������Ӧ�Ҳ�ͬλ�ô����䷴Ӧ��Ũ�ȡ�ѹǿ���������������״̬�ȶ���ͬ���ɴ����Ϳ����������ȡ��ر��Ƿ�Ӧ��Ũ�ȣ���Ϳ���������������Ҫ��Ӱ�졣�ڱ������У��ڷ�Ӧ����뷴Ӧ����ʼ��ʱ����������Ͽھ�������ӷ�Ӧ���������ʽϴ�Ӧ��Ũ�ȼ�С���ʽϴ�����Ϳ��������ʱ仯�ϴ�����Ӧ����뷴Ӧ�����ڽ�ʱ����Ӧ��Ũ�ȱ仯��С������Ϳ��������ʱ仯Ҳ��С��

ͼ7 ��ͬ�¶�ʱZrCͿ����Ʒ����Ͽھ���(H)��Ϳ���������(v)�Ĺ�ϵ
Fig. 7 Curves of H vs v at different temperatures
ͬʱ����1 500 ��ʱͿ��仯���߱ȽϿ�֪��1 450 ��ʱͿ��仯���ߵ�����б��ת���(�ɿ��ټ�С���Ʊ�Ϊ������С���Ƶ�λ�õ�)����������ϿڽϽ���λ�ô�����1 450 ��ʱ����ͬλ�ô������������ߵ�б��1 500 �� ʱ���ߵ�б��С����1 450 �� ʱ����������Ͽھ�������ӣ�Ϳ��������ʵļ�С�ٶȱ�1 500 �� ʱ��С����˵��1 500 �� ʱ����ϵͳ�ľ��������1 450 �� ʱ����ϵͳ�ľ������Բ�һЩ������Ҫ�����������¶ȵ����ߣ���Ӧ���з�Ӧ��֮��ķ�Ӧ���������ӣ��ڷ�Ӧ����뷴Ӧ����ʼ�Σ���Ӧ���������ʴ�����ӣ���Ӧ��Ũ�ȴ����٣��Ӷ�ʹ��1 500 ��ʱ����Ϳ�㴹ֱ����ľ����Ա�
3 ����
1) ��1 400��1 600 �淶Χ�ڣ���̬����ZrCl4��ѹ��ѧ��������Ʊ�ZrCͿ����������ص㣺Ϳ�������֯�ṹ���¿��Է�Ϊ�����ϸ�������ڲ���״�����������֣�����Ϳ��֮�估��״���������֮����ڶ�Ĺ���������ṹ����״��Ϊ���壬�������¶ȵ����ߣ�������ӣ���״��ֱ���������������¶ȵ����ߣ�����ϸ��������(111)��(200)������������ת��Ϊ��(200)��һ��������������Ϳ����֯�����ɵĿ���״��Ϊ���ܵ���״������Ȼ������䡣
2) ���ų����¶ȵ����ߣ����������������ҳ������̵Ŀ��ƻ�����1 400��1 550 ��ʱΪ���淴Ӧ����ѧ���ƣ���1 550��1 600 ��ʱΪ��ɢ���ƣ���������Ͽھ�������ӣ�Ϳ��ij���������С�� 1 500 ��ʱ����ֱ����ľ����Ա�1 450 ��IJ
REFERENCES
[1] SAYIR A. Carbon fiber reinforced hafnium carbide composite[J]. J Mater Sci, 2004(39): 5995.
[2] ���п�, �� ��, �����, Ф ��, �ź첨, ������, �Ʋ���. ��ѧ������� TaC Ϳ�������ò��������������[J]. �й���ɫ����ѧ��, 2008, 18(8): 1377-1382.
CHEN Zhao-ke, XIONG Xiang, LI Guo-dong, XIAO Peng, ZHANG Hong-bo, WANG Ya-lei, HUANG Bai-yun. Surface morphology of TaC coating prepared by chemical vapor deposition and preferential growth mechanism of TaC grains[J]. The Chinese Journal of Nonferrous Metals, 2008, 18(8): 1377- 1382.
[3] �����, �� ��, �Ʋ���. �¶ȶ�CVD-TaCͿ����ɡ���ò��ṹ��Ӱ��[J]. �й���ɫ����ѧ��, 2005, 15(4): 565-571.
LI Guo-dong, XIONG Xiang, HUANG Bai-yun. Effect of temperature on composition, surface morphology and micro- structure of CVD TaC coating [J]. The Chinese Journal of Nonferrous Metals, 2005, 15(4): 565-571.
[4] SUN Wei, XIONG Xiang, HUANG Bai-yun, LI Guo-dong, ZHANG Hong-bo, XIAO Peng, CHEN Zhao-ke, ZHENG Xiang-lin. Preparation of ZrC nano-particles reinforced amorphous carbon composite, coating by atmospheric pressure chemical vapor deposition[J]. Applied Surface Science, 2009, 255: 7142-7146.
[5] �� ��, �� ��, �� ��, �Ժ���, �ƴ���. ZrCl4�����������Ʊ���������Ѱ���ȼ�Ͽ���ZrCͿ��[J]. ԭ���ܿ�ѧ����, 2009, 43(11): 1017-1020.
CHEN Lei, LIU Chao, LIU Bing, ZHAO Hong-sheng, TANG Chun-he. Preparation of ZrC layer of coated fuel particle for high temperature gas cooled reactor by chemical vapor deposition with ZrCl4 vapor[J]. Atomic Energy Science and Technology, 2009, 43(11): 1017-1020.
[6] PIERSON H Q. Handbook of refractory carbides and nitrides: Properties characteristics, pressing, and applications[M]. New Jersey: Noyes Publications, 1996: 256
[7] MINATO K, OGAWA T. Fission product release from ZrC-coated fuel particles during post irradiation heating at 1 600 ��[J]. J Nuel Mater, 1995, 224: 85-92.
[8] �����, �Ŵ��, �ű���, �� ��, ������. ̼��ﯶƲ�Ļ�ѧ�������[J]. �廪��ѧѧ��: ��Ȼ��ѧ��, 2000, 40(12): 59-62.
ZHU Jun-guo, DU Chun-biao, ZHANG Bing-zhong, YANG Bing, PENG Xin-li. Chemical vapor deposition of zirconium carbide coating[J]. Journal of Tsinghua University: Science and Technology, 2000, 40(12): 59-62.
[9] MACKIE W A, XIE T B, DAVIS P R. Field emission from carbide film cathodes[J]. J Vac Sci Technol, 1995, 13: 2459- 2463.
[10] CHEN Cheng-shi, LIU Chuan-pu, TSAO C Y A. Influence of growth temperature on microstructure and mechanical properties of nanrystalline zirconium carbide films[J]. Thin Solid Films, 2005, 479: 130-136.
[11] ALESSIO L D, SANTAGATA A, TEGHIL R, ZACCAGNINO M, ZACCARDO I, MAROTTA V, FERRO D, MARIA G D. Zirconium carbide thin films deposited by pulsed laser ablation [J]. Appl Surf Sci, 2000, 168(1/4): 284-287.
[12] XIE T, MACKIE W A, DAVIS P R. Field emission from ZrC films on Si and Mo single emitters and emitter arrays[J]. J Vac Technol, 1996, 14(B): 2090-2099.
[13] �� ��, ������, ������. Һ������ŵ����ZrC �մ�Ϳ���ǿ�����ռ�Ϳ�����ܵ��о�[J]. �ȼӹ�����, 2007, 36(3): 57-60.
WU Feng, JIE Xiao-hua, CHEN Yu-ming. Study on the intensity press and the performance of the ZrC ceramic coating with electrical discharge in the liquid[J]. Materials Research and Application, 2007, 36(3): 57-60.
[14] ZHANG Qing-mao, HE Jin-jiang, LIU Wen-jin, ZHONG Min-lin. Microstructure characteristics of ZrC-reinforced composite coating produced by laser cladding[J]. Surf Coat Technol, 2003, 162: 140-146.
[15] WON Y S, KIM Y S, VARANASI V G, KRYLIOUK O, ANDERSON T J, SIRIMANNE C T, WHITE L M. Growth of ZrC thin films by aerosol-assisted MVD[J]. J Cryst Growth, 2007, 304(2): 324-332.
[16] ���¸�, ������, �� ��, ������, ����ͬ. ��ѧ�������̼���Ϳ����о���չ[J]. ���ϵ���, 2010, 24(3): 45-47.
LUAN Xin-gang, LIU Qiao-mu, LIU Jia, CHENG Lai-fei, ZHA'NG Li-tong. Progress in chemical vapor deposition of zirconium carbide coatings[J]. Materials Review, 2010, 24(3): 45-47.
[17] LIU Qiao-mu, ZHANG Li-tong, CHENG Lai-fei, WANG Yi-guang. Morphologies and growth mechanisms of zirconium carbide films by chemical vapor deposition[J]. J Coat Technol Res, 2009, 6(2): 269-273.
[18] WANG Yi-guang, LIU Qiao-mu, LIU Jin-ling, ZHANG Li-tong, CHENG Lai-fei. Deposition mechanism for chemical vapor deposition of zirconium carbide coatings[J]. J Am Ceram S, 2008, 91(4): 1249-1252.
[19] LIU Chao, LIU Bing, SHAO You-lin, LI Zi-qiang, TANG Chun-he. Vapor pressure and thermochemical properties of ZrCl4 for ZrC coating of coated fuel particles[J]. Transactions of Nonferrous Metals Society of China, 2008, 18: 728-732.
[20] JONG H P, CHOONG H J, DO J K, JI Y P. Effect of H2 dilution gas on the growth of ZrC during low pressure chemical vapor deposition in the ZrCl4-CH4-Ar system[J]. Surface & Coatings Technology, 2008, 203: 87-90.
[21] JONG H P, CHOONG H J, DO J K, JI Y P. Temperature dependency of the LPCVD growth of ZrC with the ZrCl4-CH4- H2 system[J]. Surface & Coatings Technology, 2008, 203: 324- 328.
[22] �����, �� ��, �� ��, ֣����, ������, ���п�, �� ��. ���ȿɵ��ͷ�װ��: �й�, 201010538190.4 [P]. 2010-12-30.
LI Guo-dong, XIONG Xiang, LIU Gang, ZHEN Xiang-lin, WANG Ya-lei, CHEN Zhao-ke, SUN Wei. A uniform and adjustable powder feed unit: China, 201010538190.4[P]. 2010- 12-30.
[23] �����, ֣����, �� ��, �� ��. ����Ũ�ȶԳ�ѹ��ѧ�������ZrCͿ���Ӱ��[J]. �й���ɫ����ѧ��, 2010, 20(9): 1795-1801.
LI Guo-dong, ZHEN Xiang-lin, XIONG Xiang, SUN Wei. Effect of hydrogen concentration on preparation of ZrC coating by APCVD[J]. The Chinese Journal of Nonferrous Metals, 2010, 20(9): 1795-1801.
[24] CHOY K L. Chemical vapour deposition of coatings[J]. Progress Mater Sci, 2003, 48(2): 57-170.
(�༭ ������)
������Ŀ�������ص�����о���չ�ƻ�������Ŀ(2011CB605805); ������Ȼ��ѧ�������о�Ⱥ��(51021063)
�ո����ڣ�2010-12-14�������ڣ�2011-05-19
ͨ�����ߣ�����������ڣ���ʿ���绰��13087317973; E-mail: lgd63@163.com
ժ Ҫ������ZrCl4-CH4-H2-Ar��Ӧ��ϵ����̬����ZrCl4��ĩ��ѹ��ѧ�������(CVD)�Ʊ�ZrCͿ�㡣�о��¶ȶԵ�ѹ��ѧ�������ZrCͿ��������ɡ���������������Ϳ�������ò������ṹ��Ϳ�������ٶȺͳ��������Եȷ����Ӱ�졣�����������ͬ�¶��³�����Ϳ����Ҫ��ZrC��C����ɣ������¶ȵ����ߣ�ZrC����(200)��������������ǿ������ֱ�����������������ӣ���������������Ϳ�����ṹ����״��Ϊ������������Ͽھ�������ӣ�Ϳ��ij���������С��1 500 ��ʱ������ϵͳ�ľ����Ա�1 450 ��ʱ�IJ


