DOI��10.19476/j.ysxb.1004.0609.2017.12.18
Bi������Cu/Sn-0.3Ag-0.7Cu/ Cu����������ܵ�Ӱ��
Ҧ����1, 2���� ��1��������2���� ��2������ƽ3��������2
(1. �����ѧ ��е���������ص�ʵ���ң����� 400030��
2. ����Ƽ�ѧԺ ұ������Ϲ���ѧԺ������ 401331��
3. ����Ƽ�ѧԺ ��е�붯������ѧԺ������ 401331)
ժ Ҫ��
���ù�ѧ���������������Ͷ�̬��ѧ�����ȷ����о�Bi������ֱ��Ϊ400 ��m���߶�Ϊ200 ��m����ǦCu/Sn-0.3Ag-0.7Cu(SAC0307)/Cu�߶Ⱥ��������֯��������ܵ�Ӱ�졣�����������������Bi�����ϵ�(1%(��������))ʱ���������֯ϸС��Cu6Sn5Ϊ�ִ��״��Ag3Sn�ֲ������ȣ���������Bi�����϶�(3%(��������))ʱ��������֯��Cu6Sn5��һ��ϸ����Ag3Sn��ϸ����ͬʱ�ֲ������ȣ������ȱ�״IMC���ƽֱ�����⣬�¶�Ϊ80~125 �桢Ӧ��Ϊ8~15 MPa�����£������������õ�SAC0307�������伤����(Q)�����Ӧ��ָ��(n)�ֱ�Ϊ82.9 kJ/mol��4.35����ǥ����Bi������1.0%���ӵ�3.0%ʱ�������Qֵ��89.2 kJ/mol���ӵ�94.6 kJ/mol��nֵ��4.48���ӵ�4.73��ǥ����ͷ�Ŀ��������������ߣ����к���������λ�����Ҫ��λ�����ƿ��ơ�
�ؼ��ʣ�
���ӷ�װ��������Ǧǥ�����������������ѧ������
���±�ţ�1004-0609(2017)-12-2545-07���� ��ͼ����ţ�TN601���� ���ױ�־�룺A
�����ڵ��ӷ�װ����Ҫ���Ż�е���ӡ��������Ӻ��Ƚ��������ã��Ӷ�ȷ������Ԫ����֮��Ŀɿ�������ͨ�Լ��̶���ӡˢ��·����[1-2]��������Ӳ�Ʒ����С�ͻ���������Я���Ͷ�ܻ��ȷ���չ�����������ܵ���ѧ����ѧ�Լ���ѧ���������ӣ������غɵ�������ü�����ɺ������ǰʧЧ�����������ƻ�������������Ϊ��Ҫ����ѧʧЧ��ʽ֮һ[3]������������Ǧǥ�ϵ��۵�(�ۻ��¶�)�ձ�ϵͣ�ʹ�������ڷ��������µ�ͬϵ�¶�(T/Tm)�����ܴﵽ0.75���ϣ�����ǥ�Ϻ�����������ʮ������[1]�������Ǧ�������䱻��Ϊ���ӷ�װ��Ҫ�Ŀɿ�����������ܹ㷺��ע[4]��
Ŀǰ����Sn-0.3Ag-0.7Cu(���SAC0307)Ϊ�����ĵ�����Ǧǥ�ϵ��о������ѳ�Ϊ��������ȵ����⣬�����Ѿ�����Ӧ���ڲ��ֵ��Ӳ�Ʒ��[5-6]���������ڴ���ǥ�ϺϽ���Ag�ĺ����ϵͣ��������۵��Ըߣ���ʪ���Բǥ�ϵļ���ǿ�Ⱥ���չ�ʽ����ͣ�����ʹ���ܵ�һ�������ơ��Ͻ��Ǹ��Ƶ���ǥ�����ܵ���Ҫ����֮һ��Ŀǰ������SAC0307�Ͻ��о���Ҫ�Լ���Bi��NiΪ��[7-11]������о�[8, 10-12]���������Ͻ�Ԫ�صļ���(��Bi)�ܽ��ͽ���IMC�������ٶȣ�����˽�ͷ����ǿ�ȺͿ��ϻ��̶ȡ���������������ܽǶ��о����������ʧЧ��Ϊ�����Ŀǰ���dz�Ƿȱ����ˣ�����������SAC0307Ϊ�о������о�����Bi��SAC0307����������ܵ�Ӱ����ɣ����ڸ��Ƶ�����Ǧǥ�ϼ�������Ŀ�������ܣ����ʹ��������ͬʱΪ������Ǧǥ�ϵ��з��ṩ��ѧ������ο���
1 ʵ��
������ǥ�ϺϽ��Ʊ��������£����Ȳ��ô���Ϊ99.5%��������99.95%��������99.99%����ͭ˿���մ���������¯���Ʊ�SAC0307ǥ�ϣ�Ȼ����SAC0307Ϊ�������ֱ�����1%��3%(��������)��BiԪ�����Ʊ��µ�ǥ�ϺϽ�(�ֱ��ΪSAC0307-1Bi��SAC0307- 3Bi)��Ϊ����ǥ�ϺϽ��������ǥ�ϺϽ��Ʊ�ʱ����LiCl��KCl���ڹ����θ��DZ���(LiCl��KCl��������Ϊ1:1.3)��
ǥ����ͷ��������״��ͼ1��ǥ��ǰ���Ƚ�ǥ�Ͼ�ϸ�и���������ã�����һ��ĥƽ������ͭ˿(d 0.4 mm��30 mm)һ������ڳ�������������ϴ5~8 min��Ȼ��һ��ȡ������ϴ�ɾ��ɡ��������ƴ���V���ۡ������Ƽо߿�������ľ�ȷװ�䲢���к���(��ͼ1��ʾ)���߶Ⱥ�����Ʊ�����ģ����ʵ�����������½��еġ�Ϊ��ǿ���Լ�ȥ������������ǥ����������5% ZnCl2 (��������)������ƾ���Һ�����������Ʊ��ĺ���߶ȿ�����200 ��m��ǥ����ĺ����ڳ���������ϴ����1000~2500��ɰֽ��ĥ�⻬�Ա�ʹ�á�
ǥ���������֯����ɨ��羵(SEM)�۲죬�����X��������(XRD)ȷ����ͬʱ���ø߾��ȶ�̬��ѧ������(DMA Q800)����������飬�����¶�ѡ��Ϊ80~125 �棬����Ӧ���غ��趨Ϊ8~15 MPa��ÿһ�������������3�����������Ʒ��ȡ��ƽ��ֵ��Ϊ�ò����µ�������������

ͼ1 �Ʊ�������װ��ʾ��ͼ
Fig. 1 Schematic diagram of preparing solder joint samples
2 ���������
2.1 ǥ�������༰����֯����
ͼ2��ʾΪǥ��SAC0307��SAC0307-1Bi��SAC0307-3Bi������XRD�ס���ͼ2�ɿ�����SAC0307��SAC0307-1Biǥ���Ͻ�ĺ�����Ҫ��Sn��Ag3Sn(IMC)��Cu6Sn5(IMC)��ɣ�SAC0307-3Bi��������Sn��Ag3Sn(IMC)��Cu6Sn5(IMC)��Bi����ɡ�

ͼ2 SAC0307��SAC0307-1Bi��SAC0307-3Bi�����XRD��
Fig. 2 XRD patterns of SAC0307(a), SAC0307-1Bi(b) and SAC0307-3Bi(c) joints

ͼ3 ��ͬǥ�Ͻ�ͷ��SEM����֯
Fig. 3 SEM images of different solder joints
ͼ3��ʾΪSAC0307��SAC0307-1Bi��SAC0307- 3Bi 3�ֳɷ�ǥ�ϺϽ��ǥ����ͷSEM��ͼ3�п��Կ�����ǥ��ʱǥ�Ϻ�Cu˿֮���γ�һ��ܱ����ȱ�״IMC�㣬��EDS����ΪCu6Sn5������Bi���������ӣ�IMC��ĺ�Ȳ��ϼ�С������ǰ������ܴ���ȱ�״(��ͼ3(b))ת��Ϊ�����Ϊƽ�����ȱ�״(��ͼ3(c))���ɴ˿�֪��BiԪ�ص�������һ���̶��ϼ�����IMC��������ٶȣ�SAC0307-3Biǥ�ϺϽ������IMC�����������������С����SAC0307ǥ�ϺϽ������IMC��������죬��������[13]���о����Ǻϡ�
��ͼ3���ɿ�����ǥ��������֯��Ҫ���ȹ������-Sn��ɣ�����������Ľ����仯����Cu6Sn5��Ag3Sn��ͼ3(a)�У������ڲ���Ҫ�Ǵִ�Ħ�-Sn�����Ͳ�����ֲ��ڸ�Sn�����е�IMC��������EDS������֪�����ɫ�ɴ�Ƭ״�Ŀ�������Cu6Sn5���������Ļ�ɫС������Ag3Sn��ǥ�ϻ����м���Bi���ܹ�ϸ��Ag3Sn��Cu6Sn5(��ͼ3(b)��3(c))����Bi�������ӵ�1%ʱ��ϸ������������(��ͼ3(b))����Bi�����������ӵ�3%ʱ��Cu6Sn5ϸ���������ԣ����������м���(��ͼ3(c))������Ҫԭ���ǣ�Bi���뵽SAC0307�н�����ǥ�ϵ��ۻ��¶ȣ������˽ᾧʱ�Ĺ���ȣ���֮����ߴ��Сʹ��ȴ�ٶ������¦�-Sn��ϸС��IMC���������Ż�����Ľ���Ͼ��ȷֲ���
2.2 ��Ӧ����ͬ�¶��µ������Ϊ����伤����Q
��80~125 ��������¶ȷ�Χ�ڣ�ֱ��Ϊ400 ��m���߶�Ϊ200 ��m 3��ǥ�ϵ�������15 MPa�㶨��������غ������µ������������ʱ��Ĺ�ϵ��ͼ4����ͼ4��֪����80��90��100��125 �� 4���¶������к����������߾����ڳ�ʼ���Ρ���̬���κͼ�������(Ҳ�������ѽ�)��3�������νΡ���������������Ҫ����ռ���������ι����൱���������̬���ξ����ģ���ˣ�������̬������ʶ����ӷ�װ��������������Ԥ�������Ҫ�����塣
��������������3�����ǥ��ǥ��������15 MPaӦ���������������( )��������ʱ��(t)���1��ʾ��
)��������ʱ��(t)���1��ʾ��

ͼ4 15 MPaʱ��ͬ�¶���SAC0307-xBi����Ӧ��-ʱ������
Fig. 4 Strain-time curves of SAC0307-xBi micro-scale solder joints at different temperatures and 15 MPa
��1 15 MPaʱSAC0307-xBi�����ڲ�ͬ�¶��µ��������
Table 1 Creep properties of SAC0307-xBi micro-scale solder joints at different temperatures and 15 MPa

�ӱ�1���Կ������������¶Ⱥ�Ӧ����ͬ������£�������Bi������ǥ��ǥ����ͷ��̬������ʾ�С��SAC0307ǥ���ӽ�ͷ�ģ�������SAC0307-3Biǥ����ͷ��������ʷdz��ͣ������ǵ�������������Ը���SAC0307ǥ�ϵġ����⣬�ӱ�1�����Կ��������������¶ȵ���ߣ�3��ǥ��ǥ����ͷ��������ʾ�������ߣ�������ʱ���������̡����磬��125 ��ʱ��SAC0307��̬�������Ϊ2.80��10-6 s-1��Լ�� 80 ���22��������ʱ��Ϊ600 s����80 ��������˽�12600 s������Ҫ�������¶����ߣ�ԭ�ӵ���ɢ��λ����������˶����Ӿ磬ʹ�����θ�������
ͨ������£���̬�����������Ӧ�����¶���صĺ�����һ���ʹ�ñ���ʽ(1)��ʾ�� Norton ���ɹ�ʽ������[14]��
 (1)
(1)
ʽ�У� Ϊ��̬������ʣ�AΪ����֯��صij�����
Ϊ��̬������ʣ�AΪ����֯��صij����� ΪӦ����nΪ���Ӧ��ָ����QΪ��伤���ܣ�RΪĦ�����峣����TΪ����ѧ�¶ȡ�
ΪӦ����nΪ���Ӧ��ָ����QΪ��伤���ܣ�RΪĦ�����峣����TΪ����ѧ�¶ȡ�
��伤����Q�����ɹ�ʽ�е�һ����Ҫ�IJ������Է��������εĹ��ɺ����������Ԥ����ʮ����Ҫ�����á�
��ʽ(1)���߷ֱ�ȡ��Ȼ�������Եõ�
 (2)
(2)
��Ӧ������ʱ�� Ϊ��������
��������
 (3)
(3)
��ʽ(3)���Կ�������Ӧ������ʱ�� ��
�� ��ֱ�߹�ϵ��б��Ϊ-Q/R����ͼ5��̬����������¶ȵĹ�ϵ���Կ�����ͬһ�����µ�4�����нϺõ�ֱ�߹�ϵ���Ӹ���ֱ�ߵ�б�ʿ��Եõ���伤����Qֵ�����2��ʾ���ӱ�2���Կ��������е�������15 MPaӦ����4����ͬ�¶��µ���伤���ܾ���81~96 kJ/mol����һ�о������һЩ���õ���Sn��ǥ�ϻ��������伤���ܱȽϽӽ�����75~95 kJ/mol[15]��ͬʱ�����֣�Bi�ļ�������˺������伤���ܣ�������Bi���������ӣ��������伤�������ӣ�Bi����Ϊ3%ʱ��伤�������
��ֱ�߹�ϵ��б��Ϊ-Q/R����ͼ5��̬����������¶ȵĹ�ϵ���Կ�����ͬһ�����µ�4�����нϺõ�ֱ�߹�ϵ���Ӹ���ֱ�ߵ�б�ʿ��Եõ���伤����Qֵ�����2��ʾ���ӱ�2���Կ��������е�������15 MPaӦ����4����ͬ�¶��µ���伤���ܾ���81~96 kJ/mol����һ�о������һЩ���õ���Sn��ǥ�ϻ��������伤���ܱȽϽӽ�����75~95 kJ/mol[15]��ͬʱ�����֣�Bi�ļ�������˺������伤���ܣ�������Bi���������ӣ��������伤�������ӣ�Bi����Ϊ3%ʱ��伤�������
2.3 ���¶Ȳ�ͬӦ���µ�������ߺ����Ӧ��ָ��n
Ϊ����������SAC0307-xBi�߶Ⱥ�������Ӧ��ָ������������¶��趨Ϊ125 ��㶨���䣬4�ֲ�ͬ����Ӧ���غɷֱ�Ϊ8��10��12��15 MPa��ͼ6��ʾΪ���������¶��µ�Ӧ��-ʱ��������ߡ�
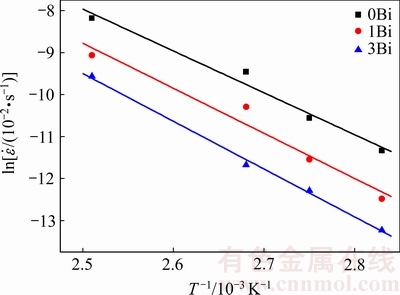
ͼ5 ������¶�����̬������ʵĹ�ϵ
Fig. 5 Relationships between steady-state creep rate and temperature of solder joints
��2 15 MPaʱSAC0307-xBi�������伤����Q
Table 2 Creep activation energy (Q) of SAC0307-xBi micro-scale solder joints at 15 MPa

��ͼ6���Կ�������Ӧ���ϵ������£�������ʺ���������Ӧ��ˮƽ����ߣ��ߴ纸�����̬����������Ա�죬��������ʱ�����������̡�ͨ��ͼ6��ʾ�����������õ���ͬ�¶���SAC0307-xBi�ߴ纸�����̬������ʺ�������ʱ�����3��ʾ��
�Ա���ʽ(1)���߷ֱ�ȡ������Ȼ�����߷ֱ�� ���ɵõ����Ӧ��ָ��n�Ľ��Ʊ���ʽ��
���ɵõ����Ӧ��ָ��n�Ľ��Ʊ���ʽ��
 (4)
(4)
��ʽ(4)���Կ��������¶Ⱥ㶨ʱ�� ��
�� ��ֱ�߹�ϵ��б�ʾ������Ӧ��ָ��n����ͼ7��̬�����������Ӧ���Ĺ�ϵ���Կ�����ͬһ�����µ�4�����нϺõ�ֱ�߹�ϵ���Ӹ���ֱ�ߵ�б�ʿ��Եõ����Ӧ��ָ��n�����4��ʾ���ӱ�4���Եó��� SAC0307������Ǧǥ�ϺϽ��м���BiԪ�غ����ƽ��Ӧ��ָ��n����֮��ߣ���������������ӣ���nֵ����4~5֮�䣬��һ��������ۼ��㴿Snǥ�ϵ����Ӧ��ָ��nֵ4~9[15]�ȽϽӽ���˵��Sn��ǥ�ϳɷ����仯�����Ӧ��ָ������伤���ܵ�Ӱ�첻������ͬ����������������ɵĽ����
��ֱ�߹�ϵ��б�ʾ������Ӧ��ָ��n����ͼ7��̬�����������Ӧ���Ĺ�ϵ���Կ�����ͬһ�����µ�4�����нϺõ�ֱ�߹�ϵ���Ӹ���ֱ�ߵ�б�ʿ��Եõ����Ӧ��ָ��n�����4��ʾ���ӱ�4���Եó��� SAC0307������Ǧǥ�ϺϽ��м���BiԪ�غ����ƽ��Ӧ��ָ��n����֮��ߣ���������������ӣ���nֵ����4~5֮�䣬��һ��������ۼ��㴿Snǥ�ϵ����Ӧ��ָ��nֵ4~9[15]�ȽϽӽ���˵��Sn��ǥ�ϳɷ����仯�����Ӧ��ָ������伤���ܵ�Ӱ�첻������ͬ����������������ɵĽ����
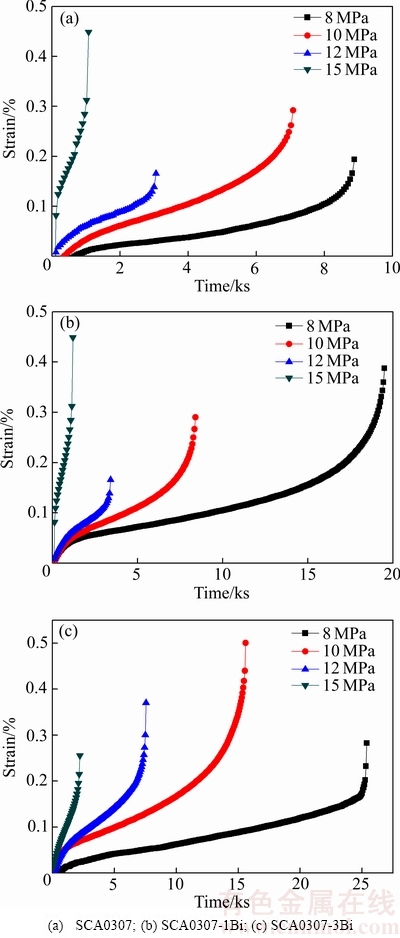
ͼ6 125 ��ʱ��ͬӦ����SAC0307-xBi����Ӧ��-ʱ������
Fig. 6 Strain-time curves of SAC0307-xBi micro-scale solder joints at different stresses and 125 ��
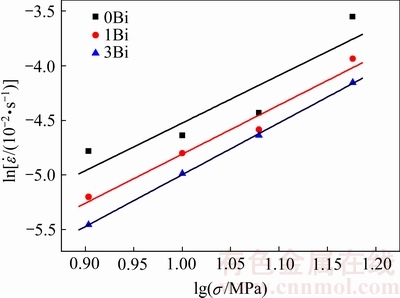
ͼ7 SAC0307-xBi����� ��
�� ��ϵ
��ϵ
Fig. 7 Relationships between  and
and  of SAC0307-xBi micro-scale solder joints
of SAC0307-xBi micro-scale solder joints
��n��3ʱ��λ�����ƿ��Ƶ���䣻nΪ4~6ʱ����λ�������˶����Ƶ����[16]��������������֪��SAC0307��SAC0307-1Bi��SAC0307-3Biǥ����������Ӧ��ָ��nֵ����4~5֮�䣬������Q(��80~95 kJ/mol֮��)���-Sn�ľ�������ɢ�����ܵ�ֵ�ӽ�(��-Sn�ľ�������ɢ������Ϊ97 kJ/mol[15])����ˣ�SAC0307-xBiǥ����������������λ�����Ҫ����λ�����ƿ��ƣ�λ�����Ƶ��ٶ���λ���ܵ���ɢ�ٶ�������������WITKIN[17]���о�����Ͻӽ�������������BiԪ�غ�Bi������Sn����ɾ�������谭���廬�����λ���˶������º���ı��ο������ӣ�Bi�����ۼ��ھ��紦��λ���ж������ã����Ժ���BiԪ�ص�����nֵ��Qֵ�����ӣ��������������ߣ���������[18]�о�������Ǻϡ�
��3 125 ��ʱSAC0307-xBi�����ڲ�ͬӦ���µĿ��������
Table 3 Creep properties of SAC0307-xBi micro-scale solder joints at different stresses and 125 ��

��4 125 ��ʱSAC0307-xBi������Ǧ�������Ӧ��ָ ��n
Table 4 Creep stress exponent (n) of SAC0307-xBi micro- scale solder joints at 125 ��

3 ����
1) ��SAC0307ǥ�ϺϽ��м���1% BiԪ��ʱ�������ڲ��Ľ����仯����Cu6Sn5��Ϊ�ִ�Ŀ�״��Ag3Sn�ڻ����еķֲ�Ҳ�����ȣ�����IMC�������ϴ���ȱ�״����Bi�������ӵ�3%ʱ�������ڲ���Cu6Sn5�������ɴִ��ΪϸС��Ag3SnҲ���ϸС�����ȣ�����IMC���Ϊ���ƽ�����ȱ�״������SAC0307�м�������BiԪ���ܹ�ϸ����֯��
2) ���е�SAC0307-xBi/Cu������Ǧǥ�ϵ�ǥ����ͷ��������߾�������ʼ��䡢��̬���ͼ������3���Σ������¶�����Ӧ��������̬������ʴ�������ӣ�����������Խ��͡�
3) ��ͬBi������ǥ��ǥ����ͷ����伤���ܾ���80~95 kJ/mol�ڣ����Ӧ������ָ��Ϊ4~5������BiԪ�صļ���SAC0307ǥ����������������ߡ���Bi����Ϊ3%ʱ��ǥ����ͷ����伤���ܺ����Ӧ��������ϵĿ����������á�
4) 3��ǥ��ǥ����ͷ�����������λ�����Ҫ��λ�����ƿ��ơ�
REFERENCES
[1] YIN L, WEI S, XU Z, GENG Y. The effect of joint size on the creep properties of microscale lead-free solder joints at elevated temperatures[J]. Journal of Materials Science: Materials in Electronics, 2013, 24(4): 1369-1374.
[2] ������, Ҧ����, �ֽ���, � ��. ��ͬ�����Ǧ�ߴ纸��������ѧ����[J]. ����ѧ��, 2014, 35(6): 61-64.
YIN Li-meng, YAO Zong-xiang, LIN Jie-xiang, DOU Xin. Creep properties of microscale lead-free solder joints with different volumes[J]. Transactions of the China Welding Institution, 2014, 35(6): 61-64.
[3] LEE K O, MORRIS J W, HUA F. Mechanisms of creep deformation in pure Sn solder joints[J]. Journal of Electronic Materials, 2013, 42(3): 516-526.
[4] ������, Michael Pecht, λ ��, �����, Ҧ����. ����߶ȶ��߶Ⱥ�����ѧ��Ϊ��Ӱ��[J]. ����ѧ��, 2013, 34(8): 27-30.
YIN Li-meng, PECHT Michael, WEI Song, GENG Yan-fei, YAO Zong-xiang. Effect of joint height on the mechanical behaviors of micro-scale solder joints[J]. Transactions of the China Welding Institution, 2013, 34(8): 27-30.
[5] CHENG F, GAO F, ZHANG J, JIN W, XIAO X. Tensile properties and wettability of SAC0307 and SAC105 low Ag lead-free solder alloys[J]. Journal of Materials Science. 2011, 46(10): 3424-3429.
[6] ������, Ҧ����, �����, �ֽ���, ½���. Sn-0.3Ag-0.7Cu ������Ǧ�߶Ⱥ������������о�[J]. ����Ԫ�������, 2014, 33(1): 56-59.
YIN Li-meng, YAO Zong-xiang, GENG Yan-fei, LIN Jie-xiang, LU Yu-hao. Creep properties of Sn-0.3Ag-0.7Cu low-Ag lead-free micro-scale solder joints[J]. Electronic Components and Materials, 2014, 33(1): 56-59.
[7] ZHANG X P, YU C B, ZHANG Y P, SHRESTHA S, DORN L. Processing treatment of a lead-free Sn-Ag-Cu-Bi solder by rapid laser-beam reflowing and the creep property of its soldered connection[J]. Journal of Materials Processing Technology, 2007, 192/193(4): 539-542.
[8] �����, ���ĸ�, ������, �� ��. Bi��Sn-0.3Ag-0.7Cu��Ǧǥ���۵㼰��ʪ���ܵ�Ӱ��[J]. ����ѧ��, 2008, 29(10): 5-8.
SUN Feng-lian, HU Wen-gang, WANG Li-feng, MA Xin. Influence of Bi on the melting point and wettability of Sn-0.3Ag-0.7Cu lead-free solder[J]. Transaction of the China Welding Institution, 2008, 29(10): 5-8.
[9] HU Wen-gang, SUN Feng-lian, WANG Li-feng. The wettability of Sn-0.3Ag-0.7Cu-xBi Pb-free solders[J]. Electronic Components and Materials, 2008, 4(27): 38-41.
[10] LIU Yang, SUN Feng-lian, LIU Yang, LI Xue-mei. Effect of Ni, Bi concentration on the microstructure and shear behavior of low-Ag SAC-Bi-Ni/Cu solder joints[J]. Journal of Materials Science: Materials in Electronics, 2014, 25(6): 2627-2633.
[11] �� ��, �����. Ni��BiԪ�ض�SnAgCuǥ����������������������ʵ�Ӱ��[J]. �й���ɫ����ѧ��, 2012, 22(2): 460-464.
LIU Yang, SUN Feng-lian. Effect of Ni and Bi addition on growth rate of intermetallic compound of SnAgCu soldering[J]. The Chinese Journal of Nonferrous Metals, 2012, 22(2): 460-464.
[12] ��Ҫ��, �ſ¿�, ������, �º��. Sn-2.5Ag-0.7Cu(0.1 RE)/Cu�������������֯��Cu6Sn5����������ѧ[J].�й���ɫ����ѧ��, 2009, 19(4): 708-713.
WANG Yao-li, ZHANG Ke-ke, HAN Li-juan, WEN Hong-hong. Microstructure and growth behavior of Cu6Sn5for Sn-2.5Ag-0.7Cu(0.1RE)/Cu solder joint interface[J]. The Chinese Journal of Nonferrous Metals, 2009, 19(4): 708-713.
[13] �� ��, �ٳ���, �̴�ǰ. Bi��Sn-3Ag-0.5Cu/Cu��Ǧǥ����ͷ����ǿ�ȵ�Ӱ��[J]. ����ѧ��, 2008, 44(4): 473-477.
ZHAO Jie, CHI Cheng-yu, CHENG Cong-qian. Effect of Bi addition on shear strength of Sn-3Ag-0.5Cu/Cu solder joints[J]. 2008, 44(4): 473-477.
[14] MAVOORI H, CHIN J, VAYNMAN S, MORAN B, KEER L, FINE M. Creep, stress relaxation, and plastic deformation in Sn-Ag and Sn-Zn eutectic solders[J]. Journal of Electronic Materials, 1997, 26(7): 783-790.
[15] KERR M, CHALWA N. Creep deformation behavior of Sn-3.5Ag solder/Cu couple at small length scales [J]. JOM, 2004, 56(6): 50-54.
[16] ��ά��, ����ͤ, �ܼ���. �����NiAl-9Mo�Ͻ�������Ϊ[J]. ����ѧ��, 2002, 38(9): 908-913.
REN Wei-li, GUO Jian-ting, ZHOU Ji-yang. Creep behavior of two-phase NiAl-9Mo eutectic alloy[J]. Acta Metallrugica Sinica, 2002, 38(9): 908-913.
[17] WITKIN D. Creep behavior of bi-containing lead-free solder alloys[J]. Journal of Electronic Materials, 2012, 41(2): 190-203.
[18] EL-DALY A A, AL-GANAINY G S, FAWZY A, YOUNIS M J. Structural characterization and creep resistance of nano-silicon carbide reinforced Sn-1.0Ag-0.5Cu lead-free solder alloy[J]. Materials and Design, 2014, 55(6): 837-845.
Effect of Bi content on creep properties of Cu/Sn-0.3Ag-0.7Cu/ Cu solder joints
YAO Zong-xiang1, 2, LUO Jian1, YIN Li-meng2, WANG Gang2, JIANG De-ping3, XIA Wen-tang2
(1. State Key Laboratory of Mechanical Transmission, Chongqing University, Chongqing 400030, China;
2. School of Metallurgy and Materials Engineering, Chongqing University of Science and Technology, Chongqing 401331, China;
3. College of Mechanical and Power Engineering, Chongqing University of Science and Technology, Chongqing 401331, China)
Abstract: The microstructure and creep properties of Bi-doped Cu/Sn-0.3Ag-0.7Cu (SAC0307)/Cu micro-scale solder joints with diameter of 400 ��m and height of 200 ��m were investigated by optical microscope, scanning electron microscope and dynamic mechanical analysis method. The results show that adding 1% (mass fraction) Bi element into SAC0307 solder leads to the microstructural refinement, larger block of Cu6Sn5, non-uniform distribution of Ag3Sn and small primary ��-Sn grains. While the SAC0307-3Bi solder joints contain relatively smaller sizes of primary ��-Sn grains, also the IMCs appear much smaller than the examined joints with low Bi content. The IMC layer at the solder/Cu interface changes from a large up-and-down scallop shape to the straight one. In addition, the creep property of micro-scale solder joints was studied under 80-125 �� and 8-15 MPa. The activation energy (Q) of solder joints increase from 82.9 kJ/mol to 94.6 kJ/mol, the stress exponent (n) increases from 4.48 to 4.73 when Bi content increases from 1.0% to 3.0% (mass fraction), which indicates the increasing trends of the creep resistance and dominant deformation mechanism of dislocation climb.
Key words: electronic packaging; low-Ag lead-free solder; micro-scale solder joint; creep; mechanical property
Foundation item: Projects(51674056, 51174246) supported by the National Natural Science Foundation of China; Project(CSTC2014JCYJA40009) supported by the Research Program of Frontier and Applied Basic Research of Chongqing, China; Project(AWJ-M15-05) supported by State Key Laboratory of Advanced Welding and Joining, Harbin Institute of Technology, China; Project(CXTDX201601032) supported by Innovation Team Building at Institutions of Higher Education in Chongqing, China
Received date: 2016-01-04; Accepted date: 2016-12-09
Corresponding author: YIN Li-meng; Tel: +86-15023730501; E-mail: yeenlm@cqust.edu.cn
(�༭ ����)
������Ŀ��������Ȼ��ѧ����������Ŀ(51674056��51174246)��������ǰ����Ӧ�û����о���Ŀ(CSTC2014JCYJA40009)���Ƚ����������ӹ����ص�ʵ���ҿ��ſ����о�����(AWJ-M15-05)�������и�У�����Ŷӽ���ƻ�������Ŀ(CXTDX201601032)
�ո����ڣ�2016-01-04�������ڣ�2016-12-09
ͨ�����ߣ������ϣ����ڣ���ʿ���绰��15023730501��E-mail: yeenlm@cqust.edu.cn
ժ Ҫ�����ù�ѧ���������������Ͷ�̬��ѧ�����ȷ����о�Bi������ֱ��Ϊ400 ��m���߶�Ϊ200 ��m����ǦCu/Sn-0.3Ag-0.7Cu(SAC0307)/Cu�߶Ⱥ��������֯��������ܵ�Ӱ�졣�����������������Bi�����ϵ�(1%(��������))ʱ���������֯ϸС��Cu6Sn5Ϊ�ִ��״��Ag3Sn�ֲ������ȣ���������Bi�����϶�(3%(��������))ʱ��������֯��Cu6Sn5��һ��ϸ����Ag3Sn��ϸ����ͬʱ�ֲ������ȣ������ȱ�״IMC���ƽֱ�����⣬�¶�Ϊ80~125 �桢Ӧ��Ϊ8~15 MPa�����£������������õ�SAC0307�������伤����(Q)�����Ӧ��ָ��(n)�ֱ�Ϊ82.9 kJ/mol��4.35����ǥ����Bi������1.0%���ӵ�3.0%ʱ�������Qֵ��89.2 kJ/mol���ӵ�94.6 kJ/mol��nֵ��4.48���ӵ�4.73��ǥ����ͷ�Ŀ��������������ߣ����к���������λ�����Ҫ��λ�����ƿ��ơ�


