��ѹ���취�Ʊ�������Mo/Cu���䵼������
�¹���, ���־, ռ ��, �� ǿ, ���
(��������ҵ��ѧ ���Ͽ�ѧ�빤��ѧԺ, ������ 150001)
ժ Ҫ��
����ר����ѹ���췽���Ʊ���3��Mo��������ֱ�Ϊ55%�� 60%��67%��Mo/Cu���ϲ���, ����������֯�͵������ܽ������о��� �������: Mo�����ֲ�����, Mo/Cu����ɾ�, �������κν��淴Ӧ��ͷǾ���; ���ϲ�����֯���ȡ� ����, �����ܶȸߴ�99%����; ���ϲ��ϵ��ȵ���Ϊ220~270W/(m��K), ������Mo���������Ӷ����͡� ��϶���(ROM)�Ϻõ�Ԥ����55%Mo/Cu���ϲ��ϵ��ȵ���, ������Maxwellģ�ͺ�H-Mģ�͵ļ���ֵ��60%��67%Mo/Cu���ϲ��ϵ��ȵ��ʲ���ֵһ�¡�
�ؼ���: Mo/Cu���ϲ���; ���ܶ�; �ȵ��� ��ͼ�����: TB331
���ױ�ʶ��: A
Highly dense Mo/Cu composites fabricated by squeeze casting and their thermal conduction properties
CHEN Guo-qin, ZHU De-zhi, ZHAN Rong, ZHANG Qiang, WU Gao-hui
(School of Materials Science and Engineering,Harbin Institute of Technology, Harbin 150001, China)
Abstract: Mo/Cu composites with Mo volume fractions of 55%, 60% and 67% were fabricated by the patented squeeze-casting technology, and the microstructures and thermal conduction properties of the Mo/Cu composites were investigated. The results show that Mo particles are homogeneous and uniform, and the Mo/Cu interfaces are clean and free from interfacial reaction products or amorphous layers. The relative density of the Mo/Cu composites is higher than 99%. The thermal conductivity of Mo/Cu composites is 220-270W/(m��K), which can meet the demands of high thermal conductivity for electronic package. The thermal conductivities of Mo/Cu composites decrease with the increase of Mo volume fraction. The ROM model can well predicate the thermal conductivities of 55%Mo/Cu composites, while the values calculated by Maxwell model and H-M Model agree well with the thermal conductivities of 60% and 67%Mo/Cu composites.
Key words: Mo/Cu composites; density; thermal conductivity
Mo/Cu���ϲ��Ͼ��������ĵ��ȡ� ���������Լ�����Ƶ�������ϵ��, �������ڴ��ģ���ɵ�·�ʹ�������������Ϊ��Ƭ�� Ƕ�顢 ���Ӽ���ɢ��Ԫ���õ���Ѹ�ٵķ�չ[1-3]�� ���ŵ��������Ͳ�Ʒ����ʡ� ������, С�ͻ�����չ, ��Mo/Cu���ϲ��ϵ��ۺ�����Ҫ��Խ��Խ��, ��Ҫ�����ڸ����ܶ�(>98%)�͵����庬���ȷ���, �������ܶ���Ӱ������ȵ��ʺ͵絼�ʵĹؼ�����[4-7]�� ��ͳ�������ս��Һ���ս��Ʊ�Mo/Cu���ϲ����Ѻ�����������ܶȵ�Ҫ��, ���û�ѧ��ս�(����Ni�� Co�Ȼ�ս�Ԫ��)�ͻ�е�Ͻ�(��ĩ������ĥ)���Ʊ������ɼ������ܻ�����, ������ܻ��̶�, �����ڻ������ĥ���ʵ����ʵ�����, ����Ӱ����Mo/Cu���ϲ��ϵĵ��Ⱥ͵�������[8-11]�� ���, Mo/Cu���ϲ��ϵ��Ʊ����ձ���Ҫ��һ���µķ�Ծ��
�������߲��ù��ռͳɱ��ϵ͵�ר����ѹ���췽��[12], �Ʊ������ܶ�Ϊ99%����, �������Ϊ55%, 60%��67%��3��Mo/Cu���ϲ���, ���Բ��ϵ�����֯�͵������ܽ����˲����������
1 ʵ��
1.1 Mo/Cu���ϲ����Ʊ�
ѡȡ����Ϊ3��m�Ľ���Mo����Ϊ��ǿ��, ѡ�õ����ԽϺá� �ɱ��ϵ͵���ͨ��ҵ��ͭT3��Ϊ����Ͻ�, �仯ѧ�ɷ�(��������)Ϊ99.7%Cu, 0.01%As, 0.05%Fe, 0.2%Ni, 0.01%Pb, 0.05%Sn, 0.1%O, �����ܺ�С��0.3%�� Mo������T3��ͭ�Ļ����������1����[13]��
Mo/Cu���ϲ��ϲ�����������ѹ����ר�������Ʊ��� �乤������: ���Ƚ�һ�������ͺ�����ȵ�Mo����װ��ģ��, �Ƴ���������ֱ�Ϊ55%�� 60%��67%�Ŀ���Ԥ�Ƽ�, ����1173~1373K����, �ٽ�ͭҺ��1473~1673K����, Ѹ�ټ�ѹ��75MPa, ����5min����ģ, �õ�Mo/Cu���ϲ��ϡ� �����Ʊ�����������ͼ1��ʾ��
1.2 ���ϲ������ܲ���
��̬���ϲ�����֯��OLYMPUS PMG3��ѧ������Philips CM-12��羵(TEM)�Ϲ۲졣
���ܲ���ǰ, ��������973K����1.5h, �����¯�����˻����� ������ˮ�����Ը��ϲ��ϵ���ʵ�ܶ�, ���������ܶȵı�ֵ��Ϊ���ϲ��ϵ����ܶȡ� ���ϲ����ȵ��ʲ��Բ��õ¹�Thermal Diffusivity NETZSCH LAF 427 Analysis����ȷ�����, ��Ʒ�ߴ�Ϊd12.7mm��3.0mm, �������ý���ɰֽĥ��, �����¶�Ϊ298~773K, �����ٶ�Ϊ5K/min��

ͼ1 Mo/Cu���ϲ��ϵ��Ʊ�����
Fig. Fabrication process of Mo/Cu composites
2 ��������
2.1 ����֯
Mo/Cu���ϲ��ϵ�����֯��ͼ2��ʾ�� ��ͼ2�ɿ���, ���ϲ��ϵ���֯���ȡ� ����, �����ʺ����ס� ���ڲ�������������ѹ����ר������, ���Ʊ������п���Чȥ�������е�����, ��ø����ܶȵĸ��ϲ��ϡ� ����ڵ��ӷ�װ���ϲ����Ǻ�������, ���ܵ���֯����������߸��ϲ��ϵ��ȵ���, ������߲��ϵ���ѧ���ܡ�
���漰����ЧӦ�Ĵ�����Ӱ�츴�ϲ������ܷ��ӵ���Ҫ���ء� ͼ3��ʾΪ60%Mo/Cu���ϲ��Ͻ����TEM�� ��ͼ3�ɿ���, Mo/Cu����ɾ��� ƽ��, �������κν��淴Ӧ��ͷǾ���, Ҳû�й۲쵽Mo�������ܽ�����
2.2 ���ܶ�
ͼ4��ʾΪMo������Mo/Cu���ϲ�������
��1 Mo��Cu�Ļ�������
Table 1 Properties of Mo and Cu

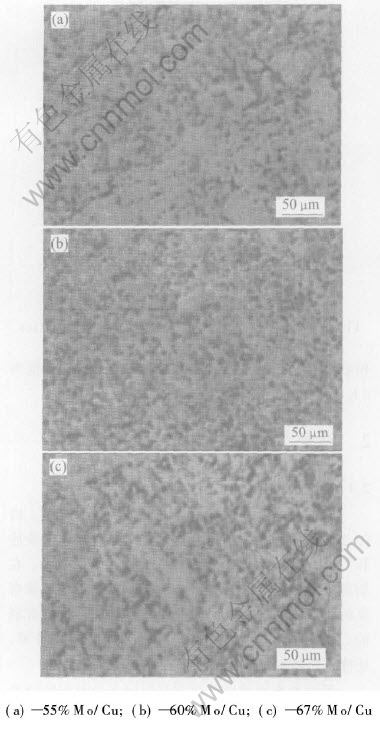
ͼ2 Mo/Cu���ϲ��ϵĽ�����֯
Fig.2 Microstructures of Mo/Cu composites

ͼ3 Mo/Cu���ϲ��Ͻ����TEM��
Fig.3 TEM image of Mo/Cu composite interfaces
�ȵ�Ӱ�졣 ��ͼ4�ɿ���, ����Mo�������������, ���ϲ��ϵ����ܶȳ��½����ơ� ��������Mo����������, һ����ʹMo����֮��ļ�϶��С; ��һ���浼��Mo��������Ӵ��Ľ�������, �ײ���Mo�ž�, �����߾�������Cu��Mo����Ԥ�ƿ��ڲ��������Ѷȡ� �����о�3�ָ��ϲ��ϵ����ܶȾ�Ϊ99.2%~99.5%, ��ȫ���ϵ��ӷ�װ�Բ��ϸ�������(>98%)��Ҫ��

ͼ4 Mo/Cu���ϲ������ܶ���Mo�����Ĺ�ϵ
Fig.4 Relationship between volume fraction of Mo and relative density of Mo/Cu composites
2.3 �ȵ���
3�ֲ�ͬ�������Mo/Cu���ϲ����ȵ������¶ȵĹ�ϵ��ͼ5��ʾ�� ��ͼ5�ɿ���, Mo/Cu���ϲ����ȵ��ʶ�����200 W/(m��K), ��ȫ������ӷ�װ�Բ��ϸߵ��ȵ�Ҫ�� �Ҹ��ϲ��ϵ��ȵ�����Mo���������Ӷ�����, �������¶ȵ�����, ���ϲ����ȵ��ʱ仯����
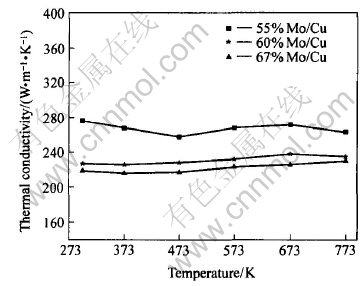
ͼ5 Mo/Cu���ϲ��ϵ��ȵ������¶ȱ仯�Ĺ�ϵ
Fig.5 Relationship between thermal conductivity of Mo/Cu composites and temperature
������ǿ���ϲ��ϵ��ȵ��ʲ���ȡ���ڸ��������ȵ��ʺ��������, ���һ�����ϵ����ܶȡ� ����״̬�Լ���������״�ͷֲ���������һ���Ĺ�ϵ�� Ŀǰ, ���㸴�ϲ����ȵ��ʵ�����ģ����Ҫ������3��[14-16]:
1) ��϶���(ROM):
��c=��m��xm+��p��xp
2) ���˹Τ(Maxwell)�о�������Ͷ�������ĵ�������, �õ����ȵ��ʵı���ʽΪ
![]()
3) Hatta��Taya�Ȼ���Eshelby��Ч��������, �ۺϿ����˲�ͬ��ǿ����״��Ӱ��, �õ��˸��ϲ�����Ч�ȵ��ʵ�һ����ʽ�� ���ڿ�����ǿ���ϲ���, ���ȵ��ʼ��㹫ʽΪ

ʽ�� ��Ϊ�ȵ���; xΪ�������; �±� c�� m�� p�ֱ�������ϲ��ϡ� ����Ϳ�����ǿ��; rΪ�����ȵ�������ǿ���ȵ��ʵı�ֵ��
һ���, ����Cu���ȵ���Ϊ398W/(m��K), Mo�������ȵ���Ϊ142.3W/(m��K)�� ͨ����ģ�ͼ���õ����ϲ����ȵ���, ����ʵ��ֵ���бȽ�, ������2���С�
��2 ���ϲ����ȵ��ʵļ���ֵ��ʵ��ֵ
Table 2 Predicted and experimental thermal conductivities of Mo/Cu composites

�ӱ�2�пɿ���, ����Maxwell ģ����H-Mģ�͵ij����㲻ͬ, ��Ԥ������������� ����ʵ��ֵ�ȽϿ��Է���, ������ģ�͵ļ���ֵ��60%��67%Mo/Cu���ϲ����ȵ��ʵ�ʵ��ֵ���; ��55%Mo/Cu���ϲ��ϵ��ȵ���ʵ��ֵ���϶��ɽ�Ϊ�ӽ��� ���о���, ʵ��ֵ������ֵ��Ϊ�ӽ�����Ҫԭ�������ڸ��ϲ�����֯����, ���ܶȸ�, ��Mo/Cu����ɾ��� ƽ��, �������κν��淴Ӧ��ͷǾ��㡣 �����߶�����߿�����ǿ���������ϲ����ȵ��ʵ���Ҫ���ء�
3 ����
1) ���ü�ѹ���췽�������Ʊ���Mo�����ֲ����ȡ� ���ܶ�Ϊ99%���ϸ����������Mo/Cu���ϲ���, ��Mo/Cu����ɾ��� ƽ��, �������κν��淴Ӧ��ͷǾ��㡣
2) 60%��67%Mo/Cu���ϲ�������ʱ���ȵ��ʷֱ�Ϊ227.1W/(m��K) ��223.8W/(m��K), ��ʵ��ֵ��Maxwellģ�ͺ�H-Mģ�͵ļ���ֵ�Ǻ�; 55%Mo/Cu���ϲ��ϵ��ȵ��ʸߴ�276.2W/(m��K), ���϶��ɼ���ֵ��Ϊ�ӽ���
REFERENCES
[1]Ali Z A, Drury O B, Cunningham M F. Fabrication of Mo/Cu multilayer and bilayer transition edge sensors[J]. IEEE Transactions on Applied Superconductivity, 2005, 15(2): 52-69.
[2]NAN Hai, QU Xuan-hui, FANG Yu-cheng. Debinding and sintering of Mo/Cu alloy fabricated by powder injection molding[J]. The Chinese Journal of Nonferrous Metals, 2004, 14(S3): 64-68.
[3]Johnson J L. Powder metallurgy processing of Mo-Cu for thermal management applications[J]. International Journal of Powder Metallurgy, 1999, 35(8): 39-48.
[4]Johnston C, Young R. Advanced thermal management materials[J]. International Newsletter on Microsystems and MEMs, 2000, 2(1): 14-15.
[5]����ƽ, ��ѡ��, �ΰػ�. W-Cu(Mo-Cu)���ϲ��ϵ������о�״��[J]. Ӳ�ʺϽ�, 2001, 18(4): 232-236.
LI Yun-ping, QU Xian-hui, DUAN Bai-hua. The new developments of tungsten-copper (molybdenum-copper) composite[J]. Cemented Carbide, 2001, 18(4): 232-236.
[6]Zweben C. Advances in composite materials for thermal management in electronic packaging[J]. JOM, 1998, 50(6): 47-51.
[7]Robins M. Thermal management materials and designs[J]. Electronic Packaging and Products, 2000, 10(1): 50-59.
[8]Johnson J L, German R M. Role of solid-state skeletal sintering during processing of Mo-Cu composites[J]. Metallurgical and Materials Transactions A��Physical Metallurgy and Materials Science, 2001,32(3): 605-613.
[9]Arikawa T, Ichida A, Takeqoshi E. Mechanical properties of Cu-Mo composites[J]. Journal of the Society of Materials Science Japan, 1999, 48(3):295-300.
[10]Zweben C. High performance thermal management materials[J]. Electronic Cooling Magazine, 1999, 5(3): 36-42.
[11]Kirk T W, Caldwell S G, Oakes J J. Mo-Cu composites for electronic packaging applications[J]. Advances in Powder Metallurgy, 1992, 9: 115-122.
[12]���, �¹���. һ�ָ�������/ͭ���ϲ��ϼ����Ʊ�����[P]. CN 200410028822. 2004-01-13.
WU Gao-hui, CHEN Guo-qin. A High Dense Mo-Cu Composite and Fabrication Method[P]. CN 200410028822. 2004-01-13.
[13]������, ����, �żҴ�. ��Ӵ����ϵ��ȵ���[J]. �繤�Ͻ�, 1996, 2(1): 15-21.
DU Yong-guo, LONG Yan, ZHANG Jia-chun. Thermal conductivity of electric contact material[J]. Electric Engineering Alloy, 1996, 2(1): 15-21.
[14]Hwang K S, Yang S C, Wang W S. Mo-Cu heat sinks made by co-sintering and infiltration techniques[J]. Advances in Powder Metallurgy and Particulate Materials, 1995, 3(1): 251-257.
[15]WU Gao-hui, ZHANG Qiang, CHEN Guo-qin. Properties of high-reinforcement-content aluminum matrix composite for electronic packages[J]. Journal of Materials Science��Materials in Electronics, 2003, 14(1): 9-12.
[16]Hasselman D P H, Lloyd F J. Effective thermal conductivity of composites with interfacial thermal barrier resistance[J]. Journal of Composites, 1987, 21(6): 508-515.
������Ŀ: �������пƼ����ؼƻ�������Ŀ(2005AA5CG041)
�ո�����: 2005-07-15; ������: 2005-08-20
�����: �¹���(1978-), ��, ��ʿ�о���
ͨѶ����: �¹���, �绰: 0451-86412164; E-mail: chenguoqin@hit.edu.cn


