���±�ţ�1004-0609(2012)1-0150-08
Bi���Ӷ�Sn-3.0Ag-0.5Cuǥ�ϵ绯ѧ��ʴ���ܼ�֦��������Ӱ��
�� ��1, 2, 3��������1����ҿ�2
(1. ���пƼ���ѧ ��ѧ�뻯��ѧԺ���人 430074��2. ���пƼ���ѧ ������ѧ�빤��ѧԺ���人 430074��
3. �����ڶ�ʦ��ѧԺ ��ѧ��������ѧѧԺ���人 430205)
ժ Ҫ��
���ö���λɨ��ͽ����迹�ȷ����о�Bi���Ӷ�Sn-3.0Ag-0.5Cuǥ����3.5% NaCl(��������)��Һ�е绯ѧ��ʴ���ܼ�֦��������Ӱ�죻����SEM��XRD���������丯ʴ��ò���ɷ֡������ʾ������Bi�������ӣ���ʴ�����ܶ������Ը�ʴ��λ���ʹ����Ա仯���迹����ʾ������ǰ���迹��������ͬ������������ʱ�䳣���ĵ�Ч��·ģ�ͱ�ʾ���������5%������Bi���������ӣ��ݿ����뾶��С����ɴ��ݵ����ʴ����Ĥ�������С����ʴ���ܽ��͡�SEM����ʾ��Bi���Ӷ�ǥ���ڽ����е绯ѧǨ���ٶ��м������ã������Ǩ�����µ�֦�����������������á�XRD����ʾ��֦����Ҫ�ɷ�ΪSn��Cu6Sn5��ͬʱ����������Bi��Ag3Sn��
�ؼ��ʣ�
Sn-3.0Ag-0.5Cuǥ����Bi��������ʴ��Ϊ��֦������������������
��ͼ����ţ�O646.6���� ���ױ�־�룺A
Effects of Bi doping on electrochemical corrosion and dendrite growth suppression of lead-free Sn-3.0Ag-0.5Cu solder
HUA Li1, 2, 3, GUO Xing-peng1, YANG Jia-kuan2
(1. School of Chemistry and Chemical Engineering, Huazhong University of Science and Technology,Wuhan 430074, China;
2. School of Environmental Science and Engineering, Huazhong University of Science and Technology,Wuhan 430074, China;
3. School of Chemistry and Life Science, Hubei University of Education, Wuhan 430205, China)
Abstract: The effects of Bi doping on the electrochemical corrosion characteristics and dendrite growth behavior of lead- free Sn-3.0Ag-0.5Cu solder in 3.5% NaCl solution (mass fraction) were investigated by potentiodynamic polarization and AC impedance measurement. The surface morphologies and elemental compositions of various elements in the solder were determined by analyzing the corrosion product formed on the specimen using SEM and XRD techniques. The results show that the corrosion current density increases with increasing Bi content. However, the corrosion potential does not change regularly. All of impedances of Sn-Ag-Cu solder with and without Bi doping have the same characteristics, the equivalent circuit with two time constants can preferably fit the electrochemical impedance spectroscopy of Sn-Ag-Cu-xBi with error less than 5%, which shows that all electrochemical corrosion characteristics have similar regularities. The impedance arc radius decreases when the Bi content increases, which shows that anti-corrosion capacity decreases with increasing Bi content. The SEM results show that the dendrite growth due to electrochemical migration can be suppressed. XRD results show that the main contents on dendrite are Sn, Cu6Sn5, also tiny Bi and Ag3Sn.
Key words: Sn-3.0Ag-0.5Cu solder; Bi doping; corrosion behavior; dendrite growth; suppression action
����ȫ����Ǧ��Ҫ�����ӷ�װʹ����Ǧǥ�����Sn-37Pb�ѳɱ�Ȼ���ơ�Ŀǰ��������Ǧǥ��ΪSn-Cu��Sn-Zn��Sn-Ag-Cu��Sn-Ag����ϵ�����У�Sn-Ag-Cuϵǥ��Ӧ����Ϊ�㷺������ŵĺ������ܡ��ϺõĻ�еǿ���Ѿ��õ��㷺�Ͽɣ������ֺ����ڻ������ϻ�ʵ���м����γɽ����仯����(IMC)�����Ż���ʱ����ӳ����¶ȵ����ߣ�IMC���ּ����� ��[1-3]��IMC�ϴࡢ���ѣ�ʹ��װ�г��ַ���ʧЧ���������¹����¹ʡ�Ϊ�˸���ǥ�����ܣ�һЩ�о������������ǥ�ϻ���������ϡ�н�����Bi��Sb��In��Ga��Ce��Ge��[4-6]�Կ˷�����ȱ�㣬ͬʱ���ͺϽ���۵㣬���Ӻ�����������ʪ�ԣ���߿ɺ��ԡ�LI��SHI[7]���о�����������Bi����ʹSn-3.0Ag-0.5Cu IMC�Ŀ����ߴ����ϸС������IMC���ɣ��Ӷ�������еǿ�ȡ������ϻ�����Ӧ���������ܡ���Bi���Ӻ�ǥ�ϵ�������������ʪ�Ȼ����и�ʴ��ҺĤ�����¿��绯ѧǨ���Ƿ���Ч���ʼ��������������߲��ö���λɨ��ͽ����迹�ȵ绯ѧ���������SEM��XRD�ȷ����ֶζ�Bi����ǰ����Ǧǥ�ϵĸ�ʴ���绯ѧǨ����Ϊ��Ӱ�����̽�֣�����Ϊ������Ǧ���Ͽ����ṩ�������ݡ�
1 ʵ��
1.1 �������Լ�
������TCW-32A�����ܻ������¶ȿ�����(�人���е�¯�豸����˾����)��CorrTestTM CS�绯ѧ ����վ(�人��˼����������˾����)��TG328A������ƽ(�Ϻ����쾫����������˾����)��ESEM����ɨ��羵(Quanta 200, FEI��˾����)��X����������(X'Pert PRO XRD���������ɿƹ�˾����)��
ҩƷ����ͪ���Ҵ���E-44������֬���ڱ���������������Ҷ������Ȼ��ƾ�Ϊ��������Sn-3.0Ag-0.5Cu����(�ձ�ǧס��˾����)���ߴ�Bi����(��99.99%��������̩���м���������������)��
1.2 �Ͻ��Ʊ�
����ֱ��Ϊ1 cm����Ϊ1.5 cm������Ϊģ�壬��Sn-3.0Ag-0.5Cu����Ϊ���壬���������Ӳ�ͬ������Bi�������ڵ�¯����300 ��������4 h��Ϊ�˷�ֹ���ϺϽ����������ۻ����������Ӹ��ͱ��������Ƚ����ͼ��������ײ����ټӺ��ϣ��Ⱥ���ȫ���Ӻú�����������һ����͡����ڹ�����ͨ�ߴ�N2��������30 min����1�Σ����ں�Ͻ�ֱ�ӵ���С�����У�����������ȴ�������õ��������û�����֬���з� װ���ֱ���200#��400#��800# SiCɰֽ��ĥ�����缫ֱ��¶���⻬���棬Ȼ���ñ�ͪ���Ҵ���ϴ���汸�á�
1.3 ֦������ʵ��
ͼ1��ʾΪ֦������ʵ��ʾ��ͼ���������õ�������ͬBi������Բ��״�����缫�û�����֬�ܷ⣬һ����ɰֽ��ĥ���⻬���棬��һ��������������ֱ����Դ����ӵ糡Ϊ5 V��ʵ�������ȡ����������ESEM��XRD������

ͼ1 ֦������ʵ��ʾ��ͼ
Fig. 1 Schematic diagram of dendrite growth experiment
1.4 ��ʴʵ��
����CS350�绯ѧ����վ�ֱ����Bi����ǰ��Sn-3.0Ag-0.5Cuǥ����3.5% NaCl��Һ�еĶ���λɨ�����ߡ�Bi��������ӦΪ����1��2%������2��5%������3��10%��ʵ��ǰ��3.5% NaCl��ҺͨN2����1 h (N2����Ϊ1 mL/s)��ʵ��������缫��ϵ���αȵ缫Ϊ���ʹ��缫(SCE)�����ñ���KCl��Һ�����š������缫ΪPtƬ�缫�������缫�븨���缫���Ϊ35��40 mm����λɨ�跶ΧΪ-200��800 mV(vs SCE)��ɨ������Ϊ0.5 mV/s��ʵ���¶�Ϊ����(25��2) �棬ESEM������ʴ��ò�������迹ѡȡ�ļ����źŷ�ֵΪ��5 mV������Ƶ�ʷ�ΧΪ100 mHz��10 kHz���Ӹ�Ƶ���Ƶɨ�裬����CorrZviewVers.2.7�������迹������ϡ�
2 ���������
2.1 �������
KEUN��[8]������Bi���ӻ�ʹSn-Znǥ����ʪ�Ȼ����µĿ��������ܽ��ͣ�Bi�Ƿ���Sn-Ag-Cuǥ�ϺϽ���ʴ���ܽ��������о��ص㡣ͼ2��ʾΪSn-3.0Ag-0.5Cu��Sn-3.0Ag-0.5Cu+xBi (x=2%��5%��10%���ֱ���Ϊ����1��2��3)��3.5%NaCl��Һ�еļ������ߣ����������������߽���Tafel��ϵĽ�����ڱ�1���ӱ�1��֪��Bi�����Ը�ʴ��λ�仯�����ԣ�����ʴ�����ܶ�(Icorr)����Bi�������Ӷ�����Bi�����ǥ�Ͻ�֮δ����ʱ���ױ���ʴ��һ��أ������ӷ�װ�����õĺ��ϣ�Bi�����������˴���10%[9]��Bi����������ǥ��Ӳ���࣬�ӹ����ܽ��ͣ��Ͻ���չ�Ժ��ͳ���Ա��[10]����Bi��������Ҳ���˹��ͣ������������۵�����á���ˣ�Bi������������Ϊ2%��3%[11-12]��������������3.5%NaCl��Һ�н���10 d��ĸ�ʴ��ò��ͼ3��ʾ�������нϴ���죬���Ӻ�ʴ��ò����ϸ�¾��ȣ�����֯���ɣ��������䣬�������Bi����ϸ���˻���Ͻ���֯���¡�
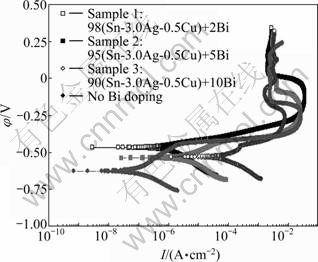
ͼ2 3.5%NaCl��Һ�в�ͬ����Bi����Sn-3.0Ag-0.5Cuǥ�ϵļ�������
Fig. 2 Polarization curves of Sn-3.0Ag-0.5Cu solder doped with different Bi contents in 3.5% NaCl solution
��1 Sn-3.0Ag-0.5Cu-xBiǥ�϶���λ�������ߵ���ϲ���
Table 1 Fitting parameters of potentiodynamic polarization curves of Sn-3.0Ag-0.5Cu-xBi solder

��ĿǰΪֹ��û��Sn-Ag-Cu-Bi��Ԫ�Ͻ���λͼ�ɹ����ģ�OHNUMA��[13]��YE��[14]������Ԫ�Ͻ�ֳ�4����Ԫ������ϵ��������Ͻ��ಢ���������һ�壬��ΪSn-3.0Ag-0.5Cu-xBi��Ԫ������ϵ����ΪSn-3.0Ag-0.5Cu-xBi������֯Ϊ��-Sn+Sn-Ag-Cu��Ԫ������֯+������IMC������(Ag3Sn��Cu6Sn5��Cu3Sn)��Bi�࣬��һ���������[7]�еõ�֤ʵ����־�[15]���������[16]ָ����ʪ�Ȼ����¸�ʴ���Թ�����֯��Sn��Ϊ������IMCΪ�����ĵ绯ѧ��ʴ���̡�����IMC�Ŀ���ʴ������ǿ����ˣ�������֯�ĸ�ʴ�Դ�SnΪ�����ں����ڻ��������У������¶��ƶ�����ʹSnԭ������IMC�빲����֯�ı߽���ɢ��������IMC��(Snƫ��)���뱾����ȣ�Sn�ĸ�ʴ������ƫ���������MULUGETA��GUNA[17]ָ����Bi������ʹIMC������ϸ�������ܳ����ӡ���λ�����ϳ�����Sn�����ࡣ��Ȼ��������Bi (��3%)����һ���̶�������Sn��߽�ƫ��������ǰ����ȣ�����Ӱ��������ˣ���Զ��ԣ�Bi����ʹ�γɵ�Sn�����ࡢ��С��ͼ4Ҳ˵������һ�㡣ͼ4(a)��ʾΪδ����BiʱSACǥ����300 ��������4 h��ȴ���SEM��ͼ4(b)��(d)��ʾ�ֱ�Ϊ����2%Bi��5%Bi��10%Bi��SACǥ������ͬ��������������ȴ���SEM����ЩSEM����ֻ�ɼ����Ƚϴ��IMC (Cu6Sn5)�����ṹ(��SnΪ��)�������ṹ�ֱ���IMC���ǣ��������ʶ�𡣴�ͼ4�п��Կ���������Bi�������ӣ��γɵ�IMC������֯��ϸ�����ȱ�С����SnΪ��ʴ���Ե㣬��λ����Ͽ���Խ�࣬��ʴ�����ܶ�Խ�ߣ���ʴ����Խ�죬���ϺϽ����ʴ����Խ���ˣ�����Bi�������ӣ�ǥ����ϵ����ʴ�����½���

ͼ3 Sn-3.0Ag-0.5Cuǥ����3.5% NaCl��Һ�н���10 d��ĸ�ʴSEM��
Fig. 3 Corrosion SEM images of Sn-3.0Ag-0.5Cu solder dipping in 3.5% NaCl solution for 10 d: (a) Without Bi doping; (b) Bi doping in 2%
2.2 �����迹
�Բ�ͬ����Bi������������ʵ�飬����δ������Ʒ�Աȣ���绯ѧ�迹��Nyquist��Bodeͼ�ֱ���ͼ5��6��ʾ������Mansfeld��Ч��·(��ͼ7)�����ݽ�����ϣ���ϲ������ڱ�2�����У�R1������Һ���裻����λ��Ԫ��![]() ��
��![]() �ֱ�����缫˫�����ݺ�ʴ����Ĥ���ݣ�R2��ɴ��ݵ��裻R3��L1�ֱ�Ϊ�븯ʴ����Ĥ�ܽ������صĵ���͵�С���Nyquist��Bodeͼ���Կ�����������ߺ���ʵ���߷dz��ƽ����ڸ�Ƶ��(100 Hz��10 kHz)�����˱ȽϹ���ѹ��İ�Բ�ݿ�����������Bi�������ӣ��ݿ����뾶��С���缫�迹��С����ʴ���ܽ��ͣ�δ����Bi��3�ֲ�ͬ����Bi���Ӻ��迹���������ƣ�����������ʱ�䳣����ʾ����Ƶ����(100 Hz��10 kHz)�͵�Ƶ����(100 mHz��100 Hz)����Ƶ�ݿ�����ӳ�����缫�������Һ˫������֮��ij�ԥ���̣���Ƶ�����ݿ����������ϸ�İ�Բ��������ƫ�룬������ǹ����缫����Һ������ڵ���ɢЧӦ���¡���������ЧӦ��ԭ������������鿪ʼ�Σ�Cl-�����ڹ����缫���淢��������Ȼ������Sn���ܽ⣬��������������绯ѧ��Ӧ���̵��ӣ����ʹ��Ƶ�����ݿ�������ƫ�롣�ɱ�2��������ݿ�֪������Bi�������ӣ�˫�����ݺ�ʴ����Ĥ����
�ֱ�����缫˫�����ݺ�ʴ����Ĥ���ݣ�R2��ɴ��ݵ��裻R3��L1�ֱ�Ϊ�븯ʴ����Ĥ�ܽ������صĵ���͵�С���Nyquist��Bodeͼ���Կ�����������ߺ���ʵ���߷dz��ƽ����ڸ�Ƶ��(100 Hz��10 kHz)�����˱ȽϹ���ѹ��İ�Բ�ݿ�����������Bi�������ӣ��ݿ����뾶��С���缫�迹��С����ʴ���ܽ��ͣ�δ����Bi��3�ֲ�ͬ����Bi���Ӻ��迹���������ƣ�����������ʱ�䳣����ʾ����Ƶ����(100 Hz��10 kHz)�͵�Ƶ����(100 mHz��100 Hz)����Ƶ�ݿ�����ӳ�����缫�������Һ˫������֮��ij�ԥ���̣���Ƶ�����ݿ����������ϸ�İ�Բ��������ƫ�룬������ǹ����缫����Һ������ڵ���ɢЧӦ���¡���������ЧӦ��ԭ������������鿪ʼ�Σ�Cl-�����ڹ����缫���淢��������Ȼ������Sn���ܽ⣬��������������绯ѧ��Ӧ���̵��ӣ����ʹ��Ƶ�����ݿ�������ƫ�롣�ɱ�2��������ݿ�֪������Bi�������ӣ�˫�����ݺ�ʴ����Ĥ����![]() �������ɴ��ݵ���(R2)��ʴ����Ĥ��صĵ���(R3)����С����һ��˵����ʴ��������Bi������������͡�������Ͻ����������С��5%��������������Mansfeld��Ч��·ģ���ܹ��Ϻõ���������ǰ������ϵ��3.5% NaCl��Һ�еĵ绯ѧ��ʴ��Ϊ��
�������ɴ��ݵ���(R2)��ʴ����Ĥ��صĵ���(R3)����С����һ��˵����ʴ��������Bi������������͡�������Ͻ����������С��5%��������������Mansfeld��Ч��·ģ���ܹ��Ϻõ���������ǰ������ϵ��3.5% NaCl��Һ�еĵ绯ѧ��ʴ��Ϊ��

ͼ4 ��ͬ����Bi����Sn-3.0Ag-0.5Cuǥ�ϺϽ����SEM��
Fig. 4 SEM images of Sn-3.0Ag-0.5Cu solder alloy with different Bi doping: (a) Without Bi doping; (b) 2% Bi doping; (c) 5% Bi doping; (d) 10% Bi doping

ͼ5 ��Ʒ1��2��3��δ���Ӻ�������3.5% NaCl��Һ�е�Nyquistͼ
Fig. 5 Nyquist figures of samples 1, 2, 3 and undoped sample in 3.5% NaCl solution: (a) Original figure; (b) Magnified figure

ͼ6 ����1��2��3��δ����������3.5% NaCl��Һ�е�Bodeͼ
Fig. 6 Bode figures of undoped and doped samples 1, 2 and 3 in 3.5% NaCl solution: (a) Without Bi doping; (b) Sample 1; (c) Sample 2; (d) Sample 3
��2 ��ͬBi������Sn-3.0Ag-0.5Cuǥ�ϵĽ����迹��Ͻ��
Table 2 Fitting results of AC impedance of Sn-3.0Ag-0.5Cu solder doped with different Bi contents

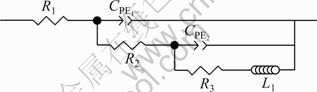
ͼ7 ��ͬBi�����γɵ�Sn-3.0Ag-0.5Cu+xBiǥ�ϵ��迹��Ч��·
Fig. 7 Impedance equivalent circuit of Sn-3.0Ag-0.5Cu+xBi solder doped with different Bi contents
2.3 Bi���Ӷ�֦����������������
�绯ѧǨ����ָ�ڵ糡�����£����������ܽ���������ƶ����̣��˹��̻ᵼ��֦������������Ӧ���������µľ���������ͬ��֦���������ڽ��ʴ��������·����������������ܽ⡢�����绯ѧ������ �¡����ӵ�����Ʒ��ʹ�ù����У�����ˮ�����۶���������γ�һ��ҺĤ����������Ⱦ����������������������⡢���༰����������ܽ�����ʱ�����ǿ����ʣ��ڵ糡�����£�ǥ���н������ӻᷢ���ܽ�Ͷ����ƶ�������������������������֦���ﵽһ�����Ⱥ�ʹPCB�����ڲ���֮�以�����ӣ��γɶ�·����Ҳ��Ӱ����Ӳ�Ʒ�ɿ�����Ҫ����֮һ�������ǵ����ӷ�װ��������/�ɳ�ϸ��ࡢ���ɶȷ���չ�����������ƻ���ֹ֦������Ҳ�Ǹ������м���������֮һ��Bi�ܽ�����Ǧ���ϺϽ���� ��[18]������Biǥ�������Ƿ����63Sn-37Pb����ȣ�����еǿ�Ⱥ���ʪ���⣬�绯ѧǨ��Ҳֵ�������о���ʵ������ʾ����ʪ�Ȼ����м��ص糡��Biǥ��ͬ������ָ�Sn��֦��������ͼ8(a)��ʾΪ98(Sn-3.0Ag- 0.5Cu)+2Biǥ�ϵ绯ѧǨ�ƺ���֦����SEM�����۹۲�Ϊ�Ұ�ɫ��Ƭ״�ÿ����Ƭ�����й�����״�ľ������(��ͼ8(b))�������ڽ��ʯ�ľ���ṹ��֦������80 h��(0.5 cm���)�����缫���������������������������·������ͬ�����¶�δ����Sn-3.0Ag-0.5Cuǥ�Ͻ���֦������ʵ�飬������ͼ9(a)��ʾ�������ṹ���ȱ�״(��ͼ9(b))�����۹۲����������а�ɫ��״�ͬ������µ�����ʱ��Ϊ10 h������ͬ�����½ϲ���2%Biʱ�����ʱ��(80 h)Ҫ�ٵö࣬˵��Bi���Ӻ�ʹ֦�������ٶȱ�������Bi���Ӻ��γɵ�֦����״��Сһ�£������֦��������ṹ���ܣ���ֹ���ڲ���֯��Sn����һ���ܽ��������ɢ��Ǩ���˶�����δ����Biʱ�����Գ���100��200 ��m (32 h)��С���ȵij�֦�����Ҳ�ͬ����֦���������ʼ�Ϊ�������������������������������������������ӳ�ʱ���Ӵ�糡ʱ����������֦״֦���ݺύ�����䳤���븯ʴʱ��ͼ��ص糡������أ����K�����䣬�����ڲ����ӽ�һ������ҺǨ�ơ�

ͼ8 98(Sn-3.0Ag-0.5Cu)-2Bi��3.5%NaCl��Һ��5 V�糡��֦������80 h���SEM��
Fig. 8 SEM images of dendrites of 98(Sn-3.0Ag-0.5Cu)-2Bi solder in 3.5% NaCl solution after 80 h dipping in electric field of 5 V: (a) Dendrites; (b) Crystals of dispersed dendrites on board

ͼ9 Sn-3.0Ag-0.5Cu��3.5%NaCl��Һ��֦������32 h���SEM��
Fig. 9 SEM images of dendrites of Sn-3.0Ag-0.5Cu solder in 3.5% NaCl solution after 32 h dipping in electric field of 5 V: (a) Dendrites; (b) Crystals of dispersed dendrites on board
�ɴ˿�֪��Bi���Ӷ�Sn-3.0Ag-0.5Cuǥ�ϵ�֦���������ʻ�绯ѧǨ����Ϊ���������ã���������ȫ��ֹ�䷢��������Ҫ��Sn-Ag-Cu-Bi�Ͻ�����֯�йء�ͼ4��SEM�����������Bi���������ӣ�Sn-Ag-Cu�Ͻ���֯�����ȼ�С����ˣ�Bi������ϸ��Sn-Ag-Cu- Bi IMC��������Ҫԭ�������ں�Bi��ǥ�Ϻ���IMC�������ٶ�С�ڲ���Bi��IMC�������ʣ�������Bi���������Ӹ�������[19]���Ӷ����»�����Bi����Խ�ߣ�IMC����Խϸ��������[17]�Ľ��һ�£�����ϸ������Ч����Sn������֯��IMC�߽��ƫ�����Ӷ�ʹ������Sn���Ͼ��Ⱥ�ϸС���γɵ�֦����С���ȡ����ܣ�������Sn����Ǩ�ơ��ռ���ɢλ�裬������ֹ���ڲ�Sn������Ǩ�����������������������ӷ�װ��ʮ�����������ӷ�װ�к������༰�߿�������һ�����Ӳ�λ����֦��������������PCB��������������·�����ص��������ջ�����PCB�塣98(Sn-3.0Ag-0.5Cu)-2Bi֦����XRD����ͼ10��ʾ������98(Sn-3.0Ag-0.5Cu)-2Biǥ�ϣ��绯ѧǨ�Ƶ���֦����������֦����Ҫ�ɷ���Sn��Ag3Sn��ͬʱ���ڼ�����Bi��Cu6Sn5��Bi��֦���д��ڵĿ���ԭ����Bi��Ͻ�߽���ƫ��������Bi����������֦���ϡ�

ͼ10 98(Sn-3.0Ag-0.5Cu)-2Bi֦����XRD��
Fig. 10 XRD pattern of dendrites of 98(Sn-3.0Ag-0.5Cu)-2Bi solder
3 ����
1) ����λ���������ʾ������Sn-Ag-Cu-xBiǥ����ϵ������Bi�������ӣ�ǥ�ϸ�ʴ���������迹����ʾ������ǰ���迹��������ͬ������������ʱ�䳣���ĵ�Ч��·ģ�ͱ�ʾ����������<5%������Bi�������ӣ��ݿ����뾶��С����ɴ��ݵ����ʴ����Ĥ�������С����ʴ���ܽ��͡�
2) SEM������ʾ��Bi���Ӷ�ǥ���ڽ����е绯ѧǨ���ٶ��м������ã������Ǩ�����µġ�֦�����������������á�����Bi������ϸ��Sn-3.0Ag-0.5Cu�Ͻ�ṹ�йء�
3) XRD�����ʾ��֦����Ҫ�ɷ�ΪSn��Cu6Sn5��ͬʱ��������Bi��Ag3Sn��
REFERENCES
[1] ������, ��. ��Ǧ����Ŀɿ�������[J]. �������װ, 2005, 5(5): 12-16.
GU Yong-lian, YANG Bang-chao. The reliability of lead-free solder joint[J]. Electronics and Packaging, 2005, 5(5): 12-16.
[2] �� ��, �ſ¿�, ����, �̹��, �� ��. ���Ӻ���ɿ��Ե��о���״[J]. ����Ԫ�������, 2005, 24(9): 58-61.
YANG Jie, ZHANG Ke-ke, ZHOU Xu-dong, CHENG Guang-hui, MEN Hua. Overview on solder joint reliability in micro-jointing[J]. Electronic Components and Materials, 2005, 24(9): 58-61.
[3] ��Ц�A, ¦�ƻ�, �� ��, �����, LEE T, �� ��. ���ӷ�װ������Ǧ������ս[J]. �������װ, 2005, 5(5): 2-7.
ZHU Xiao-kun, LOU Hao-huan, QU Xin, WANG Jia-ji, LEE T, WANG Hui. The challenge of change over to lead-free in electronic packaging[J]. Electronics and Packaging, 2005, 5(5): 2-7.
[4] �κ���, ��㳼, �� ��. Sb���Ӷ�SnAgCu��Ǧ�����Ǩ�ƿɿ��Ե�Ӱ��[J]. ����Ԫ�������, 2008, 27(8): 65-67.
HE Hong-wen, XU Guang-chen, GUO Fu. Effect of Sb doped SnAgCu lead-free solder joint on electromigration reliability[J]. Electronic Components and Materials, 2008, 27(8): 65-67.
[5] Ȩ�ӻ�. Bi�Ե�����Ǧǥ��Sn-Ag-Cu��ͷ��֯�����ܵ�Ӱ��[D]. ������: ������������ѧ, 2009: 23-28.
QUAN Yan-hui. Effect of Bi on microstructure and properties of Sn-0.3Ag-0.7Cu solder[D]. Harbin: Harbin University of Science and Technology, 2009: 23-28.
[6] ʷҫ��, ����ƽ, ��־��, ����Ƽ, ������, �� ��. ������װ��SnAgCuϵ��Ǧ���ϺϽ�������[J]. ��ɫ����, 2005, 57(3): 8-15.
SHI Yao-wu, LEI Yong-pin, XIA Zhi-dong, LIU Jian-ping, LI Xiao-yan, GUO Fu. SnAgCu lead-free solders and performance for electronic assembly[J]. Nonferrous Metals, 2005, 57(3): 8- 15.
[7] LI G Y, SHI X Q. Effects of bismuth on growth of intermetallic compounds in Sn-Ag-Cu Pb-free solder joints[J]. Transactions of Nonferrous Metals Society of China, 2006, 16: 739-743.
[8] KEUN S K, TOSHINORI M, KATSUAKI S. Effect of Bi and Pb on oxidation in humidity for low-temperature lead-free solder systems[J]. Journal of Electronic Materials, 2006, 35(1): 41-47.
[9] ���廪, ������. ����Sn-Ag��Sn-Bi�������ܵĸ���[J]. ����Ԫ�������, 1999, 18(4): 27-31.
TANG Qing-hua, PAN Xiao-guang. Improvement of Sn-Ag addition on soldering characteristic of Sn-Bi solder[J]. Electronic Components and Materials, 1999, 18(4): 27-31.
[10] ZHAO J, QI L, WANG X M, WANG L. Influence of Bi on microstructures evolution and mechanical properties in Sn-Ag-Cu lead-free solder[J]. Journal of Alloys and Compounds, 2004, 375: 196-201.
[11] VIANCO P T, REJENT J A. Properties of ternary Sn-Ag-Bi solder alloys: Part I. Thermal properties and microstructural analysis[J]. Journal of Electronic Materials, 1999, 28(10): 1127- 1137.
[12] YOSHIHARU K, MASAHISA O. Mechanical fatigue characteristics of Sn-3.5Ag-X(X=Bi, Cu, Zn and In) solder alloys[J]. Journal of Electronic Materials, 1998, 27(11): 1229- 1235.
[13] OHNUMA I, MIYASHITA M, ANZAI K, LIU X J, OHTANI H, KAINUMA R, ISHIDA K. Phase equilibria and the related properties of Sn-Ag-Cu based Pb-free solder alloys[J]. Journal of Electronic Materials, 2000, 29(10): 1137-1144.
[14] YE L, LAI Z H, LIU J, THOBLEAN A. Microstructure investigation of Sn-0.5Cu-3.5Ag and Sn-3.5Ag-0.5Cu-0.5Bi lead-free solders[J]. Soldering and Surface Mount Technology, 2001, 13(3): 16-20.
[15] ��־�. ��Ǧǥ�ϵĵ绯ѧ��ʴ��Ϊ�о�[D]. ����:����������ѧ, 2008: 17-30.
FAN Zhi-gang. Research of electrochemical corrosion behaviors of lead-free solders[D]. Dalian: Dalian University of Technology, 2008: 17-30.
[16] ������, ����ƽ, ��־��, ʷҫ��. Ag������Sn-Zn-Ag��Ǧǥ�ϸ�ʴ���ܵ�Ӱ��[J]. ���ӹ��ռ���, 2006, 27(2): 70-72.
LI Xiao-yan, LEI Yong-ping, XIA Zhi-dong, SHI Yao-wu. Influence of the content of Ag to corrosive nature of Sn-Zn-Ag lead-free solders[J]. Electronics Process Technology, 2006, 27(2): 70-72.
[17] MULUGETA A, GUNA S. Lead-free solders in microelectronics [J]. Materials Science and Engineering A, 2000, 27: 95-141.
[18] HU C C, TSAI Y D, LIN C C, LEE G L, CHEN S W, LEE T C, WEN T C. Anomalous growth of whisker-like bismuth-tin extrusions from tin-enriched tin-Bi deposits[J]. Journal of Alloys and Compounds, 2009, 472: 121-126.
[19] �ٳ���. Bi��Sn-3Ag-0.5Cu/Cu������֯����ͷ����ǿ�ȵ�Ӱ��[D]. ����: ����������ѧ, 2007: 26-30.
CHI Cheng-yu. The effect of Bi on the microstructure and shear strength of Sn-3Ag-0.5Cu/Cu solder joint[D]. Dalian: Dalian University of Technology, 2007: 26-30.
(�༭ ����Ƽ)
������Ŀ��������Ȼ��ѧ����������Ŀ(50671040, 50871044)������ʡ��������У��ѧ�к����ص�������Ŀ(C2010071)������ʡ�������ص���Ŀ(D20093103)�������ڶ�ʦ��ѧԺ���������괴���Ŷӽ���ƻ���Ŀ�������ڶ�ʦ��ѧԺӦ�û�ѧ�ص�ѧ�ƽ���ƻ���Ŀ�������ڶ�ʦ��ѧԺУ���ص���Ŀ(2009A005)
�ո����ڣ�2010-12-20�������ڣ�2011-07-15
ͨ�����ߣ���������ڣ���ʿ���绰��027-87543432; E-mail: guoxp@mail.hust.edu.cn
ժ Ҫ�����ö���λɨ��ͽ����迹�ȷ����о�Bi���Ӷ�Sn-3.0Ag-0.5Cuǥ����3.5% NaCl(��������)��Һ�е绯ѧ��ʴ���ܼ�֦��������Ӱ�죻����SEM��XRD���������丯ʴ��ò���ɷ֡������ʾ������Bi�������ӣ���ʴ�����ܶ������Ը�ʴ��λ���ʹ����Ա仯���迹����ʾ������ǰ���迹��������ͬ������������ʱ�䳣���ĵ�Ч��·ģ�ͱ�ʾ���������5%������Bi���������ӣ��ݿ����뾶��С����ɴ��ݵ����ʴ����Ĥ�������С����ʴ���ܽ��͡�SEM����ʾ��Bi���Ӷ�ǥ���ڽ����е绯ѧǨ���ٶ��м������ã������Ǩ�����µ�֦�����������������á�XRD����ʾ��֦����Ҫ�ɷ�ΪSn��Cu6Sn5��ͬʱ����������Bi��Ag3Sn��


