DOI��10.19476/j.ysxb.1004.0609.2018.12.13
���������Ǧǥ�Ͽɿ����о���չ
������1��Ѧ�ɰ�1��������1����ΰ��2�����ؾ�2
(1. �Ͼ����պ����ѧ ���Ͽ�ѧ�뼼��ѧԺ���Ͼ� 211106��
2. ֣�ݻ�е�о�������ǥ�������뼼�������ص�ʵ���ң�֣��450002)
ժ Ҫ��
������Ǧǥ�����ܵ����������ǻ�����ʶ����ߣ���Ǧǥ��Ҳ��Ӧ����������С��������������Ǧǥ�Ͽɿ��Ե��о���չ�����ƣ��������������Ǧǥ�Ϻ���ʧЧ��ԭ��̽�ָ���������������Ǧǥ�Ͽɿ��Եķ����ͻ��������Ͻ�����ǿ���ͻ�����ƣ��ܽ�Ŀǰ��Ǧǥ�Ͽɿ����о����ڵIJ��㣬����Ǧǥ��δ�����о�����������顣
�ؼ��ʣ�
���������Ǧǥ�����Ͻ�������ǿ��������������ɿ�����
���±�ţ�1004-0609(2018)-12-2499-13���� ��ͼ����ţ�TG425���� ���ױ�־�룺A
21����������Ϣ�����Ŀ��ٷ�չ�������ƶ��˵��Ӳ�ҵ��ת�ͺ����������Ե��ӷ�װ��������˸�Ϊ�Ͽ���Ҫ��[1]�����Ÿ�����Ǧ�������̳�̨�����������������Ǧǥ���������Ǧǥ�ϳ�Ϊ�ȵ㡣Ŀǰ��ҵ��Ϊ�Ͽɵ���Ҫ��SnCuϵ[2]��SnAgϵ[3]��SnAgCuϵ[4]����Ǧǥ�ϡ��������Ƕ���������ʪ�Բ��㣬�۵�����Լ��ɿ��Բ�����⣬����������������Ҫ��
�������������Ǧǥ�ϵ��о��������룬�ڸ���ǥ����ʪ��[5]�������۵�[6]�ȷ��涼ȡ���˷ḻ�ijɹ���ʹ����Ǧǥ��Ҳ��ʼ��Ӧ����ijЩ������С�������Ǧ���ķ�չ�����ǻ�����ʶ����ߣ���Ǧ��Ҳ��Ϊ��������õ��Ӳ��ϵķ�չ���ơ�������ijЩ������У���Ǧǥ�ϲ���Ҫ�����ȳ����糡�ʹų��ȵ��������[7]�������ܴ���һЩ�缫���¡���ʴ�Ȼ����У���ͺ���Ŀɿ��ԡ���ˣ��о����������Ǧǥ����֯���ܱ仯�Ļ������ɿ��Ը��ƴ�ʩ���ڱ��С�Ŀǰ��������ɿ��ԵĴ�ʩ��Ҫ��3�֣�1) �Ͻ�������Ǧǥ�����������Ͻ�Ԫ�������ƺ�������[8]��2) ������������ͨ������ǿ����ǿ�ɿ���[9]��3) ���ƻ��壬ͨ������Ʋ����߿ɿ� ��[10]��Ŀǰ���������Ǧǥ�Ͽɿ��Ե��о����Ƚ��٣���������ͨ�����ܸ���������Ժ����Ӱ��������Ը��ƺ���ɿ���ȡ�õ����½�չ����ȫ����ܽᣬ��ͼΪδ�����������Ǧǥ�Ͽɿ��Ե��о��ṩһЩ�����ָ����
1 ����ʱЧ
1.1 Ӱ�����
���ŵ���Ԫ�����ʵ���ߣ�����ķ����¶Ȳ�������[11]�������������仯�����Cu6Sn5���������������㣺
 (1)
(1)
ʽ�У�RΪĦ�����峣����TΪ�����¶ȣ� ΪSn�Ļ�ȡ�
ΪSn�Ļ�ȡ�
�¶������������ڲ�����ԭ����ɢ�Ӿ磬Cu6Sn5�������������ӡ���ͼ1��ʾ�����´ٽ��˽�������仯����(IMC)��ֻ�[12]��Ҳ���γ����ԵĿ�[13]��ͬʱ���洦Cu�������������洦�������·�Ӧ��Cu6Sn5+9Cu=5Cu3Sn��
����һ��ʱ���ʱЧ����IMC�����˫��ṹ��Cu6Sn5��Cu3Sn������������½������ͬʱ�������ֽ����仯����������ϵ��(CTE)�IJ�ͬʹ��ʱЧ�����н��洦�����γ�Ӧ�����У��Ӷ���Ϊ���Ƹ߷���[14]��
1.2 ���ƴ�ʩ
1.2.1 �Ͻ�
�����о�����[15]������ͬ��ʱЧ�����£�����0.025%Sm(��������)�����������SnAgBiǥ�Ϻ���Ŀɿ��ԡ�Nd����SnAgCuǥ�����γ���ɢ�ֲ���NdSn3ǿ���࣬����˺������ѧ����[16]����ϡ��Ԫ�غ������˹��࣬����ǥ���дִ��ϡ������֯���ǥ�ϵ���ѧ����[17]��Ce��SnAgCuǥ��Ҳ�����Ƶ�����[18]��

ͼ1 ʱЧ����SnAgCu305/Cu���������ȱ仯
Fig. 1 Interfacial IMC layer thickness of SnAgCu305/Cu joint during isothermal aging
����������MnԪ���ܹ����ƺ����������������ʹ������ʱ��ʱЧ��SnAgCu-0.15%Mn�Ľ��������С��SnAgCu��[19]����ͼ2��ʾ������Mn��������0.2%ʱ������Mn��Cu6Sn5�ġ��յ����á�[20]��IMC���ٴδֻ���BiԪ�صļ����ܹ����ǥ�ϵĿ���ƣ������[21]������������Fe��Bi���ܹ�ʹSnAgCu105ǥ����֯��ʱЧ������ʼ�ձ����ȶ����ȣ���ͼ3��ʾ[22]��

ͼ2 Sn-0.3Ag-0.7Cu-xMn�������IMC������ʱЧʱ��ƽ����t1/2�Ĺ�ϵ
Fig. 2 Relationship between interfacial IMC layer thickness of Sn-0.3Ag-0.7Cu-xMn/Cu joint and square root of isothermal aging time t1/2

ͼ3 SnAgCu-Fe-xBi��FESEM��
Fig. 3 FESEM images of as-cast samples
1.2.2 ����������
�����о�����[23]�������������ӿ�����������ǥ�����ܡ�����Sb����������Чϸ��SnAgCu������֯[24]��������������[25]������Cu6Sn5�ı��������ܿ��Ա�ʾΪ
 (2)
(2)
ʽ�У�AkΪCu6Sn5����k�ı������ ��Cu6Sn5����k��������Sb��ı���������
��Cu6Sn5����k��������Sb��ı��������� ΪCu6Sn5����k��δ��������Sb�ı���������cΪ�����������Ũ�ȣ�
ΪCu6Sn5����k��δ��������Sb�ı���������cΪ�����������Ũ�ȣ� ΪCu6Sn5����k��������Sb��������RΪ���峣����TΪ����ѧ�¶ȡ�Cu6Sn5������������Sb����������ܽ��ͣ�IMC�����ܵ����ơ�
ΪCu6Sn5����k��������Sb��������RΪ���峣����TΪ����ѧ�¶ȡ�Cu6Sn5������������Sb����������ܽ��ͣ�IMC�����ܵ����ơ�
����Ag3Sn�ܹ�������Sn-0.7Cuǥ�Ͻ��洦��ϸ��������֯����Ԫ�غ�����ͬ������£�Sn- 0.7Cu(Ag3Sn)�Ľ������Զ����SnAgCuǥ��[26]��SnAgCu-xTiO2/Cu���������ʱЧʱ��Ĺ�ϵ���Ա�ʾΪ[27]��
SnAgCu/Cu:  (3)
(3)
SnAgCu-TiO2/Cu:  (4)
(4)
��ʱЧ������SnAgCu-TiO2����ǥ�ϵ�ƽ����ɢϵ��Ϊ0.0374 ��m2/s������SnAgCu��0.0447 ��m2/s��˵������TiO2�����谭Ԫ����ɢ������IMC���γɡ�����TiO2�������˹��ߣ�����ᡰ�žۡ���������֯�ֻ�[28]����ͼ4��ʾ��

ͼ4 TiO2����������SnAgCuǥ�ϵ���֦���ߴ��Ӱ��
Fig. 4 Effect of TiO2 content on dendrite-arm spacing of SnAgCu solders
ʯīϩ����Ƭ(Graphenenanosheets�����GNSs)�߱���ǿ����ѧ����ѧ�͵�ѧ����[29]����������Ϊ���ŵ����Ͳ��ϡ�GNSs���ж�ά���ṹ�ͼ���ıȱ���������ӽ�ǥ�Ϻ��ܹ�����ǥ�ϵ���ʪ���ܺ���ѧ����[30]�����Ҷ�ǥ���ڲ�ԭ�ӵ���ɢ��ǿ�ҵ��谭����[31]����������ǥ����ʱЧ�����н������������Ӷ���ߺ���Ŀɿ��ԡ�
1.2.3 �������
���������������ڻ�����Ʊ���ɢ�赲��Ҳ�������ʱЧ�����º���Ŀɿ���[32]����ͳ����ĶƲ���Ҫ��Ni[33]��Au/Ni(ENIG)[34]��Au/Pd/Ni(ENEPIG)[35]�ȡ�Ni�Ʋ��ܹ���Ч�谭�����ԭ�ӵĻ���ɢ��ϸ��IMC�㣬��ߺ��������[36]����Ni������Au���������Է�ֹNi������������������ǥ�ϵ���ʪ��չ[34]����Ni/Au����Pd�ܹ�����Ni��Au���û����ã�������˺���ɿ��Ե�ͬʱҲ���������ż���С������������б�ENIG��Ϊ������Ӧ��ǰ����
��ͭ����������8%Zn����ϡ��Ԫ��Er�ܹ���Чϸ��������棬��֤����Ŀɿ���[37-38]�����ƻ����ڲ�����Ӧ��ʱ��Cuԭ�������ڴӻ�����ɢ��ǥ�����Խ��;���ѹ����ǥ��ǰ�Ի�������˻����ܹ���Ч�����������Ӧ������֯ȱ��[39]��������Cu����ɢ���Ӷ�����IMC��������[40]��
2 ��ѭ��
2.1 Ӱ�����
���Ӳ�Ʒ���۹����������Եĵ���ͨ�����������¶ȱ仯���ᵼ���ڲ��ĺ��㾭����ѭ�����á�������ѭ���ܴε����ӣ������ǿ��Ҳ����[41]������Cu6Sn5���ȱ�״�ֻ�ת��Ϊ��״������Cu3Sn�����[42]��ͬʱ��������������ϵ������ȫ��ͬ����ѭ���ᵼ�º�����Ӧ�����ߣ������������Ʋ���Cu6Sn5��Cu3Sn���洦��չ[43]��������в����ɿ��ԡ�
������ˣ���ѭ��Ҳ�ᵼ�º�ϡ������Ǧǥ�Ϻ�����֡����롱[44]����ͼ5��ʾ��Ŀǰ�����롱�����Ļ����в���ȷ�������ܶ�ѧ����Ϊ����֯��Ӧ���շ��ˡ����롱�IJ���[45]���ڽӴ�����ʱǥ���ڲ���ϡ����RESn3���������µ�������Ӧ��4RESn3+3O2=2RE2O3+12Sn��
�γ�ϡ��������RE2O3�����������������ѹӦ����ʹ��Ӧ����Sn���������������桱�γɾ���[46]�������ż���С�������£����뼫�п��ܵ��¶�·���Ӷ���Ͳ�Ʒ����[47]��

ͼ5 2000����ѭ����������뻨��
Fig. 5 Cross-section of plating around a whisker after 2000 thermal cycles
2.2 ���ƴ�ʩ
2.2.1 �Ͻ�
��Ϊϡ��Ԫ�أ�Ce��Pr���ڡ���Sn�ԡ���������Sn��ϣ�������ѭ��������IMC�������[48-49]���Ӷ�����˺���Ŀɿ��ԡ���������������ġ����롱������Ȼû�н����Ŀǰ��ֹ�����롱�İ취��Ҫ�У�1) �����м����㣻2) ǥ�ϺϽ�3) �л�����Ϳ�㡣���ŵ������������ͻ�������˽⡰���롱�����Ļ������ҵ���Ч�����Ʒ������Ʊ����߿ɿ��Ե���Ǧǥ�����ڱ��С�
��SnAgCuǥ���У���Al����Cu�γ�Cu-AlӲ���࣬ͨ���ڶ���ǿ���ķ�ʽ������ߺ���ǿ�ȣ�����������ϵ�CTEʧ����շ����ƣ�����˺���Ŀɿ���[50]������AlҲ�ᵼ��SnAgCuǥ�Ͽ���ʴ���ܽ��ͣ���ˣ�������������0.5%Ϊ��[51]��
2.2.2 ����������
����Al�������������������Ǧǥ�Ϻ���Ŀɿ���[52]������Al�����ھ������棬���������˺�����ѧ���ܣ����ҽ�����Cu����ɢϵ�����ӻ�����ѭ�������н������������������Ƶ�����[53]��Al2O3���������ھ��б�TiO2���ߵĻ��Ժͱ����ܣ��Ժ���ɿ��Եĸ���Ч��Ҳ��Ϊ����[54]������Fe2O3������������SnAgCuǥ�ϵ���ʪ��[55]��ͬʱ������ǥ��������CTE��ֵ[56]���������ѭ�������º���Ŀɿ��ԡ�
�л�-���������������(Polyhedral Oligomeric Silsesquioxane�����POSS)��������Ľṹ��Ϊ���ܹ�ע�����Ͳ���[57]����ͼ6��ʾ����Ϊ��ǿ������ǥ�ϣ�����Թ������ܹ�������γɿɿ��ļ��ϣ�������Ժ������ܹ��ڸ��ϲ��Ϸ���ʱ�����ȶ����ܹ���Ч�����ǥ������[58]��POSS������ۼ��ں�������仯���ᄃ�磬�谭ԭ���ؾ���ɢ���Ӷ�ϸ���˴��Խ���㣬�����ǥ�ϵĿ���ѭ������[59]��ͬʱ��POSS����Ҳ�ܽ�����ѭ�������к������Ӧ�������ơ����롱�IJ���[60]����ͼ7��ʾ��

ͼ6 POSS���ӽṹʾ��ͼ
Fig. 6 Anatomy of POSS molecule
3 ���»���
�������õ��Ӳ�Ʒ��˵���ڲ�����ķ��ۻ�����ͽ��ܴﵽ-30 �棬���Ƕ�����յĵ��»������еĺ�������˵��������¶ȿ��Դﵽ-229 ��(ڤ����ƽ���¶�)�������ͣ������Կռ��豸�ڲ�Ԫ���ĺ����ڵ���������µĿɿ�������˷dz��Ͽ���Ҫ��

ͼ7 ��ѭ����ǥ�ϱ�������֯�仯
Fig. 7 Surface microstructures evolution in specimens after cycles
3.1 Ӱ�����
���е��о�����[61]��Sn���¶Ƚ���-13 ��ʱ�ᷢ��ͬ���칹ת�䡪������ת�䣬���ķ���ϵ�Ħ�-Sn���������ϵ�Ħ�-Sn��������������Լ��ʹ�ת�䣬ʹ��ǥ�Ϻ�����ѧ�����½�[62-63]�������շ����ѡ���SnAgCu305/Cu��������-196 ��ļ������д洢25 d�����ڲ��������������ƣ���ͼ8��ʾ[64]��������в����Ŀɿ��ԡ�����������������������ȿ�����֤ϵͳ�İ�ȫ�ɿ����������ַ�ʽ��������˺����������гɱ�������������̽��̫�յIJ�������ˣ����������������͵������ܵ�ǥ���Ƿdz���ʵ������
3.2 ���ƴ�ʩ
In��ǥ����������ĵ������ܾ������õ�Ӧ��ǰ��[65]��Ŀǰ���Ѿ���һЩ��Ե��»�����In��ǥ��Ͷ��ʹ��[66]��������ǥ�ϲ����ɱ����ߣ���������۵�����Ӧ̫�յĴ��±价�������кܴ��ʹ�þ����ԡ�Sb�ܹ�����SnCuNiǥ�Ϸ�������ת�䣬������֯Ӧ���IJ���[67]��Ŀǰ�����ڸ��Ƽ���������Ǧǥ�Ͽɿ��Ե��о����Ƚ��٣���Ҫ�о���Ա���Թ�ע��
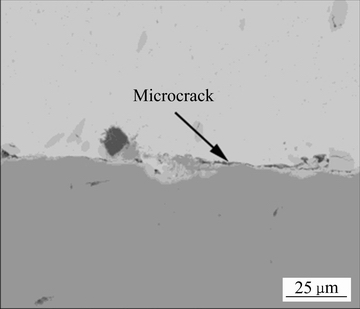
ͼ8 -196 ��洢��SnAgCu305/Cu���������֯
Fig. 8 Microstructure of SnAgCu305/Cu after storage at -196 ��
4 ��Ǩ��
4.1 Ӱ�����
���ڵ���������С�ͻ����ʵĴ����ߣ����������ܵĵ��غ�Ҳ����������Ժ�����һ���Ͼ��Ŀ��顣�ߵ����ܶ�ʹ����ԭ�������������㹻�˷����ݣ��ƶ������ڵĿ�λ��[68]������ԭ���ڵ��������¾�������ƶ����մ�һ��Ǩ�Ƶ���һ�ˣ���������Ϊ��Ǩ�ơ��������ܶȴﵽһ��ֵʱ���ڡ����ӷ������������£���λʱ��Ǩ�Ƶ�����������Cuԭ�Ӽ�����������������ֻ����������Ŀ�λ�������õ�ԭ�Ӳ�����γɿ�[69]����Ӧ���������¼����շ�����[70]����ͼ9��ʾ���ڵ糡���ȳ���ϵ�����£�����ʧЧ�ٶȻἱ������[71]��Sn-9Zn��������(150 �棬5��103A/cm2)��������100 h���ɵ��������ຸ��Cu5Zn8���ȴ������[72]��SAC305���㾭����ʱЧ��5��103A/cm2�ĵ�Ǩ�ƺ���Ϊ������Cu�������ܽ⣬�ն������γ��������Ž������չ�����յ��º���ʧЧ[73]����Ǩ��ЧӦ�����谭�˵��Ӳ�Ʒ�ĸ��»�����ؽ�������

ͼ9 ������Ǩ�ƺ��SnAgCu305ǥ�Ϻ�������֯
Fig. 9 Microstructure of SnAgCu305 after electromigration
4.2 ���ƴ�ʩ
4.2.1 �Ͻ�
ϡ��Ԫ��Ce�ܹ�ϸ��ǥ����֯���Ӷ��ں����ڲ��γ��ڶ�Ĵ�Ǿ��磬�����˵��غ�������Cu��Sn��Ǩ�ƣ��Ӷ��ӻ��˿������ƵIJ���[74]�������о�����[75]��Sn����Ǧǥ����Sn������ȡ���ܹ�����Ӱ�캸��Ŀ���Ǩ�����ܣ�����cȡ���Sn�������и�ǿ�ĵ�Ǩ�ƿ�����Co��Sn�е���ɢϵ���Ƚϴ���Sn��������ۼ��Ӷ���Cu����ɢ�γ��谭��ͬʱϸ��������֯������cȡ���Sn��������ߺ����Ǩ������[76]��
4.2.2 ����������
POSS�����������������γ����õĽ��[77]���谭�˺����ڲ����ʵ��ƶ���ʹ��Ǩ�������ܵ����Ե�����[78]��̼����(Carbon nanotube�����CNT)���ɾ�����ʯīϩ��ɵ��п�Բ���ṹ�������ǿ�ȣ����ܶ��Լ���������������ص㣬����Ϊ�����ǥ����ǿ����[79]��CNT����ϸ��Sn-58Biǥ����֯[80]������ǥ�ϻ���Ԫ�����ü��ϣ��ں�������ѧ�غ�ʱ���ȴӼ��Ͻ��滬��[81]���������Ƽ��Ӧ�����ж���չ������CNT�����������ã����ں������γɸߵ�����ͨ�����ڳ��ܵ��غɵ�����µ��ӻ����ȴ�CNT����ͨ���Ӷ����ơ����ӷ������Ի����Ӱ��[82]������CNT�Ʊ����ѣ��������žۣ�����CNT�ĸ���ǥ�ϳɱ��ϸߣ���ʱ����ʵ��Ӧ�á�
Ŀǰ�������Ǧǥ�Ϻ����Ǩ�Ƶ��о����Ƚ��٣����ŵ���Ԫ�������ܶȵ����������������ܵĵ��غɽ���һ����ߣ�������Ƶ�Ǩ�ƻ����Ļ��������о�����������������Ǩ�������������Ǧǥ�ϻ���Ҫ�о���Ա��Ŭ����
5 ��ʴ����
5.1 Ӱ�����
������ۻ����������ӣ��ڶೡЭͬ�����£�ǥ�϶Ը�ʴ����Ҳʮ�����С������ܸ�ʴ�������ͼ10��ʾ�Ŀ����������ֲ��ϴ����ܽ��������ͼ11��ʾ[83]��Ŀǰ����õ绯ѧ��ʴ�ķ���������ǥ�Ͽ���ʴ����[84]����Ϊ�����ĸ�ʴ���ʣ���ˮ�е�Cl-���������ں���ȱ�ݴ��뺸���ڲ��������ӷ�Ӧ�����������Ȼ���Ӷ��γɵ�ʴ����Ӧ�������������һ����չ�����º��㷢��������[85]��

ͼ10 ���㸯ʴ��
Fig. 10 Cavity of solder joints after corrosion
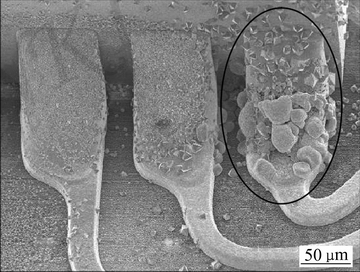
ͼ11 ���㸯ʴ�ܽ�
Fig. 11 Diffluence of solder joints after corrosion
5.2 ���ƴ�ʩ
Sn-Znǥ����ʴ���ܽϲ��������������YԪ���ܹ�ϸ����֯�ڲ��������ĸ�Zn�࣬�����˸�ʴԭ����γɵĸ��ʣ��Ӷ�������Sn-9Zn�ĸ�ʴ��λֵ�������ǥ�ϵ���ʴ���ܣ���ͼ12��ʾ[86]��CuҲ����һ���̶���ϸ����Zn��[87]�����Sn-Zn��ʴ����[88]���������е��о�����[89]������Cr��Ni��Ч��Ҫ��������Cu�ġ�

ͼ12 �Ͻ���3.5%NaCl��Һ�и�ʴ��������
Fig. 12 Polarization curves of alloys in NaCl 3.5% solution
In�ܹ���Sn-9Znǥ�ϱ����γɶۻ��������Ƹ�ʴ����֯�ڲ�����[90]�����ھ��н�ǿ�ġ���������ЧӦ��[91]��Ge����ǥ�ϱ����γɸ���㣬�谭Sn2+����ɢ����һ���ӻ��˺�������������Ge���������ֻ�������֯�д�����ۼ��ķ��ա�����Ni����ϸ����֯������ǥ�ϵĴ��ԣ�Ҳ����ͨ����������Ge��Ni������ǥ�ϵ���ʴ����[92]��
6 ����
���Ӳ�Ʒ��ʹ���ж����ڵ���Ŀ��ܣ��侭�ܵ���ѧ����������ڲ��������ʧЧ[93]�����е��о�����[94]���ھ��ܵ�����ʱ����Ǧǥ�Ϻ���Ŀɿ���������Ǧǥ�ϡ���ˣ��˽����ʱ�����ʧЧ���������ƴ�ʩ�������������������쿹������ܵ���Ǧǥ����Ϊ��Ҫ��
6.1 Ӱ�����
�ڵ�����ʱ��оƬ��PCB�����ڵ���ģ�������������ͬ�̶ȵı��Σ�ʹ������ܽϴ�ľ���Ӧ�������ڲ���ȱ���ײ���Ӧ�����ж���Ϊ����Դ[95]���������������ڽϴ��IMC������չ[96]��WLCSP����������(1500 g��0.5 ms)�������µ���150�κ����ƿ�ʼ���������ŵ�����������ӣ����Ƴ�������������[97]������ʱоƬ��PCB����оƬ�߽Ǵ������Ĵ������������Ϊ���Ƹ߷�����
6.2 ���ƴ�ʩ
Ϊ�������Ʒ�ķ���Ҫ���о���Ա�Ѿ������һЩ���ƺ��㿹������ܵĴ�ʩ��������ǥ���м���SiC������[98]������SnAgCuǥ���е�Ag����[99]�ȣ�������Щ��ʩ����������Ҫ������Ǧ���Ĵ��£�������Ӧ��������ģʽ�ġ�������������õ���Ǧǥ�ϡ�
7 ����
���˼����¡����±价���⣬�ռ����Ҳ�Ǻ������ڹ����������ٵ���һ���dz��Ͼ�����ս���ռ���ջ��²����ڲ���������ȱ�ݣ�������մ[100]���������ڱ�졢��������л���ܷdz��ܴ�����غɣ���Щȱ�ݼ����γ����ƣ���������ʧЧ���ռ临�ӵ����ӷ���ᵼ�µ���Ԫ�����Ͳ�������˥�˻���Ư ��[101]��������в�������İ�ȫ����[102]��Ŀǰ������á�������ӹ̡��Ե�����·������б���[103-104]����������ӹ�װ�þ���һ�����������������������˺������ķ��估���гɱ����ں������������С���͡���Ч�غɱ���ߡ��Ĵ������£��Ե�����·������п�����ӹ��Ѿ�Խ��Խ��������������Ӹ��Ʋ����������������ܵĽǶ����֣���ߺ����������ڷ��ջ����µĿɿ��ԡ�Ŀǰ����������ڷ��ջ�����ǥ�Ϻ���Ӱ��������о����б��������ҹ�������չ�ռ��о��Ĵ��£���չ���价���Ե�����������ɿ��Ե�Ӱ���о�ʮ�ֱ�Ҫ��
8 �ܽ���չ��
���ŵ�����ҵ�ķ�չ����Ǧǥ�ϵ�Ӧ�������㷺��������Ǧǥ�ϵ��о��ɹ�ʮ�ַḻ�������������������Ǧǥ�Ϻ���ʧЧ�������о��������죬����������ɿ��Եķ����о�Ҳ��Ҫ�����������������3�����棺ǥ�ϺϽ�����Ҫ���о�������Ŀǰ���ӵĶ�Ϊ��һԪ�أ���ǥ�ϸ��Ե�Ч���������룬ͬʱ����ϡ��Ԫ������ɵġ����롱������Ȼû�н����������������ȻҲ������Ч���������������ס��žۡ��ҳɱ����ߣ����ģ����Ӧ�ý�Ϊ���ѣ����ƻ����������ڽ�Ϊ��ӱ���о������п��ܳ�Ϊ����ɿ����о������ơ�
�ۺ����������������Ǧǥ�Ͽɿ��Եķ�չ������Ҫ���������¼������棺1) �Ӷ�Ԫ���Ƕ������Ǧǥ�ϵijɷ֣����Ǹ������Ӷ���Ԫ������ͬ����ǥ�����ܣ�2) ��������������ǥ���Ʊ��ɱ�����֤���۹������������ȶ��������žۣ�Ϊ����������ǥ�ϵ�ʵ��Ӧ����������3) ��ʵ��Ӧ���У�ǥ�Ϸ��ۻ��������Ƚϸ��ӣ���ͬʱ���ٶೡ�����ã������Զೡ�����������Ǧǥ�Ϻ���ɿ��Ե��о�ʮ�ֱ�Ҫ��4) �����ǺϽ��������ӻ��Ǹ��ƻ��壬��һ����ֻ����һ���̶��������ã�������������Ҫ���Կ���ͬʱ���ö��ַ�����Эͬ���ã�ʹ����ɿ��Եõ���һ������ߣ�5) �ڹ��Ҵ�����չ������ҵ�Ĵ��£������������ġ������������ܡ����������±����ܡ��͡����������ܡ��ĺ������ø߿ɿ���ǥ��������̫��̽�������������ڹ�������Կռ价���º����ݱ�������о�����һƬ�հף���Ҫ�о���Ա���Թ�ע��
REFERENCES
[1] LI Yang, GE Jing-guo, ZHANG Yao-cheng, DAI Jun, JING Yan-feng. Effect of BaTiO3 on the microstructure and mechanical properties of Sn1.0Ag0.5Cu lead-free solder[J]. Journal of Materials Science: Materials in Electronics, 2015, 26(1): 613-619.
[2] WANG Y W, LIN Y W, KAO C R. Inhibiting the formation of microvoids in Cu3Sn by additions of Cu to solders[J]. Journal of Alloys & Compounds, 2010, 493(1/2): 233-239.
[3] GARCIA L R, OSORIO W R, GARCIA A. The effect of cooling rate on the dendritic spacing and morphology of Ag3Sn intermetallic particles of a SnAg solder alloy[J]. Materials & Design, 2011, 32(5): 3008-3012.
[4] SU Y A, TAN L B, TEE T Y, TAN V B C. Rate-dependent properties of Sn-Ag-Cu based lead free solder joints[J]. Microelectronics Reliability, 2010, 50(4): 564-576.
[5] ������, ��ΰ��, �����, ·ȫ��. ϡ����Al-Si-Zn-Cuǥ�Ϲ������ܵ�Ӱ��[J]. ����, 2017(2): 31-36.
XUAN Qing-qing, LONG Wei-min, ZHANG Qing-ke, LU Quan-bin. Effect of rare earth elements on brazing process performance of Al-Si-Zn-Cu filler metal[J]. Welding & Joining, 2017(2): 31-36.
[6] �� ��, �Ӻ���, �� ƽ, �� ��, �����. SnInǥ����Au/Ni/Cuǥ����������仯������о�[J]. ����, 2016(3): 18-21.
ZHAO Jie, ZHONG Hai-feng, LIU Ping, ZHOU Fei, JING Jing-nan. Intermetallic compounds formed on brazed interface between SnIn solder and Au/Ni/Cu[J]. Welding & Joining, 2016(3): 18-21.
[7] TU K N. Recent advances on electromigration in very-large- scale-integration of interconnects[J]. Journal of Applied Physics, 2003, 94(9): 5451-5473.
[8] ZHANG Q K, LONG W M, YU X Q, PEI Y Y. Effects of Ga addition on microstructure and properties of Sn-Ag-Cu/Cu solder joints[J]. Journal of Alloys & Compounds, 2015, 622: 973-978.
[9] GAIN A K, CHAN Y C. Growth mechanism of intermetallic compounds and damping properties of Sn-Ag-Cu-1wt% nano- ZrO2composite solders[J]. Microelectronics Reliability, 2014, 54(5): 945-955.
[10] LIU Yang, SUN Feng-lian, LUO Liang-liang, YUAN C A, ZHANG Guo-qi. Microstructure evolution and shear behavior of the solder joints for flip-chip LED on ENIG substrate[J]. Journal of Electronic Materials, 2015, 44(7): 2450-2457.
[11] �� ��, �� ��, ������, ������. �����н���ԭ�ӵ���Ǩ�Ƽ���Խ��淴ӦӰ����о���չ[J]. �й���ɫ����ѧ��, 2015, 25(8): 2157-2166.
ZHAO Ning, ZHONG Yi, HUANG Ming-liang, MA Hai-tao. Research progress in thermomigration of metal atoms inmicro solder joints and its effect on interfacial reaction[J]. The Chinese Journal of Nonferrous Metals, 2015, 25(8): 2157-2166.
[12] ������, ��ͥ, ������, ����ʤ, �ƹ���. ����ʱЧ��In-3Ag/Cu���ӽ�����֯�ݱ�������Ӱ��[J]. �й���ɫ����ѧ��, 2015, 25(5): 1256-1263.
MA Yun-zhu, LUO Hui-ting, LI Yong-jun, LIU Wen-sheng, HUANG Guo-ji. Effects of isothermal aging on In-3Ag/Cu interface microstructure evolution characteristics[J]. The Chinese Journal of Nonferrous Metals, 2015, 25(5): 1256-1263.
[13] ZHAO Guo-ji, SHENG Guang-min, WU Li-li, YUAN Xin-jian. Interfacial characteristics and microstructural evolution of Sn-6.5Zn solder/Cu substrate joints during aging[J]. Transactions of Nonferrous Metals Society of China, 2012, 22(8): 1954-1960.
[14] LIU Yang, MEERWIJK J, LUO Liang-liang, ZHANG Hong-lin, SUN Feng-lian, YUAN C A, ZHANG Guo-qi. Formation and evolution of intermetallic layer structures at SAC305/Ag/Cu and SAC0705-Bi-Ni/Ag/Cu solder joint interfaces after reflow and aging[J]. Journal of Materials Science: Materials in Electronics, 2014, 25(11): 4954-4959.
[15] ��÷. SnAgBi-xSmǥ����֯�����ܵ��о�[D]. ������: ������������ѧ, 2016: 1-48.
CHOU Ai-mei. Study on microstructure and properties of SnAgBi-xSm solder[D]. Harbin: Harbin University of Science and Technology, 2016: 1-48.
[16] ������. ϡ��Pr��Nd��SnAgCu��Ǧǥ����֯������Ӱ���о�[D]. �Ͼ�: �Ͼ����պ����ѧ, 2012: 1-130.
GAO Li-li. Effect of Pr and/or Nd on the Microstructures and Properties of Sn Ag Cu Solder[D]. Nanjing: Nanjing University of Aeronautics and Astronautics, 2012: 1-130
[17] WANG He, XUE Song-bai, WANG Jian-xin. Study on the microstructure and properties of low-Ag Sn-0.3Ag-0.7Cu-0.5Ga solder alloys bearing Pr[J]. Journal of Materials Science: Materials in Electronics, 2017, 28(11): 8246-8254.
[18] YOON J W, NOH B I, JUNG S B. Effect of rare earth metal Ce addition to Sn-Ag solder on interfacial reactions with Cu substrate[J]. Metals and Materials International, 2014, 20(3): 515-519.
[19] ��Ӣ��. �̲��Ӷ���Ǧ����Sn-0.3Ag-0.7Cu���淴Ӧ����ѧ���ܵ�Ӱ��[D]. ����: ����������ѧ, 2014: 1-55.
PAN Ying-cai. Effects of Mn doping on interfacial reaction and mechanical properties of Sn-0.3Ag-0.7Cu lead-free solder[D]. Guangzhou: South China University of Technology, 2014: 1-55.
[20] ̷ �. Fe��Mn��SAC0307ǥ�����ܵ�Ӱ��[D]. ������:��������ҵ��ѧ, 2014: 1-55.
TAN Qi. Effect of iron or manganese on the properties of SAC0307 solder[D]. Harbin: Harbin Institute of Technology, 2014: 1-55.
[21] �� ��, �����. Ni��BiԪ�ض�SnAgCuǥ����������������������ʵ�Ӱ��[J]. �й���ɫ����ѧ��, 2012, 22(2): 460-464.
LIU Yang, SUN Feng-lian. Effect of Ni and Bi addition on growth rate of intermetallic compound of SnAgCu soldering[J]. The Chinese Journal of Nonferrous Metals, 2012, 22(2): 460-464.
[22] ALI B, SABRI M F M, SUKIMAN N L, JAUHARI I. Microhardness and shear performance of Fe/Bi-bearing SAC105 solder alloys under high temperature aging[J]. Journal of Materials Science Materials in Electronics, 2016: 1-10.
[23] EL-DALY A A, AL-GANAINY G S, FAWZY A, YOUNIS M J. Structural characterization and creep resistance of nano-silicon carbide reinforced Sn-1.0Ag-0.5Cu lead-free solder alloy[J]. Materials & Design, 2014, 55(6): 837-845.
[24] EL-DALY A A, HAMMAD A E, FAWZY A, NASRALLH D A. Microstructure, mechanical properties, and deformation behavior of Sn-1.0Ag-0.5Cu solder after Ni and Sb additions[J]. Materials & Design, 2013,43: 40-49.
[25] TANG Y, LI G Y, PAN Y C. Influence of TiO2 nanoparticles on IMC growth in Sn-3.0Ag-0.5Cu-xTiO2 solder joints in reflow process[J]. Journal of Alloys & Compounds, 2013, 554(2): 195-203.
[26] �� Դ. ����Ag3Sn��Cu6Sn5������Sn����Ǧ��������Ӱ���о�[D]. ����: ����������ѧ, 2015: 1-92.
WANG Yuan. Effect of Ag3Sn, Cu6Sn5 nanoparticle on properties of Sn-based lead-free solder[D]. Beijing: Beijing Institute of Technology, 2015: 1-92.
[27] �� ��, TU K N, ������, �γ���, �� ��. ʱЧ��SnAgCu/SnAgCu-TiO2�������������Ӱ��[J]. ����ѧ��, 2013, 34(8): 43-46.
ZHANG Liang, TU K N, GUO Yong-huan, HE Cheng-wen, ZHANG Jian. Effect of aging on the interface and properties of SnAgCu/SnAgCu-TiO2 solder joints[J]. Transactions of the China Welding Institution, 2013, 34(8): 43-46.
[28] �� ��, ���̹�, �����, ������, �γ���. ����TiO2������SnAgCuǥ����֯�����ܵ�Ӱ��[J]. ϡ�н��������빤��, 2013, 42(9): 1897-1900.
ZHANG Liang, HAN Ji-guang, LIU Feng-guo, GUO Yong-huan, HE Cheng-wen. Effect of nano-particles TiO2 on the microstructures and properties of SnAgCu solders[J]. Rare Metal Materials and Engineering, 2013, 42(9): 1897-1900.
[29] MIRACLE D B. Metal matrix composites�CFrom science to technological significance[J]. Composites Science & Technology, 2005, 65(15/16): 2526-2540.
[30] CHEN G, WU F, LIU C, SILBERSCHMIDT V V, CHAN Y C. Microstructures and properties of new Sn-Ag-Cu lead-free solder reinforced with Ni-coated graphene nanosheets[J]. Journal of Alloys & Compounds, 2016, 656: 500-509.
[31] KONG K J, CHOI Y, RYU B H, LEE J O, CHANG H. Investigation of metal/carbon-related materials for fuel cell applications by electronic structure calculations[J]. Materials Science & Engineering C, 2006, 26(5/7): 1207-1210.
[32] HO C E, HSU L H, YANG C H, YEH T C, LEE P T. Effect of Pd(P) thickness on the soldering reaction between Sn-3Ag-0.5Cu alloy and ultrathin-Ni(P)-type Au/Pd(P)/Ni(P)/Cu metallization pad[J]. Thin Solid Films, 2014, 584: 257-264.
[33] KOMIYAMA T, CHONAN Y, ONUKI J, OHTA T. The influence of phosphorus concentration of electroless plated NiP film on interfacial structures in the joints between SnAg solder and NiP alloy film[J]. Materials Transactions, 2002, 43(2): 227-231.
[34] CHEN Fei-jun, YAN Shi, YANG Zhen-guo. Failure analysis on electrolytic Ni/Au surface finish of PCB used for wire bonding and soldering[J]. Soldering & Surface Mount Technology, 2014, 26(4): 180-193.
[35] MA Rui, LI Ming-yu, FANG Lin, ZHU Shao-de, ZHENG Rui-sheng. Effect of the Ni/Pd/Au-Cu pre-plated finish lead frame surface structure treated by various surface roughening methods on packaging properties[J]. Journal of Adhesion Science and Technology, 2016, 30(4): 422-433.
[36] ����ũ, �� ��, Ф ��, �����. Ni��Sn96.5Ag3.5/Cu֮����ɢ��Ϊ���赲����[J]. �й���ɫ����ѧ��, 2000, 10(2): 199-202.
ZHU Qi-nong, LUO Le, XIAO Ke, DU Li-guang. Ni as diffusion barriers between eutectic Sn-Ag solder and Cu[J]. The Chinese Journal of Nonferrous Metals, 2000, 10(2): 199-202.
[37] YU Xiao, HU Xiao-wu, LI Yu-long, ZHANG Ru-hua. Effect of alloying Cu substrate on microstructure and coarsening behavior of Cu6Sn5 grains of soldered joints[J]. Journal of Materials Science Materials in Electronics, 2015, 26(5): 2782-2794.
[38] �� ��, ��С��, ������. ����ϡ���Ͻ�Sn3Ag0.5Cu/Cuǥ�����淴Ӧ��Ӱ��[J]. ����Ԫ�������, 2016, 35(2): 65-69.
XU Tao, HU Xiao-wu, JIANG Xiong-xin. Effect of RE microalloying in substrate on interface reaction of Sn3Ag0.5Cu/ Cu solder joint[J]. Electronic Components and Materials, 2016, 35(2): 65-69.
[39] ��Ң��, ������, ʷ����, �� ��, ������. ���ȥӦ���˻��TC18�ѺϽ����Ӧ������֯���ܵ�Ӱ��[J]. �й���ɫ����ѧ��, 2011, 21(11): 2780-2785.
ZHANG Yao-wu, ZENG Wei-dong, SHI Chun-ling, KANG Chao, PENG Wen-wen. Influence of vacuum stress relieving annealing on residual stress and microstructure properties of TC18 titanium alloy[J]. The Chinese Journal of Nonferrous Metals, 2011,21(11): 2780-2785.
[40] �� Х, ������, ��С��, ���绪. Cu�����˻�����Cu/Sn58Bi/Cuǥ����ͷ�����ṹ[J]. ����ѧ��, 2015, 36(10): 29-32.
YU Xiao, LI Yu-long, HU Xiao-wu, ZHANG Ru-hua. Study of interfacial microstructure of Cu/Sn58Bi/Cu solder joints with annealed Cu[J]. Transactions of the China Welding Institution, 2015, 36(10): 29-32.
[41] SHARMA A, JANG Y J, KIM J B, JUNG J P. Thermal cycling, shear and insulating characteristics of epoxy embedded Sn-3.0Ag-0.5Cu (SAC305) solder paste for automotive applications[J]. Journal of Alloys & Compounds, 2017, 704: 795-803.
[42] SHNAWAH D A, SABRI M F M, BADRUDDIN I A. A review on thermal cycling and drop impact reliability of SAC solder joint in portable electronic products[J]. Microelectronics Reliability, 2012, 52(1): 90-99.
[43] XU Lu-hua, PANG J H L, CHE Fang-xin. Impact of thermal cycling on Sn-Ag-Cu solder joints and board-level drop reliability[J]. Journal of Electronic Materials, 2008, 37(6): 880-886.
[44] DUDEK M A, CHAWLA N. Mechanisms for Sn whisker growth in rare earth-containing Pb-free solders[J]. Acta Materialia, 2009, 57(15): 4588-4599.
[45] ʯ���, ����ƽ. �Ʋ�����������Է�����������о���չ[J]. �й���ɫ����ѧ��, 2011, 21(5): 1021-1030.
SHI Hong-chang, XIAN Ai-ping. Research development of tin whisker spontaneous growth on plating surface[J]. The Chinese Journal of Nonferrous Metals, 2011, 21(5): 1021-1030.
[46] TU K N, CHEN C, WU A T. Stress analysis of spontaneous Sn whisker growth[M]. US: Springer, 2006.
[47] SUGANUMA K, BAATED A, Kim K S, HAMASAKI K, NEMOTO N, NAKAGAWA T, YAMADA T. Sn whisker growth during thermal cycling[J]. Acta Materialia, 2011, 59(19): 7255-7267.
[48] Zhang L, Xue S B, Zeng G, GAO L L, YE H. Interface reaction between SnAgCu/SnAgCuCe solders and Cu substrate subjected to thermal cycling and isothermal aging[J]. Journal of Alloys and Compounds, 2012, 510(1): 38-45.
[49] WU Jie, XUE Song-bai, WANG Jing-wen, LIU Shuang, HAN Yi-long, WANG Liu-jue. Recent progress of Sn-Ag-Cu lead-free solders bearing alloy elements and nanoparticles in electronic packaging[J]. Journal of Materials Science Materials in Electronics, 2016: 1-35.
[50] ��־��. Cu-Al�������SnAgCu����ɿ��Ե�Ӱ��[D]. ������: ��������ҵ��ѧ, 2014: 1-65.
ZHANG Zhi-xin. Effect of copper-aluminum intermetallics on the reliability of SnAgCu solder joints[D]. Harbin: Harbin Institute of Technology, 2014: 1-65.
[51] Fayeka M, Fazal M A, Haseeb A S M A. Effect of aluminum addition on the electrochemical corrosion behavior of Sn-3Ag-0.5Cu solder alloy in 3.5wt% NaCl solution[J]. Journal of Materials Science Materials in Electronics, 2016, 27(11): 1-8.
[52] Zhang Liang, Han Ji-guang, Guo Yong-huan, SUN Lei. Creep behavior of SnAgCu solders containing nano-Al particles[J]. Journal of Materials Science: Materials in Electronics, 2015, 26(6): 1-6.
[53] Gain A K, Zhang Liang-chi. Harsh service environment effects on the microstructure and mechanical properties of Sn-Ag-Cu-1wt% nano-Al solder alloy[J]. Journal of Materials Science Materials in Electronics, 2016, 27(11): 11273-11283.
[54] Tsao L C, Wu R W, Cheng T H, FAN K H, CHEN R S. Effects of nano-Al2O3 particles on microstructure and mechanical properties of Sn3.5Ag0.5Cu composite solder ball grid array joints on Sn/Cu pads[J]. Materials & Design, 2013, 50(17): 774-781.
[55] Gu Y, Zhao X, Li Y, LIU Y, WANG Y, LI Z Y. Effect of nano-Fe2O3additions on wettability and interfacial intermetallic growth of low-Ag content Sn-Ag-Cu solders on Cu substrates[J]. Journal of Alloys & Compounds, 2015, 627: 39-47.
[56] Chen Ping, Zhao Xiu-chen, Wang Yong, ZHENG Bing, LIU Cheng-liang, CHEN Si-qi. Effect of nano ��-Fe2O3 additions on physical and mechanical properties of Sn-1.0Ag-0.7Cu- xFe2O3 low Ag lead-free solders[J]. Journal of Materials Science: Materials in Electronics, 2016, 27(2): 1507-1519.
[57] LI Gui-zhi, WANG Li-chang, NI Han-li, CHARLES U P Jr. Polyhedral oligomeric silsesquioxane(POSS) polymers and copolymers: A review[J]. Journal of Inorganic & Organometallic Polymers, 2001, 11(11): 123-154.
[58] SHEN Jun, PENG Chang-fei, YIN Heng-gang, CHEN Jie. Influence of minor POSS molecules additions on the microstructure and hardness of Sn3Ag0.5Cu-xPOSS composite solders[J]. Journal of Materials Science: Materials in Electronics, 2012, 23(9): 1640-1646.
[59] Shen Jun, Tang Qin-tang, Pu Ya-yun, ZHAI Da-jun, CAO Zhong-min, CHEN Jie. Influence of POSS nano-particles on Sn-3.0Ag-0.5Cu-xPOSS/Cu composite solder joints during isothermal aging[J]. Journal of Materials Science: Materials in Electronics, 2013, 24(12): 4881-4887.
[60] ��˼��, ������, ������, �� ��, �� ��. Sn����Ǧǥ�Ͼ���������Ϊ���о�[J]. ϡ�н��������빤��, 2015(11): 2868-2872.
LIU Si-han, MA Li-min, SHU Yu-tian, ZUO Yong, GUO Fu. Growth behavior of whiskers in Sn-based lead-free solders[J]. Rare Metal Materials and Engineering, 2015(11): 2868-2872.
[61] Plumbridge W J. Tin pest issues in lead-free electronic solders[J]. Journal of Materials Science: Materials in Electronics, 2007, 18(1): 307-318.
[62] Tsui Y, Mahmoud R, Surrey E, HAMPSHIRE D. Superconducting and mechanical properties of low-temperature solders for joints[J]. IEEE Transactions on Applied Superconductivity, 2016, 26(3): 1-4.
[63] Zhang Yu-ming, Zhu Hong-lai, Fujiwara M, XU Jin-quan, MING Dao. Low-temperature creep of SnPb and SnAgCu solder alloys and reliability prediction in electronic packaging modules[J]. Scripta Materialia, 2013, 68(8): 607-610.
[64] �� ��. Sn63Pb37��Sn3.0Ag0.5Cuǥ�ϼ��亸��ĵ��¿ɿ����о�[D]. ������: ��������ҵ��ѧ, 2014: 1-87.
ZHAO Xin. Study on reliability of Sn63Pb37, Sn3.0Ag0.5Cu solders and solder joints under low temperature[D]. Harbin: Harbin Institute of Technology, 2014: 1-87.
[65] Noor E E M, Zuhailawati H, Radzali O. Low temperature In-Bi-Zn solder alloy on copper substrate[J]. Journal of Materials Science: Materials in Electronics, 2016, 8(2): 1-8.
[66] Shimizu K, Nakanishi T, Karasawa K, HASHIMOTO K, NIWA K. Solder joint reliability of indium-alloy interconnection[J]. Journal of Electronic Materials, 1995, 24(1): 39-45.
[67] �º���, ������, л ��, ·����, ţ ��, �� ϼ. Sn-Sb-Cu-Ni���Ϻͺ����ڵ�����������֯�������о�[J]. ���Ϲ���, 2015, 43(11): 57-64.
CHEN Hai-yan, ZENG Jian-bo, XIE Yu, LU Mei-xiu, NIU Yan, LI Xia. Research on microstructure and properties of Sn-Sb-Cu-Ni solder and its joints at low temperature[J]. Journal of Material Engineering, 2015,43(11): 57-64.
[68] Li Y, Lim A B Y, Luo K, CHEN Z, WU F S, CHAN Y C. Phase segregation, interfacial intermetallic growth and electromigration-induced failure in Cu/In-48Sn/Cu solder interconnects under current stressing[J]. Journal of Alloys & Compounds, 2016, 673: 372-382.
[69] Zuo Yong-zuo, Ma Li-min, Liu Si-han, SHU Yu-tian, GUO Fu. Evolution of microstructure across eutectic Sn-Bi solder joints under simultaneous thermal cycling and current stressing[J]. Journal of Electronic Materials, 2015, 44(1): 597-603.
[70] Yue Wu, Qin Hong-bo, Zhou Min-bo, XIAO M A, ZHANG Xin-ping. Electromigration induced microstructure evolution and damage in asymmetric Cu/Sn-58Bi/Cu solder interconnect under current stressing[J]. Transactions of Nonferrous Metals Society of China, 2014, 24(5): 1619-1628.
[71] LI Xue-mei, SUN Feng-lian, ZHANG Hao, XIN Tong. Effect of temperature on interface diffusion in micro solder joint under current stressing[J]. Transactions of Nonferrous Metals Society of China, 2015, 25(5): 1699-1703.
[72] �� ��. �ߴ�ЧӦ��ʱЧ����Ǩ�ƶ�Cu/Sn-9Zn(SAC305)/Cu�������ܵ�Ӱ��[D]. ����: ����������ѧ, 2015: 1-61.
ZHANG Fei. Size effect on tensile properties of Cu/Sn-9Zn(SAC305)/Cu solder interconnects under aging and current stressing[D]. Dalian: Dalian University of Technology, 2015: 1-61.
[73] Ҷ ��. ��װоƬNi/Sn-3.0Ag-0.5Cu/ENEPIG(OSP)��Ǧ����ĵ�Ǩ����Ϊ[D]. ����: ����������ѧ, 2011: 1-70.
YE Song. Electromigration behavior of Ni/Sn-3.0Ag- 0.5Cu/ENEPIG(OSP) solder joints in flip chip packaging[D]. Dalian: Dalian University of Technology, 2011: 1-70.
[74] Xie H X, Friedman D, Mirpuri K, CHAWLA N. Electromigration damage characterization in Sn-3.9Ag-0.7Cu and Sn-3.9Ag-0.7Cu-0.5Ce solder joints by three-dimensional X-ray tomography and scanning electron microscopy[J]. Journal of Electronic Materials, 2014, 43(1): 33-42.
[75] Lu M, Shih D Y, Lauro P, GOLDSMITH C, HENDERSON D W. Effect of Sn grain orientation on electromigration degradation mechanism in high Sn-based Pb-free solders[J]. Applied Physics Letters, 2008, 92(21): 1335.
[76] Kim Y, Nagao S, Sugahara T, SUGANUMA K, UESHIMA M, ALBERCHT H J, WILKE K, STORGIES J. Enhanced reliability of Sn-Ag-Bi-In joint under electric current stress by adding Co/Ni elements[J]. Journal of Materials Science: Materials in Electronics, 2014, 25(7): 3090-3095.
[77] Lee A, Subramanian K N. Development of nano- composite lead-free electronic solders[J]. Journal of Electronic Materials, 2005, 34(11): 1399-1407.
[78] ��f, ��㳼, ۢ ��, �� ��, ��־��, ����ƽ. �������ṹ����ǿ������SnBi�����Ǩ�Ƶ�Ӱ��[J]. ϡ�н��������빤��, 2011(S2): 45-50.
ZHANG Rui-hong, XU Guang-chen, TAI Feng, GUO Fu, XIA Zhi-dong, LEI Yong-ping. Effects of nano-structured reinforcements on the electromigration behavior of SnBi solder joints[J]. Rare Metal Materials and Engineering, 2011(S2): 45-50.
[79] Niranjani V L, Rao B S S C, Singh V, KAMAT S V. Influence of temperature and strain rate on tensile properties of single walled carbon nanotubes reinforced Sn-Ag-Cu lead free solder alloy composites[J]. Materials Science & Engineering A, 2011, 529(1): 257-264.
[80] �� ��, �� ��, �� ��, �� ʤ, Ǯ����, ������. ��̼���ܵ�Sn-58Biǥ�ϵ��Ʊ�����ǥ����[J]. ����ѧ��, 2011, 32(9): 9-12.
HE Peng, AN Jing, MA Xin, CHEN Sheng, QIAN Yi-yu, LIN Tie-song. Investigation preparation method and soldering behaviors of Sn-58Bi lead-free solder with carbon nanotubes[J]. Transactions of the China Welding Institution, 2011, 32(9): 9-12.
[81] �� ��. ��̼���ܵ�Sn-58Bi��Ǧǥ�ϵ��Ʊ����������о�[D]. ������: ��������ҵ��ѧ, 2010: 1-45.
AN Jing. Investigation on the preparation method and properties of Sn-58Bi lead-free solder with carbon nanotubes[D]. Harbin: Harbin Institute of Technology, 2010: 1-45.
[82] Xu S, Chan Y C, Zhang K, YUNG K C. Interfacial intermetallic growth and mechanical properties of carbon nanotubes reinforced Sn3.5Ag0.5Cu solder joint under current stressing[J]. Journal of Alloys & Compounds, 2014, 595(15): 92-102.
[83] ������. SnAgCu��Ǧ����ˮ�����ʴ��Ϊ��Ԥ����ʩ���о�[D]. ������: ��������ҵ��ѧ, 2008: 1-57.
BAI Peng-fei. Study on the corrosion and prevention of SnAgCu lead-free solder joint in aqua environment[D]. Harbin: Harbin Institute of Technology, 2008: 1-57.
[84] Gao Yan-fang, Cheng Cong-qian, Zhao Jie, WANG Li-hua, LI Xiao-gang. Electrochemical corrosion of Sn-0.75Cu solder joints in NaCl solution[J]. Transactions of Nonferrous Metals Society of China, 2012, 22(4): 977-982.
[85] Liu J C, Park S W, Nagao S, NOGI S, KOGA H, MA J S, ZHANG G, SUGANUMA K. The role of Zn precipitates and Cl- anions in pitting corrosion of Sn-Zn solder alloys[J]. Corrosion Science, 2015, 92: 263-271.
[86] �Թ���, �� ƽ. ��Y��Sn-9Znǥ�ϺϽ���֯�븯ʴ���ܵ�Ӱ��[J]. �ȼӹ�����, 2014(21): 177-178.
ZHAO Guo-ji, ZHAO Ping. Influence of minor Y additions on microstructure and corrosion property of Sn-9Zn alloy[J]. Hot Working Technology, 2014(21): 177-178.
[87] Peng H T, Che C S, Kong G. Effect of minor Cu addition on corrosion behavior of Sn-Zn-xCu touch-up solder alloys[J]. Materials & Corrosion, 2017, 68(7): 791-798.
[88] Ma Li, Hu Qiang, Sun Yan-bin. Effect of Cu on the electrochemical corrosion behavior of Sn-8Zn-3Bi lead-free solder alloy[J]. Advanced Materials Research, 2015,1095: 95-98.
[89] Liu Jian-chun, Wang Zheng-hong, Xie Jing-yang, MA Ju-sheng, SHI Qing-yu, ZHANG Gong, SUGANUMA K. Effects of intermetallic-forming element additions on microstructure and corrosion behavior of Sn-Zn solder alloys[J]. Corrosion Science, 2016, 112: 150-159.
[90] Nazeri M F M, Mohamad A A. Corrosion resistance of ternary Sn-9Zn-xIn solder joint in alkaline solution[J]. Journal of Alloys and Compounds, 2016, 661: 516-525.
[91] ������, ϴ��ƽ. ��Ge�Դ�����Һ̬Sn���������ܵ�Ӱ��[J]. ����ѧ��, 2007, 43(7): 759-763.
GONG Guo-liang, XIAN Ai-ping. Influence of trace on oxidation of liquid Tin in atmosphere[J]. Acta Metallurgica Sinica, 2007, 43(7): 759-763.
[92] ����Ƽ. Ge��Ni��Ԫ�ض�Al-Si-Cuǥ�����ܵ�Ӱ��[D]. �Ϸ�: �Ϸʹ�ҵ��ѧ, 2014: 1-51.
SUN Yu-ping. Effect of Ge, Ni elements on the properties of Al-Si-Cu filler metal[D]. Hefei: Hefei University of Technology, 2014: 1-51.
[93] Huang Ming-liang, Zhao Ning, Liu Shuang, HE Yi-qian. Drop failure modes of Sn-3.0Ag-0.5Cu solder joints in wafer level chip scale package[J]. Transactions of Nonferrous Metals Society of China, 2016, 26(6): 1663-1669.
[94] Hokka J, Mattila T T, Li J, TEERI J, KIVILAHTI J K. A novel impact test system for more efficient reliability testing[J]. Microelectronics Reliability, 2010, 50(8): 1125-1133.
[95] Peng W, Marques M E. Effect of thermal aging on drop performance of chip scale packages with SnAgCu solder joints on Cu pads[J]. Journal of Electronic Materials, 2007, 36(12): 1679-1690.
[96] Kim J Y, Yu J, Kim S H. Effects of sulfide-forming element additions on the Kirkendall void formation and drop impact reliability of Cu/Sn-3.5Ag solder joints[J]. Acta Materialia, 2009, 57(17): 5001-5012.
[97] Che F X, Pang J H. Study on reliability of PQFP assembly with lead free solder joints under random vibration test[J]. Microelectronics Reliability, 2015, 55(12): 2769-2776.
[98] El-Daly A A, Fawzy A, Mansour S F,YOUNIS M J. Novel SiC nanoparticles-containing Sn-1.0Ag-0.5Cu solder with good drop impact performance[J]. Materials Science & Engineering A, 2013, 578: 62-71.
[99] Lee T K, Kim C U, Bieler T R. Influence of high-G mechanical shock and thermal cycling on localized recrystallization in Sn-Ag-Cu solder interconnects[J]. Journal of Electronic Materials, 2014, 43(1): 69-79.
[100] �Դ�Ϊ. �ռ���ѭ���ͷ��ջ�����LF6���Ͻ���֯�����ܵ�Ӱ��[D]. ����: ����������ѧ, 2010: 1-63.
ZHAO Da-wei. Effect of space thermal cycling and radiation environment on the microstructures and properties of welded LF6 aluminum alloy[D].Jiaozuo: Henan Polytechnic University, 2010: 1-63.
[101] ��ѧ��, ������, �½�. ���������������ʧЧ������Ӧ���о�[J]. ��ؼ���, 2015, 34(2): 154-156.
CHEN Xue-yong, ZHANG Xiao-guang, CHEN Jie. Failure mechanism and application of electrical connectors used in aerospace[J]. Measurement & Control Technology, 2015, 34(2): 154-156.
[102] �� ��, �� ǿ, ��̫��, Τ����, �� ��. �ռ���价�������ڹ����ǹ��Ϸ�����ӹ̶Բ�[J]. ��������������, 2012, 29(4): 392-396.
ZHOU Fei, LI Qiang, XIN Tai-lin, WEI Xi-feng, ZHANG Hua. Analyses and countermeasures of in-orbit satellite failures caused by space radiation environment[J]. Spacecraft Environment, 2012, 29(4): 392-396.
[103] �����, �����. �ռ���价���������������ӹ̼�����չ[J]. �������װ, 2009, 9(8): 43-47.
LUO Yan-heng, ZHANG Rui-jun. Space radiation environment and resist-radiation hardening technology progress of optical devices[J]. Electronics & Packaging, 2009, 9(8): 43-47.
[104] �����, �� ��, �� ��, ����ǰ, ���ξ, ��ɼ�, �� �, ���鲨, �����. �ռ���ӷ�����ռ�����������о���չ[J]. ����ҽѧ��ҽѧ����, 2014, 27(6): 453-457.
JIA Xiang-hong, ZOU Hong, Xu Feng, YU Xiang-qian, WU Da-wei, YANG Cheng-jia, JIANG Rui, MA Hong-bo, ZONG Qiu-gang. Research progress of space electrons radiation risk and its protection strategy[J]. Space Medicine & Medical Engineering, 2014, 27(6): 453-457.
Research progress on reliability of lead-free solders under special conditions
WANG Jian-hao1, XUE Song-bai1, MA Chao-li1, LONG Wei-min2, ZHONG Su-juan2
(1. College of Materials Science and Technology, Nanjing University of Aeronautics and Astronautics, Nanjing 211106,China;
2. State Key Laboratory of Advanced Brazing Filler Metals and Technology, Zhengzhou Research Institute of Mechanical Engineering, Zhengzhou450002, China)
Abstract��Lead-free solders are applied under special conditions with the improvement of property of the solders and people's awareness of environmental protection. The research status and development trend of lead-free solders used under special conditions were reviewed synthetically. First of all, the failure mechanism of solder joints under different special conditions was discussed. Moreover, the ways to enhance the reliability of lead-free solders under several special conditions were reported and analyzed, such as microalloying, particle strength and substrate improvement. In addition, the defects of the current reliability research of lead-free solders were summarized, and the further research was prospected.
Key words: special condition; lead-free solder; microalloying; particle strength; substrate improvement; reliability
Foundation item: Project(51675269) supported by the National Natural Science Foundation of China; Project supported by the Priority Academic Program Development of Jiangsu Higher Education Institutions, China
Received date: 2017-08-24; Accepted date: 2017-11-15
Corresponding author: XUE Song-bai; Tel: +86-25-84896070; E-mail: xuesb@nuaa.edu.cn
(�༭ �� ��)
������Ŀ��������Ȼ��ѧ����������Ŀ(51675269)�����ո�У����ѧ�ƽ��蹤��������Ŀ
�ո����ڣ�2017-08-24�������ڣ�2017-11-15
ͨ�����ߣ�Ѧ�ɰأ����ڣ���ʿ���绰��025-84896070��E-mail��xuesb@nuaa.edu.cn
ժ Ҫ��������Ǧǥ�����ܵ����������ǻ�����ʶ����ߣ���Ǧǥ��Ҳ��Ӧ����������С��������������Ǧǥ�Ͽɿ��Ե��о���չ�����ƣ��������������Ǧǥ�Ϻ���ʧЧ��ԭ��̽�ָ���������������Ǧǥ�Ͽɿ��Եķ����ͻ��������Ͻ�����ǿ���ͻ�����ƣ��ܽ�Ŀǰ��Ǧǥ�Ͽɿ����о����ڵIJ��㣬����Ǧǥ��δ�����о�����������顣
[5] ������, ��ΰ��, �����, ·ȫ��. ϡ����Al-Si-Zn-Cuǥ�Ϲ������ܵ�Ӱ��[J]. ����, 2017(2): 31-36.
[15] ��÷. SnAgBi-xSmǥ����֯�����ܵ��о�[D]. ������: ������������ѧ, 2016: 1-48.
[16] ������. ϡ��Pr��Nd��SnAgCu��Ǧǥ����֯������Ӱ���о�[D]. �Ͼ�: �Ͼ����պ����ѧ, 2012: 1-130.
[19] ��Ӣ��. �̲��Ӷ���Ǧ����Sn-0.3Ag-0.7Cu���淴Ӧ����ѧ���ܵ�Ӱ��[D]. ����: ����������ѧ, 2014: 1-55.
[20] ̷ �. Fe��Mn��SAC0307ǥ�����ܵ�Ӱ��[D]. ������:��������ҵ��ѧ, 2014: 1-55.
[26] �� Դ. ����Ag3Sn��Cu6Sn5������Sn����Ǧ��������Ӱ���о�[D]. ����: ����������ѧ, 2015: 1-92.
[45] ʯ���, ����ƽ. �Ʋ�����������Է�����������о���չ[J]. �й���ɫ����ѧ��, 2011, 21(5): 1021-1030.
[50] ��־��. Cu-Al�������SnAgCu����ɿ��Ե�Ӱ��[D]. ������: ��������ҵ��ѧ, 2014: 1-65.
[64] �� ��. Sn63Pb37��Sn3.0Ag0.5Cuǥ�ϼ��亸��ĵ��¿ɿ����о�[D]. ������: ��������ҵ��ѧ, 2014: 1-87.
[72] �� ��. �ߴ�ЧӦ��ʱЧ����Ǩ�ƶ�Cu/Sn-9Zn(SAC305)/Cu�������ܵ�Ӱ��[D]. ����: ����������ѧ, 2015: 1-61.
[73] Ҷ ��. ��װоƬNi/Sn-3.0Ag-0.5Cu/ENEPIG(OSP)��Ǧ����ĵ�Ǩ����Ϊ[D]. ����: ����������ѧ, 2011: 1-70.
[81] �� ��. ��̼���ܵ�Sn-58Bi��Ǧǥ�ϵ��Ʊ����������о�[D]. ������: ��������ҵ��ѧ, 2010: 1-45.
[83] ������. SnAgCu��Ǧ����ˮ�����ʴ��Ϊ��Ԥ����ʩ���о�[D]. ������: ��������ҵ��ѧ, 2008: 1-57.
[86] �Թ���, �� ƽ. ��Y��Sn-9Znǥ�ϺϽ���֯�븯ʴ���ܵ�Ӱ��[J]. �ȼӹ�����, 2014(21): 177-178.
[91] ������, ϴ��ƽ. ��Ge�Դ�����Һ̬Sn���������ܵ�Ӱ��[J]. ����ѧ��, 2007, 43(7): 759-763.
[92] ����Ƽ. Ge��Ni��Ԫ�ض�Al-Si-Cuǥ�����ܵ�Ӱ��[D]. �Ϸ�: �Ϸʹ�ҵ��ѧ, 2014: 1-51.
[100] �Դ�Ϊ. �ռ���ѭ���ͷ��ջ�����LF6���Ͻ���֯�����ܵ�Ӱ��[D]. ����: ����������ѧ, 2010: 1-63.
[101] ��ѧ��, ������, �½�. ���������������ʧЧ������Ӧ���о�[J]. ��ؼ���, 2015, 34(2): 154-156.
[103] �����, �����. �ռ���价���������������ӹ̼�����չ[J]. �������װ, 2009, 9(8): 43-47.


