DOI: 10.11817/j.issn.1672-7207.2015.01.008
����-������ǿ����ǥ���о����½�չ
����1, 2��Tu K N 3������1��������1�����1
(1. ����ʦ����ѧ ���繤��ѧԺ������ ���ݣ�221116��
2. ���տƼ���ѧ �Ƚ����Ӽ���ʡ���ص�ʵ���ң����� ��212003��
3. Department of Materials Science and Engineering, University of California, Los Angeles, CA, 90095)
ժ Ҫ��
-������Ǧǥ���о���Ӧ����״���ֱ���ܹ�������Խ�����������մɡ�̼���ܼ��߷��Ӽ��ֿ�������Ǧǥ�����ܵ�Ӱ�졣��Ҫ����Ǧǥ���ڲ���֯��������֯���ۻ����ԡ���ʪ�ԡ���ѧ���ܺ�������ܼ�����̽�ֿ�����ǥ����֯�����ܵ�Ӱ�졣ͬʱ����������ǿ����Ǧǥ����Ӧ�ù����г��ֵ����⼰��Ӧ�Ľ����ʩ�����Կ�����ǿ��Ǧǥ�ϵķ�չ���ƽ��з�����չ����
�ؼ��ʣ�
��Ǧǥ����������֯����ѧ������������ǿ��
��ͼ����ţ�TG454 ���ױ�־�룺A ���±�ţ�1672-7207(2015)01-0049-17
Reviews on latest advances in micro/nano-sized particles enhanced composite solders
ZHANG Liang1, 2, Tu K N3, SUN Lei1, GUO Yonghuan1, HE Chengwen1
(1. School of Mechanical & Electrical Engineering, Jiangsu Normal University, Xuzhou 221116, China;
2. Provincial Key Laboratory of Advanced Welding Technology, Jiangsu University of Science and Technology,
Zhengjiang 212003, China;
3. Department of Materials Science and Engineering, University of California, Los Angeles, CA 90095)
Abstract: The investigation and application of lead-free solders bearing micro/nano-sized particles were reviewed synthetically. Moreover, the effects of additives such as metals, compounds, ceramics, carbon nano-tube, polymer on lead-free solders were reported and analyzed synchronously. Based on the works on microstructures, interface structure, melting temperature, mechanical property and creep behaviors, the effects of particles on properties and microstructures of solders were discussed systematically. In addition, the problems and difficulty in the process of the applications of lead-free solders bearing particles were analyzed synchronously, some suggestions were put forward on how to solve those problems mentioned above, and the prospect on lead-free solders with particle reinforcement was analyzed.
Key words: lead-free solders; interface structure; mechanical properties; particle reinforcement
�ڵ��ӹ�ҵ�У�SnPbǥ��������ص����ܵõ��㷺Ӧ�ã�����Ǧ�Ķ���ȴ�����˹��������ձ�Ĺ�ע��һʱ֮�䡰��Ǧ������ҲԽ��Խ�ߣ���ʹ��Ǧǥ�ϵ��о���Ϊ���ӹ�ҵ�����ſ���[1-3]���������Ǧǥ���У��������ܺͳɱ��Ŀ��ǣ�SnAgCu[4-5]��SnCu[6-7]��SnAg[8-9]��SnZn[10-11]�ȳ�Ϊ���SnPb��Ϊ��������Ǧǥ�ϡ�����Щ��Ǧǥ����Ȼ����һЩȱ�㣬�����ۻ��¶Ƚϸߡ���֯�д��ڴ��Ĵ����ࡢ��ƣ�����ܽϲ�������Խϲ�ɿ��Խϵ͵�[12-15]����ˣ�����о������ϵ����Ǧǥ�ϵ���Щȱ�ݽ����˽�һ��������ϣ�����͵���Ǧǥ�ϵ����ܴﵽ����������ͳ��SnPbǥ�ϡ�Ϊ�˽�һ�������Ǧǥ�ϵ����ܣ�ҵ���о�����Ҫ��ȡ����2�ַ�����1) ǥ�ϵ��Ͻ���Ҫ����Ǧǥ�����������ĺϽ�Ԫ�أ��������ǥ�ϵ�ijһ���ܻ����ۺ�����, ����Ga���Ը���ǥ�ϵ���ʪ��[16]��ϡ��Ԫ�ؿ������ǥ�ϵ��ۺ��� ��[17]�����ǣ����������ӺϽ�Ԫ���Ķ��ǻ������ã�����ϡ�����ӹ���ʱ����ʹ�����������������[18-19]������ɺ��������ʧЧ��Ŀǰ�Ͻ����о��߿���������Ǧǥ����Ҫ���о��ֶΣ�ͬʱ��ϵ������ǥ�ϵIJ��ֲ�Ʒ�Ѿ�����ص�λ�õ���ҵ���Լ���һ����Ӧ�ú��ƹ㣬�����ձ�ǧס������ʽ�����Լ�³��˹ǥ�����Ϲ�˾�ȡ�2) ��������-������ͨ������ǿ��������ǥ�ϵ����ܡ����ӵĿ�����Ҫ��������������������������մɿ�����ͬʱҲ���о�������̼���ܺ߷��ӿ�����[20]���������ӿ���������ͳߴ�ı仯����Ǧǥ�ϵ���֯�������кܴ�IJ�ͬ���������������Ӳ������Ըı���Ǧǥ�ϵ��ڲ���֯��ͬʱ��ǥ���ڲ��������������γɣ���������������մɿ��������Ӳ������γ����࣬������Ӱ��Ļ���Ҳ������ͬ������б�Ҫ��Ժ���ͬ���ͼ���ͬ�ߴ��������Ǧǥ�ϵ����ܺ���֯�����ۺϷ�����̽�ֿ�����Ӱ�켰���á����������ۺϷ�������-��������Ǧǥ����֯�����ܵ�Ӱ�죬�о���������Ǧǥ���ڲ���֯��������֯���ۻ����ԡ���ʪ�ԡ���ѧ���ܡ���������Լ��ɿ��Ե�Ӱ�졣����������-������Ǧ����Ŀɿ��ԣ��Ա�Ϊ������ǿ������Ǧǥ�ϵ��з��ṩ��������ָ����
1 ����ǥ����֯��Ӱ��
1.1 �ڲ���֯
���Ͽ�ѧ�빤�̵�4��Ҫ���Dz��ϵĻ�ѧ�ɷ֡���֯�ṹ���ӹ�������ʹ������[21]������һ����ѧ�ɷֵIJ��ϣ�����һ���ļӹ����գ�����ض�����֯�ṹ���Ӷ�������涨��ʹ������Ҫ�������ض���֯�ṹ�����˲������Ե����ܣ���ˣ������о���������Ǧǥ���ڲ���֯��Ӱ�졣
Ni����(����Ϊ2~3 ��m)��ΪSn3.5Agǿ���࣬��ʹǥ�ϻ�����������Եĸı䣬ͼ1[22]��ʾΪSnAg��SnAg-0.5Ni 2��ǥ�ϲ�ͬ��ȴ��ʽ�µ���֯ͼ����ͼ1���Կ�����SnAgǥ����֯����Ҫ�ɦ�-Sn��Ag3Sn������ɣ�����Ni�����Ժ�-Sn��Ag3Sn��ijߴ�����Լ�С��ͬʱ������Ni3Sn4�ࡣYao��[23]��������Ni����(��)����ϸ��Sn3.8Ag0.7Cu�ڲ���Ag3Sn�ߴ磬��δ�ᵽ�Ԧ�-Sn�ߴ��Ӱ�졣Al���������ӵ�Sn3.5Ag0.5Cuǥ���У�ǥ�ϻ����е�Cu6Sn5��Ag3Sn�ijߴ���õ��������ͣ��о��߽������ڽ����仯��������ġ������κˡ�������[24]������Ag�������ӵ�Sn9Znǥ���У�����AgZn3���ȷֲ���ǥ�ϻ����У�ͬʱ��״�ĸ�Zn��ͦ�-Sn�õ�һ���̶ȵ�ϸ��[25]��Lin��[26]�о���Cu����(1~5 ��m)��Sn3.5Agǥ�Ͽ���������֯��Ӱ�죬SnAgǥ��������֯��Ҫ�ɸ�Sn�����״��֦��������֯(��֦����ĸ�Sn���Ag3Sn)��ɣ�Cu�������ӿ���ϸ��������֯��ijߴ磬����Ҫ�ǹ�����ǥ�ϻ�����Cu6Sn5������������ȷֲ���
��SnAgCu������SiC����������SiC���������������ӣ�ǥ���ڲ�Ag3Sn�����ߴ���С��������Ϊ0.05%ʱ�ߴ���С��Ϊ0.24 ��m����������SiC����������Ag3Sn�����ߴ���������0.20%ʱ��Ag3Sn�ߴ���0.01%����ǥ�ϻ���Ag3Sn�ߴ���ƣ������-Sn����Ǿ���Ҳ����ϸ��[27]������Ӣ��[28]������Y2O3��(1 ��m)�м���RMAǥ����������Ⱥ�����Sn3.0Ag0.5Cu��ĩ(30~50 ��m)�Ƴɺ��ࡣ�о�����Y2O3������ɢ�ֲ���ǥ�ϻ����У��Ծ�����һ���ġ����������ã��ɴ������˦�-Sn�Ĵֻ���ͬʱ��СAg3Sn��Cu6Sn5�ijߴ硣ͬʱ��Sn58Biǥ��������Al2O3��Fe2O3��SiO2��TiO2���������Ƶ�ϸ������[29]��
1.2 ������֯
��ǥ�������У�����ǥ�ϵ��ۻ���ǥ�Ϻͻ���֮��ᷢ����Ӧ���γ�һ����Խ����仯����(IMC)��ͬʱ�ڷ����ڼ䣬����Ԫ�ص���ɢ��IMC�ĺ�Ȼ��������ӡ��������IMC����ʱ����������ܻ����Զ�[30]����ˣ�IMC���γɶԺ���Ŀɿ���������Ҫ��Ӱ�졣
ͨ����е��Ϸ�����Co�������뵽Sn3.5Agǥ���У����ֽ�������仯�����ĺ�ȼ���û�б仯������Cu6Sn5����̬���ȱ�״ת��ΪС����״��ͬʱ����Co�����������ӣ����洦���ִ�����(Cu,Co)3Sn2�࣬��ͼ2��ʾ[31]��ͨ��Co���������Sn3.8Ag0.7Cu���࣬�о�Co������SnAgCu������֯��Ӱ�죬����Co������������������Cu3Sn����������Ҫ����Co���Խ���Cu3Sn�Ľ��滥��ɢϵ�������ǻ����Դٽ�Cu6Sn5������[32]����Sn3.8Ag0.7Cu�����л��Mo������������Mo�����������ڵ�ǥ������ֹCu������CuԪ�ص���ɢ��ͬʱ����Mo����������Cu����ɢ�������Խ��ͣ�Mo�����������ƽ����������������Cu6Sn5�����ijߴ����Լ�С��Cu3Sn�������ٶȵõ����Խ���[33]����������[34]��Sn3.5Ag����������Ni����(����Ϊ1~3 ��m), ��������Ni�ļ��룬���´�������ά��Cu-Ni-Sn�ܵ����γɡ���ʹ�ʹ����Ԫ�ص���ɢ���������ӽ����ĺ�ȡ�

ͼ1 SnAg-xNiǥ����֯[22]
Fig. 1 Microstructure of SnAg-xNi solder[22]
����ǿ��[35]ѡ����Sn9Znǥ��������Cu����(����8��m)�������ڳ�ʱ��������ʱ������Cu ��������Ч����SnZn/Cu ��ͷ����Cu-Zn �����仯����������ٶȣ��Ӷ���С����IMC ��ĺ�ȣ�����IMC ������ǥ����Cu ���������������Ӷ���С����SnZn ǥ���м���Cu �������ͽ���IMC ��ĺ�ȣ���ԭ��ɽ���Ϊ����Cu �����ļ��룬�����˺�ǥ����Zn ��Ӧ��Cu �������������Һ̬ǥ����Zn �ĺ��������Zn ����ɢ�ٶȽ��ͣ�����ǥ��SnZn/Cu ��������IMC��Ƚ��͡�Amagai[36]�о���Co��Ni��Pt��Al��P��Cu��Zn��Ge��Ag��In��Sb��Au����������Sn3Ag�����������仯����������Ϊ��Ӱ�죬����Co��Ni��Pt 3���������������������ӽ��������仯����ĺ�ȣ�3��Ԫ�ؿ����۽��ڽ��������仯�����У�Al��P��Cu��Zn��Ge��Ag��In��Sb��Au����������߽����ĺ�ȣ��ڽ��� ����û�з���Al��P��Ge��In��Sb�ȺϽ�Ԫ�ء�Co��Ni��Pt 3�����������Cu��Sb��In��Bi��Ge��Al��Zn�����������ӵ�Sn3Ag������Լ�С������ѵķ������ʡ�����Ag�������ӵ�SnZnǥ���ж�SnZn/Ni����Ľ�����֯Ҳ�����Ե�Ӱ�죬����������Ϊ1%��Ag�ĺ�������û�з�������SnZn/Ni��������Ϊ�����Ľ����仯��������������ڲ����������ֲ���Ϊ���ȣ�ͬʱ�����������Ե�������֯������������������Ϊ2%~4%ʱ��������֯�ݻ�Ϊ���Ե�������֯[37]����Ҫ����Ϊ�������ڽ��洦������淴Ӧ���Ӷ��γ��µ����ࡣ

ͼ2 ������֯ͼ[31]
Fig. 2 Microstructure of interface[31]
Gain��[38]�о�������Al��Ni������SnAgCu/OSP-Cu������֯��Ӱ�죬����0.5%����Ni������ʹ��������Sn-Cu-Ni�����仯���0.5%��Al����Ҳ��ʹ�������Sn-Ag-Al�����仯�����ࡣ�����������������������֯�����������ֲμ��ڲ��ͽ��淴Ӧ����ұ���Ʊ��ĺϽ���Ǧǥ�������ơ�����ͨ��ұ��ʽ�з��ĺ�ϡ��Ce��SnAgCu��Ǧǥ�ϣ��ں�����ϡ��Ԫ��Ce�����ڲ�SnԪ�ط�Ӧ���γ�Ce-Sn����[39]�������ڳ�ʱ��ķ��۹����У���������-����ֻ�ܶ���Ӱ�������������ڳ�ʱ��Ľ����¶�ѭ�������У��������������Ĵ���ʱ��������֯����Cu-Sn(SnAgCu/Cu��SnCu/Cu��SnAg/Cu)����Cu-Zn(SnZn/Cu)����Ϊ����Ŀǰ������ǥ���о��У��о��ɹ������о���ʱ���ʱЧ�����н�������������������������Ӱ����ƣ�ȱ����ʱ����������ʱ��������֯�ݻ���
ͨ��ұ����Sn3.5Ag0.7Cuǥ��������NiͿ��̼���ܣ������ڵ���ʱЧ����ѭ�������У������������ٶȵõ����ԵĽ��ͣ�����Ҫ����ΪNi-CNT�����ӿ����������ƽ���Sn����ɢ���Ӷ����ƽ����Cu-Ni-Sn�������[40]�����о����о������̼����SnAgCu���������֯�ṹ�����������Ƶ����ƽ�����������[41]��TiO2���������ӵ�Sn3.0Ag0.5Cu�����������������������ͽ����ĺ�Ⱥ;����ߴ磬����������������Ϊ0.1%ʱ���Խ����Ľ����仯����������ﵽ�������[42]����Si3Ni4���ӵ�Sn0.7Cuǥ���У�������һ���̶��ϼ�С�����仯����ĺ�ȣ����Ǽ�С�ķ��Ƚ�С[43]���������������Ǧǥ���в����������֯������Ӧ�������������������ķֲ��Ժ�����֯����Ӱ�죬��ˣ��ڳ�ʱ������ڼ䣬��������Ӱ����Ȼ���ڣ����Dz����������ᱻ�����ڼ�������Ԫ����ɢ�γɵĽ����仯�����������������Ӱ�콫����һ���̶ȼ�����
Ϊ���о�����-�����Ժ����������仯�����Ӱ�죬���ݾ��鹫ʽ[44]����Ԫ�ص���ɢϵ������Ͻ�������仯�����ʱЧʱ��֮��Ĺ�ϵʽ�����㺸���������仯��������������ܡ�tʱ�̽����Ľ����仯�����ȿ��Ա�ʾΪ
 (1)
(1)
���У�XtΪtʱ�̵Ľ����ĺ�ȣ�X0Ϊ������ʼ��ȣ�k���¶���ص���ɢϵ����
��Ԫ�ص���ɢϵ��k�ľ��鹫ʽΪ
 (2)
(2)
��ʽ(2)����ȡ���������Եõ�
 (3)
(3)
ͨ������ln k-1/Tͼ�����Լ�������仯����ļ�����Q��
2 ����ǥ�����ܵ�Ӱ��
2.1 �ۻ�����
����Ǧǥ�϶��ԣ�ǥ�ϵ��۵������ǥ�ϵ��������ķ�ֵ�¶ȣ���ͳ��SnPb����ǥ�ϵ��ۻ��¶�Ϊ183 �棬��Դ�ͳSnPbǥ�ϵ������¶�Ҳ�ϵͣ�����Ǧǥ�ϵ��ۻ��¶���Խϸߣ�����SnAgCu���۵�Ϊ217 �棬���������ǥ�ϵ���������ֵ�¶ȣ�һ��Ϊ245 �����ҡ���ˣ����о�������-������Ǧǥ��ʱ��ǥ�ϵ��ۻ��¶�Ҳ��Ϊ���������ܵ�һ����Ҫָ�ꡣ
Co�������ӵ�Sn3.5Agǥ�ϣ����ۻ��¶ȼ���û��Ӱ�죬����ǥ���ۻ�����ȵõ����Խ��ͣ�����Ҫ������Co����������ǥ�������̹����е��κ�λ��[31]������Ag������SnZnǥ�ϵ�Һ���ߵ��¶�������Ӱ�죬SnZn��Һ�����¶�Ϊ199 �棬������Ag������������Ϊ3%��4%ʱ���¶���210 ��[37]�������[45]�о����ָ߷��Ӳ���POSS���������Ӷ�Sn3.5Agǥ�ϵ��ۻ��¶�Ӱ�첻��Һ�����¶���220~226 ��֮�䡣����Al2O3���ӵ�SnZnǥ��Ҳ�������Ƶ�Ч������ǥ�ϵ��ۻ��¶�Ӱ���С��SnZn-3Al2O3���ۻ��¶�Ϊ198.98 �棬��SnZn���ۻ��¶�Ϊ198.5 ��[46]����ˣ�������������-����������ǥ�ϵ���������ֵ�¶ȿ��Ժ�δ���ӿ�����ĸ�Ͻ���ͬ���ʿ��Բ��ı������������ա�
��Fe��(1~2 ��m)���ӵ�Sn3Ag0.5Cu����������壬�Ʊ��ɺ��࣬DSC���Է���Fe��SnAgCuǥ�ϵ��ۻ��¶ȼ���û��Ӱ�죬��SnAgCu������SiC��������SnAg������ZrO2�������ۻ��¶ȱ仯Ҳ��С[47]����Ni�������ӵ�SnAgCuǥ�ϣ�Һ���ߵ��¶���219.9��ת��Ϊ220.5~221.8�棬Ni���������ӶԸ���ǥ�ϵ��ۻ��¶�Ӱ���С[27]����SnAgCu-xNiǥ�ϵ��о���Ҳ���������Ƶ�����[48]�����о���ѡ����Sn58Biǥ��������̼���ܣ��������ܶ�ǥ���ۻ��¶ȵ�Ӱ�첻����[49]������Ŀǰ�о��߲��õ����ӿ���������������ǥ�ϵ��ۻ��¶ȷ���û�й��ס�����[50]��ȡҺ�ѧ��ԭ�����Ժĵ缫ֱ���绡����SnAgCuǥ����������ǥ���Ʊ���������ĩ�����Խ�Sn3.0Ag0.5Cu�������ӵ��ۻ��¶Ƚ�Ϊ180.5 �棬�ʹ�ͳSnPb����ǥ�ϵ��ۻ��¶��൱�����ǿ��ǵ����ģ�����ͳɱ����⣬����ǥ���ڹ�ҵ�е��ƹ��Ӧ�û�����д������о�������
2.2 ��ʪ��
ǥ�ϵ���ʪ����������Ǧǥ�ϵ�һ����Ҫָ��[51]��ǥ�ϵ���ʪ����ָҺ̬ǥ����ĸ�ı�����չ������[52]�����ڹ��ն��ԣ���һ���ļ����¶��£�ǥ��ֻ�о������õ���ʪ�ԣ�������ĸ�ı�����ʪ��չ�γ����õĽ�ͷ����Ϊ���㣬���������������������ге��Ż�е֧�ź͵������ӵ����ã���ˣ�������ι���Ҳֱ�Ӿ����˵��Ӳ�Ʒ��ʹ�����ܡ����ڴ�ͳ��SnPbǥ�ϣ���ΪPbԪ�صĴ��ڣ�ǥ�ϵ���ʪ���ܽϺã�����������Ǧǥ�������ͳ��SnPbǥ�Ϻ�ǥ�ϵ���ʪ��Ҳ���Ա�Ϊ�˸��������Ǧǥ�ϵ���ʪ�ԣ��Ͻ������Ǧǥ�ϵ���ʪ����Ŀǰ�о����о����ȵ㡣Ŀǰ����ǥ����ʪ�Ե���Ҫ��2�֣�һ���Dz�����ʪƽ�ⷨ��ͨ����ʪʱ�����ʪ������ǥ����ʪ�Ե����ӣ���һ���ǽ�������ǥ���ڻ��������ʪ��������չ���������ֱ�Ӳ���ǥ�ϵ���ʪ�ǡ�
Lee��[31]��������Co������SnAgǥ���У�ǥ�ϵ���ʪ�Լ���û�б仯������Ni�����ܹ��������Sn0.65Cu�ǹ���ǥ�ϵ���ʪ�ԣ����������Ϊ0.10%��������������������һ�����ӣ���ʪ����һ�����½����о��߽����������ڼ��ܽϵ͵���ԭ�����ƶ�Niԭ�ӵ��ƶ���Ni��������������ʹ����ǥ�ϱ���Ĥ���ӣ���ʪ�Ա��[53]����Sn3.5Agǥ������������Ni������Ҳ���������ƵĴٽ����ã�������Cu������������������ǥ�ϵ���ʪ��[54]��SnAgCuǥ������������Ag������ǥ�ϵ���ʪ���ܵõ���������[55]��Ŀǰ�Ժ�����������Ǧǥ���Ʊ���Ҫ�Dz��û�е�����Ƴɺ���ķ�ʽ�����������������žۣ��ڻ�е���費��ʱ������ʹ�����������������档��˺���������Ǧǥ�ϵ��Ʊ�����������һ��ؼ��ļ�����
Al2O3���������ӵ�Sn3.5Ag0.5Cuǥ�ϣ�ǥ�ϵ���ʪ�ǵõ����Եļ�С����ͼ3��ʾ������������Ϊ0.5%ʱ����ʪ�ǵ���СֵΪ28.9��[56]����Sn3.5Ag0.7Cu������TiB2������̼����(NWCNTs)(ֱ��Ϊ3~20 nm����Ϊ��ʮ��m)�� ǥ�ϵ���ʪ����������֮�������Ե�������ϵ�����������������ֱ�Ϊ1.50%��0.04%����ʱ��ʪ�Ǽ�С��22.2%��15.7%[57]��POSS���������ӿ������Sn3.5Agǥ�ϵ���ʪ��չ������������ֵΪ2%[45]��������Ϊ��������POSS ������ǿ���а���1~3 ��Si��OH ���ţ�ͬʱ�����˼��ܽϸߵĶ��������ͱ������ Si��O ���ţ���ǥ�������������ǥ�Ͻ�ϣ����ͽ����ܣ��Ӷ���ʪĸ�ġ���Si3Ni4���ӵ�Sn0.7Cuǥ���У�����������Сǥ�ϵ���ʪ�ǣ�����������Ϊ1%����ʪ����30.38���Ϊ14.25��[43]����Sn3.5Ag0.7Cu������NiͿ��̼���ܣ�����ǥ�ϵ���ʪ�����Լ�С��������������Ϊ0.05%��0.10%��ʹ����ʪ�ǽ��ʹ�Լ12.5%��13.2%���о�����Ϊ����Ҫ����ΪNi-CNTsǿ����ļ����С��Һ̬����ǥ����Cu���崦�ı�������[58]��ʯīϩ����Ƭ��Ϊ���ӿ���������������SnAgCuǥ�ϵ���ʪ�ǣ�����ʯīϩ����Ƭ�����ӣ�ǥ�ϵ���ʪ���������ͣ������������ӵ�0.10%ʱ����ʪ�ǽ�Ϊ��Сֵ����ĸ�Ͻ����ʪ���½���15.5%[59]��
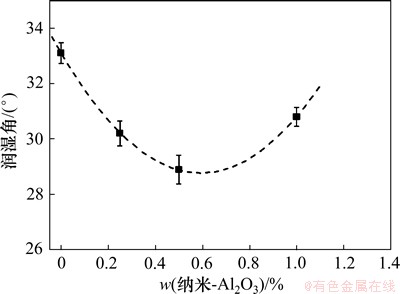
ͼ3 ������Al2O3����SnAgCuǥ����ʪ��[59]
Fig. 3 Contact angle of SnAgCu solder bearing Al2O3 particles[59]
ǥ����ʪ�Ե�Ӱ��������Ҫ��5��������ǥ�ϳɷ֡��¶ȡ�ĸ�ı���״̬��ǥ������������[60]�����⼸��Ӱ��������ǥ�ϳɷֵ��о���Ŀǰ�о��������ķ����ܸı�ǥ�ϳɷֿ�����һ����������ǥ�ϵ���ʪ�ԣ�������߷�����Բ�����������Щ�о���[61]ȷ��Ϊ����ǥ����ʪ�Եġ�����ͬ�������о���[62]��Ϊѡ����ʵ�ǥ��Ӧ�ó�Ϊ����ǥ����ʪ�Ե���Ҫ�ֶΣ�����ͨ��ʵ��֤ʵ�˲�ͬǥ����ǥ�ϵ���ʪ��Ӱ����ϴ�
2.3 ��ѧ����
��ѧ����ָ������������ǥ�ϵ���һָ�ꡣĿǰ��Ҫ����������̽�֣�һ�����ɰ�״��ǥ�ϣ�ֱ�ӽ�����������в��ԣ����ַ����ǽ������ϳ��õķ�������һ�ַ�������ǥ�Ͻ���ǥ��ʵ�飬�Ժ��������ѧ���ܲ��ԣ�����QFP������45�����죬Ƭʽ����/������У�ģ��������[63-64]�����Ŀǰ����ǥ�ϵ��о�����2�ַ���Ӧ����Խ϶࣬��2�ַ���Ҳ��Խ�Ϊ����ʵ���������Ϊǥ�����ն�Ҫ�����������飬����ת��Ϊ���㣬��ˣ��Ժ��������ѧ���ܲ��Ը�����ʵ�������
���о��߲���˫�����Ʊ�ǥ����ͷ�ļ�����Ʒ����SnAgCuǥ������������Fe����������0.5%������Fe��������ʹ����ļ���ǿ�����18%��������Fe��������Ϊ1.0%ʱ������ǿ�����39%[47]������Al������Ϊ����������������SnAgCu����ļ���ǿ�ȣ����������������������Ӻ���ļ���ǿ���������ӣ�����ѭ����ʱЧ�����У��������ǿ����Ȼ�������Ƶ�����[24]������Mo���ӵ�SnAgCuǥ�Ͽ����������������Ӧ�����о���̽���˺�������1.0%��2.0% 2�֣����õ���ѧ���ܲ��Է�ʽ�ǡ�����ͷ��״��ǥ�ϰ����з���[65]������Co�����������Sn3.5Ag����ļ���ǿ�ȣ���Co�����ӹ�����Ϊ2.0%ʱ������ļ���ǿ�Ȼ������½�������Ҫ�Ǵ�ʱ������洦���ִ���(Cu,Co)3Sn2�࣬�����Զ��������[31]��Ag���������뵽SnZnǥ�Ϻ�SnZn����ļ������������ӣ�ͬʱ����Ag�����������ӣ������������42.1 MPa��Ϊ48.9 MPa������Ҫ����ΪAg�����������ӣ����´�����AgZn3�������������ڶ������ǿ��[25]��
����3%TiB2��Sn3.5Ag0.7Cuǥ�ϵ������ǿ�Ⱥ�����ǿ�ȷֱ����23%��26%����ǥ�ϵ����Զ��õ���ͬ�̶ȵĽ��ͣ�����Ҫ����ڴ��Ե��մɿ������ΪDZ�ڵ�����Դ��������������������Ե������½�[57]������POSS�����������Sn3.5Agǥ����ͷ�ļ���ǿ�ȣ����ӷ��ȿ��Դﵽ33.7%��POSS�Ĵٽ��������仯ѧ������ֱ�ӵ���ϵ[45]��Ϊ�����������ӶԺ���ǿ�ȣ����Բ���ʽ(4)�����ͣ���ʽ����������ǿ�����������/ֱ��֮��ĺ��������Է�������ֱ��ԽС������ļ���ǿ��Խ�ߣ��ʶ������������ӿ�����߽�ͷ�ļ���ǿ��[66]��
 (4)
(4)
���У� Ϊ����ļ���ǿ�ȣ�
Ϊ����ļ���ǿ�ȣ� Ϊ����ļ���ǿ�ȣ�VfΪ���ϵ������������GΪ����ļ���ģ����bΪ����˹ʸ����dΪ���Ͽ���ֱ����kdΪ�����ۼ�������
Ϊ����ļ���ǿ�ȣ�VfΪ���ϵ������������GΪ����ļ���ģ����bΪ����˹ʸ����dΪ���Ͽ���ֱ����kdΪ�����ۼ�������
̼���ܵ�����Ҳ���Sn3.5Ag0.7Cuǥ����ǿ����Ч�����о��߽�������̼���ܵ��µ���Ӧ���Ͷ�λ���Ķ�������[67]��ʯīϩ����Ƭ��Ϊ���ӿ��������������SnAgCuǥ�ϵ��������������߷��Ƚ�10%����С����չ�ԣ���������Ϊ0.03%ʱ����С����Ϊ20%[59]������Al2O3������Ϊ���ӿ��������������SnAgCu����ǥ�ϵ�����Ӧ����Ӳ�ȣ��о��߽������������Al2O3��Ag3Sn������Ϊǿ������߲��ϵ����ܣ�������ɢǿ������[56]����Sn0.7Cuǥ������������TiO2����������������ͼ4��ʾ����ͼ4���Կ����������������ӿ��������ǥ�ϵ����������(UTS)������������Ϊ1%ʱ��UTS��߷���Ϊ33.4%������Ӧ����߷���Ϊ43%[68]��
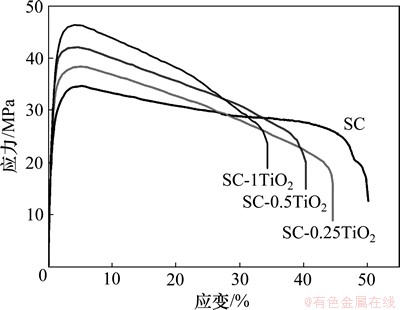
ͼ4 SnCu����ǥ����������Ӧ��-Ӧ������[68]
Fig. 4 Tensile stress-strain of SnCu solders at room temperature[68]
����SrTiO3������Ϊ��������������SnAgCu����ļ���ǿ�ȣ�����ѭ����ʱЧ�����к�������SnAgCu�����ֽϸߵĺ������ǿ�ȣ��ұ��ֽϸߵ������ȶ��ԣ��½����Ƚ�С[69]������ZrO2����������Sn3.0Ag0.5Cu��Ҳ��������������ʹ����ļ���ǿ��������ߣ��о��߽�������ڵڶ������ǿ������[70]������ZrO2������Sn9Znǥ����Ҳ���������Ƶ���ǿЧ����ͬʱ��ʹ�������ѧ��������ѭ�������б��������ȶ���[71]����Sn3.5Ag��������������SnO2����(0.5%��0.7%��1.0%)������������������ǥ�ϵ����������/����Ӧ�����������������������й�ϵ������������0.5%�����������ǥ�ϵ����������������Ӧ������������������Ϊ0.7%ʱ���ٽ����ôﵽ����ǵ���������������Ϊ1.0%ʱ��ǥ�ϵ��������Ե���Sn3.5Agǥ�ϵ�����[72]��Ϊ�˽������������о��߲��ü������ɵķ���̽����������Ӱ����ơ����⣬���о���Ǧǥ��/������ѧ����Ӱ������ϣ��о����������ڴ�Ag3Sn��Cu6Sn5������֯�ı仯̽�ֶ����ܵ�Ӱ��[73]��
������������ϸ��������֯��ͬʱ��СAg3Sn��Cu6Sn5�����ijߴ磬Ϊ�˶����о��������Ժ�����ѧ���ܵĴٽ����ƣ����Դ������������Ӧ������������������������λ����������Ӧ��[74]���Ա�ʾΪ
 (5)
(5)
���У� Ϊ���������Ӧ����nΪ����λ������
Ϊ���������Ӧ����nΪ����λ������ Ϊ�Ͻ������Ӧ��������λ����nΪ
Ϊ�Ͻ������Ӧ��������λ����nΪ
 (6)
(6)
���� ��
�� Ϊ���ɱȣ�LΪ����֮���ƽ�����롣���������Ӧ��Ϊ
Ϊ���ɱȣ�LΪ����֮���ƽ�����롣���������Ӧ��Ϊ
 (7)
(7)
���� Ϊ�ڶ�������Ķ���Ӧ����
Ϊ�ڶ�������Ķ���Ӧ���� ��bΪ��������ô�Ͻ������Ӧ��Ϊ
��bΪ��������ô�Ͻ������Ӧ��Ϊ
 (8)
(8)
���������������ӣ������е�Ag3Sn��Cu6Sn5�����ߴ��С���Ҿ��ȷֲ���ǥ�ϻ����У��������L���Լ�С������ʽ(8)��ǥ�ϵ�����Ӧ�� ���������ӣ���ˣ���������Ҳ֤����������������ʹǥ�ϵ���ѧ����������ߡ�
���������ӣ���ˣ���������Ҳ֤����������������ʹǥ�ϵ���ѧ����������ߡ�
2.4 �������
������Ǧǥ�϶��ԣ�ǥ�ϵ��ۻ��¶Ƚϵͣ�����SnAgCu���۵�Ϊ217 �棬��������ǥ�ϵĹ�һ���¶ȴﵽ0.61���ڽ��������У��涨���ϵĹ�����һ���¶ȳ���0.5������Ϊ���ϵĸ���������[75-76]���ʶ���Ǧǥ���������·����˸��������Σ�������Ҳ��������Ǧǥ�ϵ�һ����Ҫָ�ꡣ
Niranjani��[77]�о��˺�����Ni��Mo������Sn3.5Agǥ�ϵ������Ϊ������ǥ�ϵ�������ݷ���Modified-Garofalo���̣���̬������ʡ���ʼ����λ�ƺͳ�ʼ��̬��ʱ�����������Ni��Mo���������Ӷ����͡�����������Mo����Ϊ1.5%ʱ�������Կ��������о��ȷֲ�����������ͼ5��ʾ������Ag�������ӵ�Sn0.7Cuǥ�Ϻ���Ŀ���������������Եı仯������Ag������ǿ��Sn-Cu������ǥ�ϵ�����������������ߣ��Ҿ��и��ߵ���伤����[78]������Ag������λ���ж������ã��谭λ���;�����˶����Ӷ���߸���ǥ�Ͻ�ͷ���������� ��[79]��Shi��[80]ѡ����Sn37Pb��Sn0.7Cuǥ������������Ag��Cu��Al2O3��TiO2������������Ǧǥ�ϵ�����迹�õ�������ߡ�ͬʱ���������������Ӵ�������������������Ag�������ӵ�SnPbǥ���У����о���Ҳ���������ƵĹ���[81]������Ǧǥ�������ӿ���������ǿ���������ȷֲ��ڻ�����֯�У�����-Sn��Χ�ƿ����ᾧ��ʹǥ�Ͼ�������������䣬���ֽṹ�����������²��������绬�ƺͱ��Σ���ˣ������������������[82-85]��
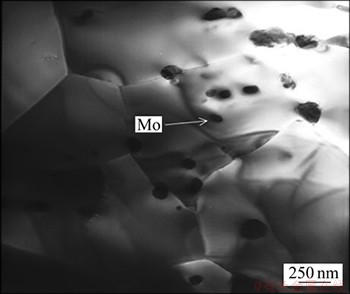
ͼ5 Sn3.5Ag1.5Mo�Ͻ�TEM��֯[77]
Fig. 5 TEM image of Sn3.5Ag1.5Mo alloy[77]
��Sn3.5Ag0.7Cu������̼���ܣ�ǥ�ϵĿ��������������ߣ�ͬʱ���ʧЧʱ����������[86]����Sn1.7Sb1.5Ag������2.3%Al2O3��������ǥ�ϵ�����������Լ�С��ǥ�ϵĿ����������������[87]����Ҫ�����ڿ����Ծ������ƺ;����߽��ƶ����谭���á���SnPbǥ������������TiO2����Ҳ�������Ƶ�Ч��[88]����Cu6Sn5�������ӵ�Sn3.5Agǥ���У�ǥ�ϵĿ�������ܵõ�������ߣ�����Cu6Sn5������ǥ�ϵ���̬�������Ϊ7.69��10-6 s-1��Ӧ������Ϊ12.34��Sn3.5Agǥ�ϵ���̬�������Ϊ8.98��10-6 s-1��Ӧ������Ϊ10.11[89]�����ṹ���л�-����������(POSS)����������Ҳ�����������Sn3.5Ag����������������SnAgCu����Ǧǥ��Ҳ�������ƵĹ��ɣ�ͬʱ��SnAgCu������ǥ�ϵ���������SnAg������ǥ�ϵ�����[90]���о�������-������Ǧǥ�ϵĿ�������ܵ�Ӱ��������⣬�о��߾��ӿ�����λ���������������߽�֮��Ĺ�ϵ���н��ͣ�ͬʱ��ǥ�����Ͽڶ���ģʽ[91]Ҳ���Է���ǥ�������λ��ơ�
�����Ǧǥ��������ܵ��о����о���̽������Ǧǥ�ϵ���䱾����ϵ����Ϊ���õ���䱾��ģ����Dornģ�ͺ�Garofalo-Arrheniusģ�͡����о���Ǧǥ���������У���۵���������Ҫ�������ѹ��2��[92-93]���۵���������Ҫ�Dz�������ѹ�۵ķ�����������(Cu6Sn5��Cu3Sn)�ı���[94-95]����Ϊ��Ǧǥ�ϵ��ۻ��¶Ƚϵͣ��ڷ����ڼ佫�������Ե������Σ�������Ҳ�Ǻ���ʧЧ����Ҫԭ��[96-97]����ˣ��������Ҳ����Ǧǥ���о��е�һ����Ҫ���棬����䱾����ϵ����ѧ���ܸ��õ��������ϵ�������ܣ��Ժ�����-������Ǧǥ�ϵ���䱾�������б�Ҫ��������̽�֡�Shi��[98]̽�ֺ�����Ag����Sn0.7Cu���������Σ��������䱾�����̣��ֽ�̽����Ӧ��-Ӧ���ϵ����ʽ(9)~(12)��ʾ��
������Ag����SnCu���㱾�����̣�
 (��Ӧ��) (9)
(��Ӧ��) (9)
 (��Ӧ��) (10)
(��Ӧ��) (10)
SnCu���㱾�����̣�
 (��Ӧ��) (11)
(��Ӧ��) (11)
 (��Ӧ��) (12)
(��Ӧ��) (12)
���� ��
�� ΪӦ�����ʣ�RΪ���峣����TΪ����ѧ�¶ȣ�
ΪӦ�����ʣ�RΪ���峣����TΪ����ѧ�¶ȣ� Ϊʩ�ӵļ�������
Ϊʩ�ӵļ�������
Dornģ��[99]��ʽ(13)��ʾ����ģ������ѧ��ֱ�۵���������Ǧǥ������̬���εı�����ϵ������SnAgCu��SnCu��SnAg��ϵ��ǥ���д������о��ɹ������ں���ɿ����о����Ѿ�Ӧ��������Ԫģ�⡣���ǻ��ں�����-��������ǥ�ϵijɹ���ȱ����ر�����
 (13)
(13)
���У� Ϊ���ϵ�������ʣ�AΪ���ϳ�����
Ϊ���ϵ�������ʣ�AΪ���ϳ����� Ϊʩ�ӵ�Ӧ����QΪ��伤���ܡ�
Ϊʩ�ӵ�Ӧ����QΪ��伤���ܡ�
Garofalo-Arrheniusģ��[100-101]Ҳ��ĿǰӦ�ý�Ϊ�㷺����䱾����ϵ֮һ��
 (14)
(14)
���У�C1��C2��C3��C4Ϊ���ϵ�4��������
�о���ģ����Ҫ�Dz��õ������������Եķ� ��[102]������о��߲��ø�ģ�ͻ�������Ԫģ����������������[103-104]�����ں�����-��������ǥ���Լ�����ɿ��������б�����
3 ����ǿ����Ǧ����ɿ���
�ڴ��ģ�ļ��ɵ�·�к������������ǧ�ƣ������ڵ�·�мȳе��ŵ������ӣ��ֳе��Ż�е֧�ŵ�����[105]�����ں���ߴ��С�������ϴ���ʵ�ʵĵ��Ӳ�Ʒ�У���������Ŀɿ���ֱ�Ӿ������������Ӳ�Ʒ���������豸�Ŀɿ���[106-107]��Ӱ�캸��ɿ��Ե����ؽ϶࣬�������չ�ҵ����ͳ�Ʒ��ֵ�������ʧЧԭ��55%�������¶ȱ仯����ģ�20%��������ģ�19%�dz�����������ģ�����6%�ǻҳ���ԭ��[108]����ˣ��ں���ɿ����о��У������о����������о��������¶��غ������µĿɿ��ԣ��ر�����ѭ����ʱЧ[109-112]��
��Ժ�����-������Ǧ����ɿ��Ե��о��ɹ����١����о���̽���˺�����Ag����Sn0.7Cu��������ѭ�������н����������Ϊ�����ֺ�������������������仯�����������������С��Sn0.7Cu������������ʣ�������Ag����������ֳ���С�Ľ�����ɢϵ��[113]��Sivasubramaniam��[114]�ڶ�ʱ��ʱЧ(150 ��)�������о���Sn4.0Ag0.5Cu����Cu����(3~20 ��m)������Cu2O(~150 nm)�Ľ��淴Ӧ���������ӿ�������������С���������仯����������ٶȣ���ʱЧ�����к��������㱣�ֽϸߵ�ǿ�ȡ����ڽ��洦�����仯������Ϊ�����࣬�ڷ����ڼ����ڽ����Ŀ����������Լ�������ϵ����ʧ�䵼�º����ڸ������������ƣ�������չ���º����ʧ Ч[115-117]��
������-����Ǧ����ɿ����о��л�������������ݵ��о������ڿհΣ����纸��ĵ���Ǩ�ƣ����ڵ�������һֱ�ڵ����������¹����������ڲ��ĵ�Ǩ���Ե���Ϊ��Ҫ[118]������-���������ӶԺ������Ǩ���Ƿ���Ӱ��Ŀǰ��û����صı�����ͬʱ���ں�����-��������ɿ����еĵ��䡢�������о�Ҳ����δ֪״̬������Щ����Ҳֱ�ӹ�ϵ����ϵ��������Ǧǥ���ܷ��ڵ��ӹ�ҵ�л���ƹ��Ӧ�á�����Ԫģ����Ը��������ٵؽ��к���ɿ��Ե��о�[119]���ò����о�������û������о����������ԣ���Ҳ��Ҫ����Ϊ������Ǧǥ�ϵ�����ȱ���������и������̽�ֺ��о���һ������ǥ�ϵ�Ӧ�ú��ƹ��������Ǧǥ�ϵ����ܺͺ���ɿ��Է����г��㡢ϵͳ�����ݻ���֮�ϡ���ˣ�����Ժ�����-������Ǧ����Ŀɿ��Խ��д����о���
4 ������ǿ��Ǧǥ���о��������ڵ�����
Ŀǰ����-������ǿ����ǥ�ϳ�Ϊ�о����о���һ����Ҫ�ȵ㡣����������ص����ġ�ר���϶࣬��̽�ֿ��������Ӷ�ǥ�����ܵĸ��ơ������о��ɹ��Ϸḻ�����Ǿ����ڵ��ӹ�ҵ��ʹ�ú��ƹ�Ŀ�����ǿ����ǥ�ϰ�������û�С�����Ҫ����Ϊ��ϵ��������Ǧǥ�ϻ�ȱ��ϵ�е�����֤��������ԡ���ͳ����Ǧǥ����Ϊ��������õ����ܶ������ӹ�ҵ���Ϊʹ�ã���ʹ���ڽ������ǶԻ�������Ҫ�ߵ�����£���Ʒ�Ѿ�ʹ������Ǧǥ�ϣ�����Ʒȴ�õ��˻���Ȩ[120]����Ȼ���ʹ�ô�ͳ��SnPbǥ�ϣ���Ҫ��ҵ���Ѿ�������ǥ�ϵ����ܽ��˽⣬���ܹ�Ԥ֪��ǥ���ڷ����ڼ�Ŀɿ��ԡ��෴��������-��������ǥ�ϵ��о��ɹ��ϵ�һ���������о������һ��ǥ�ϵ�ijһ�����������������ܽ������о���ȱ������һ��ǥ�ϵ�������ʶ��
��Ժ�����-��������ǥ�ϵ��о������������ۺϷ������ָ�ϵ��ǥ�ϴ�������5���������һ���о���
1) ǥ�ϵ��Ʊ�����������Ŀǰ���о��ɹ����֣��ֵ��о��߲��ú����Ͽ����Ʊ�������-����ǥ�ϣ������Ʊ�������һ���̶��Ͽ���ʹ��������ں����У����Ǻ��ѱ�֤�����ľ����Ժͺ��ӹ�����ǥ���п���������ر��������������žۣ�һ��Ľ��蹤�ն���ʹ���������ȷֲ���ǥ�ϵĻ��壬���������ž�[121]�ᵼ�º��ں������ѧ���ܵ��½��Ϳɿ��Խ��ͣ�ֱ��ʹ�о�������Ŀ�������档�����������Ĺ����У�����ǥ�ϱ�������ʹ������������ر��������������������Ϊ�������������ǥ�ϻ��巢����Ӧ�����������ͣ����ǥ�ϱ��棬������һ���̶���������ǥ�ϵ���ʪ���Ӷ���ǥ�ϵ����ܡ�
2) ƥ��ǥ�����о���������-����ǥ���ۻ��¶Ⱥ���ʪ����һ��仯��������-��������������Ĵٽ����ò��Ǻ��������ں�����ѧ���ܷ�������ͻ�����ۻ��¶Ⱥ���ʪ��ȴ������ǥ�ϵ����������գ���ˣ�������-�����ĸ���ǥ�Ϲ���������Խϲ��ѡ����ʵ�ǥ����������ֲ���ϵ��ǥ�ϵ�ȱ�ݣ����о��߷������ֽ���SnZnǥ��ѡ����ʵ�ǥ��������ʪ�Կ������116.1%[122]����ˣ����Դ��о�ǥ���ĽǶ�����ߺ�����-��������ǥ�ϵĹ������ܡ�
3) ����Ŀɿ��ԡ�Ŀǰ��������ǥ�ϵ��о��ɹ��϶࣬���ÿһ������ǥ�ϵĿɿ����о��ɹ�����Խ��٣�ǡǡ����ɿ��Բ�����ʵ��ӳǥ����ʹ�ù����е���ʵ���������һ������ǥ���ڷ����ڼ���������ϵ�еIJ����Բ��ԣ���������̽�ֲſ����ڹ�ҵ���ƹ�Ӧ�á��ڿɿ����о��лͬ�̶ȵس���һЩ�����⡱״�������纬ϡ����Ǧǥ������о����Ѿ��ڹ������ܡ���ѧ���ܵȷ���ȡ����ϵ�гɹ��������ڿɿ����о��г����ˡ����롱����[123-124]��ֱ�ӵ��º�ϡ����Ǧǥ���ƹ����衣��ˣ���������Ǧǥ���ƹ�Ӧ��֮ǰ��������к�����ѭ����ʱЧ�����䡢��ʪ�����ҳ���[125-130]ϵ�в��ԣ�ֻ�б�֤����ɿ��Բ����к�����нϸߵĿɿ��ԣ��ſ��Խ�������ǥ���ڵ��ӹ�ҵ���ƹ�ʹ�á�
4) ǥ�ϵı������̺�ƣ������Ԥ�ⷽ�̡�ǥ�ϵı���������Ҫ��ͨ��ʵ���о����Բ���Ӧ��-Ӧ��֮��Ĺ�ϵ��Ŀǰ��Ϊ���õ���Anand����Ա���ģ�͡�Garofalo-Arrhenius���ģ�͡�Dorn���ģ�͵�[131-136]��ͨ���������̵��о����Դ���ѧ�ϸ��õ���ʶ����ǥ�ϵ����ܣ��Ӷ���������ǥ�ϵ��������ݡ����⣬����ƣ������Ԥ��ģ��Ҳ����Ҫ�о���һ����Ҫ���棬��������Ԫģ��Ľ�����Խ������Ԥ�ⷽ�̿��ٵؼ��㺸���ʹ��������Ŀǰ������Ԥ��ģ����Ҫ�ǻ�������Ӧ�䡢��һ��䡢�ۺ����Ժ���䡢��������Ӧ�����ܶȵ�[137-142]��Ŀǰ��û��ר����Ժ�����-������Ǧ����ƣ������ģ�͵�����о��ɹ�����������Ԥ����о�����Ϊ����ɿ����о��ṩ���� ֧�š�
5) ��ϵ��������������о���������������-����ǥ�ϵ��о��ɹ�������Ϊģ�������Ͼ���ĵ��������ɹ����١���Ǧǥ�ϵ��о����ն�Ҫ�ڵ��ӹ�ҵ��ʹ�ã���ô��Ҫ��ϵ��������������������գ�����QFP��BGA��WLCSP������[143-146]������Բ�ͬ�ĵ�������������ijߴ��Ӻ���������������[147]�������ڷ������Եijߴ�ЧӦ[148]��ͬʱ��ͬ��̬�����Ӧ���������Ҳ����ͬ[149-150]����ˣ���ʵ�ʵ��о��У�������-��������ǥ�Ͻ�Ͼ���ĵ������������о�������ʵ�����塣
5 ����
���ŵ��ӹ�ҵ�Ŀ��ٷ�չ����Ǧǥ�ϵ��о���Ϊ���ӹ�ҵ��һ����Ҫ���о��ȵ㡣Ŀǰ��Ժ�����-��������ǥ��Ҳ��Ϊ����о��������Ķ�����Ը�ϵ��ǥ�ϵ��о��������Ѿ����зḻ���о��ɹ���ϵ�е��о��ɹ���Ҫ���������-��������Ǧǥ�����ܺ�����֯��Ӱ�죬�����������ǥ�ϵ���ѧ���ܡ�������������Ը������ã�ͬʱ��ǥ���ڲ���֯��ϸ�����á��Ժ�������������������á�����Ҫ�����ǥ�ϵ����ܺͺ���IJ������ܽ����о���ȱ��ϵͳ���о��ɹ���ͬʱ��ͨ������-�������ǥ�ϵ����ܾ������Եľ����ԣ�����ͨ����һ��������ǥ�ϵ����ܿ����Խ�С�����ǿ������ǥ���ȴ�ʩ��һ�����������ܡ���������ǥ�ϵ��о�Ӧ�ý�һ����ǥ�ϵ��Ʊ������ӹ��ա��ɿ��Եȷ���������о����Ӷ�Ϊ������-��������ǥ�ϵ��ƹ��Ӧ���ṩ��ʵ�����ϡ�
�ο����ף�
[1] Chiang H W, Chen J Y, Chen M C, et al. Reliability testing of WLCSP lead-free solder joints[J]. Journal of Electronic Materials, 2006, 35(5): 1032-1040.
[2] ����, Ѧ�ɰ�, ����ѧ, ��. Sn-9Zn-xCeǥ����֯��ǥ�����ܵķ���[J]. ����ѧ��, 2010, 31(6): 77-80.
HU Yuhua, XUE Songbai, CHEN Wenxue, et al. Microstructure and solderability of Sn-9Zn-xCe lead-free solder[J]. Transactions of the China Welding Institution, 2010, 31(6): 77-80.
[3] ����, ���̹�, ������, ��. ������������SnAgCuǥ����֯������[J]. ����ѧ��, 2013, 34(6): 65-68.
ZHANG Liang, HAN Jiguang, GUO Yonghuan, et al. Microstructure and properties of SnAgCu solders bearing Al nano-particles[J]. Transactions of the China Welding Institution, 2013, 34(6): 65-68.
[4] Zhang L, Xue S B, Chen Y, et al. Effects of cerium on Sn-Ag-Cu alloys based on finite element simulation and experiments[J]. Journal of Rare Earths, 2009, 27(1): 138-144.
[5] Su Y A, Tan L B, Tee T Y, et al. Rate-dependent properties of Sn-Ag-Cu based lead-free solder joints for WLCSP[J]. Microelectronics Reliability, 2010, 50(4): 564-579.
[6] Wang Y W, Lin Y W, Kao C R. Inhibiting the formation of microvoids in Cu3Sn by additions of Cu to solders[J]. Journal of Alloys and Compounds, 2010, 493(1/2): 233-239.
[7] Li G D, Shi Y W, Hao H, et al. Effects of phosphorus element on the comprehensive properties of Sn-Cu lead-free solder[J]. Journal of Alloys and Compounds, 2010, 491(1/2): 382-385.
[8] Xu R L, Liu Y C, Wei C, et al. Effects of Zn additions on the structure of the soldered Sn-3.5Ag and Cu interfaces[J]. Soldering & Surface Mount Technology, 2010, 22(2): 13-20.
[9] Garcia L R, Os��rio W R, Garcia A. The effect of cooling rate on the dendritic spacing and morphology of Ag3Sn intermetallic particles of a SnAg solder alloy[J]. Materials & Design, 2011, 32(5): 3008-3012.
[10] Zhang L, Xue S B, Gao L L, et al. Development of Sn-Zn lead-free solders bearing alloying elements[J]. Journal of Materials Science: Materials in Electronics, 2011, 21(1): 1-15.
[11] Hu J, Hu A M, Mao D L. Depressing effect of 0.1wt.% Cr addition into Sn-9Zn solder alloy on the intermetallic growth with Cu substrate during isothermal aging[J]. Materials Characterization, 2010, 61(3): 355-361.
[12] Song J M, Huang C F, Chuang H Y. Microstructural characteristics and vibration fracture properties of Sn-Ag-Cu-TM (TM=Co, Ni and Zn) alloys[J]. Journal of Electronic Materials, 2006, 35(12): 2154-2163.
[13] Zhang L, Xue S B, Gao L L, et al. Effects of trace amount addition of rare earth on properties and microstructure of Sn-Ag-Cu alloys[J]. Journal of Materials Science: Materials in Electronics, 2010, 20(12): 1193-1199.
[14] ����. �Ͻ�Sn-9Zn��Ǧǥ������Ӱ�켰��ʪ�����о�[D]. �Ͼ�: �Ͼ����պ����ѧ���Ͽ�ѧ�뼼��ѧԺ, 2010: 1-112.
WANG Hui. Study on solderability and wetting mechanisms of micro-alloyed Sn-9Zn lead-free solder[D]. Nanjing: Nanjing University of Aeronautics and Astronautics. College of Materials Science and Technology, 2010: 1-112.
[15] Chen W X, Xue S B, Wang H. Wetting properties and interfacial microstructures of Sn-Zn-xGa solders on Cu substrate[J]. Materials & Design, 2010, 31(4): 2196-2200.
[16] ����ѧ. Ag��Ga��Al��Ce��Sn-9Zn��Ǧǥ�����ܵ�Ӱ��[D]. �Ͼ�: �Ͼ����պ����ѧ���Ͽ�ѧ�뼼��ѧԺ, 2010: 1-60.
CHEN Wen-xue. Effects of Ag, Ga, Al and Ce on the properties of Sn-9Zn lead-free solder[D]. Nanjing: Nanjing University of Aeronautics and Astronautics. College of Materials Science and Technology, 2010: 1-60.
[17] Wang J X, Xue S B, Han Z J, et al. Effects of rare earth Ce on microstructures, solderability of Sn-Ag-Cu and Sn-Cu-Ni solders as well as mechanical properties of soldered joints[J]. Journal of Alloys and Compounds, 2009, 467(1/2): 219-226.
[18] Ye H, Xue S B, Zhang L, et al. Sn whisker growth in Sn-9Zn-0.5Ga-0.7Pr lead-free solder[J]. Journal of Alloys and Compounds, 2011, 509(5): 52-55.
[19] Chuang T H. Rapid whisker growth on the surface of Sn-3Ag-0.5Cu-1.0Ce solder joints[J]. Scripta Materialia, 2006, 55(11): 983-986.
[20] Shi Y W, Yan Y F, Liu J P, et al. Constitutive modeling on creep deformation for a SnPb-based composite solder reinforced with microsized Cu particles[J]. Microelectronics Reliability, 2010, 50(12): 2020-2025.
[21] ���ڽ�. ������װԪ�����뵼�弤����Ǧ��ǥ�������о�[D]. �Ͼ�: �Ͼ����պ����ѧ���Ͽ�ѧ�뼼��ѧԺ, 2009: 1-98.
HAN Zongjie. Diode laser soldering to electronic mounting components/devices with lead-free solder[D]. Nanjing: Nanjing University of Aeronautics and Astronautics. College of Materials Science and Technology, 2009: 1-98.
[22] Lee H T, Lee Y H. Adhesive strength and tensile fracture of Ni particle enhanced Sn-Ag composite solder joints[J]. Materials Science and Engineering A, 2006, 419(1/2): 172-180.
[23] Yao P, Liu P, Liu J. Interfacial reaction and shear strength of SnAgCu-xNi/Ni solder joints during aging at 150 ��[J]. Microelectronic Engineering, 2009, 86(10): 1969-1974.
[24] Gain A K, Fouzder T, Chan Y C, et al. The influence of addition of Al nano-particles on the microstructure and shear strength of eutectic Sn-Ag-Cu solder and Au/Ni metalized Cu pads[J]. Journal of Alloys and Compounds, 2010, 506(1): 216-223.
[25] Gain A K, Chan Y C, Sharif A, et al. Interfacial microstructure and shear strength of Ag nano particle doped Sn-9Zn solder in ball array packages[J]. Microelectronics Reliability, 2009, 49(7): 746-753.
[26] Lin D C, Srivatsan T S, Wang G X, et al. Microstructural development in a rapidly cooled eutectic Sn-3.5%Ag solder reinforced with copper powder[J]. Powder Technology, 2006, 166(1): 38-46.
[27] ��ƽ. ������ǿSn3.8Ag0.7Cu������Ǧ���ϵ��о�[D]. ���: ����ѧ���Ͽ�ѧ�빤��ѧԺ, 2009: 1-107.
LIU Ping. Study on particles reinforced Sn3.8Ag0.7Cu composite lead free solders[D]. Tianjin: Tianjin University. School of Materials Science and Engineering, 2009: 1-107.
[28] ����Ӣ, �ڴ�ȫ, ������, ��. Y2O3��ǿSn-3Ag-0.5Cu������Ǧǥ��[J]. ���ӹ��ռ���, 2004, 25(4): 156-158, 161.
LIU Xiaoying, YU Daquan, MA Haitao, et al. Effects of Y2O3 on Sn-3Ag-0.5Cu alloy and joint[J]. Electronics Process Technology, 2004, 25(4): 156-158, 161.
[29] ����Ӣ, ������, ����. ��ϸ�����������Sn-58Biǥ����֯������Ӱ��[J]. ����������ѧѧ��, 2008, 48(1): 51-57.
LIU Xiaoying, MA Haitao, WANG Lai, et al. Effect of super-fine oxide powders on mechanical properties and microstructures of Sn-58Bi[J]. Journal of Dalian University of Technology, 2008, 48(1): 51-57.
[30] ����, Tu K N, ������, ��. ʱЧ��SnAgCu/SnAgCu-TiO2�������������Ӱ��[J]. ����ѧ��, 2013, 34(8): 43-46.
ZHANG Liang, Tu K N, GUO Yonghuan, et al. Effect of aging on the interface and properties of SnAgCu/SnAgCu-TiO2 solder joints[J]. Transactions of the China Welding Institution, 2013, 34(8): 43-46.
[31] Lee J S, Chu K M, Patzelt R, et al. Effects of Co addition in eutectic Sn-3.5Ag solder on shear strength and microstructural development[J]. Microelectronic Engineering, 2008, 85(7): 1577-1583.
[32] Haseeb A S M A, Leng T S. Effects of Co nanoparticle addition to Sn-3.8Ag-0.7Cu solder on interfacial structure after reflow and ageing[J]. Intermetallics, 2011, 19(5): 707-712.
[33] Arafat M M, Haseeb A S M A, Fohan M R. Interfacial reaction and dissolution behavior of Cu substrate in molten Sn-3.8Ag-0.7Cu in the presence of Mo nanoparticles[J]. Soldering & Surface Mount Technology, 2011, 23(3): 140-149.
[34] ������, ����, ֣�վ�, ��. Ni������ǿ��Ǧ����ǥ����IMC��ֵ̬�ݱ�[J]. ����Ԫ�������, 2007, 26(9): 43-46.
NIE Jingkai, GUO Fu, ZHENG Hnajing, et al. Morphology evolution of intermetallic compounds in nickel particle reinforced lead-free composite solder[J]. Electronic Components and Materials, 2007, 26(9): 43-46.
[35] ����ǿ, ����, ����ǿ. Cu������ǿ��Sn-9Zn����ǥ��/Cuǥ����ͷ���淴Ӧ[J]. ����ѧ��, 2007, 28(5): 105-108.
WEI Guoqiang, KUANG Min, YANG Yongqiang. Interfacial reaction of Sn-9Zn/Cu joint with Cu particle-reinforced composite solder Sn-9Zn[J]. Transactions of the China Welding Institution, 2007, 28(5): 105-108.
[36] Amagai M. A study of nanoparticles in Sn-Ag based lead free solders[J]. Microelectronics Reliability, 2008, 48(1): 1-16.
[37] Das S K, Sharif A, Chan Y C, et al. Effect of Ag micro-particles content on the mechan ical strength of the interface formed between Sn-Zn binary solder and Au/Ni/Cu bond pads[J]. Microelectronic Engineering, 2009, 86(10): 2086-2093.
[38] Gain A K, Chan Y C. The influence of a small amount of Al and Ni nano-particles on the microstructure, kinetics and hardness of Sn-Ag-Cu solder on OSP-Cu pads[J]. Intermetallics, 2012, 29: 48-55.
[39] Zhang L, Xue S B, Gao L L, et al. Microstructure characterization of SnAgCu solder bearing Ce for electronic packaging[J]. Microelectronic Engineering, 2011, 88(9): 2848-2851.
[40] Han Y D, Jing H Y, Nai S M L, et al. Interfacial reaction and shear strength of Ni-coated carbon nanotubes reinforced Sn-Ag-Cu solder joints during thermal cycling[J]. Intermetallics, 2012, 31: 72-78.
[41] Nai S M L, Wei J, Gupta M. Interfacial intermetallic growth and shear strength of lead-free composite solder joints[J]. Journal of Alloys and Compounds, 2009, 473(1/2): 100-106.
[42] Tang Y, Li G Y, Pan Y C. Influence of TiO2 nanoparticles on IMC growth in Sn-3.0Ag-0.5Cu-xTiO2 solder joints in reflow process[J]. Journal of Alloys and Compounds, 2013, 554(25): 195-203.
[43] Mohd S M A A, Bakri A M M A, Kamarudin H, et al. Solderability of Sn-0.7Cu/Si3N4 lead-free composite solder on Cu-substrate[J]. Physics Procedia, 2011, 22: 299-304.
[44] Zhang L, Xue S B, Zeng G, et al. Interface reaction between SnAgCu/SnAgCuCe solders and Cu substrate subjected to thermal cycling and isothermal aging[J]. Journal of Alloys and Compounds, 2012, 510(1): 38-45.
[45] ����, ۢ��, ����, ��. ���ṹǿ��������Sn-Ag����Ǧ����ǥ��[J]. ���Ϲ���, 2009(8): 38-48.
LIU Bin, TAI Feng, GUO Fu, et al. Research of new Sn-Ag based lead-free composite solders containing nano-structured reinforcements[J]. Journal of Materials Engineering, 2009(8): 38-48.
[46] Fouzder T, Gain A K, Chan Y C, et al. Effect of nano Al2O3 additions on the microstructure, hardness and shear strength of eutectic Sn-9Zn solder on Au/Ni metalized Cu pads[J]. Microelectronics Reliability, 2010, 50(12): 2051-2058.
[47] ����Ӣ, ������, ���ұ�, ��. Fe�۶�Sn-3Ag-0.5Cu����ǥ����֯�����ܵ�Ӱ��[J]. �й���ɫ����ѧ��, 2012, 22(4): 1169-1176.
LIU Xiaoying, MA Haitao, LUO Zhongbin, et al. Effect of Fe particles on microstructures and properties of Sn-3Ag-0.5Cu lead-free solder[J]. The Chinese Journal of Nonferrous Metals, 2012, 22(4): 1169-1176.
[48] Gao L L, Xue S B, Zhang L, et al. Effect of alloying elements on properties and microstructures of SnAgCu solders[J]. Microelectronic Engineering, 2010, 87(11): 2025-2034.
[49] ����. ��̼���ܵ�Sn-58Bi��Ǧǥ�ϵ��Ʊ����������о�[D]. ������: ��������ҵ��ѧ���Ͽ�ѧ�빤��ѧԺ, 2010: 1-38.
AN Jing. Investigation on the preparation method and properties of Sn-58Bi lead-free solder with carbon nanotubes[D]. Harbin: Harbin Institute of Technology. School of Materials Science and Engineering, 2010: 1-38.
[50] ����. Ӧ�����׳ߴ�ЧӦ����Sn����Ǧ�����ۻ��¶ȵĻ����о�[D]. �Ϻ�: �Ϻ���ѧ���Ͽ�ѧ�빤��ѧԺ, 2010: 1-122.
ZOU Changdong. Fundamental research on the melting temperature depression of the Sn-based lead-free solder alloy via size effect of nanoparticles[D]. Shanghai: Shanghai University. School of Materials Science and Engineering, 2010: 1-122.
[51] Zhang L, Han J G, Guo Y H, et al. Microstructures and properties of SnZn lead-free solder joints bearing La for electronic packaging[J]. IEEE Transactions on Electron Devices, 2012, 59(12): 3269-3272.
[52] ����, ���̹�, �γ���, ��. ϡ��Ԫ�ض���Ǧǥ����֯�����ܵ�Ӱ��[J]. �й���ɫ����ѧ��, 2012, 22(6): 1680-1696.
ZHANG Liang, HAN Jiguang, HE Chengwen, et al. Effect of rare earth on microstructures and properties of lead-free solders[J]. The Chinese Journal of Nonferrous Metals, 2012, 22(6): 1680-1696.
[53] ���ij�, �ʹ���, ����, ��. ����Ni������Sn0.65Cu�ǹ���ǥ����ʪ�ԺͿ������Ե�Ӱ��[J]. ���ܳ�����, 2013, 5(1): 16-19.
HUANG Wenchao, GAN Guisheng, TANG Ming, et al. The effect of nano-Ni particles on the wettability and oxidation resistance of Sn0.65Cu hypoeutectic solder[J]. Journal of Netshape Forming Engineering, 2013, 5(1): 16-19.
[54] ����. �����������ĸ�����Ǧǥ�ϼ������ӽ�ͷ�����о�[D]. ʯ��ׯ: ʯ��ׯ����ѧԺ���Ͽ�ѧ�빤��ѧԺ, 2008: 1-69.
SUN Li. Researches on properties of nanoparticles composite lead-free solders and its micro-joined joint[D]. Shijiazhuang: Shijiazhuang Railway Institute. School of Materials Science and Engineering, 2008: 1-69.
[55] Bukat K, Koscielski M, Sitek J, et al. Silver nanoparticles effect on the wettability of Sn-Ag-Cu solder pastes and solder joints microstructure and copper[J]. Soldering & Surface Mount Technology, 2011, 23(3): 150-160.
[56] Tsao L C, Chang S Y, Lee C I, et al. Effects of nano-Al2O3 additions on microstructure development and hardness of Sn3.5Ag0.5Cu solder[J]. Materials and Design, 2010, 31(10): 4831-4835.
[57] Nai S M L, Wei J, Gupta M. Influence of ceramic reinforcements on the wettability and mechanical properties of novel lead-free solder composites[J]. Thin Solid Films, 2006, 504(1/2): 401-404.
[58] ������. NiͿ��̼������ǿSn-Ag-Cu��Ǧǥ�ϵĿɿ����о�[D]. ���: ����ѧ���Ͽ�ѧ�빤��ѧԺ, 2009: 1-108.
HAN Yongdian. Reliability study on a Sn-Ag-Cu lead-free solder reinforced with Ni coated carbon nanotubes[D]. Tianjin: Tianjin University. School of Materials Science and Engineering, 2009: 1-108.
[59] Liu X D, Han Y D, Jing H Y, et al. Effects of graphene nanosheets reinforcement on the performance of Sn-Ag-Cu lead-free solder[J]. Materials Science & Engineering A, 2013, 562(1): 25-32.
[60] ����ѧ. �ṹͭ��������ǦSnAgCu������ʪ����ò�о�[D]. ����: ������ͨ��ѧ���Ͽ�ѧ�빤��ѧԺ, 2006: 1-52.
WANG Fuxue. Morphology of lead-free SnAgCu solder wetting on Cu with artifical non-wetting zone[D]. Dalian: Dalian Jiaotong University. School of Materials Science and Engineering, 2006: 1-52.
[61] ������. ��Ǧǥ��������·��ǰ��[J]. ����, 2007(2): 6-10.
ZHANG Qiyun. A puzzle in lead free soldering, its outlet and application prospect[J]. Welding & Joining, 2007(2): 6-10.
[62] ����, Ѧ�ɰ�, ����ѧ, ��. ��ͬǥ����Sn-Znϵ��Ǧǥ����ʪ���Ե�Ӱ��[J]. ����ѧ��, 2009, 30(1): 5-8.
WANG Hui, XUE Songbai, CHEN Wenxue, et al. Effect of Ag, Al, Ga addition on wettability of Sn-9Zn lead-free solder[J]. Transactions of the China Welding Institution, 2007, 28(8): 33-36.
[63] Zhang L, Han J G, He C W, et al. Effect of Zn on properties and microstructure of SnAgCu alloy[J]. Journal of Materials Science: Materials in Electronics, 2012, 23(11): 1950-1956.
[64] Liu D S, Hsu C L, Kuo C Y, et al. A novel high speed impact testing method for evaluating the low temperature effects of eutectic and lead-free solder joints[J]. Soldering & Surface Mount Technology, 2012, 24(1): 22-29.
[65] Rao B S S C, Kumar K M, Kripesh V, et al. Tensile deformation behavior of nano-sized Mo particles reinforced SnAgCu solders[J]. Materials Science and Engineering A, 2011, 528(12): 4166-4172.
[66] ����, ۢ��, ����, ��. ���ṹǿ����Ǧ�������ѧ����[J]. ���ϲ���ѧ��, 2009, 26(2): 11-17.
LIU Bin, TAI Feng, GUO Feng, et al. Mechanical properties of lead-free solder joint containing nano-structured reinforcements[J]. Acta Materiae Compositae Sinica, 2009, 26(2): 11-17.
[67] Nai S M L, Wei J, Gupta M. Lead-free solder reinforced with multiwalled carbon nanotubes[J]. Journal of Electronic Materials, 2006, 35(7): 1518-1522.
[68] Tsao L C, Huang C H, Chung C H, et al. Influence of TiO2 nanoparticles addition on the microstructural and mechanical properties of Sn0.7Cu nano-composite solder[J]. Materials Science and Engineering A, 2012, 545: 194-200.
[69] Fouzder T, Shafiq I, Chan Y C, et al. Influence of SrTiO3 nano-particles on the microstructure and shear strength of Sn-Ag-Cu solder on Au/Ni metalized Cu pads[J]. Journal of Alloys and Compounds, 2011, 509(5): 1885-1892.
[70] Gain A K, Chan Y C, Yung W K C. Effect of additions of ZrO2 nano-particles on the microstructure and shear strength of Sn-Ag-Cu solder on Au/Ni metalized Cu pads[J]. Microelectronics Reliability, 2011, 51(12): 2306-2313.
[71] Shen J, Chan Y C. Effects of ZrO2 nanoparticles on the mechanical properties of Sn-Zn solder joints on Au/Ni/Cu pads[J]. Journal of Alloys and Compounds, 2009, 477(1/2): 552-559.
[72] Babaghorbani P, Nai S M L, Gupta M. Development of lead-free Sn-3.5Ag/SnO2 nanocomposite solders[J]. Journal of Materials Science: Materials in Electronics, 2009, 20(6): 571-576.
[73] ����, ���̹�, ������, ��. SnAgCu/SnAgCuCe���������֯������[J]. ��е����ѧ��, 2012, 48(8): 67-73.
ZHANG Liang, HAN Jiguang, GUO Yonghuan, et al. Microstructures and property of SnAgCu/SnAgCuCe solder joints[J]. Journal of Mechanical Engineering, 2012, 48(8): 67-73.
[74] Dieter G E. Mechanical metallurgy[M]. New York: McGraw-Hill Book Company, 1988: 145-240.
[75] ʱ����, ����. ������ѧ����[M]. ����: ������ѧ������, 2010: 218-238.
SHI Haifang, REN Xin. Mechanical properties of materials[M]. Beijing: Peking University Press, 2010: 218-238.
[76] ������. ϡ��Pr��Nd��SnAgCu��Ǧǥ����֯������Ӱ���о�[D]. �Ͼ�: �Ͼ����պ����ѧ���Ͽ�ѧ�뼼��ѧԺ, 2012: 43-52.
GAO Lili. Effect of Pr and/or Nd on the microstructures and properties of SnAgCu solder[D]. Nanjing: Nanjing University of Aeronautics and Astronautics. College of Materials Science and Technology, 2012: 43-52.
[77] Niranjani V L, Rao B S S C, Sarkar R, et al. The influence of addition of nanosized molybdenum and nickel particles on creep behavior of Sn-Ag lead free solder alloy[J]. Journal of Alloys and Compounds, 2012, 542(12): 136-141.
[78] ۢ��, ����, ���, ��. ����Ag������ǿ����ǥ��������ܵ��о�[J]. ϡ�н��������빤��, 2010, 39(6): 1005-1008.
TAI Feng, GUO Fu, SHEN Hao, et al. Creep properties of Ag nanoparticle reinforced Sn-Cu composite solders[J]. Rare Metal Materials and Engineering, 2010, 39(6): 1005-1008.
[79] Shi Y W, Liu J P, Yan Y F, et al. Creep properties of composite solders reinforced with nano- and microsized particles[J]. Journal of Electronic Materials, 2008, 37(4): 507-514.
[80] Shi Y W, Liu J P, Xia Z D, et al. Creep property of composite solders reinforced by nano-sized particles[J]. Journal of Materials Science: Materials in Electronics, 2008, 19(4): 349-356.
[81] Liu J P, Guo F, Yan Y F, et al. Development of creep-resistant, nanosized Ag particle-reinforced Sn-Pb composite solders[J]. Journal of Electronic Materials, 2004, 33(9): 958-963.
[82] �ų���, ����, �ʹ���, ��. ����������ǥ�ϵ��о���չ[J]. ����������ѧѧ��(��Ȼ��ѧ), 2012, 26(6): 36-41, 49.
DU Changhua, WANG Tao, GAN Guisheng, et al. Research progress on nano-composite solders[J]. Journal of Chongqing University of Technology (Natural Science), 2012, 26(6): 36-41, 49.
[83] ����, �̶���, ����ƽ, ��. Ag������ǿSn-58Bi��Ǧǥ����ѧ�����о�[J]. �ִ�����, 2011(10): 49-51.
WANG Tao, CHONG Donghai, CHEN Yiping, et al. Study on the mechanical properties of Ag particle reinforced Sn-58Bi lead-free solder[J]. Modern Welding Technology, 2011(10): 49-51.
[84] ����. ϡ���������ͭ��Ǧǥ����֯���ܵ�Ӱ��[D]. ������: ��е��ѧ�о���Ժ, 2006: 1-63.
CHEN Yan. Effect of cerium on property and microstructure for SnAgCu lead free solder[D]. Harbin: China Academy of Machinery Science and Technology, 2006: 1-63.
[85] ���Ľ�, ������. ������Ǧ���Ӻ��ϵ��о���չ�뷢չ����[J]. �������ܲ���, 2009, 16(2): 55-59.
MIN Wenjin, XUAN Tianpeng. Research progress and development tendency of tin-based lead-free electronic solder[J]. Metallic Functional Materials, 2009, 16(2): 55-59.
[86] Nai S M L, Wei J, Gupta M. Using carbon nanotubes to enhance creep performance of lead free solder[J]. Materials Science and Technology, 2008, 24(4): 443-448.
[87] Kangooie M, Mahmudi R, Geranmayeh A R. Impression creep of a lead-free Sn-1.7Sb-1.5Ag solder reinforced by submicro-size Al2O3 particles[J]. Journal of Electronic Materials, 2010, 39(2): 215-222.
[88] Mavoori H, Jin S. New, creep-resistant, low melting point solders with ultrafine oxide dispersions[J]. Journal of Electronic Materials, 1998, 27(11): 1216-1222.
[89] Tai F, Guo F, Han M T, et al. Creep and thermomechanical fatigue properties of in situ Cu6Sn5 reinforced lead-free composite solder[J]. Materials Science and Engineering A, 2010, 527(15): 3335-3342.
[90] ۢ��, ����, ����, ��. �������ṹ������ǿ��Ǧ����ǥ������[J]. ���ϲ���ѧ��, 2010, 27(1): 144-149.
TAI Feng, GUO Fu, LIU Bin, et al. Properties of new nano-structured particles reinforced lead-free composite solders[J]. Acta Materiae Compositae Sinica, 2010, 27(1): 144-149.
[91] ����ƽ, �ڴ���, ������, ��. ������Ǧǥ�ϵĿ����������Sn60Pb40ǥ�ϵĶԱȷ���[J]. ����ѧ��, 2007, 28(2): 1-4.
ZHANG Xinping, YU Chuanbao, ZHANG Yupeng, et al. Creep resistance performance of two lead-free solder and comparison with Sn60Pb40 solder[J]. Transactions of the China Welding Institution, 2007, 28(2): 1-4.
[92] ����. ����ǥ���¶���Ӧ��������������ܵı�������[D]. ���: ����ѧ���Ͽ�ѧ�빤��ѧԺ, 2004: 1-27.
ZHANG Li. Constitutive description of temperature and strain rate dependent tensile behavior of solder[D]. Tianjin: Tianjin University. School of Materials Science and Engineering, 2004: 1-27.
[93] ������, ����, �Ŵ���, ��. Sn-3.7Ag-0.9Zn��Ǧǥ�ϺϽ�ѹ����������о�[J]. ����Ԫ�������, 2010(10): 61-64.
LIU Jialin, ZENG Ming, ZHANG Congzheng, et al. Impression creep property of Sn-0.7Ag-0.9Zn lead-free solder alloy[J]. Electronic Components and Materials, 2010, 29(10): 61-64.
[94] ��ѩϼ, Ф��ʤ, Ԭ����, ��. ��������ѹ�۷�������Ǧ������Cu6Sn5�����仯�������ѧ����[J]. ϡ�н��������빤��, 2013, 42(2): 316-319.
YANG Xuexia, XIAO Gesheng, YUAN Guozheng, et al. Nanoindentation identifications of mechanical properties of Cu6Sn5 intermetallic compounds derived by lead-free solder joints[J]. Rare Metal Materials and Engineering, 2013, 42(2): 316-319.
[95] Marques V M F, Wunderle B, Johnston C, et al. Nanomechanical characterization of Sn-Ag-Cu/Cu joints. Part 2: nanoindentation creep and its relationship with uniaxial creep as a function of temperature[J]. Acta Materialia, 2013, 61(7): 2471-2480.
[96] ������, ������, ������, ��. ��ѭ��������SnAgCu-CNT��Ӻ��������Ϊ��ֵģ��[J]. ����ѧ��, 2007, 28(11): 85-88, 92.
HAN Yongdian, JING Hongyang, XU Lianyong, et al. Numerical simulation of creep behavior of SnAgCu-CNT lap shear solder under thermal cycles[J]. Transactions of the China Welding Institution, 2007, 28(11): 85-88, 92.
[97] �ſ¿�, ��Ҫ��, ������, ��. RE����������������SnAgCuǥ����ͷ������������Ӱ��[J]. ϡ�н��������빤��, 2007, 36(8): 1473-1476.
ZHANG Keke, WANG Yaoli, FAN Yanli, et al. Effect of Ce-La mixed rare earth content and environment conditions on the creep rupture life of SnAgCu solder joints[J]. Rare Metal Materials and Engineering, 2007, 36(8): 1473-1476.
[98] Shi Y W, Yan Y F, Liu J P, et al. Constitutive relations for creep in a SnCu-based composite solder reinforced with Ag particles[J]. Journal of Electronic Materials, 2009, 38(9): 1866-1873.
[99] Zhang L, Xue S B, Gao L L, et al. Creep behavior of SnAgCu solders with rare earth Ce doping[J]. Transactions of Nonferrous Metals Society of China, 2010, 20(3): 412-417.
[100] Wang T H, Wang C C, Lai Y S, et al. Optimization of board-level thermomechanical reliability of high performance flip-chip package assembly[J]. Microelectronic Engineering, 2008, 85(4): 659-664.
[101] ʢ��, Ѧ�ɰ�, ����, ��. �������ģ�͵�װоƬ����ƣ������Ԥ��[J]. ����ѧ��, 2008, 29(10): 53-56.
SHENG Zhong, XUE Songbai, ZHANG Liang, et al. Fatigue life prediction for flip chip soldered joints based on creep strain model[J]. Transactions of the China Welding Institution, 2008, 29(10): 53-56.
[102] ����. SnAgCuϵ��Ǧ����ɿ��Լ���������о�[D]. �Ͼ�: �Ͼ����պ����ѧ���Ͽ�ѧ�뼼��ѧԺ, 2011: 46-57.
ZHANG Liang. Study on reliability of SnAgCu based lead-free soldered joint and related theory[D]. Nanjing: Nanjing University of Aeronautics and Astronautics. College of Materials Science and Technology, 2011: 46-57.
[103] Lai Y S, Wang T H. Optimal design towards enhancement of board-level thermomechanical reliability of wafer-level chip-scale packages[J]. Microelectronics Reliability, 2007, 47(1): 104-110.
[104] Zhang L, Xue S B, Gao L L, et al. Reliability study of Sn-Ag-Cu-Ce soldered joints in quad flat packages[J]. Microelectronics Reliability, 2010, 50(12): 2071-2077.
[105] ������. QFP����ɿ��Լ����������߳ߴ���Ż�ģ��[D]. �Ͼ�: �Ͼ����պ����ѧ���Ͽ�ѧ�뼼��ѧԺ, 2007: 1-30.
WU Yuxiu. Research on the reliability of soldered joints and optimum simulation for QFP gull wing lead sizes[D]. Nanjing: Nanjing University of Aeronautics and Astronautics. College of Materials Science and Technology, 2007: 1-30.
[106] ʢ��. QFP����ɿ����о�������ѭ��ƣ������Ԥ��[D]. �Ͼ�: �Ͼ����պ����ѧ���Ͽ�ѧ�뼼��ѧԺ, 2010: 1-20.
SHENG Zhong. Prediction on thermal fatigue life & study on the reliability of QFP soldered joint[D]. Nanjing: Nanjing University of Aeronautics and Astronautics. College of Materials Science and Technology, 2010: 1-20.
[107] ����, ���̹�, ������, ��. WLCSP����Sn3.9Ag0.6Cu����ƣ������Ԥ��[J]. ����ѧ��, 2012, 33(3): 97-100.
ZHANG Liang, HAN Jiguang, GUO Yonghuan, et al. Fatigue life prediction of Sn3.9Ag0.6Cu soldered joints in WLCSP device[J]. Transactions of the China Welding Institution, 2012, 33(3): 97-100.
[108] Gao Q, Zhao M, Wang H F. SMT solder joints�� semi-experimental fatigue model[J]. Mechanics Research Communications, 2005, 32(3): 351-358.
[109] Zhang L, Xue S B, Gao L L, et al. Effect of thermal cycling on properties and microstructure of SnAgCuCe soldered joints in QFP devices[J]. Chinese Journal of Mechanical Engineering, 2011, 24(4): 561-566.
[110] Pang J H L, Low T H, Xiong B S, et al. Thermal cycling aging effects on Sn-Ag-Cu solder joint microstructure, IMC and strength[J]. Thin Solid Films, 462/463: 370-375.
[111] Ф������, �����, ��־��, ��. SnAgCu������װ������ʱЧ����ѭ�������е���֯������ǿ�ȱ仯[J]. ����ѧ��, 2001, 37(4): 439-444.
SHAWKRET Ahat, DU Liguang, SUN Zhiguo, et al. Effects of aging and thermal cycling on the microstructure and shear strength of SnAgCu surface mount solder joint[J]. Acta Metallurgica Sinica, 2001, 37(4): 439-444.
[112] �ſ¿�, ������, ��Ҫ��, ��. Sn2.5Ag0.7CuxREǥ��ʱЧ�������IMC�о�[J]. ���Ϲ���, 2010(10): 18-21, 37.
ZHANG Keke, HAN Lijuan, WANG Yaoli, et al. Research of intermetallic compounds at interface of Sn2.5Ag0.7CuxRE solder joints during aging[J]. Journal of Materials Engineering, 2010(10): 18-21, 37.
[113] Tai F, Guo F, Xia Z D, et al. Effects of nano-sized Ag reinforcing particulates on the microstructure of Sn0.7Cu solder joints[J]. International Journal of Minerals, Metallurgy and Materials, 2009, 16(6): 677-684.
[114] Sivasubramaniam V, Bosco N S, Janczak-rusch J, et al. International intermetallic growth and strength of composite lead-free solder alloy through isothermal aging[J]. Journal of Electronic Materials, 2008, 37(10): 1598-1604.
[115] Zhang Q K, Zhu Q S, Zou H F, et al. Fatigue fracture mechanisms of Cu/lead-free solders interfaces[J]. Materials Science and Engineering A, 2010, 527(6): 1367-1376.
[116] Jen Y M, Chiou Y C, Yu C L. Fracture mechanics study on the intermetallic compound cracks for the solder joints of electron packages[J]. Engineering Failure Analysis, 2010, 18(2): 797-810.
[117] Ѧ�ɰ�, ������, ��ƽ, ��. ��ѭ����QFP����ǿ�ȼ�������֯Ӱ����ɵ���ֵģ��[J]. ����ѧ��, 2006, 27(11): 1-4.
XUE Songbai, WU Yuxiu, CUI Guoping, et al. Numerical simulation of effect of thermal cycling on tensile strength and microstructure of QFP soldered joint[J]. Transactions of the China Welding Institution, 2006, 27(11): 1-4.
[118] ����ƽ, ������, �ڴ���. ���Ӻ��ӷ�װ��Ǧǥ�ϵ��о���Ӧ�ý�չ[J]. �����о�ѧ��, 2008, 22(1): 1-9.
ZHANG Xinping, YIN Limeng, YU Chuanbao. Advances in research and application of lead-free solders for electronic and photonic packaging[J]. Chinese Journal of Materials Research, 2008, 22(1): 1-9.
[119] Zhang L, Han J G, He C W, et al. Reliability behavior of lead-free soldered joints in electronic components[J]. Journal of Materials Science: Materials in Electronics, 2013, 24(1): 172-190.
[120] Ѧ�ɰ�, ����, ������, ��. ��Ԫ�ض���Ǧǥ������Ӱ����о���״�뷢չ����[J]. ����, 2009(3): 24-33.
XUE Songbai, ZHANG Liang, GAO Lili, et al. Current situation and prospect on effects of micro alloying elements on properties of lead-free solders[J]. Welding & Joining, 2009(3): 24-33.
[121] �ܺ�־, ����ȫ, ����, ��. ����CeO2/Zn-4.5Al-RE-Mg-Ti�ĸ��Ͻ����Ʊ������о�[J]. ϡ�н��������빤��, 2010, 39(3): 534-537.
ZHOU Hengzhi, LI Ziquan, ZENG Guang, et al. Research on combination stirring fabrication technology of nano-CeO2/Zn-4.5Al-RE-Mg-Ti composites[J]. Rare Metal Materials and Engineering, 2010, 39(3): 534-537.
[122] ������, Ѧ�ɰ�, ����, ��. Sn-Znϵǥ��ר��������[J]. ����ѧ��, 2012, 33(10): 101-104.
HAN Ruonan, XUE Songbai, HU Yuhua, et al. Development of flux for Sn-Zn lead-free solder[J]. Transactions of the China Welding Institution, 2012, 33(10): 101-104.
[123] �»�, ��㶫, ʷҫ��, ��. Sn������̬���о�[J]. ���Ͽ�ѧ�빤��, 2010, 18(1): 111-115.
HAO Hu, LI Guangdong, SHI Yaowu, et al. Study of morphologies for tin whiskers[J]. Materials Science & Technology, 2010, 18(11): 111-115.
[124] Ye H, Xue S B, Petch M. Effects of thermal cycling on rare earth (Pr)-induced Sn whisker/hillock growth[J]. Materials Letters, 2013, 98: 78-81.
[125] Maleki M, Cugnoni J, Botsis J. Microstructure-based modeling of the ageing effect on the deformation behavior of the eutectic micro-constituent in SnAgCu lead-free solder[J]. Acta Materialia, 2013, 61(1): 103-114.
[126] Chen W H, Yu C F, Cheng H C, et al. IMC growth reaction and its effects on solder joint thermal cycling reliability of 3D chip stacking packaging[J]. Microelectronics Reliability, 2013, 53(1): 30-40.
[127] Sabri M F M, Shnawah D A, Badruddin I A, et al. Microstructural stability of Sn-1Ag-0.5Cu-xAl (x=1, 1.5, and 2 wt.%) solder alloys and the effects of high-temperature aging on the mechanical properties[J]. Materials Characterization, 2013, 78: 129-143.
[128] ��ѩϼ, Ф��ʤ, ��ѧ��. �弶�������غ�����Ǧ������״��BGA��װ�ɿ��Ե�Ӱ��[J]. ������, 2013, 32(1): 104-107.
YANG Xuexia, XIAO Gesheng, SHU Xuefeng. Effects of solder joint shapes on reliability of BGA packages under board level drop impact loads[J]. Journal of Vibration and Shock, 2013, 32(1): 104-107.
[129] ����, �Ϲ�. ������غ��µ�·�������ά����Ԫģ��[J]. ������, 2012, 31(20): 61-64.
LIU Fang, MENG Guang. Three-dimension finite element simulation for a PCB assembly under random vibration loading[J]. Journal of Vibration and Shock, 2012, 31(20): 61-64.
[130] ����, ��Т��. ʪ�Ȼ����µ�װ����Ǧ����Ŀɿ���[J]. ����Ԫ�������, 2008, 27(8): 68-71.
WANG Dong, MA Xiaosong. Reliability of lead-free solder joint for FCOB in hygrothermal environment[J]. Electronic Components and Materials, 2008, 27(8): 68-71.
[131] ������, ���ʴ�, ����. Anand���������ں���ɿ����о��е�Ӧ��[J]. �纸��, 2012, 42(12): 66-69.
WANG Xuyan, XU Renchun, LIU Gang. Application of anand constitutive equations in solder joints reliability[J]. Electric Welding Machine, 2012, 42(12): 66-69.
[132] Zhang L, Xue S B, Gao L L, et al. Determination of Anand parameters for SnAgCuCe solder[J]. Modelling and Simulation in Materials Science and Engineering, 2009, 17(7): 075014.
[133] Bai N, Chen X, Gao H. Simulation of uniaxial tensile properties for lead-free solders with modified Anand model[J]. Materials & Design, 2009, 30(1): 122-128.
[134] Zhang G S, Jing H Y, Xu L Y, et al. Creep behavior of eutectic 80Au/20Sn solder alloy[J]. Journal of Alloys and Compounds, 2009, 476(1/2): 138-141.
[135] Wiese S, Feustel F, Meusel E. Characterisation of constitutive behavior of SnAg, SnAgCu and SnPb solder in flip chip joints[J]. Sensors and Actuators A: Physical, 2002, 99(1/2): 188-193.
[136] Li X Y, Wang Z S. Thermo-fatigue life evaluation of SnAgCu solder joints in flip chip assemblies[J]. Journal of Materials Processing Technology, 2007, 183(1): 6-12.
[137] ����, Ѧ�ɰ�, ��ʤ��, ��. ����Ԫģ�������Ӻ���ɿ����о��е�Ӧ��[J]. �纸��, 2008, 38(9): 13-21, 72.
ZHANG Liang, XUE Songbai, YU Shenglin, et al. Application of FEM analysis in reliability of micro-soldered joints[J]. Electric Welding Machine, 2008, 38(9): 13-21, 72.
[138] ��־��, �����, ������, ��. PBGA��Ǧ����Ӧ��Ӧ����ֵģ�⼰ƣ������Ԥ��[J]. ������������ѧѧ��, 2007, 12(3): 156-159, 164.
JIANG Zhizhong, SUN Fenglian, WANG Lifeng, et al. Numerical simulation of stress-strain and life prediction for lead-free solder joints of PBGA package[J]. Journal of Harbin University of Science & Technology, 2007, 12(3): 156-159, 164.
[139] ����, Ѧ�ɰ�, ���ڽ�, ��. FCBGA����SnAgCu����ƣ������Ԥ��[J]. ����ѧ��, 2008, 29(7): 85-88.
ZHANG Liang, XUE Songbai, HAN Zongjie, et al. Fatigue life prediction of SnAgCu soldered joints of FCBGA device[J]. Transactions of the China Welding Institution, 2008, 29(7): 85-88.
[140] ����. ��װ������Ŀɿ��Է���[D]. ������: ��������ҵ��ѧ���Ͽ�ѧ�빤��ѧԺ, 2006: 6-9.
FU Bing. Reliability analysis of flip chip solder joint[D]. Harbin: Harbin Institute of Technology. School of Materials Science and Engineering, 2006: 6-9.
[141] ����. ��ѭ���غ���BGA���Ϻ���ƣ���������о�[D]. ������: ��������ҵ��ѧ���Ͽ�ѧ�빤��ѧԺ, 2011: 3-30.
ZHANG Lin. Fatigue life of BGA composite solder joint under thermal cycle loading[D]. Harbin: Harbin Institute of Technology. School of Materials Science and Engineering, 2011: 3-30.
[142] Chen F X, Pang J H L. Characterization of IMC layer and its effect on thermomechanical fatigue life of Sn-3.8Ag-0.7Cu solder joints[J]. Journal of Alloys and Compounds, 2012, 541: 6-13.
[143] ����, Ѧ�ɰ�, ¬����, ��. �������ģ��ϸ�����������ƣ������Ԥ��[J]. ��е����ѧ��, 2009, 45(9): 279-284.
ZHANG Liang, XUE Songbai, LU Fangyan, et al. Fatigue life prediction for fine pitch device soldered joints based on creep model[J]. Journal of Mechanical Engineering, 2009, 45(9): 279-284.
[144] Yu H, Shangguan D K. Solidification and reliability of lead-free solder interconnection[J]. Soldering & Surface Mount Technology, 2013, 25(1): 31-38.
[145] Zhang L, Xue S B, Gao L L, et al. Effect of thermal cycling on properties and microstructure of SnAgCu soldered joints in QFP devices[J]. Chinese Journal of Mechanical Engineering, 2011, 24(4): 561-566.
[146] ����, ���̹�, ������, ��. WLCSP�����ṹ�Ż�ģ�⼰��Ǧ����ɿ���[J]. ����ѧ��, 2012, 33(7): 53-56.
ZHANG Liang, HAN Jiguang, GUO Yonghuan, et al. Optimum simulation and soldered joints reliability of WLCSP device[J]. Transactions of the China Welding Institution, 2012, 33(7): 53-56.
[147] Chang Y W, Chiu S H, Chen C, et al. Effect of Si-die dimensions on electromigration failure time of flip-chip solder joints[J]. Materials Chemistry and Physics, 2011, 127(1/2): 85-90.
[148] �����, ����. ����ļ��γߴ�ЧӦ[J]. ������������ѧѧ��, 2012, 17(2): 100-104.
SUN Fenglian, ZHU Yan. Geometrical size effects on the performance of micro-joint[J]. Journal of Harbin University of Science and Technology, 2012, 17(2): 100-104.
[149] ����, �ƴ�Ծ, �ܵ¼�. ���ں�����̬Ԥ��������Ӧ�����Ĺ��ղ�����QFP����ɿ���Ӱ�����[J]. ���Թ���ѧ��, 2006, 13(6): 103-108.
WU Zhaohua, HUANG Chunyue, ZHOU Dejian. Study on the impact of process parameters on the reliability of quad flat package solder joints based on shape prediction and plastic strain calculation[J]. Journal of Plasticity Engineering, 2006, 13(6): 103-108.
[150] ������, ���, ������. ������̬�Ա�����װԪ����Ǧ����ɿ��Ե�Ӱ��[J]. �ȼӹ�����, 2011, 40(19): 173-177.
HAO Xiuyun, YANG Jie, WANG Yupeng. Effect of solder joint shape on reliability of lead-free solder joint[J]. Hot Working Technology, 2011, 40(19): 173-177.
(�༭ ����ƽ)
�ո����ڣ�2014-02-14�������ڣ�2014-04-18
������Ŀ(Foundation item)��������Ȼ��ѧ����������Ŀ(51475220)������ʡ��Ȼ��ѧ����������Ŀ(BK201244)������ʡ��У��Ȼ��ѧ����������Ŀ(12KJB460005)�����տƼ���ѧ�Ƚ����Ӽ���ʡ���ص�ʵ���ҿ��Ż���������Ŀ(JSAWS-11-05) (Project(51475220) supported by the Natural Science Foundation of China; Project (BK2012144) supported by the Natural Science Foundation of Jiangsu Province; Project(12KJB460005) supported by the Natural Science Foundation of the Higher Education Institutions of Jiangsu Province; Project(JSAWS-11-05) supported by Provincial Key Lab of Advanced Welding Technology Foundation, Jiangsu University of Science and Technology)
ͨ�����ߣ���������ʿ�������ڣ�˶ʿ����ʦ�����µ��ӷ�װ�����뼼���о���E-mail: zhangliang@jsnu.edu.cn
ժҪ���ۺ����ۺ�����-������Ǧǥ���о���Ӧ����״���ֱ���ܹ�������Խ�����������մɡ�̼���ܼ��߷��Ӽ��ֿ�������Ǧǥ�����ܵ�Ӱ�졣��Ҫ����Ǧǥ���ڲ���֯��������֯���ۻ����ԡ���ʪ�ԡ���ѧ���ܺ�������ܼ�����̽�ֿ�����ǥ����֯�����ܵ�Ӱ�졣ͬʱ����������ǿ����Ǧǥ����Ӧ�ù����г��ֵ����⼰��Ӧ�Ľ����ʩ�����Կ�����ǿ��Ǧǥ�ϵķ�չ���ƽ��з�����չ����
[2] ����, Ѧ�ɰ�, ����ѧ, ��. Sn-9Zn-xCeǥ����֯��ǥ�����ܵķ���[J]. ����ѧ��, 2010, 31(6): 77-80.
[3] ����, ���̹�, ������, ��. ������������SnAgCuǥ����֯������[J]. ����ѧ��, 2013, 34(6): 65-68.
[14] ����. �Ͻ�Sn-9Zn��Ǧǥ������Ӱ�켰��ʪ�����о�[D]. �Ͼ�: �Ͼ����պ����ѧ���Ͽ�ѧ�뼼��ѧԺ, 2010: 1-112.
[16] ����ѧ. Ag��Ga��Al��Ce��Sn-9Zn��Ǧǥ�����ܵ�Ӱ��[D]. �Ͼ�: �Ͼ����պ����ѧ���Ͽ�ѧ�뼼��ѧԺ, 2010: 1-60.
[21] ���ڽ�. ������װԪ�����뵼�弤����Ǧ��ǥ�������о�[D]. �Ͼ�: �Ͼ����պ����ѧ���Ͽ�ѧ�뼼��ѧԺ, 2009: 1-98.
[27] ��ƽ. ������ǿSn3.8Ag0.7Cu������Ǧ���ϵ��о�[D]. ���: ����ѧ���Ͽ�ѧ�빤��ѧԺ, 2009: 1-107.
[34] ������, ����, ֣�վ�, ��. Ni������ǿ��Ǧ����ǥ����IMC��ֵ̬�ݱ�[J]. ����Ԫ�������, 2007, 26(9): 43-46.
[35] ����ǿ, ����, ����ǿ. Cu������ǿ��Sn-9Zn����ǥ��/Cuǥ����ͷ���淴Ӧ[J]. ����ѧ��, 2007, 28(5): 105-108.
[45] ����, ۢ��, ����, ��. ���ṹǿ��������Sn-Ag����Ǧ����ǥ��[J]. ���Ϲ���, 2009(8): 38-48.
[49] ����. ��̼���ܵ�Sn-58Bi��Ǧǥ�ϵ��Ʊ����������о�[D]. ������: ��������ҵ��ѧ���Ͽ�ѧ�빤��ѧԺ, 2010: 1-38.
[50] ����. Ӧ�����׳ߴ�ЧӦ����Sn����Ǧ�����ۻ��¶ȵĻ����о�[D]. �Ϻ�: �Ϻ���ѧ���Ͽ�ѧ�빤��ѧԺ, 2010: 1-122.
[52] ����, ���̹�, �γ���, ��. ϡ��Ԫ�ض���Ǧǥ����֯�����ܵ�Ӱ��[J]. �й���ɫ����ѧ��, 2012, 22(6): 1680-1696.
[54] ����. �����������ĸ�����Ǧǥ�ϼ������ӽ�ͷ�����о�[D]. ʯ��ׯ: ʯ��ׯ����ѧԺ���Ͽ�ѧ�빤��ѧԺ, 2008: 1-69.
[58] ������. NiͿ��̼������ǿSn-Ag-Cu��Ǧǥ�ϵĿɿ����о�[D]. ���: ����ѧ���Ͽ�ѧ�빤��ѧԺ, 2009: 1-108.
[60] ����ѧ. �ṹͭ��������ǦSnAgCu������ʪ����ò�о�[D]. ����: ������ͨ��ѧ���Ͽ�ѧ�빤��ѧԺ, 2006: 1-52.
[61] ������. ��Ǧǥ��������·��ǰ��[J]. ����, 2007(2): 6-10.
[62] ����, Ѧ�ɰ�, ����ѧ, ��. ��ͬǥ����Sn-Znϵ��Ǧǥ����ʪ���Ե�Ӱ��[J]. ����ѧ��, 2009, 30(1): 5-8.
[66] ����, ۢ��, ����, ��. ���ṹǿ����Ǧ�������ѧ����[J]. ���ϲ���ѧ��, 2009, 26(2): 11-17.
[73] ����, ���̹�, ������, ��. SnAgCu/SnAgCuCe���������֯������[J]. ��е����ѧ��, 2012, 48(8): 67-73.
[74] Dieter G E. Mechanical metallurgy[M]. New York: McGraw-Hill Book Company, 1988: 145-240.
[75] ʱ����, ����. ������ѧ����[M]. ����: ������ѧ������, 2010: 218-238.
[76] ������. ϡ��Pr��Nd��SnAgCu��Ǧǥ����֯������Ӱ���о�[D]. �Ͼ�: �Ͼ����պ����ѧ���Ͽ�ѧ�뼼��ѧԺ, 2012: 43-52.
[78] ۢ��, ����, ���, ��. ����Ag������ǿ����ǥ��������ܵ��о�[J]. ϡ�н��������빤��, 2010, 39(6): 1005-1008.
[83] ����, �̶���, ����ƽ, ��. Ag������ǿSn-58Bi��Ǧǥ����ѧ�����о�[J]. �ִ�����, 2011(10): 49-51.
[84] ����. ϡ���������ͭ��Ǧǥ����֯���ܵ�Ӱ��[D]. ������: ��е��ѧ�о���Ժ, 2006: 1-63.
[85] ���Ľ�, ������. ������Ǧ���Ӻ��ϵ��о���չ�뷢չ����[J]. �������ܲ���, 2009, 16(2): 55-59.
[90] ۢ��, ����, ����, ��. �������ṹ������ǿ��Ǧ����ǥ������[J]. ���ϲ���ѧ��, 2010, 27(1): 144-149.
[91] ����ƽ, �ڴ���, ������, ��. ������Ǧǥ�ϵĿ����������Sn60Pb40ǥ�ϵĶԱȷ���[J]. ����ѧ��, 2007, 28(2): 1-4.
[92] ����. ����ǥ���¶���Ӧ��������������ܵı�������[D]. ���: ����ѧ���Ͽ�ѧ�빤��ѧԺ, 2004: 1-27.
[93] ������, ����, �Ŵ���, ��. Sn-3.7Ag-0.9Zn��Ǧǥ�ϺϽ�ѹ����������о�[J]. ����Ԫ�������, 2010(10): 61-64.
[101] ʢ��, Ѧ�ɰ�, ����, ��. �������ģ�͵�װоƬ����ƣ������Ԥ��[J]. ����ѧ��, 2008, 29(10): 53-56.
[102] ����. SnAgCuϵ��Ǧ����ɿ��Լ���������о�[D]. �Ͼ�: �Ͼ����պ����ѧ���Ͽ�ѧ�뼼��ѧԺ, 2011: 46-57.
[105] ������. QFP����ɿ��Լ����������߳ߴ���Ż�ģ��[D]. �Ͼ�: �Ͼ����պ����ѧ���Ͽ�ѧ�뼼��ѧԺ, 2007: 1-30.
[106] ʢ��. QFP����ɿ����о�������ѭ��ƣ������Ԥ��[D]. �Ͼ�: �Ͼ����պ����ѧ���Ͽ�ѧ�뼼��ѧԺ, 2010: 1-20.
[107] ����, ���̹�, ������, ��. WLCSP����Sn3.9Ag0.6Cu����ƣ������Ԥ��[J]. ����ѧ��, 2012, 33(3): 97-100.
[112] �ſ¿�, ������, ��Ҫ��, ��. Sn2.5Ag0.7CuxREǥ��ʱЧ�������IMC�о�[J]. ���Ϲ���, 2010(10): 18-21, 37.
[118] ����ƽ, ������, �ڴ���. ���Ӻ��ӷ�װ��Ǧǥ�ϵ��о���Ӧ�ý�չ[J]. �����о�ѧ��, 2008, 22(1): 1-9.
[120] Ѧ�ɰ�, ����, ������, ��. ��Ԫ�ض���Ǧǥ������Ӱ����о���״�뷢չ����[J]. ����, 2009(3): 24-33.
[122] ������, Ѧ�ɰ�, ����, ��. Sn-Znϵǥ��ר��������[J]. ����ѧ��, 2012, 33(10): 101-104.
[123] �»�, ��㶫, ʷҫ��, ��. Sn������̬���о�[J]. ���Ͽ�ѧ�빤��, 2010, 18(1): 111-115.
[128] ��ѩϼ, Ф��ʤ, ��ѧ��. �弶�������غ�����Ǧ������״��BGA��װ�ɿ��Ե�Ӱ��[J]. ������, 2013, 32(1): 104-107.
[129] ����, �Ϲ�. ������غ��µ�·�������ά����Ԫģ��[J]. ������, 2012, 31(20): 61-64.
[130] ����, ��Т��. ʪ�Ȼ����µ�װ����Ǧ����Ŀɿ���[J]. ����Ԫ�������, 2008, 27(8): 68-71.
[131] ������, ���ʴ�, ����. Anand���������ں���ɿ����о��е�Ӧ��[J]. �纸��, 2012, 42(12): 66-69.
[137] ����, Ѧ�ɰ�, ��ʤ��, ��. ����Ԫģ�������Ӻ���ɿ����о��е�Ӧ��[J]. �纸��, 2008, 38(9): 13-21, 72.
[139] ����, Ѧ�ɰ�, ���ڽ�, ��. FCBGA����SnAgCu����ƣ������Ԥ��[J]. ����ѧ��, 2008, 29(7): 85-88.
[140] ����. ��װ������Ŀɿ��Է���[D]. ������: ��������ҵ��ѧ���Ͽ�ѧ�빤��ѧԺ, 2006: 6-9.
[141] ����. ��ѭ���غ���BGA���Ϻ���ƣ���������о�[D]. ������: ��������ҵ��ѧ���Ͽ�ѧ�빤��ѧԺ, 2011: 3-30.
[143] ����, Ѧ�ɰ�, ¬����, ��. �������ģ��ϸ�����������ƣ������Ԥ��[J]. ��е����ѧ��, 2009, 45(9): 279-284.
[146] ����, ���̹�, ������, ��. WLCSP�����ṹ�Ż�ģ�⼰��Ǧ����ɿ���[J]. ����ѧ��, 2012, 33(7): 53-56.
[148] �����, ����. ����ļ��γߴ�ЧӦ[J]. ������������ѧѧ��, 2012, 17(2): 100-104.
[150] ������, ���, ������. ������̬�Ա�����װԪ����Ǧ����ɿ��Ե�Ӱ��[J]. �ȼӹ�����, 2011, 40(19): 173-177.


