退火对氟化类金刚石膜结构及电学性能的影响
肖剑荣1, 2,徐 慧1,王焕友1,马松山1
(1. 中南大学 物理科学与技术学院,湖南 长沙,410083;
2. 桂林工学院 数理系,广西 桂林,541004)
摘 要:以CF4和CH4为源气体,在不同的温度和功率下,使用射频等离子体增强化学气相沉积(RF-PECVD) 法制备氟化类金刚石(F-DLC)薄膜,并在Ar气中进行退火处理。利用椭偏仪、X射线衍射仪、傅里叶变换红外光谱(FTIR)、拉曼光谱仪(Raman)以及QS电桥对薄膜厚度、结构以及电学性质进行表征。研究结果表明:在退火温度为300 ℃时,薄膜很稳定;退火温度达到400 ℃时,大部分H从膜内逸出,C―Hx (x=1, 2, 3)化学键基本消失,C―Fx,C=C和C=O等化学键的相对含量发生改变;薄膜的介电常数与薄膜内F的含量有关,退火使F的含量减少,介电常数增大。
关键词:F-DLC薄膜;介电常数;PECVD;退火
中图分类号:TN304.55 文献标识码:A 文章编号:1672-7207(2007)04-0669-05
Effects of annealing on structural and electric property of fluorinated diamond-like carbon thin films
XIAO Jian-rong1, 2, XU Hui1, WANG Huan-you1, MA Song-shan1
(1. School of Physics Science and Technology, Central South University, Changsha 410083, China;
2. Department of Maths and Physics, Guilin University of Technology, Guilin 541004, China)
Abstract: Fluorinated diamond-like carbon (F-DLC) thin films were deposited by radio frequency plasma enhance chemical vapor deposition (RF-PECVD) reactor with CF4 and CH4 as source gases, and the thin films were annealed in Ar environment. The thickness, structural and electrical properties of the films were characterized by spectroscopic ellipsometer (ELLI), X-ray diffraction (XRD), Fourier transform infrared (FTIR) spectrometry, Raman spectra and QS circuit. The results show that F-DLC thin films are thermally stable at 300 ℃. When the annealing temperature is at 400 ℃, the hydrogen atoms break away from the films, and the films have a little chemical bonding of C―Hx (x=1, 2, 3). The relative contents of C=C, C=O and C―Fx in the films are transformed after annealing. The dielectric constant of the films relates to the content of F. The content of F decreases with the increase of annealing temperature, and the dielectric constant increases.
Key words: F-DLC thin films; dielectric constant; plasma enhance chemical vapor deposition; annealing
近年来,氟化非晶碳(a-C:F)因具有较低的介电常数和化学惰性,有望成为超大规模集成电路(ULSI)电介质材料而受到研究者的重视[1-5]。但其热稳定性较差,在温度达到300 ℃以上就会分解,难以满足集成电路材料的后续加工工艺和器件的高温下工作条件[6-7]。类金刚石(DLC)具有很好的热稳定性,掺氟后成为氟化类金刚石(F-DLC)薄膜,既具有较低的介电常数又有较好的热稳定性,能广泛应用于摩擦学、电子学、光学及生物医学等领域,目前倍受研究者的关注[8-11]。人们对F-DLC薄膜电学性质进行了研究,如:黄峰 等[5]研究真空退火对薄膜结构的影响,高功率下制备出薄膜,其热稳定性较好,但是对退火后薄膜电学性质变化方面没有进行研究;江美福等[10]制备出介电常数达1.77的薄膜,并得出薄膜的介电常数与膜内F的含量有关,但所得薄膜的稳定性不强;H.Yokomichi等[9]通过研究发现沉积温度影响薄膜的特性,同时指出 膜内悬挂键的密度和F的浓度影响薄膜的介电常数;W. Y. Jeong等[3]发现随着退火温度增加,薄膜内F的含量减小,关联加强,稳定性提高。但这些研究都没有对成膜工艺―结构―性质这三者之间的关系进行系统分析。在此,本文作者以CF4和CH4为源气体,Ar为工作气体,利用射频等离子体化学气相沉积(RF-PECVD)法制备F-DLC薄膜,在不同温度下的Ar环境中退火,研究退火工艺对薄膜结构的影响以及薄膜介电常数与薄膜组分的内在关系。
1 实 验
采用的射频等离子体增强化学气相沉积(RF-PECVD)设备见文献[12]。实验中,采用(100)面P型硅片作为沉积薄膜的基片。基片依次浸泡在丙酮、酒精溶液中,利用超声波清洗机清洗各20 min,洗涤其表面的有机污垢,然后,用去离子水冲洗,再用烘箱烘干。沉积前,先在2.5 Pa Ar环境中,用100 W射频功率轰击基片表面10 min。每次沉积本底真空为 1.0×10-3 Pa,CF4和CH4的流量分别为32 cm3/min和8 cm3/min,Ar的流量为2 cm3/min,沉积气压为5.2~ 5.7 Pa,沉积时间为60 min。射频功率分别取100,150和200 W,沉积温度分别取室温(基片没有加热,但由于粒子的轰击,温度达到近50 ℃),100 ℃和200 ℃。退火时Ar的流量为20 cm3/min,压力约为2.5 Pa,退火温度为250~400 ℃,时间均为60 min。
利用ELLI-B型椭偏仪测得薄膜的厚度,用QS37型电桥测量薄膜的介电常数。用D/Max250型全自动X射线衍射仪对薄膜无规则网络的有序度进行测试分析。用NEXUS-470型傅里叶变换红外光谱仪获得薄膜的透射光谱,从而确定退火前后薄膜中的化学键种类及其浓度。
2 结果与分析
2.1 薄膜的厚度与退火温度的关系
作为ULSI的线间介质层必须满足集成电路的加工工艺,即在热冲击下能保持其结构和性质的相对稳定,也就是说它必须具有良好的热稳定性。图1所示为不同退火温度下,膜厚的变化率(即退火后膜厚的变化量与退火前膜厚之比)与沉积功率的关系曲线。可见,低功率下沉积的薄膜经过退火之后,膜厚的变化很大;而高功率下沉积的薄膜,其变化则比较小。产生这样结果的原因是:较低功率下沉积的薄膜,薄膜内存在相对较多的弱结合,如C―Hx (x=1, 2, 3)等,加热使之断裂,从薄膜中逸出,使薄膜厚度减小;另一方面,退火虽然会使薄膜中的一些原子或原子团脱离薄膜,但在薄膜中出现一些空洞。同时,薄膜内一些沉积时产生的空洞在受热时会变小,甚至消失,使得薄膜变得更加致密。退火温度越高,膜厚的变化越大。这是因为温度越高,产生上述两种现象的结果就越明显。图2所示为不同退火温度下,膜厚的变化率与沉积温度的关系曲线。可见,高温下沉积的薄膜比低温下沉积的薄膜稳定。于50 ℃沉积的薄膜在退火之后,膜厚的变化率达到50%左右。而于100 ℃和200 ℃沉积的薄膜,在相同的退火温度下,其膜厚变化率几乎相同,这说明于100 ℃和200 ℃沉积的薄膜都比较 稳定。
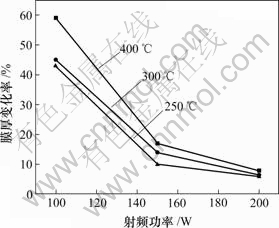
图1 不同退火温度下膜厚变化率与沉积功率的关系
Fig.1 Relationship between films thickness change rate and deposition power at different annealing temperatures
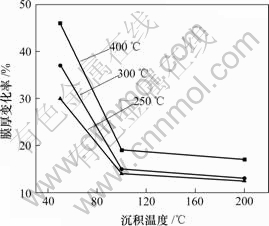
图2 不同退火温度下膜厚变化率与沉积温度关系
Fig.2 Relationship between films thickness change rate and deposition temperature at different annealing temperatures
2.2 薄膜的XRD分析
在非晶态固体中,由于原子在空间是无规则排列的,没有衍射特征峰。但短程序的存在使得在小角度衍射范围仍具有择优性的衍射极大,形成非晶态谷包。从非晶态固体的X射线衍射谷包,不仅可以获得结构中的临近关系,还可以检验结构的有序程度。图3所示为薄膜退火前后样品的X射线衍射谱。可见,退火后薄膜的非晶态谷包发生了很大的变化,由此可以定性说明薄膜的内部结构在退火后发生了改变。

1―退火前;2―于400 ℃退火
图3 退火前后薄膜的XRD谱
Fig.3 XRD patterns of films before and after annealing
2.3 退火对薄膜化学键的影响
真空退火对化学键结构有很大的影响。图4所示为在150W和100 ℃条件下刚沉积的样品和该样品在250,300和400 ℃退火后的FTIR谱图。可见,IR谱中主要有4个基团结构与频率对应的分布区域:在1 200,1 600,2 900和3 500 cm-1处,分别对应C―F,C=CF2,C―Hx,O―H [13]基团区。源气体中没有氧,薄膜中的氧可能来自真空室中背景大气或薄膜测试前表面被空气氧化所致。可见,在薄膜C―Hx基团频率区2 900 cm-1附近的3个峰受退火温度的影响相当大,当退火温度达到400 ℃时,这些峰几乎消失。因为在非晶碳膜中H存在有2个比较明显的逸出温度:一个在360 ℃附近,另一个在600~700 ℃。在400 ℃退火时,薄膜中与C结合的H大部分逸出薄膜,所以,这3个峰(对应sp3-CH3,sp3-CH2和sp2-CH2)基本消 失[14]。观察薄膜的“指纹区”,峰位主要集中在1 600和1 200 cm-1处,在1 600 cm-1附近主要是一些不饱和的基团,如C=O(1 726 cm-1)和C=C(1 600~ 1 620 cm-1)[3]。退火之后C=O峰位几乎消失,而C=C峰变化不大,说明C=C在薄膜中具有较好的稳定性。在1 400 cm-1附近,主要是C―Fx键,退火后,曲线变得平坦[3]。这些峰的幅度随着退火温度的变化发生明显改变,说明随着退火温度的变化,薄膜内的化学键也随之发生改变。
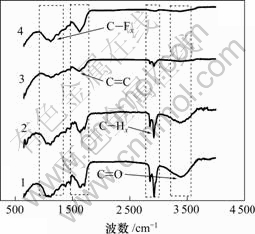
1―退火前;2―于250 ℃退火;
3―于300 ℃退火;4―于400 ℃退火
图4 退火前后薄膜的FTIR谱
Fig.4 FTIR spectra of films as deposited and after annealing
用高斯分峰拟合方法,根据各拟合峰下的面积可得到各峰对应的化学键在薄膜的相对浓度。同时,还可以通过整个薄膜的吸收带来估算薄膜内F和C原子的相对浓度,原子的浓度应用Beer公式获得[8, 15]:

2.4 退火对薄膜sp结构的影响
图5所示为F-DLC薄膜退火前后(沉积条件为 150 W,100 ℃;退火温度400 ℃)的Raman光谱及高斯拟合结果。可见,薄膜D和G峰在退火后变化十分明显。为了进一步研究退火对薄膜中sp2和sp3键结构的影响,对各谱线的800~2 000 cm-1区域利用谱峰解叠方法,对其进行高斯拟合。得到薄膜的D和G峰的强度之比ID/IG由1.75增大为2.80。而在非晶碳中,sp3/sp2值与ID/IG值成反向变化关系[16-17],因此,随着ID/IG的增大,说明薄膜内sp2结构含量增加,环式结构相对含量上升,sp3结构的含量相对减少。其原因是碳sp3相不稳定,热退火使得部分sp3相向sp2相转变,而引起了sp2区域尺寸增大。退火后,薄膜内sp2结构的石墨成分比例增大,使得薄膜的绝缘性下降,这正好符合高温下沉积薄膜的绝缘性下降这一现象。而此时,薄膜的热稳定性加强。同时,比较单晶和微晶石墨Raman的D和G峰(峰位分别位于1 355 cm-1和1 575 cm-1),发现退火前后薄膜的D峰向高频方向偏移较大,而G峰偏移较小。其原因是:D峰反映膜内sp3结构,即空间四面体结构,但薄膜是二维,缺少三维的限制,退火前后,其内部结构均会发生部分畸变,导致其峰位左右微移;而G峰反映膜内sp2结构,即平面结构,因此,它在二维的情况下没多大的变化。根据D. Beeman等[18]的模型,峰位中包含键角无序和键结构的信息,键角无序以及一定数量的四配位键会造成G峰和D峰的低频移动。

1―退火前;2―于400 ℃退火
图5 退火前后薄膜的Raman光谱及高斯拟合
Fig.5 Raman spectra and Gaussian fittings of films before and after annealing
2.5 退火对薄膜的介电常数的影响
薄膜的介电常数与退火温度的关系变化曲线(样品沉积条件为150 W,100 ℃)如图6所示。可见,随着退火温度的升高,薄膜内F的相对含量减小,其相对浓度降低,介电常数从1.95升高到2.93。F-DLC薄膜的介电常数取决于膜内的电子极化[19],而在F-DLC薄膜中,产生电子极化主要来自于C―F和C―F3的贡献,而C―F2的影响不大[2]。薄膜的介电常数随退火温度的升高而增大的原因是:温度升高,薄膜内F从膜内逸出,从而F的原子数分数减小,导致薄膜介电常数升高。正如射频功率增大一样,退火温度升高也会使薄膜的原子之间的关联加强,使薄膜的稳定性增加[20]。从图6还可以看出,当退火温度为250 ℃时,薄膜的介电常数为2.03,与刚沉积时的1.95相比相 差不大,说明该膜在250 ℃相当稳定,这一结果与W. Y. Jeong等的研究结果十分相似[3]。

图6 介电常数、F的相对浓度与退火温度的关系曲线
Fig.6 Relationship between dielectric constant, relative content of F and annealing temperature
3 结 论
a. 真空退火可消除膜中一些弱结合,使膜的质量提高。相对高温、高功率下沉积的薄膜,受退火温度的影响小。
b. 退火使薄膜的化学键结构和组分发生变化。随着退火温度增加,薄膜内sp2比例增大,趋于石墨化,薄膜关联加强,稳定性提高。于400 ℃退火后,膜C―Hx基团几乎消失,C―Fx,C=C和C=O等基团的相对浓度变化很大。
c. 薄膜的介电常数与膜内F的含量有关,F的含量越高,介电常数越小。退火后,薄膜内F的浓度降低,介电常数增大。
参考文献:
[1] Freire J F L, Maiada C M E H, Jacobsohn L G, et al. Film growth and relationship between microstructure and mechanical properties of a-C?H?F films deposited by PECVD [J]. Diamond Relat Mater, 2001, 10: 125-131.
[2] 肖剑荣, 徐 慧, 李幼真, 等. a-C?H?F薄膜的化学键结构[J]. 中国有色金属学报, 2005, 15(10): 1589-1593.
XIAO Jian-rong, XU Hui, LI You-zhen, et al. Chemical bands structure of fluorinated amorphous carbon films[J]. Chinese Journal of Nonferrous Metals, 2005, 15(10): 1589-1593.
[3] Jeong W Y, Young H L, Bakhtier F. Annealing effects on structural and electrical properties of fluorinated amorphous carbon films deposited by plasma enhanced chemical vapor deposition[J]. Thin Solid Films, 2003, 423: 97-102.
[4] Wang X, H R Harris, Bouldin K, et al. Structural properties of fluorinated amorphous carbon films[J]. J Appl Phys, 2000, 87: 621-623.
[5] 黄 峰, 程珊华, 宁兆元, 等. 真空退火对氟化非晶碳薄膜结构的影响[J]. 物理学报, 2002, 51: 1383-1387.
HUANG Feng, CHENG Shan-hua, NING Zhao-yuan, et al. The influence of annealing in vacuum on structures of a-C?F thin films[J]. Acta Phys Sin, 2002, 51: 1383-1387.
[6] Endo K, Tatsumi T. Fluorinated amorphous carbon thin films grown by helicon plasma enhances chemical vapor deposition for low dielectric constan interlayer dielectric[J]. Appl Phys Lett, 1996, 68: 2864-2866.
[7] Yokomici H, Hayashi T, Masuda A. Changes in structure and nature of defects by annealing of fluorinated amorphous carbon thin films with low dielectric constant [J]. Appl Phys Lett, 1998, 72: 2704-2706.
[8] Liu S, Gangopadhyay S, Sreenivas G, et al. Infrared studies of hydrogenated amorphous carbon (a-C?H) and its alloys (a-C?H, N, F) [J]. Phys Rev B, 1997, 55: 13020-13024.
[9] Yokomichi H, Hayashi T, Tomihiro A, et al. Preparation of fluorinated amorphous carbon thin films[J]. J Non-crystal Solids, 1998, 227/230: 641-644.
[10] 江美福, 宁兆元. 氟化类金刚石薄膜的拉曼和红外光谱结构研究[J]. 物理学报, 2004, 53: 1588-1593.
JIANG Mei-fu, NING Zhao-yuan. Structural analysis of fluorinated diamond-like carbon films by Raman and Fourier transform infrared absorption spectroscopy[J]. Acta Phys Sin, 2004, 53: 1588-1593.
[11] Kawaguchi M, Choi J, Kato T. Vapor deposition of perfluoropolyether lubricant on fluorinated diamondlike carbon surface[J]. J Appl Phys, 2006, 99: 08N108-08N108-3.
[12] LIU Xiong-fei, XIAO Jian-rong, JIAN Xian-zhong, et al. a-C?F?H films prepared by PECVD[J]. Trans Nonferrous Met Soc China, 2004, 14(3): 426-429.
[13] YE Chao, NING Zhao-yuan, CHENG Shan-hua, et al. Optical gap of fluorinated amorphous carbon films prepared by electron cyclotron resonance trifluromethane and benzene plasmas[J]. Diamond Relat Mater, 2004, 13: 191-197.
[14] Buuron A J M, Sanden M C M, Ooij W J, et al. Fast deposition of amorphous carbon films by an expanding cascaded arc plasma jet[J]. J Appl Phys, 1995, 78: 528-540.
[15] XIN Yu, NING Zhao-Yuan, YE Zhao, et al. Optical emission study of CH4+CHF3 ECR plasma and properties of a-C?F?H films[J]. Surf Coat Technol, 2003, 173: 172-177.
[16] Ferrari A C, Robertson J. Interpretation of Raman spectra of disordered and amorphous carbon[J]. Phys Rev B, 2000, 61: 14095-14107.
[17] Jung H, Park H. Structural and electrical properties of co-sputtered fluorinated amorphous carbon film[J]. Thin Solid Films, 2002, 420/421: 248-252.
[18] Beeman D, Silverman J, lynds R, et al. Modeling studies of amorphous carbon[J]. Phys Rev B, 1984, 30: 870-875.
[19] Endo K, Shinoda K, Tatsumi T. Plasma deposition of low-dielectric-constant fluorinated amorphous carbon[J]. J Appl Phys, 1999, 86: 2739-2745.
[20] 黄 松, 辛 煜, 宁兆元, 等. 微波输入功率引起a-C?F薄膜交联结构的增强[J]. 物理学报, 2002, 51: 2635-2639.
HUANG Song, XIN Yu, NING Zhao-yuan, et al. Enhancement of cross-linked structure for a-C?F films caused by microwave input power[J]. Acta Phys Sin, 2002, 51: 2635-2639.
收稿日期:2007-01-22
基金项目:湖南省自然科学基金资助项目(05JJ40135)
作者简介:肖剑荣(1967-),男,湖南洞口人,博士,从事功能材料的研究
通讯作者:肖剑荣,男,博士;电话:0731-8836762;E-mail: csu_xiaojianrong@yahoo.com.cn