�����н���ԭ�ӵ���Ǩ�Ƽ���Խ��淴ӦӰ����о���չ
��Դ�ڿ����й���ɫ����ѧ��2015���8��
�������ߣ����� ���� ������ ������
����ҳ�룺2157 - 2167
�ؼ��ʣ����ӷ�װ���������㣻ǥ�ϣ���Ǩ�ƣ����淴Ӧ�������仯����
Key words��electronic packaging; interconnect solder joint; solder; thermomigration; interfacial reaction; intermetallic compound
ժ Ҫ�����Ӳ�Ʒ�����淢չҪ����ߵķ�װ�ܶȡ����õ����ܺ�С�ijߴ磬ʹ�õ������������صĹ����ܶ��������ߣ��ɴ˲������صĽ��������⣬������Ϊ��Ҫɢ��ͨ�������������ڽ������ϸߵ��¶��ݶȣ��⽫�շ�����ԭ�ӵ���Ǩ�ƣ����������صĿɿ������⡣�Խ������й�Sn-Pb��Sn-Ag��Sn-Ag-Cu��Sn-Bi��Sn-Zn�����������н���ԭ�ӵ���Ǩ����Ϊ�ؼ���������ۺϷ������ܽ���Ǩ�ƶ��������淴Ӧ��Ӱ�죬��������ԭ����Ǩ�ƵĻ������������������ɴ�����Q*�ļ��㷽����������������Ҫ����Ԫ�ص�Q*ֵ�����ָ������������Ǩ���о����ڵ���Ҫ���⣬������δ���о���չ���ƽ�����չ����
Abstract: The electronic products are increasingly demanding for higher packing density, better performance and smaller size, resulting in significant increase of power density applied on devices. The issue of Joule heating becomes more severe and a temperature gradient will form in the solder joints which act as the main heat dissipation channel. As a result, thermomigration of metal atoms will occur, which causes serious reliability problems of the solder joints. The thermomigration of metal atoms in Sn-Pb, Sn-Ag, Sn-Ag-Cu, Sn-Bi, Sn-Zn micro interconnect solder joints as well as the key issues were analyzed synthetically. The effect of thermomigration on interfacial reaction was included. The mechanism and the driving force of thermomigration of metal atoms were explained. The calculation methods for heat transport (Q*) and the values of Q* of main metal elements in solder joints were summarized. The main issues and trends of the studies on thermomigration in micro interconnect solder joints were finally proposed.
���±�ţ�1004-0609(2015)08-2157-10
�� ������ �㣬��������������
(����������ѧ ���Ͽ�ѧ�빤��ѧԺ������ 116024)
ժ Ҫ�����Ӳ�Ʒ�����淢չҪ����ߵķ�װ�ܶȡ����õ����ܺ�С�ijߴ磬ʹ�õ������������صĹ����ܶ��������ߣ��ɴ˲������صĽ��������⣬������Ϊ��Ҫɢ��ͨ�������������ڽ������ϸߵ��¶��ݶȣ��⽫�շ�����ԭ�ӵ���Ǩ�ƣ����������صĿɿ������⡣�Խ������й�Sn-Pb��Sn-Ag��Sn-Ag-Cu��Sn-Bi��Sn-Zn�����������н���ԭ�ӵ���Ǩ����Ϊ�ؼ���������ۺϷ������ܽ���Ǩ�ƶ��������淴Ӧ��Ӱ�죬��������ԭ����Ǩ�ƵĻ������������������ɴ�����Q*�ļ��㷽����������������Ҫ����Ԫ�ص�Q*ֵ�����ָ������������Ǩ���о����ڵ���Ҫ���⣬������δ���о���չ���ƽ�����չ����
�ؼ��ʣ����ӷ�װ���������㣻ǥ�ϣ���Ǩ�ƣ����淴Ӧ�������仯����
��ͼ����ţ�TG111.6 �� �� ���ױ�־�룺A
ZHAO Ning, ZHONG Yi, HUANG Ming-liang, MA Hai-tao
(School of Materials Science and Engineering, Dalian University of Technology, Dalian 116024, China)
Abstract: The electronic products are increasingly demanding for higher packing density, better performance and smaller size, resulting in significant increase of power density applied on devices. The issue of Joule heating becomes more severe and a temperature gradient will form in the solder joints which act as the main heat dissipation channel. As a result, thermomigration of metal atoms will occur, which causes serious reliability problems of the solder joints. The thermomigration of metal atoms in Sn-Pb, Sn-Ag, Sn-Ag-Cu, Sn-Bi, Sn-Zn micro interconnect solder joints as well as the key issues were analyzed synthetically. The effect of thermomigration on interfacial reaction was included. The mechanism and the driving force of thermomigration of metal atoms were explained. The calculation methods for heat transport (Q*) and the values of Q* of main metal elements in solder joints were summarized. The main issues and trends of the studies on thermomigration in micro interconnect solder joints were finally proposed.
Key words: electronic packaging; interconnect solder joint; solder; thermomigration; interfacial reaction; intermetallic compound
����ԭ�ӵ���Ǩ������һ�������������·���������ɢ���Ƶ�����Ǩ�ƹ��̡���Ϊ��ϸ����Ǩ������о�ʼ��1879�꣬�о����֣��Թ������¶Ȳ����ʹ����ҺŨ�Ȳ����ȣ��ȶ˵�����ҺŨ�ȵ�����˵ģ����ƶ��¶��ݶ��������ε�Ǩ��ͨ��[1]�����Ƶأ��ɷ־��ȵĺϽ���һ���¶��ݶ��½���ò����ȡ������Ƚ�����ԭ����ɢ�������ö�ȥ�Ͻ������ΪSORETЧӦ��Ҳ��Ϊ��Ǩ�ƻ��¶��ݶ�������ԭ����ɢ�����ӷ�װ��������ǥ����ҪΪSn����Ԫ���Ԫ�Ͻ���һ���¶��ݶ���Ҳ�ᷢ����Ǩ������[2-3]��
��ǰ�����Ӳ�Ʒ��������ܶȡ������ܡ���ܺ��ͻ������������ڷ���ʱ�����Ľ������ѳ�Ϊ���Ӽ������ٵ���Ҫ����֮һ[4-5]��ͼ1��ʾΪ�� �͵ĵ��ӷ�װ��������ṹʾ��ͼ�����������ڹ���ʱ��оƬ�ྦྷ��ܼ�������߲����Ľ�����Զ���ڻ�������Ľ�����[6]�����ع����ɢ�ȵ����õĺ����Ȼ��Ϊ�������ݵ���Ҫͨ��������ں������γ��¶��ݶ�[7]���������ӹ�ҵ���뼯�ɵ�·(IC)�ĺ�Ħ������ʱ����3D IC��װ��Ϊ��������ģIC�������ij�·֮һ��3D IC��װ��оƬ�Ķѵ�ʹ����������������أ���Ҫ�����ȳ�����ɢ�ȣ���ˣ��������¶��ݶ���������3D IC��װ�㷺������(��-bump)��ͨ��(TSV)����оƬ��������ijߴ��10 ��m���ң��ȵ�װ����ߴ�Сһ������������10 ��m���������¶����1 �棬���γ�1000 ��/cm���¶��ݶȣ������շ�����ԭ�ӵ���Ǩ�ƣ��������صĿɿ�������[4]��
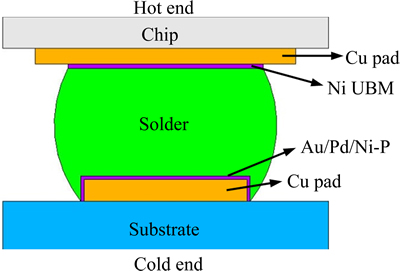
ͼ1 ���ӷ�װ��������ṹʾ��ͼ
Fig. 1 Schematic diagram of micro-electronic packaging interconnect solder joint
ǥ�������½�����(UBM)֮��Ľ��淴Ӧ��Ӱ���װ�����ɿ��ԵĹؼ������淴Ӧ�γɽ����仯����(IMC)��ʵ�ֺ���ұ�����ӵı�Ҫ������������IMC�Ĵ��Ա���ʹ�����ȼ���ò����õ���Ч�� ��[8-9]������ijߴ������С�����½���IMCռ��������ı������������[10]������IMC���������ݻ���ǥ�Ϻͻ������ԭ����ɢ��Ӱ�죬�������¶��ݶ�ʹǥ���н���ԭ�ӵĶ�����ɢ������ǿ��������Ǩ�ƣ���ʹԪ�����·ֲ���������Ӱ�����IMC������������Ӱ�������Ŀɿ���[2, 11]��
�����������������ѧ�߶����������ڵ���Ǩ����������˱����������ڵ�Sn-Pbǥ�ϵ�Ŀǰ����Ǧǥ�ϣ�ȡ���˽�Ϊ��˶�ijɹ���������һЩ��������δ�⡣�������߶Խ������������й�Sn-Pb��Sn-Ag��Sn-Ag-Cu��Sn-Bi��Sn-Zn��ǥ�Ϻ������Ǩ����Ϊ����Ի������淴Ӧ��Ӱ���Լ���Ǩ���о������漰�Ĺؼ�����������ۺϷ�����������������ϱ����������ڿ����������������Ǩ�Ƽ����淴Ӧ�����һЩ�о��������δ�����о����ƽ�����չ����
1 ���������е���Ǩ����Ϊ
1.1 Sn-Pb����
Sn-Pbǥ�ϵ�Ӧ�þ����ƾõ���ʷ������Ǩ����Ϊ���о���Ϊ�ḻ���о�������˼·���д����ԡ��ڶ�Sn-37Pb��װ�������ֱ������ʱǥ�������Ǩ�ƣ���������ȶ�������һ��ʱ����Ǩ�ƿ���ǿ��Ǩ��ЧӦ�������Dz�һ��ʱ����Ǩ�ƽ�������Ǩ��ЧӦ[7]��ͨ���Ľ�ʵ�����������Ǩ�Ƶ�Ӱ�죬����Ǩ�ƽ��ж����о�������ֱ��Ϊ100 ��m��Sn-Pb�������㣬оƬ��ǥ�ϳɷ�ΪSn-97Pb�������ǥ�ϳɷ�ΪSn-37Pb���������¶��ݶȴﵽ1000 ��/cmʱ������Snԭ�����ȶ�оƬ��Ǩ�ƣ�Pbԭ������˻����Ǩ��[12]��OUYANG��[13]��Cu/95Pb5Sn-37Pb63Sn/Cu�������Ժ�������˷ֱ������Դ���ȳ����ں������γ�Լ2500 ��/cm���¶��ݶȣ��۲쵽����ɷַ����ٷֲ�����Ϊ������Sn���ȶ�Ǩ�ƶ�Pb�����Ǩ�Ƶ��µģ���ָ��������Ǩ�Ƶ��¶��ݶ��ż�ֵԼΪ1000 ��/cm���Թ���Sn-37Pb��װ������Ǩ�ƵĽ�һ���о�������ǥ���еIJ�Ƭ�ṹ������Ǩ�ƺ���֯ϸ�������ڲ�Ƭ�ṹ��Ľ��治��������Ǩ����һ���������̣���֯ϸ�����������������ϵ���Ϊ����[14]�����ź�����гɷַ�����Ԫ��Ũ�ȳʽ���ʽ�ֲ�����Ǩ�ƺ�Pb�ں�����˸���Ũ�ȼ������ߣ�Զ����˵�ƽ��Ũ�ȣ��ӳ�ʼ��37%(��������)�½���25%���ң���Զ����˵�Sn��������ԭλ�ã�ƽ��Ũ�ȴӳ�ʼ��63%���ߵ�70%����[2]����֤��Sn-Pb������Ǩ����Pb�������ɷ֡�
���ǣ��������¶�Sn-Pb�������Ǩ���о�ȴ�õ���ͬ��ʵ������TAO��[15]�о���25 ����Sn-Pb���Ϻ������Ǩ�ƣ�����оƬ��ǥ�ϳɷ�ΪSn-97Pb�������ǥ�ϳɷ�ΪSn-37Pb���۲쵽��˳��ִ�����Sn�࣬��ˣ��ڽϸߵ��¶��ݶȺͽϵ͵Ļ����¶��£�SnΪ��Ҫ����Ǩ��Ԫ�أ��������Ǩ�ơ�������¶��ݶȵ�ԭ������ѧ���ۣ���һ��������Sn��Pb����Ǩ����Ϊ��ָ��ǥ��������Ԫ�ؾ����ȶ������Ǩ�ƣ����ڲ�ͬ�¶�������Ԫ�ص���ɢ���ʲ�ͬ��������Ǩ�Ƶ�����Ԫ�ش��ڲ���[16]��
1.2 Sn-Ag����
Sn-Agǥ�Ϲ����ɷ�ΪSn-3.5Ag���۵�Ϊ221 �棬�������������еõ���Ϊ�㷺��Ӧ�á���װ����Cu/Sn-3.5Ag/Cu��150 ������Ǩ��ʱ���ȶ�Cuԭ��ͨ����϶��ɢ��ʽ���ٽ���Sn���壬оƬ��Cu UBM��IMC֮���γɿ�[17]�����ۼ���õ���Cu���¶��ݶȸ���400 ��/cmʱ����Ǩ�������������ڵ����ܶ�Ϊ9.7��103 A/cm2ʱ�ĵ�Ǩ������������Ǩ������Ŀ��ᵼ�º����������·�ȿɿ������⡣
������Ni/Sn-2.5Ag/Ni���˷ֱ������ȳ�����Դ�γ�7380 ��/cm���¶��ݶȣ��۲쵽�����Ľ���Ni3Sn4���������ȶ�Ni�㱻�����ܽ���Ni3Sn4���������ƣ������Ni�����Ľ�����Ni3Sn4����������������Ϊ���¶��ݶ���ʹ�ȶ�Niԭ�������Ǩ �ƣ������ȶ�Ni�㱻�������ģ�ͬʱNiԭ������˻��ۣ��ٽ�����˽��淴Ӧ[18]�����⣬Ag3Sn��������˷ֲ�������ΪAg�����Ǩ�ơ���Ǩ������Ӱ�����IMC��������UBM���ܽ���Ϊ��GUO��[19]��ǥ���º�����Ǩ�Ƶ�ʵ����Ҳ�������Ƶ�����Cu/Sn-2.5Ag/Cu������260 �����̨�ϻ���40 min�۲쵽�ȶ˽���Cu6Sn5 IMC���Ϊ3.5 ��m�������Cu6Sn5 IMC�����ﵽ12.3 ��m�������˽���IMC�������Գ�������ͬʱ���֣����Cu UBM�����������ȶ˵ġ�������Ϊ����Ǩ�������ȶ�Cuԭ�ӿ��������Ǩ�ƣ�һ����ٽ����ȶ�Cu UBM��Һ̬ǥ���е��ܽ⣬��һ����Ǩ�Ƶ���˵�Cuԭ�Ӳ�����淴Ӧ����Cu6Sn5����ʽ�������ٽ�����˽���IMC��������ͨ������Ԫģ��õ������ڵ��¶��ݶȽ�Ϊ51 ��/cm���ɼ�������ԭ����Һ���е���ɢ����Զ�����ڹ����еģ�ǥ�������²�����Ǩ������Ҫ���¶��ݶȻ������������Խ��͡�
1.3 Sn-Ag-Cu����
Sn-Ag-Cuǥ�Ͼ������õ���ѧ���ܡ���ʪ�Ժ� �ɿ��ԣ���Ŀǰ��ߴ����Ե���Ǧǥ�ϡ�����Cu/Sn-4.0Ag-0.5Cu/Cu��1000 ��/cm���¶��ݶ������£�Cu�����Ǩ�ƴ�ʹ�ȶ˽���Cu6Sn5�ܽ⣬������ʱ����С[20]�����ڿ�λǨ�Ʒ����Sn�����ֻ�������ͬ���Լ���Ӧ��ЧӦ���������Ӳ�ȴ���˵��ȶ���С[21]����ԭλ�۲�Sn-3.0Ag-0.5Cu��װ������Snԭ�ӵ���Ǩ������ʱ�������ȶ˳����𣬶���˳��ֿ�������ѹ����ɢ��ʾ�����Ǩ�����λͨ������һ�£�˵����λǨ������Ǩ�Ƶ���������[22]��Sn-3.0Ag-0.5Cu�����ڻ����¶�Ϊ150 �� ʱ��һ���¶��ݶ��±���62 h��۲쵽Snԭ���������ȶ�Ǩ�Ƶ����������¶�Ϊ125 ���������������ʱ����ʹ����341 h����Ȼû��Snԭ�ӵ�Ǩ������˵��125~150 ��֮����ڴ���Snԭ����Ǩ�Ƶ��¶��ż�ֵ����������ɱ�Ӧ��ЧӦ��ɵģ�����Sn��������ȶ�Ǩ�ƣ�������γ���Ӧ�������ȶ��γ�ѹӦ����Sn�ܵ�ָ����˵ı�Ӧ�����ã���Ǩ�����ܵ���Ӧ���ķ���ЧӦ[2]��
��Ǩ�Ƶ��ż���������Ǩ���о���һ���ؼ����⣬�����ڵ���ijһ�ض�ֵʱ����Ǩ�ƽ����ᷢ�������ż���������һ���������Աȵ�װоƬ��װ��3D IC��װ��Ǧǥ�Ϻ���Snԭ�ӵ���Ǩ��[4]����Ǩ�����ͱ�Ӧ��������Snԭ�ӵľ�ͨ��(Jnet)����ʽ���£�
 (1)
(1)
ʽ�У�CΪԭ��Ũ�ȣ�����λ���ԭ�Ӹ�����DΪ��ɢϵ����kΪ��������������TΪ�����¶ȣ�FTM��FBS�ֱ�Ϊ�¶��ݶȺͱ�Ӧ������ԭ��Ǩ�Ƶ������������ڳߴ�Ϊ100 ��m�ĵ�װ���㣬�����¶�ԼΪ150 �桢�¶��ݶ�Ϊ2829 ��/cm��26 h��۲쵽�����ȶ˳���Sn����˳��ֿ��������FTM=8.25��10-18 N��FBS=3.52��10-18 N���ɴ˿�֪��FTMԶ����FBS����Ӧ�������Ե�����Ǩ��������ˣ�Sn��Ǩ����Sn-3.0Ag-0.5Cu��װ����ʧЧ����Ҫԭ����3D IC��װ���㣬�ߴ�Ϊ5.8 ��m�������¶�ԼΪ134 �桢�¶��ݶ�Ϊ5345 ��/cm��644 h��δ�۲쵽���Ե�SnǨ���������FTM=1.62��10-17 N��FBS=6.08��10-17 N��FTMС��FBS����ˣ���Ӧ�����Ե�����Ǩ������Snԭ��Ǩ�Ʋ����ԡ���ˣ�������Snԭ�ӳ�����Ǩ�Ƶ��ٽ������ɱ�ʾΪFTM+FBS=0����
 (2)
(2)
��
 (3)
(3)
ʽ�У���Ϊԭ�������Q*ΪԪ�ش����ȣ���Ϊ���Լ��ޣ���xΪ����߶ȣ�����Ϊ��x( )��Snԭ����Ǩ�Ƶ��ż���������ʽ(3)��֪����������һ��ʱ������Sn��Ǩ���¶��ݶ��ż�ֵ���ź���߶ȵ����Ӷ���С���¶��ż�ֵ�溸��߶ȵ����Ӷ���������Snԭ����Ǩ�Ƶ��������溸��߶ȵļ�С�������ɴ˿ɼ��������������Ǩ����Ϊ���ֳ����(�ߴ�)ЧӦ��
)��Snԭ����Ǩ�Ƶ��ż���������ʽ(3)��֪����������һ��ʱ������Sn��Ǩ���¶��ݶ��ż�ֵ���ź���߶ȵ����Ӷ���С���¶��ż�ֵ�溸��߶ȵ����Ӷ���������Snԭ����Ǩ�Ƶ��������溸��߶ȵļ�С�������ɴ˿ɼ��������������Ǩ����Ϊ���ֳ����(�ߴ�)ЧӦ��
��������Ǩ����Ϊ�IJ���ͨ�������ŵ�Ǩ�ƣ���-����������½���ԭ�ӵ�Ǩ����Ϊ�Է������������֯�ṹ�ݻ��Ϳɿ����о�����ʵ�����塣GU��[23]�о���Cu/Sn-3.0Ag-0.5Cu/Ni������5��103 A/cm2ֱ���������µ�Ǩ�ƺ���Ǩ�Ƶ����ЧӦ�����֣�Ni��Cu�����Ǩ�ƣ�Sn���ȶ�Ǩ�ơ�����ָ������Cuԭ�ӵ�Ǩ�ƹ�������Ǩ��ռ��������Niԭ�ӵ�Ǩ�ƹ����е�Ǩ��ЧӦռ����������Ǩ��ЧӦҲ������ͬ���������ɺ��ԣ���Ǩ�ƶ�SnǨ��ͨ�������ÿ��Ժ��Բ��ơ�LI��[24]�о����֣�Cu/Sn-3.0Ag- 0.5Cu/Cu������ͨ��ʱ�������������Cu���̺ͽ���IMC������������䱡�������������渽����ǥ���г��ִ��Cu6Sn5������ѻ���ģ��õ��������������¶��ݶ�Ϊ2250 ��/cm����������Ǩ��������������Ǩ������������Ǩ�ƿ�����������ԭ����ɢ���̣��������������渽��IMC���쳣�ѻ���SA��[25]ͨ��ʵ��۲쵽Cu/Sn-3.5Ag-0.7Cu/Cu���㾭2��104 A/cm2�ĵ����ܶ����ú��ں���������������Cu6Sn5 IMC�쳣�ѻ���������Ϊ��������ڵ��¶��ݶȵ��½���IMC�쳣������Ǩ�ƺ͵�Ǩ����ʹ������IMC�����ڱ���ѻ�����-�������������������Ŀɿ��Է�����������3D IC��װ�����о���һ���ѵ�ؼ���
��ʵ��Ļ����ϣ��о���������ͼ�������Ϸ�����Ǩ�ƹ��̲��������ϵ�����ģ�ͣ�BASARAN��[26-29]�Դ˹�������ϵ���о������ø���ͬ��Ӳ�������ģ�ͺ;����ֻ�ģ�ͣ��õ�ǥ��ǿ���ܵ�����Ժ��ṹ�ݻ���Ӱ�죬����Ǩ�Ʋ�����Ӧ���������ϵ��������ޣ�ǥ��ǿ�Ƚ��ή��[26]����������ѧ������������ѧ���̡�����Ǩ�ƹ��ɺ��ȴ������̣������Ǩ�ƹ����в������˵���ѧģ�Ͳ�������Ԫ��������ģ�����[27]���ڷ���Sn-3.0Ag-0.5Cu�����Ǩ�ƺ���Ǩ������ʵ��ͼ���ģ��ʱ�������Ǩ�ƺ���Ǩ�Ƶ��²������˵ı��﹫ʽ���Բ��ϵ��ӻ��̶Ƚ��б��������������ӵ�������γɵ��¶��ݶȸߴ�1000 ��/cm����Ϊ����������ʧЧ���ɵ�Ǩ�ƺ���Ǩ�Ƶ����������ɡ��ڵ���ӵ������ͺ����������Ȱߵ㣬�γɵ��¶��ݶ�ʹ����������������Ǩ�ƣ���ʹ������������ֿ�[28-29]��
1.4 Sn-Bi����
����Sn-58Biǥ����Ϊ���нϵ͵��۵�(139 ��)���ܵ���ע��DING��[30]ͨ��ʵ����ƣ��ڳ��»��� (20 ��)�µ����о�Cu/Sn-58Bi/Cu�����н���ԭ�ӵ���Ǩ�ƣ�������Լ3500 ��/cm���¶��ݶ�������100 h�����ȶ˸�Bi����ɢ����Զ����棬����˸�Bi������в��ҿ������档��ˣ�Biԭ�������Ǩ�ơ���Ǩ��200 h��Bi������˼��۸������ԣ������ȶ�IMC�п¿ϴ���ն�����Ҫ����˵Ĵ�öࡣGU��[31-33]��Sn-Bi�������Ǩ����Ϊ����ϵ���о�������Sn-58Bi�����ڵ����ܶ�5��103 A/cm2��50 �������£��γ�527 ��/cm���¶��ݶȣ�ָ��Sn-58Bi����Ǩ�ƹ�����Sn-37Pbǥ�ϵ���Ǩ�ƹ������ƣ�����Ǩ�����Ǩ��ͬ��ʱ��ٽ����淴Ӧ���У���֮�����ƽ��淴Ӧ[31]������ƾջ����ṹ����110 ����ͨ��2.5 A���о�Sn-58Bi��ɺ���к���Ĵ���Ǩ��ЧӦ�����Ǩ�Ƶ����Ч Ӧ[32]���ڵ���������Bi������Ǩ���γɸ�Bi�ࣻ���¶��ݶ��£�Bi��������ۻ����ʵ���Ǩ�����Ǩ�Ʒ�����ͬʱ��������ٽ�Bi��Ǩ�ƣ���֮������Bi��Ǩ�ơ������Au/Ni-P/Cu/Sn-8Zn-3Bi/Ni/Ni-P/Au���Ժ����о�����Ǩ��ЧӦ�����Ǩ�Ƶ����ЧӦ����110 ����ʩ��5��103 A/cm2������ֱ����ʱ�������γ�196 ��/cm���¶��ݶ�[33]��ֱ��ͨ��ʱ�����㵥��Znԭ�ӵ�Ǩ�ƺ���Ǩ�Ƶ������仯�ֱ�Ϊ3.2��10-28��2.2��10-28 J����ֵ�������˵����Ǩ��ЧӦ�͵�Ǩ��ЧӦͬ�����ɺ��ԡ�����ͨ��ʱ��ֻ����Ǩ��ЧӦ����Cu�ĵ����ʱ�Ni��С��Cu��Ϊ��ˣ�ͨ��384 h����˽����γɺ�5.2 ��m�ĸ�Zn�㣬����ΪZnԭ�Ӵ��ȶ������Ǩ�ơ�
1.5 Sn-Zn����
Sn-Znǥ�ϵĹ����۵�(198.5 ��)��Sn-37Pb�Ľӽ�����Ϊ����DZ��Ӧ�ü�ֵ����Ǧǥ�ϺϽ𡣱����������ڿ��������Cu/Sn-1Zn/Cu������Ǩ�ƶ�ǥ�����淴ӦӰ��������о������ͼ2��ʾ�������� 250 ����̨��ǥ�����Ͻ���Ϊ��ˣ��½���Ϊ�ȶˡ�����Ԫ�����õ�ǥ�����γ���Լ35 ��/cm���¶��ݶȣ�ʵ���п������Թ۲쵽�ȶ˺����IMC�����IJ��졣��Ӧ5 minʱ����ˡ��ȶ˽��洦�����������IJ�״Cu5Zn8 IMC���ȶ�IMC�ĺ���Դ�����˵ġ�ǥ��15 min�Ժ��ȶ�ԭ��ճ���ڻ����ϵ�Cu5Zn8 IMC�����䣬ͬʱ���ڻ������γ�Cu6Sn5 IMC����Cu5Zn8��Cu6Sn5��Ⱦ�����������˽���Cu5Zn8 IMC���ܽ⣬��ת��ΪCu6Sn5��(������Znԭ��)����������[34]�о���Ǩ�ƶԺ�����淴Ӧ��Ӱ��ʱͬ���۲쵽�����Ƶ�IMC�������ɼ������ŷ�Ӧ�Ľ��У���˽���Cu5Zn8 IMC���ܽ⡢��ʧ�����ȶ˽���Cu5Zn8 IMC��������˵��Һ̬ǥ����Znԭ�����¶��ݶ������²������ȶ�Ǩ�ơ���������������Ǩ����Ϊ�о����·��֡�
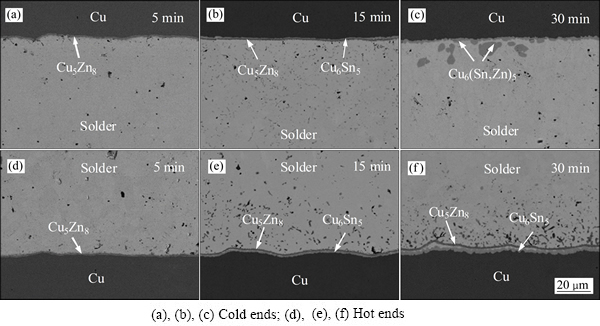
ͼ2 Cu/Sn-1Zn/Cu������250 ����̨ǥ����ͬʱ����SEM��
Fig. 2 SEM images of Cu/Sn-1Zn/Cu solder joints after reflow on hotplate at 250 �� for different time
1.6 ��������
����UBM��IMC������ǥ�ϵ���Ǩ����Ϊ��CHEN��[35]��150 �����о�IMC����Ǩ�ƣ���������Cu-Sn IMC�����Ǩ�ƣ�ͬʱ���ں����ȶ��γɿ�����Ӱ�캸��ɿ��ԡ�����Ni-Sn IMC��ʹ��1400 ��/cm�¶��ݶ�����Ȼδ����Ǩ�ƣ�ͨ����ȵ�Ǩ��������������õ�Ni��Ǩ����Ҫ���¶��ݶ�����Ϊ8050 ��/cm��
��Ǩ�ƿɵ��º���UBM�����ܽ⡣Ti���㷺����Al�ߺ�UBM֮����ɢ�赲�㣬�䴫����Ϊ768 kJ/mol[36]��CHEN��[37]�о���װ������Tiԭ�ӵ���Ǩ�ƣ�Al�ߺ�Sn-3.5Agǥ��֮��Ϊ5 ��m Cu UBM/0.12 ��m Ti������Ԫ�����õ�ʵ��ʱ��Ti�����γ���5800 ��/cm���¶��ݶȣ�Tiԭ�ӻ�úܴ����Ǩ����������ԼΪ1.75��10-17 N�������ȶ������Ǩ�ƣ�����Ti���ܽ�ʧЧ�����Alԭ�ӿ�ʼ�����Ǩ�ƽ���Cu UBM�γ�Al-Cu IMC������Al�����γɴ����Ŀ���
�����������ڿ���������ͬ������ʵʱԭλ�����������о���Ǩ��ЧӦ��Cu/Sn/Cu����ǥ�����淴Ӧ��Ӱ��[38]������Ԫģ����ʾ�������γ���82.2 ��/cm���¶��ݶȡ�ͨ��ͬ������ԭλ�۲쵽�䡢�ȶ�IMC�ķǶԳ���������Cu����ķǶԳ����ܽ⣬������ͼ3��ʾ[38]������γ�Cu6Sn5��Cu3Sn����IMC��Cu6Sn5�������������ȶ�ֻ�γ�Cu6Sn5 IMC���һ���������һ����Ⱥ�ֹͣ��������Ǩ���������������Cu������ܽ⣬���������ȶ�Cu������ܽ⣬���ұ��ܽ��Cuԭ�������Ǩ�ƣ�Ϊ��˽���IMC�Ŀ��������ṩԭ��ͨ�������⣬��Ǩ�ƻ����½���IMC��ǥ����ȴ���γɲ��Գ���ò�����Cu6Sn5 IMC���ȱ�״ת��ΪСƽ��ṹ�����ȶ��Ա���Ϊ�ȱ�״����IMC��������ѧ������֪����Ǩ��ЧӦ�����º�����˽���CuŨ�ȸ����ȶˣ������Sn-Cu��ͼ��֪�����Һ̬���������¶ȸ����ȶ˵ģ�����˵Ĺ���Ƚ�Զ�����ȶ˵ģ���ˣ�Сƽ��״IMC������������γɣ����ȶ����γ��ȱ�״IMC��ͬʱ������Cuԭ�����¶��ݶ����������ȶ������Ǩ�ƣ����Ӳ������ȶ�Cuԭ���ڽ����ϳ����������ȶ�ֻ�γ��ȱ�״IMC��Сƽ��״IMC�����ٶ�(S)����S��2��Tr/G��ʾ(ʽ�У�rΪIMC�������ʰ뾶��GΪ�¶��ݶȣ���TΪ��Թ����)�����ں������G������IMC����������ͬ����SΪ��ֵ�������˿��γ�Сƽ��״IMC�����ȶ�SΪ��ֵ�����γ�Сƽ��״IMC��

ͼ3 ǥ�������к����䡢�ȶ˽���IMC��Ⱥ��ȶ�Cu�ܽ�����ʱ��仯[38]
Fig. 3 Thicknesses of interfacial IMCs at cold and hot ends and dissolved Cu at hot end during soldering[38]
2 ��Ǩ����������Ԫ�ش�����
2.1 ��Ǩ��������
��Ǩ�����¶��ݶ���������������ɢԭ�ӽ������ý�����¶��ݶȿ������������˶��������ڸ������нϸߵ�������������ɢԭ�ӽ������ã���������ԭ����Ǩ�ơ����ݷƿ˵�һ���ɣ�ԭ����ɢ����������ԭ��ͨ���ɻ�ѧ���ݶȾ���
 (4)
(4)
ʽ�У�JΪԭ��ͨ����xΪλ�ƣ���Ϊ��ѧ��[39]����ͬ�����ɢ������������ֵ�Ũ���ݶȷ����෴����Ǩ��ʱ��־������¶��ݶ���ͬ����ˣ���ѧ�Ʊ仯��Ϊ��ֵ�����¶��ݶ���Ϊ��������������Q*Ϊ�����ȣ������T��Q*�ĺ���������Ǩ��ԭ��ͨ��J�ֿɱ�ʾΪ
 (5)
(5)
��ʽ(4)��(5)��֪��Q*���������ͬ�����٣�����ÿ��ԭ�����������ܡ����⣬Q*�ķ���Ҳ������ʽ(5)���壬���ԭ�Ӵ��ȶ��������ɢ��Q*Ϊ����ԭ�Ӵ�������ȶ���ɢ��Q*Ϊ��[2]������ʽ(4)��(5)����Ǩ��������FTM�ɱ�ʾΪ
 (6)
(6)
����Ǩ����������������������[12]�����¶��ݶ�Ϊ1000 ��/cm������ԭ����Ծ����a = 3��10-8 cm����ԭ��Ǩ�ƾ�����¶ȱ仯Ϊ3��10-5 �棬���ܱ仯��Q��1.3��10-27 J���ɵ�FTM��0.4��10-17 N���Աȵ�Ǩ��������FEM���ݱ��������е����ܶ�1��104 A/cm2������ǥ����Ԫ�ص�Ǩ��[40]����Ǩ���������ɱ�ʾΪ[39]
 (7)
(7)
ʽ�У�ȡ���ӵ��e=1.6��10-19 C�������ʦ�=1��10-7 ����m����Ч�����Z*=10����FEM=1.6��10-17 N���ɼ�����Ǩ���������ȵ�Ǩ����ҪС��������С����1��104 A/cm2�ĵ����ܶȿ����շ�����ĵ�Ǩ�ƣ���1000 ��/cm���¶��ݶȽ��������Ǩ�ơ�
��Ψ��Ĺ۵㣬���¶��ݶȶ�Ԫ����ɢͨ����Ӱ����Ũ���ݶȵ�Ӱ�������ƵĴ������Էƿ˶��ɽ�����������Ԫ�����¶��ݶ������£����ݷƿ˵�һ����������ɢͨ��
 (8)
(8)
���Ƶأ�Ҳ���Ը��ݷƿ˵ڶ����ɵ���ɢͨ��
 (9)
(9)
ͨ��ʽ(8)��(9)�ɵõ��ض�����º���������Ԫ�صķֲ���ʱ��Ĺ�ϵ��
2.2 ��Ǩ��Ԫ�ش�����Q*����
ԭ��ͨ��JTM�Ķ���
 (10)
(10)
ʽ�У�AΪ�����������tΪ��Ӧʱ�䣻NΪԭ�Ӹ�����
��ʽ(5)��(10)�ɵ�
 (11)
(11)
�ɼ�������֪��ɢϵ��D��ƽ���¶�T���¶��ݶ� ��ԭ��ͨ��JTM�������ͨ��ʽ(11)ȷ��Q*��ʵ���п�ͨ��ֱ�Ӳ���������Ԫ�����ȷ������ƽ���¶Ⱥ��¶��ݶȣ���ˣ�ȷ��JTM��Q*�ļ���������Ҫ��������Q*�����ʵ�鷽���ܽ����¡�
��ԭ��ͨ��JTM�������ͨ��ʽ(11)ȷ��Q*��ʵ���п�ͨ��ֱ�Ӳ���������Ԫ�����ȷ������ƽ���¶Ⱥ��¶��ݶȣ���ˣ�ȷ��JTM��Q*�ļ���������Ҫ��������Q*�����ʵ�鷽���ܽ����¡�
2.2.1 ������ԭ�Ӻ����IJ���
OUYANG��[14]����Sn-37Pb��װ���㣬������˸�Ǧ���PbŨ�����ʼŨ�ȲCPb=0.32��Ǧ����X=12.5 ��m������Sn-73Pb���ܶȦ�=10.25 g/cm3��Ħ������M=183.3 g/mol������ʱ��t=27 h+20 min��ʵ���¶�Ϊ180 �桢�¶��ݶ�Ϊ1000 ��/cm������ 1.36�� 1014 atom/(cm2��s)����ʽ(11)�ɵ�Pb�Ĵ�����Q*=+25.3 kJ/mol��
1.36�� 1014 atom/(cm2��s)����ʽ(11)�ɵ�Pb�Ĵ�����Q*=+25.3 kJ/mol��
2.2.2 ����ѹ��Ǩ�����IJ���
OUYANG��[41]��ʵ��ǰʹ�þ۽��������ڹ���Sn-37Pb�������ʴ��ֱ��0.1 ��m����200 nm������ѹ����Ϊ��ʾ����2143 ��/cm���¶��ݶ��±���96 h������JSn+JPb=-JV(����JVΪ��λǨ��ͨ����PbΪǨ������Ԫ��)��������Pb�����Ǩ�ƣ���ʾѹ�����෴�����ƶ���ƽ�����릤x = 3.2 ��m��
����Sn-37Pb�ܶȦ�=8.11 g/cm3��Ħ������M=136.39 g/mol������Ǩ��ͨ��Ϊ
 3.3��1013 atom/(cm2��s)������ʽ(11)�����Pb�Ĵ�����Q*=+26.8 kJ/mol��
3.3��1013 atom/(cm2��s)������ʽ(11)�����Pb�Ĵ�����Q*=+26.8 kJ/mol��
2.2.3 UBM�������IJ���
GUO��[19]������Cu/Sn-Ag/Cu������ǥ��ǰ����Cu UBM��ƽ����Ⱦ�ΪX0=(20��1.0) ��m��������260 ����̨��ǥ��40 min�����Cu UBM���ٵ�(17.9��0.2) ��m���ȶ�Cu UBM����ٵ�(15.1��0.1) ��m���ȶ�UBM���ĺ�Ȧ�x=4.9 ��m��Cu���ܶȦ�=8.92 g/cm3��Ħ������M=63.5 g/mol������
 1.49��1016 atom/(cm2��s)������ʽ(11)�����Cu�Ĵ�����Q* =20 kJ/mol��
1.49��1016 atom/(cm2��s)������ʽ(11)�����Cu�Ĵ�����Q* =20 kJ/mol��
2.2.4 Ԫ��Ũ�ȷֲ��IJ���
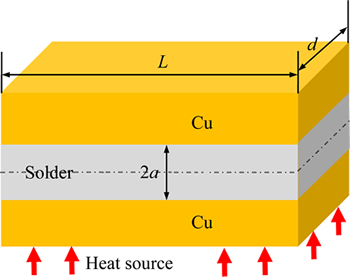
ͼ4 ��Ǩ��ʵ������ʾ��ͼ
Fig. 4 Schematic diagram of tested sample for thermomigration
�������������һ���µĴ����ȼ��㷽������ͼ4��ʾ����Sn-Biǥ��Ϊ�������躸��߶�Ϊ2a����ˮƽ������ɽ������Ϊ�ȶ˺���ˣ������ΪJTM�����Bi��������Ǩ��ǰ��IJ�ֵ����֪ǥ�ϵ��ܶȺ�Ħ���������ֱ����Ǩ�ƺ�����ǥ��(���¶��ݶ�) ʱ��t��ĺ������Ԫ��Ũ�ȷֲ���⣬�ɵõ��¶��ݶ��´�����BiŨ�ȷֲ�f(x)������ǥ���������BiŨ�ȷֲ�g(x)����xΪ����˽���ľ��룬ǥ�ϵ��ܶȺ�Ħ�������ֱ�Ϊ����M��Ϊȷ��JTM����ȡ����L������d�ĺ��㵥Ԫ����Ԫ�����V=Lddx����
Ϊf(x)��g(x)�ں�����˽��浽��������[0, a]��Χ�����������
 (12)
(12)
�������ʽ(11)�ɼ����Bi�Ĵ����ȡ����ڿ�������������(���¶��ݶ�)�½���ԭ������淴Ӧ�����ص����ģ����������ַ�����ȣ�Ũ�ȷֲ����ַ����ɸ�Ϊȷ��ȫ�档
������Q*����Ǩ�ƵĹؼ�����֮һ��ͨ��Q*���¶��ݶȿ��Լ����Ԫ�ص�ǰ�����µ������������Ԫ�ص�Ǩ�ƻ�������ɡ��������߽����ױ�����������������Ҫ����Ԫ�صĴ�����Q*�ܽ����ڱ�1�С�
��1 �����������Ԫ����Ǩ�ƴ�����(Q*)
Table 1 Transport heat (Q*) of metal element in micro solder joints

3 ����ԭ����Ǩ�ƶԺ�����淴Ӧ��Ӱ��
ǥ����UBM֮��Ľ��淴Ӧ��Ӱ���װ�����ɿ��ԵĹؼ������淴Ӧ�γ�IMC��ʵ�ֺ���ұ�����ӵı�Ҫ������������IMC�Ĵ��Ա���ʹ�����ȼ���ò����õ���Ч���ƣ�������IMC���������ݻ���ǥ�Ϻͻ������ԭ����ɢ��Ӱ�죬�������¶��ݶ�ʹǥ���н���ԭ�ӵĶ�����ɢ������ǿ��������Ǩ�ƣ���ʹԪ�����·ֲ�����Ӱ�����IMC��������UBM���ܽ⣬����Ӱ�������Ŀɿ��ԡ��¶��ݶ������º�����ԭ��Ǩ��ʾ��ͼ��ͼ5��ʾ������������洦��Ũ���ݶ������ԭ��Ǩ��(Jchem)���ɱ�ʾΪ[38] Jchem=JGB+JB(ʽ��JBΪ����ɢͨ����JGBΪ������ɢͨ��)���������е�ԭ������˽�����Ǩ�ƣ�����˲����γɽ���IMC��ԭ��ͨ��JIMC1=Jchem+JTM-Jsolder= JGB+JB+JTM-Jsolder(ʽ��JsolderΪ��IMC����ɢ����ǥ�ϵ�ͨ�������ȶ˲����γɽ���IMC��ԭ��ͨ��JIMC2=Jchem-JTM-Jsolder=JGB+JB-JTM-Jsolder)����������߶Ƚ�С���ڳ�ʼ����˺��ȶ˵�Jchem��Jsolder�IJ���ɺ��ԣ���JIMC1��JIMC2�������Ϸ�����֪������ԭ������˽�����Ǩ�ƣ��������Ũ�ȵ����߽������ȶ˵ģ��ٽ����IMC�����������������IMC�ͽϸߵ�����Ũ�Ƚ��������UBM������ܽ⣬��˵�Ũ���ݶ���С���ȶ˵ģ�ʹ��JIMC1��JIMC2�õ�ά�֣����ȶ�����Ũ�Ƚϵͣ�IMC����������ͬʱ���ȶ˻���Ҳ�����ܽ⡣ͬ����������ԭ�����¶��ݶ����������ȶ�Ǩ�ƣ���Ǩ�ƴٽ��ȶ�IMC���������������ȶ�UBM������ܽ⣬��������˻�����ܽ⡣�ɴ˿ɼ��������н���ԭ����Ǩ��ʹǥ����Ԫ�����·ֲ���������Ӱ�����IMC��������UBM���ܽ⡣
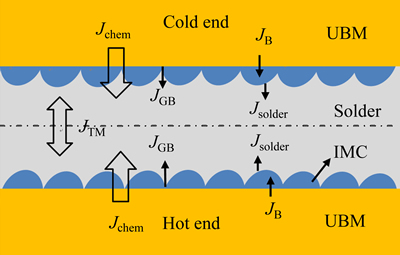
ͼ5 ������ԭ��ͨ��ʾ��ͼ
Fig. 5 Schematic diagram of atomic fluxes in solder joint
4 չ��
����3D IC��װ��������������ٷ�չ�����е���Ǩ���������ԣ���������Ŀɿ�������Ӧ�����ע��Ŀǰ������������Ǩ����Ϊ����Ի������淴ӦӰ��ı�������Ҫ������ԭ�ӵ�Ǩ�ƹ�������ơ�����IMC�ķǶԳ�������UBM�Ĺ����ܽ����ĺ���������ģ�͵ȣ����Դ�����������������о�����Ҫ�������¼������档
1) ǥ����ϵ�ڶ࣬��Ԫ�ص���Ǩ����Ϊ���ϴ�һЩ�о����֮�����ì�ܣ����һ���о�������֤����ȷ��Ǩ��Ԫ�ؼ���Ǩ�Ʒ���
2) ʵ��������Ϊ��һ��ֻ�漰ijһ�ֻ��������أ���ʵ�ʺ���ͨ������Ǩ�ơ���Ǩ�ơ���Ӧ���͵���ӵ��ЧӦ���ۺ����ã���Ҫ��ʵ��������ϼ��Է����ͱ�����
3) ����ǥ��������ǥ��ΪҺ̬����Ǩ����Ϊ�о����٣���Ӧ��Ԫ�ش����Ⱥ���Ǩ���ż��������ݽ�Ϊ�ѷ�������о�ؽ�迪չ��
4) ������Ǩ�Ƶ��½��淴Ӧ�IJ��Գ��ԣ�������ʹ�������γ���Ϳ���ʹ�ú���Ի�е���ػ��������У������������ӵĿ�·����ˣ�������Ҫ������Ǩ����������������Ŀɿ��ԣ�����������Ԥ�⣬Ϊ���Ӳ�ҵ��չ�������֮�ǡ�
REFERENCES
[1] PLATTEN J K. The soret effect: A review of recent experimental results[J]. Journal of Applied Mechanics, 2006, 73(1): 5-15.
[2] CHEN C, HSIAO H Y, CHANG Y W, OUYANG F Y, TU K N. Thermomigration in solder joints[J]. Materials Science and Engineering R: Reports, 2012, 73(9): 85-100.
[3] �Ž���, ��ܲƽ, ������, �� ��. ���ɵ�·�����ṹ�е���Ǩ��[J]. ����ѧ��, 2010, 59(6): 4395-4402.
ZHANG Jin-song, WU Yi-ping, WANG Yong-guo, TAO Yuan. Thermomigration in micro interconnects in integrated circuits[J]. Acta Physica Sinica, 2010, 59(6): 4395-4402.
[4] OUYANG F Y, JHU W C. Comparison of thermomigration behaviors between Pb-free flip chip solder joints and microbumps in three dimensional integrated circuits: Bump height effect[J]. Journal of Applied Physics, 2013, 113(4): 043711.
[5] HUANG M L, YE S, ZHAO N. Current-induced interfacial reactions in Ni/Sn-3Ag-0.5Cu/Au/Pd(P)/Ni-P flip chip interconnect[J]. Journal of Materials Research, 2011, 26(24): 3009-3019.
[6] LAI Y S, KAO C L. Calibration of electromigration reliability of flip-chip packages by electrothermal coupling analysis[J]. Journal of Electronic Materials, 2006, 35(5): 972-977.
[7] YE H, BASARAN C, HOPKINS D. Thermomigration in Pb�CSn solder joints under joule heating during electric current stressing[J]. Applied Physics Letters, 2003, 82(7): 1045.
[8] LAURILA T, VUORINEN V, KIVILAHTI J K. Interfacial reactions between lead-free solders and common base materials[J]. Materials Science and Engineering R: Reports, 2005, 49(1): 1-60.
[9] �Թ���, ʢ����, ����ǿ. Sn-6.5Zn ǥ��/Cu ���庸���������������仯������γɻ���[J]. �й���ɫ����ѧ��, 2012, 22(2): 434-440.
ZHAO Guo-ji, SHENG Guang-min, DENG Yong-qiang. Formation mechanism of intermetallic compounds and interface characteristics of joint of Sn-6.5Zn solder/Cu substrate[J]. The Chinese Journal of Nonferrous Metals, 2012, 22(2): 434-440.
[10] HSIAO H Y, LIU C M, LIN H W, LIU T C, Lu C L, HUANG Y S, CHEN C, TU K N. Unidirectional growth of microbumps on (111)-oriented and nanotwinned copper[J]. Science, 2012, 336(6084): 1007-1010.
[11] ������, ���״�, �� ��. Cu-Ni �������ö� Cu/Sn/Ni ����Һ-�̽��淴Ӧ��Ӱ��[J]. �й���ɫ����ѧ��, 2013, 23(4): 1073-1078.
HUANG Ming-liang, CHEN Lei-da, ZHAO Ning. Effect of Cu-Ni cross-solder interaction on liquid-solid interfacial reaction in Cu/Sn/Ni solder joint[J]. The Chinese Journal of Nonferrous Metals, 2013, 23(4): 1073-1078.
[12] HUANG A T, GUSAK A M, TU K N, LAI Y S. Thermomigration in SnPb composite flip chip solder joints[J]. Applied Physics Letters, 2006, 88(14): 141911.
[13] OUYANG F Y, HUANG A T, TU K. N. Thermomigration in SnPb composite solder joints and wires[C]// KRUSIUS J P. Proceedings of the 56th Electronic Components and Technology Conference. San Diego: IEEE, 2006: 1974-1978.
[14] OUYANG F Y, TU K N, LAI Y S, GUSAK A M. Effect of entropy production on microstructure change in eutectic SnPb flip chip solder joints by thermomigration[J]. Applied Physics Letters, 2006, 89(22): 221906.
[15] TAO Y, DING L, WU Y P, SHANGGUAN D K, WU B Y. Investigation of thermomigration in composite SnPb solder joints[C]// BI K Y. Proceedings of the 11th International Conference on Electronic Packaging Technology & High Density Packaging. Xi��an: IEEE, 2010: 1190-1194.
[16] TAO Y, DING L, WU Y P, WU B, CAI M. Theoretical analysis on the element diffusion during thermomigration[C]// BI K Y. Proceedings of the 12th International Conference on Electronic Packaging Technology & High Density Packaging. Shanghai: IEEE, 2011: 1008-1012.
[17] CHEN H Y, CHEN C, TU K N. Failure induced by thermomigration of interstitial Cu in Pb-free flip chip solder joints[J]. Applied Physics Letters, 2008, 93(12): 122103.
[18] OUYANG F Y, JHU W C, CHANG T C. Thermal-gradient induced abnormal Ni3Sn4 interfacial growth at cold side in Sn2.5Ag alloys for three-dimensional integrated circuits[J]. Journal of Alloys and Compounds, 2013, 580(15): 114-119.
[19] GUO M Y, LIN C K, CHEN C, TU K N. Asymmetrical growth of Cu6Sn5 intermetallic compounds due to rapid thermomigration of Cu in molten SnAg solder joints[J]. Intermetallics, 2012, 29(1): 155-158.
[20] ABDULHAMID M F, LI S D, BASARAN C. Thermomigration in lead-free solder joints[J]. International Journal of Materials and Structural Integrity, 2008, 2(1): 11-34.
[21] ABDULHAMID M F, BASARAN C. Influence of thermomigration on lead-free solder joint mechanical properties[J]. Journal of Electronic Packaging, 2009, 131(1): 011002.
[22] OUYANG F Y, KAO C L. In situ observation of thermomigration of Sn atoms to the hot end of 96.5Sn-3Ag-0.5Cu flip chip solder joints[J]. Journal of Applied Physics, 2011, 110(12): 123525.
[23] GU X, DING K P, CAI J, KONG L W. Electromigration and thermomigration in Sn3Ag0.5Cu solder joints[C]// BI K Y. Proceedings of the 11th International Conference on Electronic Packaging Technology & High Density Packaging. Xi��an: IEEE, 2010: 1273-1279.
[24] LI M Y, CHANG H, PANG X C, WANG L, FU Y G. Abnormal accumulation of intermetallic compound at cathode in a SnAg3.0Cu0.5lap joint during electromigration[J]. Journal of Physics D: Applied Physics, 2011, 44(11): 115501.
[25] SA X Z, ZHOU W, WU P. Electromigration in Cu-cored Sn-3.5Ag-0.7Cu solder interconnects under current stressing[J]. Journal of Electronic Materials, 2014, 43(4): 1144-1149.
[26] BASARAN C, LI S D, ABDULHAMID M F. Thermomigration induced degradation in solder alloys[J]. Journal of Applied Physics, 2008, 103(12): 123520.
[27] LI S D, ABDULHAMID M F, BASARAN C. Simulating damage mechanics of electromigration and thermomigration[J]. Simulation, 2008, 84(8): 391-401.
[28] YAO W, BASARAN C. Computational damage mechanics of electromigration and thermomigration[J]. Journal of Applied Physics, 2013, 114(10): 103708.
[29] YAO W, BASARAN C. Damage mechanics of electromigration and thermomigration in lead-free solder alloys under alternating current: An experimental study[J]. International Journal of Damage Mechanics, 2013, 23(2): 203-221.
[30] DING L, TAO Y, WU Y P. Thermomigration in Sn58Bi solder joints at low ambient temperature[C]// BI K Y. Proceedings of the 12th International Conference on Electronic Packaging Technology & High Density Packaging. Shanghai: IEEE, 2011: 944-949.
[31] GU X, CHAN Y C. Thermomigration and electromigration in Sn58Bi solder joints[J]. Journal of Applied Physics, 2009, 105(9): 093537.
[32] GU X, YUNG K C, CHAN Y C. Thermomigration and electromigration in Sn58Bi ball grid array solder joints[J]. Journal of Materials Science��Materials in Electronics, 2010, 21(10): 1090-1098.
[33] GU X, YUNG K C, CHAN Y C, YANG D. Thermomigration and electromigration in Sn8Zn3Bi solder joints[J]. Journal of Materials Science��Materials in Electronics, 2011, 22(3): 217-222.
[34] ������, ���״�, ������, �� ��. ��Ǩ�ƶ�Ni/Sn3.0Ag0.5Cu/Au/Pd/Ni-P��װ������淴Ӧ��Ӱ��[J]. ����ѧ��, 2012, 61(19): 198104.
HUANG Ming-liang, CHEN Lei-da, ZHOU Shao-ming, ZHAO Ning. Effect of electromigration on interfacial reaction in Ni/Sn3.0Ag0.5Cu/Au/Pd/Ni-P flip chip solder joints[J]. Acta Physica Sinica, 2012, 61(19): 198104.
[35] CHEN H Y, CHEN C. Thermomigration of Cu-Sn and Ni-Sn intermetallic compounds during electromigration in Pb-free SnAg solder joints[J]. Journal of Materials Research, 2011, 26(8): 983-991.
[36] CAHN R W, HAASEN P. Physical metallurgy (Vol. 1)[M]. Amsterdam: North-Holland, 1996: 616-618.
[37] CHEN H Y, LIN H W, LIU C M, CHANG Y W, HUANG A T, CHEN C. Thermomigration of Ti in flip-chip solder joints[J]. Scripta Materialia, 2012, 66(9): 694-697.
[38] QU L, ZHAO
[39] TU K N. Solder joint technology: Materials, properties and reliability[M]. New York: Springer, 2007: 338-345.
[40] ZENG K, TU K N. Six cases of reliability study of Pb-free solder joints in electronic packaging technology[J]. Materials Science and Engineering R: Reports, 2002, 38(2): 55-105.
[41] HSIAO H Y, CHEN C. Thermomigration in flip-chip SnPb solder joints under alternating current stressing[J]. Applied Physics Letters, 2007, 90(15): 152105.
[42] CHUANG Y C, LIU C Y. Thermomigration in eutectic SnPb alloy[J]. Applied Physics Letters, 2006, 88(17): 174105.
[43] HSIAO H Y, CHEN C. Thermomigration in Pb-free SnAg solder joint under alternating current stressing[J]. Applied Physics Letters, 2009, 94(9): 092107.
[44] SU Y P, OUYANG F Y. The growth of Ag3Sn intermetallic compound under a temperature gradient[C]// KOZUE N. Proceedings of the International Conference on Electronic Packaging (ICEP 2014). Toyama: IEEE, 2014: 634-639.
(�༭ ������)
������Ŀ��������Ȼ��ѧ����������Ŀ(51301030); �����У��������ҵ���ר���ʽ���Ŀ(DUT14QY45)
�ո����ڣ�2014-11-15�������ڣ�2015-02-28
ͨ�����ߣ��� ���������ڣ���ʿ���绰��0411-84708430��E-mail: zhaoning@dlut.edu.cn

